
在FOPLP封装工艺中,许多有机材料被用于IC封装。例如,FOPLP技术中引入EMC(有机导电膜)来固定芯片以形成面板样品;引入干膜通过真空压合工艺形成钝化层以保护芯片和RDL层;引入PSPI(光刻胶)作为钝化层以保证芯片的正常功能;引入PR(光刻胶)来辅助形成RDL。

1. 环氧模塑料


图2 FOPLP封装芯片采用的EMC架构
2. 干膜
为了解决液态树脂涂布过程中印刷不均匀、气泡等导致良率下降的问题,以及控制导体厚度、省去半加成法去除铜箔等步骤,干膜技术因其相较于液态树脂的优势而被引入IC封装领域。干膜通常采用真空压合工艺覆盖在晶圆或面板上。在FOPLP技术中,通常引入感光干膜作为钝化层,如图2所示。感光干膜通常由聚乙烯薄膜(PE)、光刻胶薄膜和聚酯薄膜(PET)组成。感光干膜的结构组成如表1所示。PE薄膜作为感光层的载体,用于将混合后的感光材料涂布成膜。PET薄膜是感光干膜的保护层,主要用于隔离氧气、防止分层和机械划伤。其中,光刻胶薄膜又称感光层,是感光干膜最重要的组成部分,主要由光刻胶用感光材料构成。碱溶性树脂作为感光干膜的成膜剂,将感光胶各组分键合形成膜,并作为防腐蚀的假骨架。

表1 感光干膜的结构组成
光聚合物单体在紫外光照射下发生聚合反应,生成聚合物,使感光部分不与显影液熔合,形成耐腐蚀的图像。在曝光过程中,光引发剂吸收紫外光的能量产生自由基,引发光聚合单体发生交联反应。引发的聚合物单体聚合反应发生后,需要在干膜上形成分辨率为10-40um的精细图案,因此对感光层中各材料组分的分配比例要求极高。光刻胶膜的主要成分及供应商如表2所示。

表2 光刻胶膜的主要成分及供应商
3. 感光聚酰亚胺
在FOPLP技术中,通常会引入由有机材料形成的PA层覆盖在RDL层上。PA层的数量通常不止一层,这取决于FOPLP技术的工艺要求。随着技术的发展,PSPI通常被用作FOPLP技术中的PA层,如图2所示。与传统光刻胶相比,PSPI无需使用遮光剂,可以显著减少工艺步骤。同时,PSPI还作为缓冲涂层、辐射屏蔽材料以及层间绝缘材料发挥着重要作用。
PSPI主要有两大应用:光刻胶和电子封装。与传统光刻胶相比,PSPI无需使用遮光剂,可以显著减少工艺步骤。同时,PSPI还作为电子封装粘合剂发挥着重要作用,PSPI还可用作缓冲涂层、钝化层、辐射屏蔽材料、层间绝缘材料以及芯片封装材料。PSPI在微电子工业中也得到了广泛的应用,包括集成电路封装和多芯片组件封装。
目前,已有多家公司开发了PSPI材料,例如东丽株式会社、富士电子材料、HD微系统、锦湖石油化学、旭化成株式会社、长兴材料、JSR株式会社和默克公司。表3列出了全球PSPI主要公司及其市场份额,其中市场份额最大的三家公司分别为东丽株式会社、富士电子材料和HD微系统,其市场份额分别为78%、5.7%和4.8%。中国也有一些公司开展了PSPI相关业务,包括吉林光学电子材料股份有限公司、江苏圣日科技股份有限公司和湖北鼎龙股份有限公司。

表3 PSPI全球领先公司及市场份额
传统正性光刻胶主要由成膜剂(线性酚醛树脂)、感光剂和溶剂三部分组成,均具有良好的感光性。在正性PSPI的分子设计中,期望其在曝光区域可溶解,并在显影过程中被洗掉,同时在未曝光区域也能在显影过程中形成图案。为此,通常在PI中引入一些可溶于稀碱溶液的功能基团,例如羧基。此外,在PSPI的制备中,还添加了PI溶解抑制剂,例如重氮醌磺酸盐类化合物,这些抑制剂在曝光时会分解。根据PSPI光刻胶样品的成像机理,PSPI光刻胶可分为正性光刻胶和负性光刻胶。根据曝光波长,PSPI光刻胶又可分为G线/I线/混合线光刻胶。不同类型的PSPI光刻胶在树脂选择上有明显的差异,常细分为负性酯型PSPI、负离子型PSPI、正性重氮萘醌型PSPI、化学增幅型PSPI等多种类型,如图3所示。负性酯型PSPI的光敏基团通过酯键连接到聚酰亚胺预聚物上,如图3a所示;负离子型PSPI是通过与有机胺化合物反应成盐得到PAA树脂,如图3b所示;正性重氮萘醌(DNQ)型PSPI是通过侧基引入或直接加入邻叠氮萘醌基团来赋予光敏性,如图3c所示;化学增幅型PSPI通常由光致产酸剂(PAG,如PTMA)和基质树脂(PAA)组成,如图3d所示。 PAG在紫外光照射下分解为超强酸,催化基体树脂的分解或交联反应,由于其可回收利用,效率高,具有化学放大效应。

图3 PSPI的分类:(a)负酯型PSPI,(b)负离子型PSPI,(c)正重氮醌型PSPI,(d)化学放大型PSPI
4. 光刻胶
光刻胶通常由四部分组成:树脂型聚合物、感光剂、溶剂和添加剂。树脂型聚合物是一种惰性聚合物基质,用作粘合剂将光刻胶中的不同材料粘合在一起。树脂型聚合物还赋予光刻胶的机械和化学性能,例如粘附性、柔韧性和热稳定性。树脂型聚合物对光不敏感,在紫外光照射后不会发生化学变化。感光剂是光刻胶中的感光组分,能够与光(尤其是在紫外光区)的辐射能发生反应。溶剂使光刻胶保持液态,以便将其涂覆到硅片基底上。添加剂用于控制和改变光刻胶的特定化学性质或光响应特性。
目前,半导体光刻胶的核心技术基本被日本和美国公司垄断,包括JSR、TOK、罗姆哈斯、信越和富士胶片。 JSR、TOK、ROHMHAAS、ShinEtsu、FUJIFILM在全球光刻胶市场的占有率分别为28%、21%、15%、13%、10%。半导体光刻胶是技术含量最高、价格最昂贵的材料。根据曝光波长,半导体光刻胶可分为g线(436nm)、i线(365nm)、KrF光刻胶(248nm)、ArF光刻胶(193nm)和EUV光刻胶(13.5nm)五大类,如表5所示。ArF光刻胶和EUV光刻胶主要用于12英寸晶圆,g线光刻胶/i线光刻胶/KrF光刻胶主要用于6英寸或8英寸晶圆。其中ArF光刻胶是目前分辨率最高的半导体光刻胶。 g线和i线光刻胶是目前市场上应用最为广泛的光刻胶。

表4 半导体工业使用的主要光刻胶类型
为了形成RDL层,FOPLP技术中使用的光刻胶结构如图4所示。通过电镀工艺在晶圆的整个表面形成未图案化的Cu层,然后在Cu层上进行光刻,形成图案化的PR层。采用湿法刻蚀工艺形成图案化的Cu层。在湿法刻蚀过程中,PR层未开孔的区域可以防止下方Cu层被去除,而PR层开孔区域下方的Cu层则被去除。最后,去除图案化的PR层,形成图案化的RDL层。
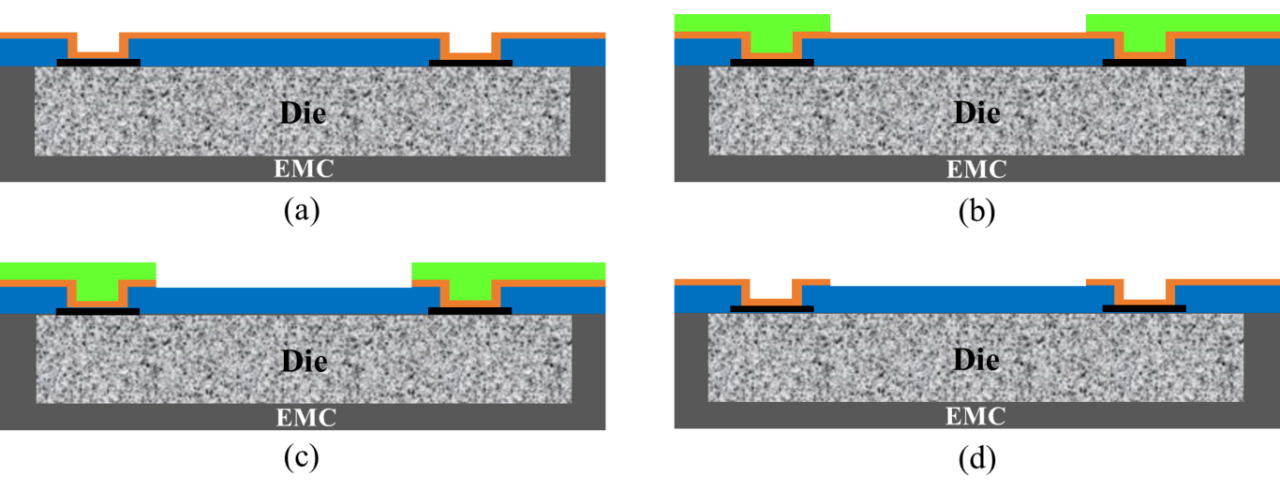
图4 FOPLP技术中使用光刻胶的工艺流程:(a)面板上铜层沉积,(b)在铜层上形成光刻胶图案,(c)在铜层上进行蚀刻工艺,(d)去除光刻胶
来源:刘继康. FOPLP IC封装技术简介. Authorea.
DOI:10.22541/au.172657747.74655822/v1

|
序号 |
拟定议题 |
演讲单位 |
|
1 |
PEEK材料在半导体不同制程中的应用 |
邀请中 |
|
2 |
PPS材料在半导体领域的应用 |
邀请中 |
|
3 |
半导体级PP材料应用与研究 |
邀请中 |
|
4 |
特种工程塑料型材在半导体设备领域应用 |
邀请中 |
|
5 |
氟塑料在酸碱制程中的耐腐蚀性能极限测试方法论 |
邀请中 |
|
6 |
半导体级氟塑料国产化进展 |
邀请中 |
|
7 |
半导体级氟塑料(PFA)管材挤出工艺 |
邀请中 |
|
8 |
氟橡胶在半导体设备密封领域的应用 |
邀请中 |
|
9 |
高性能橡胶在半导体制造热管理中的创新应用:耐高温密封与高效散热技术 |
邀请中 |
|
10 |
半导体晶圆传输系统橡胶缓冲材料的抗损伤与抗静电协同优化技术 |
邀请中 |
|
11 |
塑料晶圆载具中的应用 |
邀请中 |
|
12 |
IC托盘材料选型 |
邀请中 |
|
13 |
CMP保持环材料耐磨性提升 |
邀请中 |
|
14 |
晶圆清洗花篮的材料介绍 |
邀请中 |
|
15 |
先进封装光罩盒的新需求 |
邀请中 |
|
16 |
半导体微污染控制:析出物检测与工艺适配 |
邀请中 |
|
17 |
抗静电ABS在半导体制程中的应用 |
邀请中 |
|
18 |
抗静电PC/PVC洁净室板材表面处理技术 |
邀请中 |
|
19 |
全球PFAS法规收紧对含氟高分子供应链的影响与替代材料开发进展 |
邀请中 |
|
20 |
终端对半导体材料的需求及应用趋势 |
邀请中 |
更多议题征集中,创新演讲及赞助请联系Mickey周小姐: 18320865613(同微信)
报名方式一:加微信并发名片报名
电话:艾果儿 18312560351(同微信)
邮箱:ab008@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
报名方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名:
https://www.aibang360.com/m/100258?ref=172672

