目前各大工厂都在追求车间无人化,设备自动化程度成为行业是否先进的代名词,现代数字图像处理技术的发展为图像识别系统的形成奠定了理论基础,使晶圆能够实现自动识别和对准。
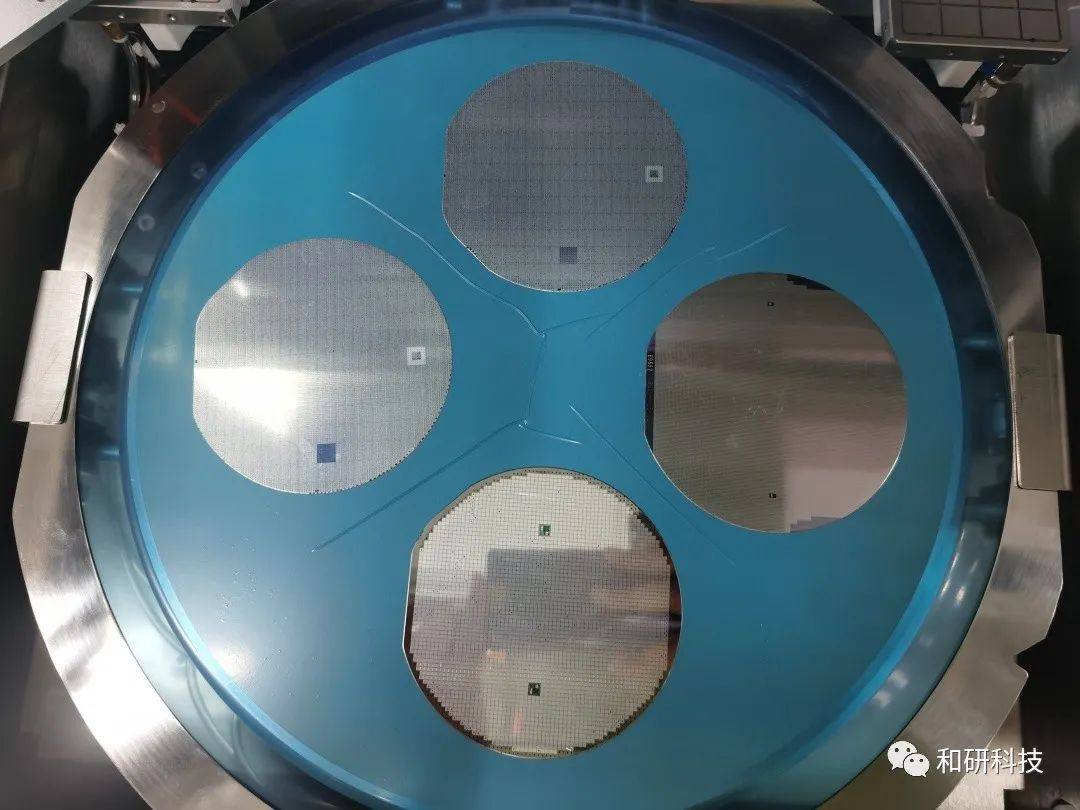
在实际生产制程中,一台12寸划片机一般只会加工12寸产品,如果工厂需要使用12寸设备切割8寸产品,一般会有两种处理方式:第一种,将原来12寸的陶瓷吸盘更换成8寸吸盘,同时搬运系统也要改成8寸规格,这样的话每次切换产品都会导致宕机,同时人工成本也会有所增加;第二种,不改变陶瓷吸盘尺寸,直接用12寸frame贴8寸wafer,这种做法虽然节省了时间和人工,但是会产生衬底胶膜的浪费,增加耗材成本,显然如果更换6寸、4寸产品问题会更明显。

为了满足客户12寸机型兼容5寸及以下晶圆的切割,沈阳和研科技有限公司开发了能够实现12寸frame贴多片5寸以下晶圆同盘自动切割,为工厂产品线扩充提供了方便。

原文始发于微信公众号(和研科技):和研科技:同一frame内多片wafer切割工艺

