
随着社会的发展,电子产品都在追踪小型化、高速化,目前集成电路最先进的工艺制程已经达到3nm,集成电路制造设备的资本投入越来越高,仅有少数几家晶圆龙头有能力继续往先进制程突破。
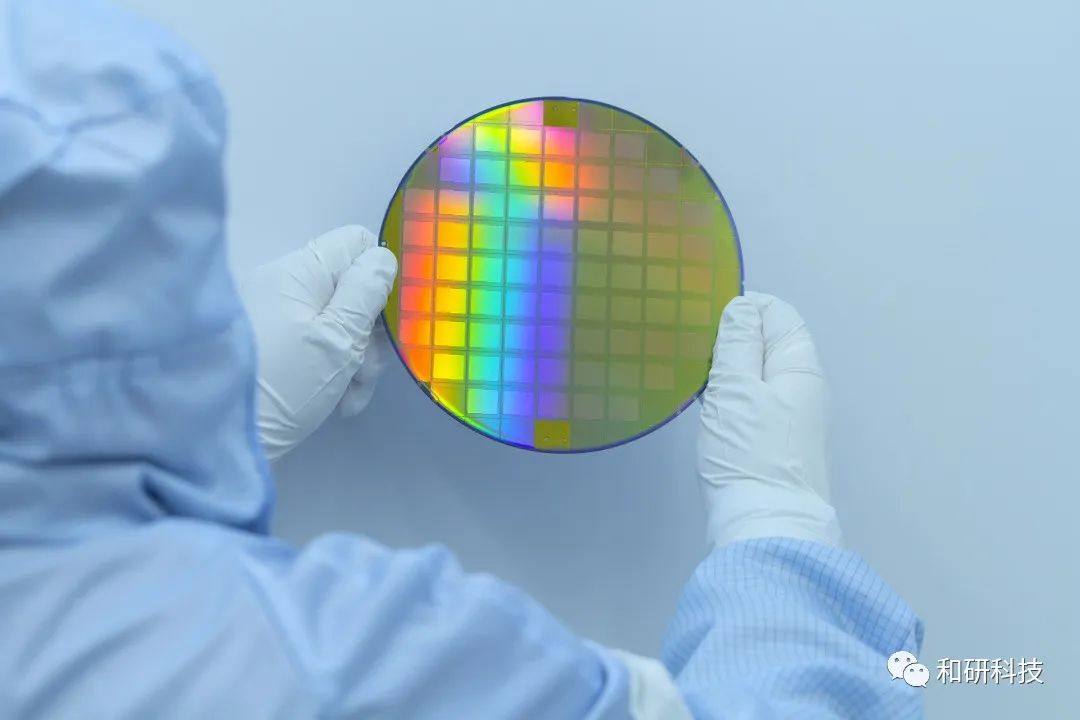
制程越先进,生产技术与制造工序越复杂,制造成本呈指数级上升趋势,所以大家开始考虑从封装角度去突破,这时先进封装孕育而生。先进封装是相对于传统封装来说的,相较于传统封装有以下3个特点。

1
功能密度的提升
先进封装在功能相同的情况下,可以减少空间占用;
2
缩短互连长度
从最开始对传统封装中,引线穿过外壳和引脚需要数十毫米甚至更长,延时和功耗都比较可观,先进封装将互联长度从毫米级缩短至微米级,使得性能和功耗都得以提升;
3
实现系统重构
电子系统的构建亦可以在芯片级基板级进行,在封装内部即可实现所谓系统级封装。
如何实现先进封装
1 ►Bumping(植球)工艺
首先第一个功臣就是Bumping(植球)工艺,它来源于倒装芯片所需的焊球,而倒装芯片一定程度上替代了引线键合,为此后产生的多种封装形式提供了基础,可谓迈进先进封装的第一步。
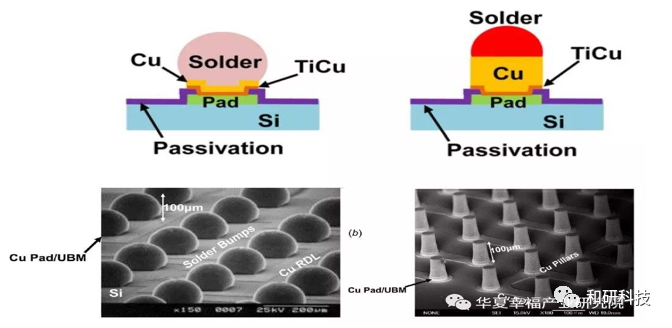
2 ► RDL(重布线)
第二个不可或缺的工艺叫做RDL(重布线),他的作用主要是为2D平面上的芯片电气延伸与互连提供媒介。芯片的I/O触点通常分布在边沿或者四周,直接进行芯片倒装会因缺少引线或引线过于密集而导致连接受限,RDL则可将这些触点重新布局到占位更为宽松的区域,并形成面阵列排布,以此减少后续的封装或表面贴装的难度。RDL的完成要用到镀膜、光刻、刻蚀等制程,故而很多晶圆厂制造起来比封测厂要有经验的多。
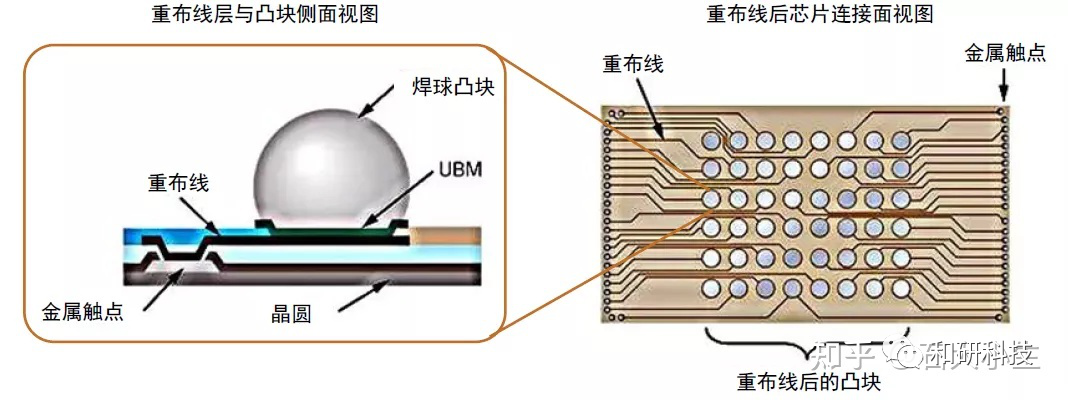
3 ►TSV(硅通孔)工艺
最后要说的是TSV(硅通孔)工艺,它主要用于立体封装,在垂直方向上为芯片起到电气延伸和互连的作用。按照集成类型的不同TSV分为2.5D和3D,2.5D通孔位于中介层,而3D通孔贯穿芯片本身,直接连接上下层芯片。直接互联上下两片结构相同的芯片能够实现大带宽、低时延的数据传输,一定程度上消除了芯片外存储器件总线速度慢、功耗高的缺点。这一特性与存储器行业的需求不谋而合,因此TSV大量应用于高端Flash和DRAM堆叠中。因此,就存储器而言,TSV已从封装技术变为整颗芯片制造过程中的重要组成部分。
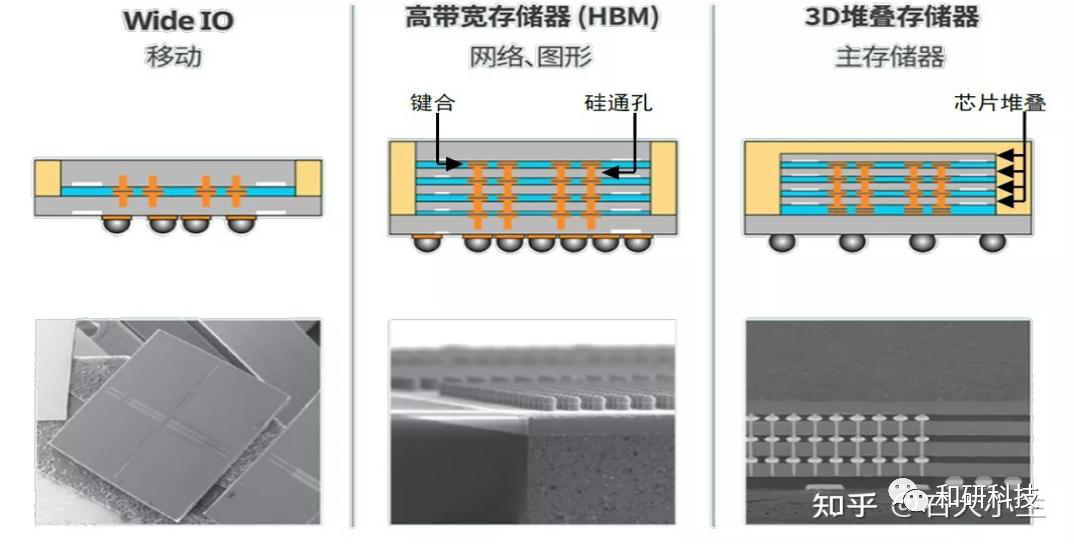
在先进封装家族中,无论是英特尔(EMIB、Foveros、Foveros Omni、Foveros Direct)、台积电(InFO-OS、InFO-LSI、InFO-SOW、 InFO-SoIS、CoWoS-S、CoWoS-R、CoWoS-L、SoIC)、三星(FOSiP、X-Cube、I-Cube、HBM、DDR/LPDDR DRAM、CIS)、ASE(FoCoS、FOEB)、索尼( CIS)、美光 (HBM)、SKHynix (HBM) 还是YMTC (XStacking),他们的封装的各不相同,而且这些封装类型也被我们所有最喜欢的 AMD、Nvidia 等公司使用。

原文始发于微信公众号(和研科技):什么是先进封装及如何实现



