在现代半导体芯片的精密制造中,高分子材料扮演着不可或缺的角色。它们不仅是工艺实现的媒介,更是推动制程技术持续微缩的关键驱动力。
以下是在核心制程环节中发挥重要作用的高分子材料,如有不足或遗漏,欢迎大家加群补充。


光刻胶可分为EUV 光刻胶、ArF 干式及漫没式光刻胶、KrF 光刻胶、i/G 线光刻胶,为主体成像材料,具有在特定光波长下感光功能。
作为图形载体及图形向衬底转移时的掩膜材料,是最关键的光刻材料。
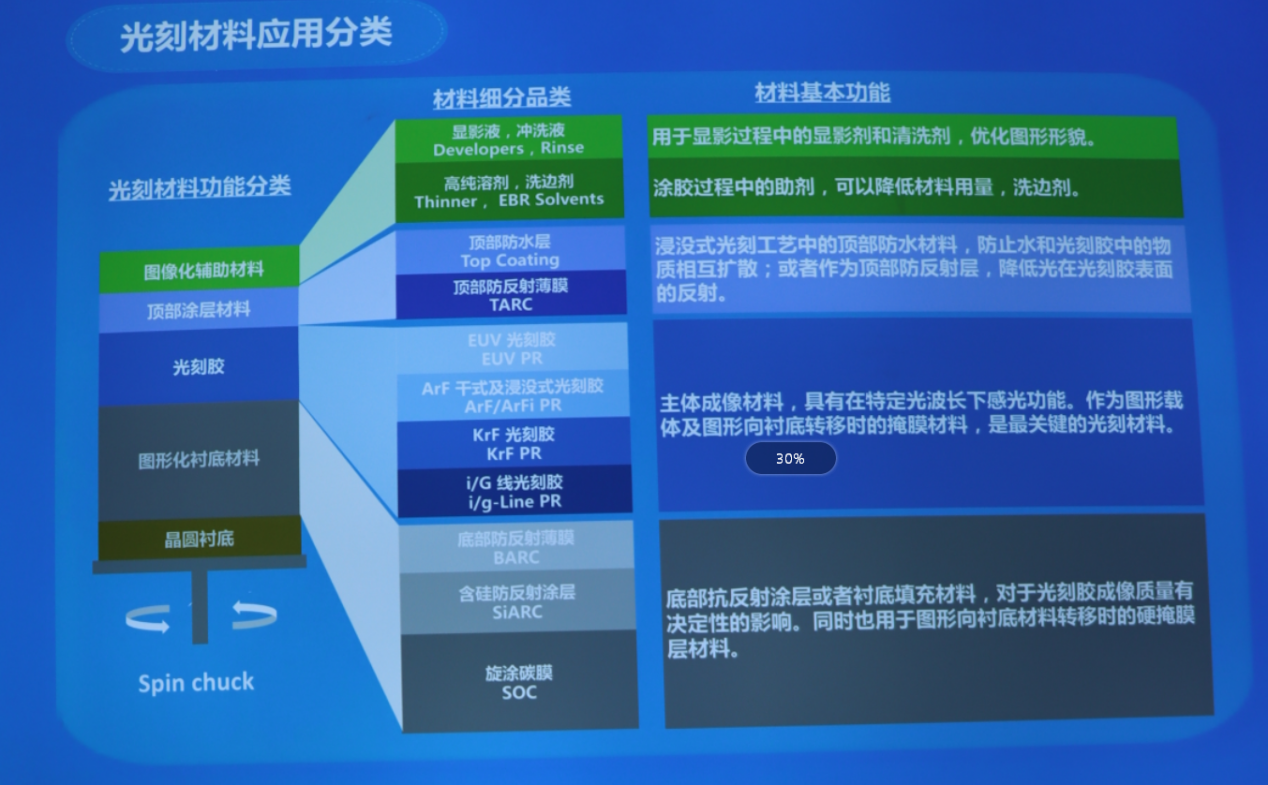
图摄于恒坤
2.正性光刻胶:
曝光区域溶解于显影液(如DNQ-酚醛树脂体系)。线条边缘清晰,占据主流地位。
3.负性光刻胶:
曝光区域交联固化(如环化橡胶-双叠氮体系),未曝光区域溶解。成本较低但分辨率受限。
4.化学放大光刻胶:
核心材料为 PHS(聚对羟基苯乙烯) 及其衍生物。利用光酸催化剂实现“化学放大”,大幅提升感光度与分辨率,是 KrF、ArF 浸没式光刻主流。
EUV 光刻胶则需特殊设计(金属氧化物或分子玻璃)。
5.抗反射涂层:
-
底部抗反射涂层:常用聚酰亚胺或旋涂碳材料,吸收/消除入射光反射,减少驻波效应。
-
顶部抗反射涂层:多为含光吸收基团的丙烯酸酯类聚合物,涂覆于光刻胶表面。
1.硬掩模材料:
-
旋涂碳层:高分子前驱体(如酚醛树脂)经高温处理转化为无定形碳,具有优异蚀刻选择性。
-
旋涂二氧化硅:含硅高分子(如硅倍半氧烷)经烘烤形成 SiO₂ 状薄膜。
2.蚀刻阻挡层/剥离工艺牺牲层:
-
聚酰亚胺:兼具耐高温、优异绝缘性和化学稳定性。
-
PMMA:常用作剥离工艺中的牺牲层材料,易溶于特定溶剂。
抛光垫:通常由改性聚氨酯发泡制成,其硬度、孔隙率和弹性直接影响抛光速率和晶圆表面均匀性。
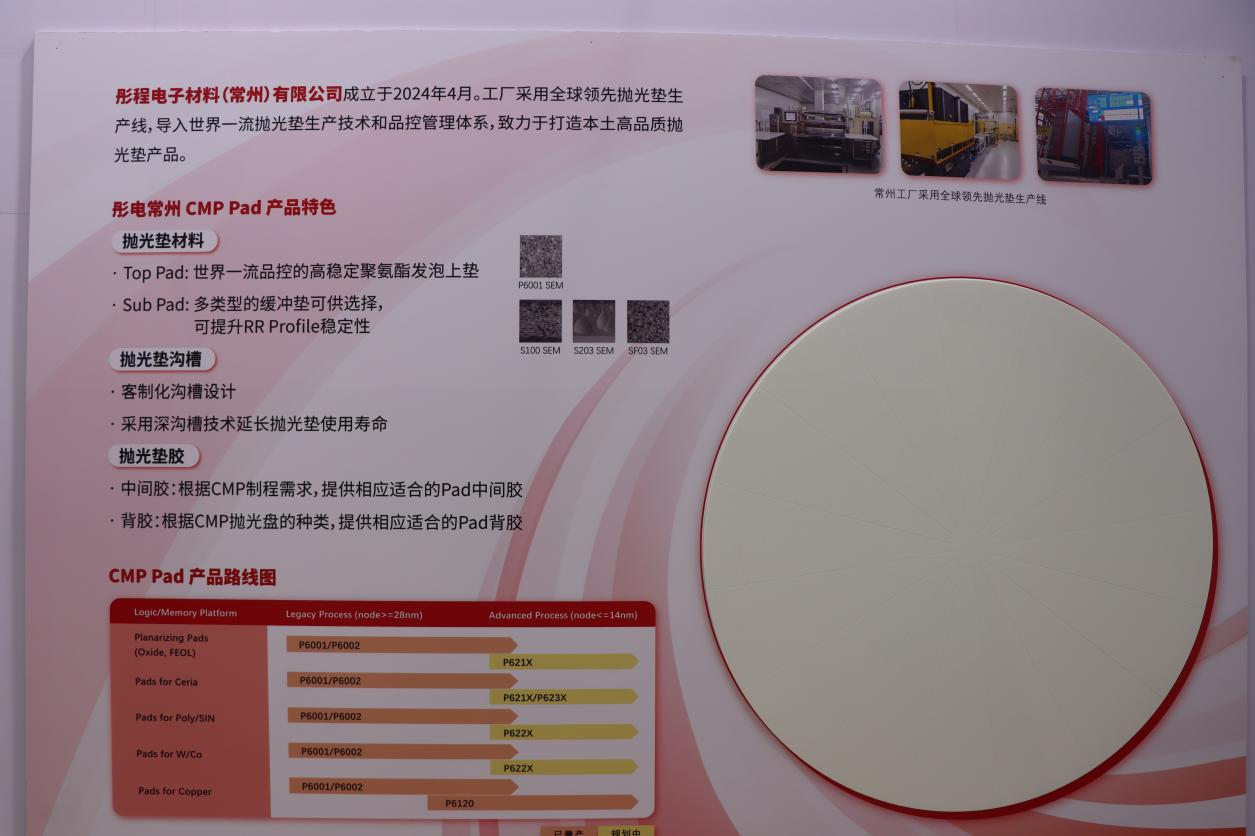
抛光垫图摄于2025SEMICON 彤程新材展台

研磨环图摄于2025SEMICON恩欣格展台
旋涂介电材料
-
聚酰亚胺前驱体:旋涂后亚胺化,形成绝缘层。
-
苯并环丁烯:低介电常数、优异平坦化能力、低吸湿性。
-
多孔低κ材料:常在 SiLK(聚芳醚)等骨架中引入纳米孔隙,降低介电常数。
封装树脂:
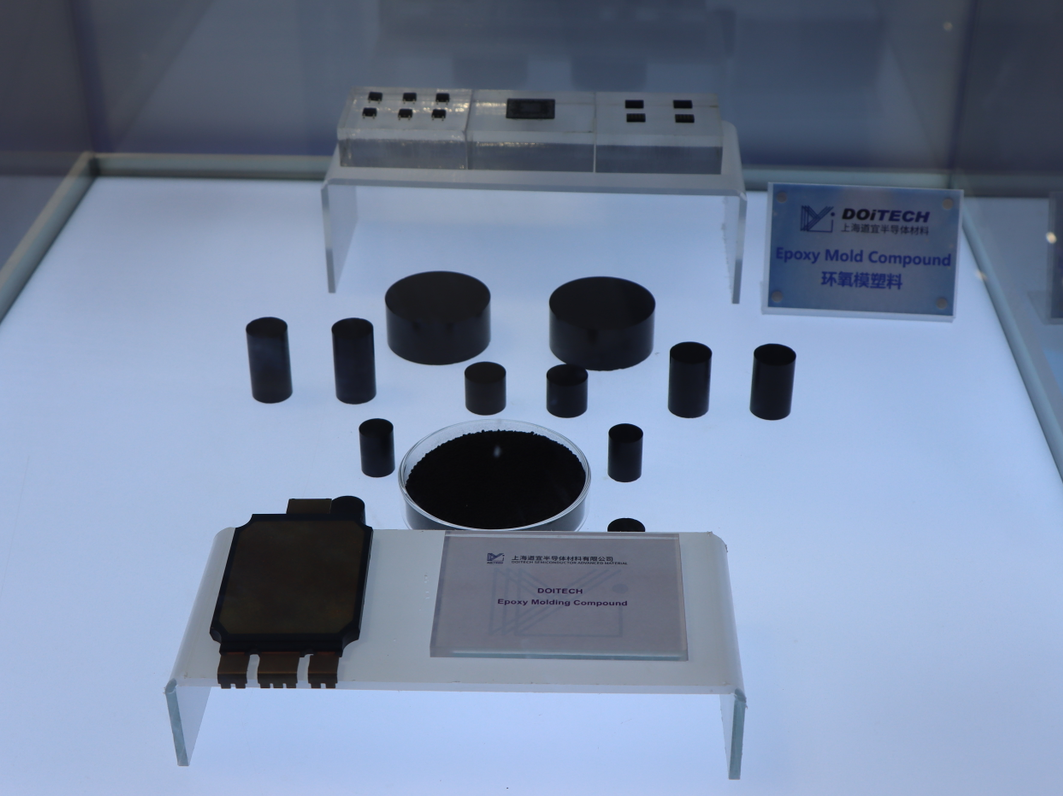
环氧模塑料图摄于semicon2025道宜半导体材料展台
环氧树脂:主流材料,成本低、工艺性好、机械与绝缘性能可靠。
SiP技术趋势对环氧树脂塑封料(EMC)的要求包括:适用于狭缝间隙/狭窄间距的出色的填充能力;翘曲的控制;耐分层/耐焊料挤出等。

聚酰亚胺:用于高端封装中的应力缓冲层、钝化层、柔性基板。
底部填充胶:环氧树脂体系,填充芯片与基板间隙,缓解热应力。
临时键合胶:特殊聚酰亚胺或环氧树脂,在薄晶圆加工中提供支撑,完成后易于剥离。
柔性基板:聚酰亚胺薄膜 是核心材料,耐高温、柔韧、尺寸稳定。
光敏绝缘介电材料:光敏聚酰亚胺或BCB,用于扇出型封装中的重布线层。
电镀模具:厚光刻胶(如 SU-8 环氧树脂)用于制造电镀所需的深沟槽结构。
清洗与保护:可剥离丙烯酸酯类保护涂层。
1.超高纯度:金属离子杂质需控制在 ppb 甚至 ppt 级,避免污染和器件失效。
2.精确可控的物理化学性质:分子量、分子量分布、官能团、玻璃化转变温度等需高度均一。
3.极端工艺耐受性:耐高温、耐等离子体、耐强酸强碱及各种溶剂腐蚀。
4.纳米级加工性能:分辨率、线边缘粗糙度、图案保真度要求极高。
5.低介电常数与损耗:互连层材料需降低信号延迟和串扰。
从光刻胶在硅片上绘制最初的蓝图,到封装树脂为芯片穿上坚固的“盔甲”,高分子材料贯穿了半导体制造的全链条。
随着制程节点不断突破(如 EUV 光刻)和先进封装技术(如 3D 集成、Chiplet)的兴起,对高分子材料提出了更严苛的要求:更高分辨率、更低介电常数、更优热机械性能和更高纯度。
新型高分子(如更先进的聚酰亚胺、自组装材料、分子玻璃)和纳米复合材料(如聚合物/无机杂化材料)的研发,将持续推动半导体技术向更小、更快、更强、更节能的方向发展。
在这个微观世界的精密舞台上,高分子材料正扮演着越来越耀眼的角色。
【邀请函】艾邦首届半导体高分子材料应用发展论坛(2025年10月30日,无锡)
演讲议题(持续更新中)
|
序号 |
拟定议题 |
演讲单位 |
|
1 |
PEEK材料在半导体不同制程中的应用 |
邀请中 |
|
2 |
PPS材料在半导体领域的应用 |
邀请中 |
|
3 |
半导体级PP材料应用与研究 |
邀请中 |
|
4 |
特种工程塑料型材在半导体设备领域应用 |
邀请中 |
|
5 |
氟塑料在酸碱制程中的耐腐蚀性能极限测试方法论 |
邀请中 |
|
6 |
半导体级氟塑料国产化进展 |
邀请中 |
|
7 |
半导体级氟塑料(PFA)管材挤出工艺 |
邀请中 |
|
8 |
氟橡胶在半导体设备密封领域的应用 |
邀请中 |
|
9 |
高性能橡胶在半导体制造热管理中的创新应用:耐高温密封与高效散热技术 |
邀请中 |
|
10 |
半导体晶圆传输系统橡胶缓冲材料的抗损伤与抗静电协同优化技术 |
邀请中 |
|
11 |
塑料晶圆载具中的应用 |
邀请中 |
|
12 |
IC托盘材料选型 |
邀请中 |
|
13 |
CMP保持环材料耐磨性提升 |
邀请中 |
|
14 |
晶圆清洗花篮的材料介绍 |
邀请中 |
|
15 |
先进封装光罩盒的新需求 |
邀请中 |
|
16 |
半导体微污染控制:析出物检测与工艺适配 |
邀请中 |
|
17 |
抗静电ABS在半导体制程中的应用 |
邀请中 |
|
18 |
抗静电PC/PVC洁净室板材表面处理技术 |
邀请中 |
|
19 |
全球PFAS法规收紧对含氟高分子供应链的影响与替代材料开发进展 |
邀请中 |
|
20 |
终端对半导体材料的需求及应用趋势 |
邀请中 |
更多议题征集中,创新演讲及赞助请联系Mickey 周小姐: 18320865613(同微信)
报名方式一:加微信并发名片报名
电话:艾果儿 18312560351(同微信)
邮箱:ab008@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
报名方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名:
https://www.aibang360.com/m/100258?ref=172672
阅读原文,即可报名!
一颗芯片的制造工艺非常复杂,需经过几千道工序,加工的每个阶段都面临难点。欢迎加入艾邦半导体产业微信群:

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊


