IC封装过程中使用的高分子材料主要包括环氧塑封料、有机硅封装材料、底部填充胶、聚酰亚胺材料等,它们在保护芯片、提升可靠性、散热及电气连接等方面发挥关键作用。

以下是主要材料类别及代表性企业的详细分析,如有遗漏或错误,欢迎大家加群补充交流。


EMC
环氧塑封料(EMC)


1
环氧塑封料是IC封装中用量最大的高分子材料(占封装材料成本的60%以上)。
由环氧树脂、酚醛树脂固化剂、硅微粉填料及助剂组成,通过热固化形成保护壳体,具备绝缘、耐湿、导热和机械支撑功能。

摄于 semicon2025圣泉电子展台
2
国内代表性企业:
1.江苏华海诚科新材料有限公司

国内环氧塑封料龙头,产品覆盖DIP、SOP、QFN等封装形式,并开发了应用于BGA、SiP、FOWLP等先进封装的高端EMC。

图片来源于华海诚科官微
已通过长电科技、华天科技等封测大厂认证,逐步替代进口产品。
2.衡所华威电子有限公司

全球领先的环氧模塑料供应商,产能世界第二。其产品覆盖0.35μm以下高端集成电路封装,国内市场占有率达35%,主导制定了《环氧塑封料》国家行业标准。

3.北京康美特科技股份有限公司

LED环氧模塑料性能对标杜邦、信越等国际企业,应用于SMD、COB封装,客户包括兆驰股份、国星光电等LED封装企业。
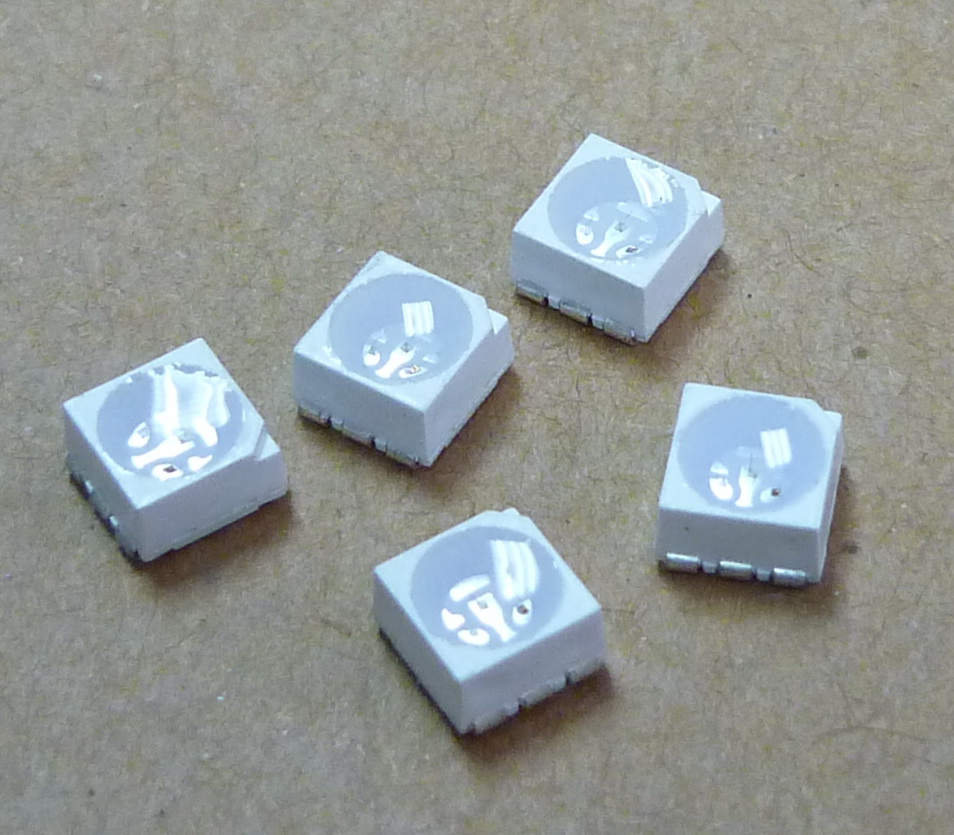
LED封装用环氧树脂灌封胶 KMT-2091

此外国内外环氧塑封料(EMC)相关企业还包含飞凯材料,上海道宜半导体,圣泉电子,万华化学,NAGASE长濑,力森诺科,住友、Panasonic松下、康美特科技、中科科化新材、中新泰合电子、中鹏新材、天津凯华、长春封塑料、创达新材、德高化成、玟昕科技等。
包括但不仅限于以上提及企业,更多欢迎大家补充。

Silicone
有机硅封装材料


1
有机硅材料耐高温(-50℃~250℃)、柔韧性好、透光率高,主要用于LED芯片封装、传感器密封等场景。

德高化成 TECORE® TS系列荧光硅胶膜
2
代表性企业:
1.北京康美特科技股份有限公司

国内Mini LED有机硅封装胶量产先驱,技术达国际先进水平。其高折射率有机硅胶应用于京东方、三星等显示巨头的Mini/Micro LED封装。
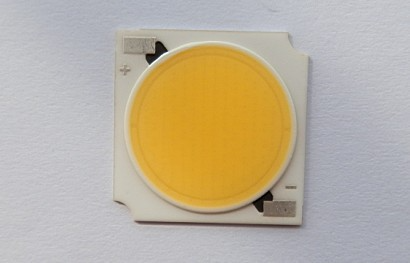
KMT-高折射率LED有机硅胶

KMT-高折射率LED有机硅胶产品性能表
2.德高化成新材料股份有限公司

开发耐400℃高温的有机硅封装胶,适用于GaN-SiC功率器件封装,打破日本技术垄断。
其荧光碳量子点改性有机硅技术提升LED封装效率50%。

TECORE® TS系列荧光硅胶膜
德高化成荧光硅胶膜材料的发明将逐一点胶的分立过程简化成为集成化封装,大大提高了LED封装的效率、一致性,同时也降低了白光LED的制造成本。
包括但不仅限于以上企业,更多欢迎大家补充。



Underfill
底部填充胶与电子胶黏剂


1
底部填充胶用于填充芯片与基板间隙,缓解热应力;电子胶黏剂则用于芯片粘结、密封等。
2
代表性企业:
1.江苏华海诚科新材料有限公司

开发FC-BGA封装用底部填充胶,通过客户验证,未来将用于HBM高带宽存储封装。

图片来源于衡所华威官微
2.德高化成新材料股份有限公司

提供光固化/热固化电子胶黏剂,应用于MEMS传感器和车规级芯片封装,其清润模材料缩短固化时间60%。
包括但不仅限于以上企业,更多欢迎大家补充


Pl
聚酰亚胺(PI)与特种树脂


1
聚酰亚胺具备优异耐高温性、低介电常数和机械强度,用于柔性基板、应力缓冲层等;特种树脂如呋喃树脂用于耐腐蚀封装。

摄于 CHINAPLAS2025黄山金石木展台
2
代表性企业:
1.山东永创材料科技有限公司

全球呋喃树脂产能前三,产品应用于航空航天和电路封装领域,新厂投产后将占全球需求40%。

YC系列自硬呋喃树脂
YC系列自硬呋喃树脂是环保型铸造用粘合剂,用于制作砂型(芯)。
不同型号的呋喃树脂可用于铸造各种金属,如铸钢、铸铁、铸有色金属等。其外观为淡黄色至红褐色透明液体。
2.德高化成新材料股份有限公司

聚酰亚胺材料用于高端封装柔性基板,同时开发临时键合胶支持超薄晶圆加工。

3.嘉盛德材料科技股份有限公司

生产IC封装用无卤阻燃环氧树脂,供应覆铜板企业(生益科技、宏仁电子)。
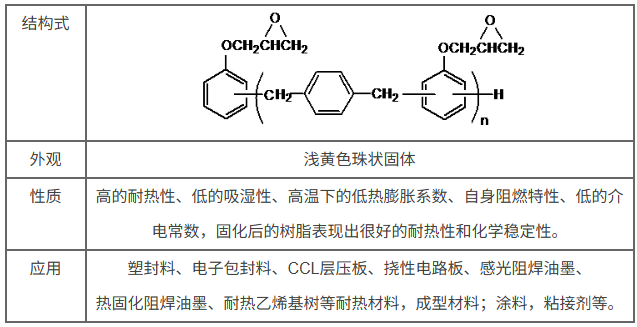
PXNE2000芳烷基苯酚型自阻燃环氧树脂
包括但不仅限于以上企业,更多欢迎大家补充。


Material
其他辅助材料


1
临时键合胶:德高化成开发可剥离聚酰亚胺胶,用于3D集成中的薄晶圆支撑。
2
环保清润模材料:德高化成产品缩短模具清理时间,环保性能领先。

TECORE® 清模树脂AZ系列
基于三聚氰胺甲醛树脂作为基础材料,通过加热固化去除金属模具表面的有机脏污。
AZ系列有两种产品类型:适用于转移成型的圆柱饼形状的AZ-1,和适用于压合成型的方形饼干形状的AZ-C。


以下表格汇总了IC封装中主要高分子材料的类别、功能及典型应用领域:
|
材料类别 |
主要功能 |
典型应用领域 |
|
环氧塑封料(EMC) |
绝缘保护、导热、机械支撑 |
DIP/SOP/QFN/BGA/SiP封装 |
|
有机硅封装材料 |
耐高温密封、高透光保护 |
LED/Mini LED/传感器封装 |
|
底部填充胶 |
填充芯片间隙、缓解热应力 |
FC-BGA/HBM存储封装 |
|
聚酰亚胺(PI) |
柔性基板、应力缓冲 |
柔性电路、高端封装基板 |
|
呋喃树脂 |
耐腐蚀保护 |
航空航天电子封装 |
|
临时键合胶 |
薄晶圆加工支撑 |
3D集成、Chiplet封装 |

Summary
总结:国产化趋势与技术方向
当前IC封装高分子材料市场仍由日企(信越、稻畑)和德企(汉高)主导,但国内企业在细分领域已实现突破。
国产替代进展:华海诚科、德高化成在高端EMC和有机硅胶领域市占率达10%,康美特Mini LED胶实现全产业链国产化。
技术趋势
1.高导热/低介电:满足5G/AI芯片散热与信号延迟需求;
2.纳米改性:如德高化成碳量子点改性树脂提升封装密度;
3.环保材料:无卤阻燃树脂(嘉盛德)符合绿色制造要求。
未来随着Chiplet、3D封装技术普及,对底部填充胶、临时键合胶等材料的需求将激增,国内企业有望在政策与产业链协同下加速技术迭代
【邀请函】2025年半导体高分子材料应用发展论坛(10月30日无锡)
演讲议题(持续更新中)
|
序号 |
拟定议题 |
演讲单位 |
|
1 |
PEEK材料在半导体不同制程中的应用 |
邀请中 |
|
2 |
PPS材料在半导体领域的应用 |
邀请中 |
|
3 |
半导体级PP材料应用与研究 |
邀请中 |
|
4 |
特种工程塑料型材在半导体设备领域应用 |
邀请中 |
|
5 |
氟塑料在酸碱制程中的耐腐蚀性能极限测试方法论 |
邀请中 |
|
6 |
半导体级氟塑料国产化进展 |
邀请中 |
|
7 |
半导体级氟塑料(PFA)管材挤出工艺 |
邀请中 |
|
8 |
氟橡胶在半导体设备密封领域的应用 |
邀请中 |
|
9 |
高性能橡胶在半导体制造热管理中的创新应用:耐高温密封与高效散热技术 |
邀请中 |
|
10 |
半导体晶圆传输系统橡胶缓冲材料的抗损伤与抗静电协同优化技术 |
邀请中 |
|
11 |
塑料晶圆载具中的应用 |
邀请中 |
|
12 |
IC托盘材料选型 |
邀请中 |
|
13 |
CMP保持环材料耐磨性提升 |
邀请中 |
|
14 |
晶圆清洗花篮的材料介绍 |
邀请中 |
|
15 |
先进封装光罩盒的新需求 |
邀请中 |
|
16 |
半导体微污染控制:析出物检测与工艺适配 |
邀请中 |
|
17 |
抗静电ABS在半导体制程中的应用 |
邀请中 |
|
18 |
抗静电PC/PVC洁净室板材表面处理技术 |
邀请中 |
|
19 |
全球PFAS法规收紧对含氟高分子供应链的影响与替代材料开发进展 |
邀请中 |
|
20 |
终端对半导体材料的需求及应用趋势 |
邀请中 |
更多议题征集中,创新演讲及赞助请联系Mickey 周小姐: 18320865613(同微信)
报名方式一:加微信并发名片报名
电话:艾果儿 18312560351(同微信)
邮箱:ab008@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
报名方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名:
https://www.aibang360.com/m/100258?ref=172672
阅读原文,即可报名!
一颗芯片的制造工艺非常复杂,需经过几千道工序,加工的每个阶段都面临难点。欢迎加入艾邦半导体产业微信群:

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊


