
2024年3月20日-22日,半导体行业盛会SEMICON CHINA 2024在上海新国际博览中心盛大举行。帝科湃泰PacTite®精彩亮相并展示其创新的半导体封装浆料解决方案:LED封装、IC封装、功率半导体封装,以及电子元器件、印刷电子等领域的明星产品,与行业同仁共襄盛会。
_
多维产品组合,赋能澎湃中国“芯”
作为全球领先的电子材料公司,帝科DKEM®以先进配方化材料技术平台为依托,聚焦金属化与互联技术专长,在深耕太阳能光伏领域的同时,积极拓展湃泰PacTite®品牌的多维半导体电子材料产品组合。
湃泰PacTite®以LED与IC封装银浆为技术及市场突破口,以功率半导体系列封装浆料为未来发展方向,积极布局电子元器件与印刷电子应用,推出了DECA200/DECA400系列LED芯片封装银胶与IC芯片封装银胶、DECA600/DECA610系列功率半导体封装烧结银以及DK1200系列AMB陶瓷覆铜板钎焊浆料等半导体封装用系列产品组合。

_
创新材料,点亮LED多彩未来
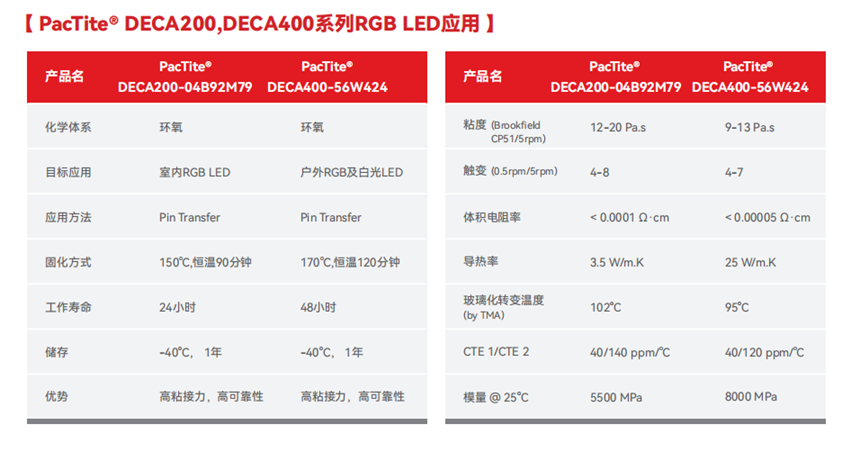
_
压力烧结银,助力车载功率半导体发展
随着全球新能源市场的火热发展,大功率IGBT器件广泛应用于电机驱动、车载充电模块;以及新能源功率模块对工作温度和可靠性的要求越来越高,催生SiC和GaN等宽禁带半导体芯片的普及应用,烧结银工艺成为提升其封装可靠性和性能的关键技术。

_
前沿突破,引领半导体封装材料国产化
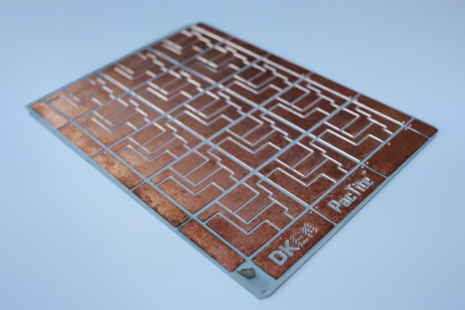
同时,帝科湃泰PacTite®推出DECA650系列金属熔融型瞬态液相烧结(TLPS) 导电浆料,适用于HDI、MPI、 LCP等电子电路填充微通孔结构或相关半导体测试基板用,可以实现电路叠层间高质量的金属间化合物 (IMC) 的互连导通,具有低温互联、高温服役的卓越可靠性。
本次展会中,帝科湃泰PacTite®不仅全面展示了半导体封装解决方案,更与各位客户同仁就产品需求、挑战和行业趋势进行了积极的沟通,协同创新,助力行业突破边界,赋能中国“芯”。
激发无限可能 Inspire the Possibilities
///
原文始发于微信公众号(帝科电子材料):澎湃中国“芯” | 帝科湃泰PacTite®半导体封装浆料解决方案亮相SEMICON CHINA 2024
一颗芯片的制造工艺非常复杂,需经过几千道工序,加工的每个阶段都面临难点。欢迎加入艾邦半导体产业微信群:

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊


