2024年3月7日,田中贵金属工业有限公司宣布已利用 AuRoFUSE™(金-金接合用低温烧成膏材)建立了用于高密度封装的金 (Au) 颗粒接合技术。
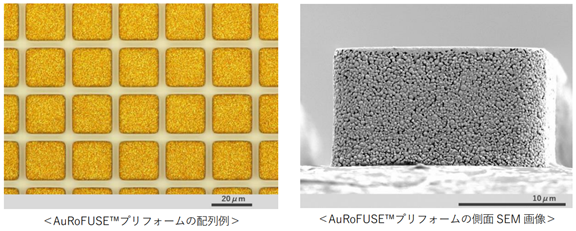
AuRoFUSE™是一种仅由亚微米尺寸的Au颗粒和溶剂组成的接合材料,除了具有低电阻和高导热性之外,还可以在低温下实现金属接合。通过该技术,通过使用AuRoFUSE™预制片,实现了尺寸为20μm、间隙为4μm的窄间距安装。
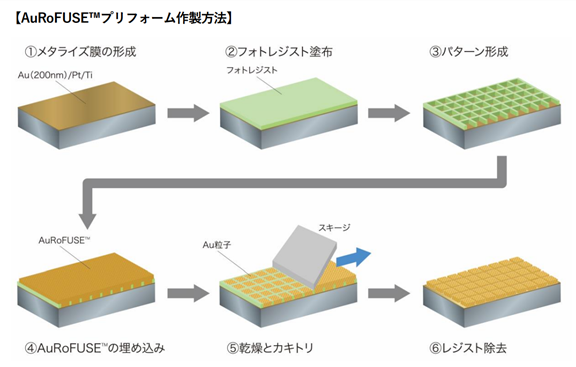
此外,在200°C、20MPa(兆帕)、10秒的热压粘合后,AuRoFUSE™预制片在压缩方向上表现出约10%的收缩,在水平方向上几乎没有变形,并且具有足够的耐用性以供实际使用。可用作具有优异接合强度的金凸块。 此外,由于主要成分为金,化学稳定性优异,因此安装后的可靠性也很高。
根据目的,可以使用各种接合方法来安装半导体器件,例如使用焊料材料或电镀。 使用焊接材料的方法可以快速、低成本地生产凸块,但随着凸块间距变得更细,焊接材料在熔化时会横向扩散,这会增加由于电极之间接触而导致短路的风险。此外,采用化学镀来制造镀铜(Cu)或镀金凸块的方法是实现高密度安装的技术开发的主流,可以实现窄间距,但在接合时需要相对较高的压力,可能会导致芯片损坏。

田中贵金属工业一直在利用AuRoFUSE™进行研究和开发,该材料具有多孔、可追随不规则性的特性,并且可以在低温和低压下粘合,以实现半导体的高密度封装。最初,田中贵金属的目标是使用点胶、针转移和丝网印刷等主流方法来实现这一目标,但焊膏的流动性使其不适合高密度安装。利用这项新开发的技术,通过在粘合前干燥膏体使其失去流动性,可以抑制横向扩散并实现高密度安装。此外,由于它具有多孔结构,因此很容易变形,即使电极之间存在高度差异、基材翘曲或厚度差异也可以粘合。
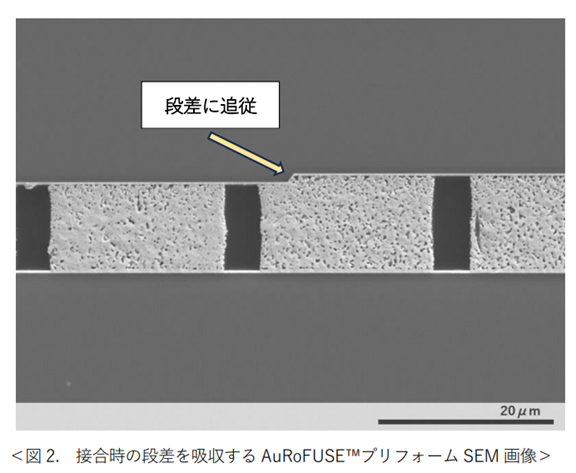
该技术实现了半导体布线的小型化以及各种芯片的集成化(更高密度)。预计将为需要高度创新的先进技术做出贡献,包括LED(发光二极管)和LD(半导体激光器)等光学器件、计算机和智能手机等数字设备以及汽车零部件中的使用。



