八大半导体制造工艺:晶圆制造→氧化工艺→光刻工艺→蚀刻工艺→沉积和离子注入工艺→金属化工艺→EDS工艺→封装工艺。本篇文章主要介绍半导体晶圆制造工艺。

半导体集成电路和晶圆有何关系?
半导体集成电路是将很多元件集成到一个芯片内,以处理和储存各种功能的电子部件。由于半导体集成电路是通过在晶圆的薄基板上制造多个相同电路而产生的,因此晶圆是半导体的基础,就像制作披萨时添加配料之前先做面团一样。晶圆是指将硅(Si)、砷化镓(GaAs)等生成的单晶柱切成薄片的圆盘。大部分晶圆都是由沙子中提取的硅制成的。地球上有大量的硅,可以稳定供应,并且硅具有无毒、环保的特点。
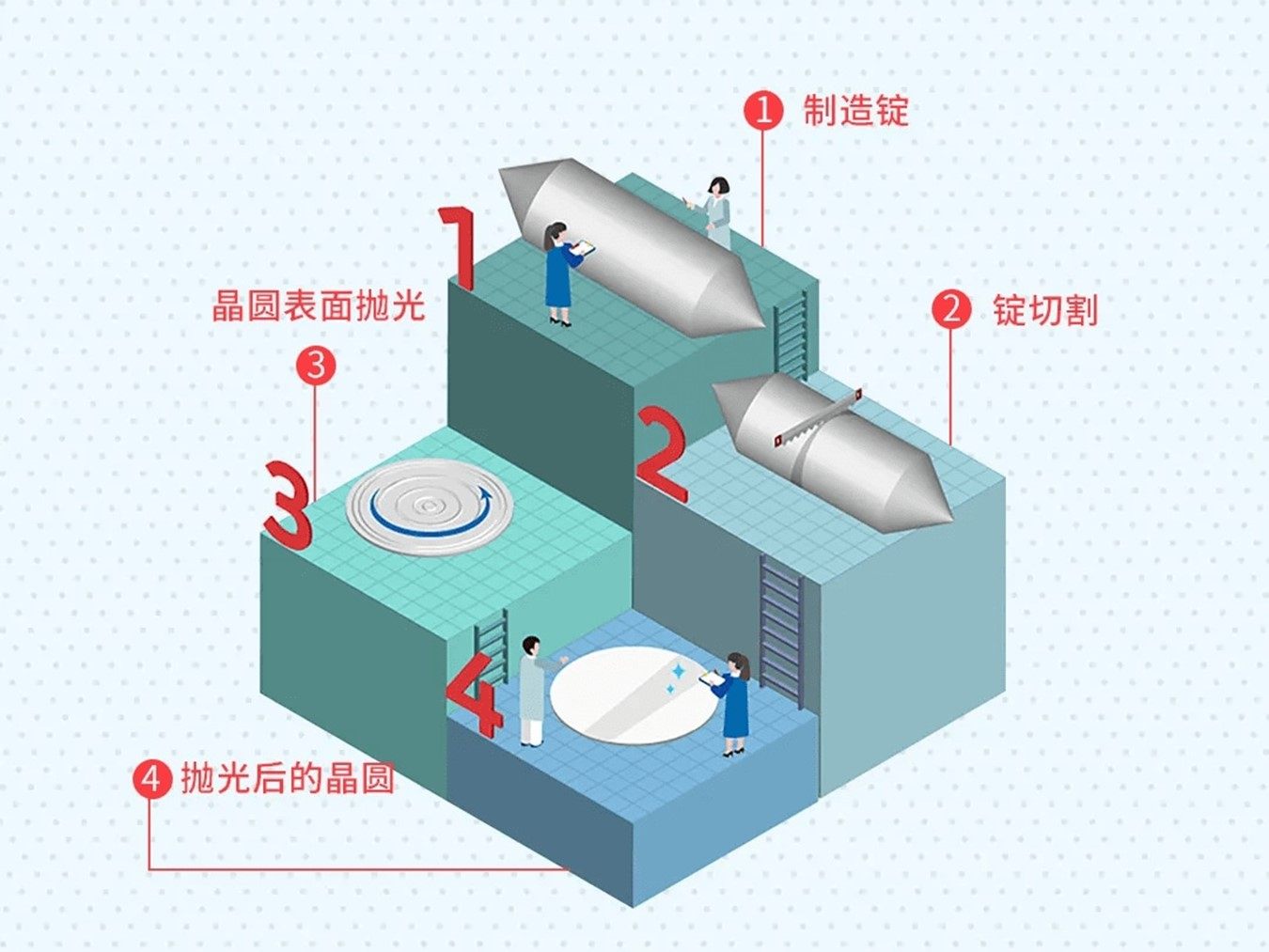
▲ 半导体晶圆制造工艺
第一阶段
制造锭(Ingot)
为了将从沙子中提取的硅作为半导体材料使用,首先需要经过提高纯度的提纯工序。将硅原料高温熔解,制造高纯度的硅熔液,并使其结晶凝固。这样形成的硅柱叫做锭(Ingot)。用于半导体中的锭采用了数纳米(nm)微细工艺,是超高纯度的硅锭。

第二阶段
锭切割成薄晶圆(Wafer Slicing)
为了将圆陀螺模样的镜制成圆盘状的晶圆,需要使用金刚石锯将其切成均匀厚度的薄片。薄片的直径决定了晶圆的尺寸。晶圆的尺寸有 150mm(6英寸)、200mm(8 英寸)、300mm (12 英寸)等等。晶圆越薄,制造成本越低,直径越大,一次可生产的半导体芯片数量就越多,因此晶圆的厚度和大小呈逐渐变薄和扩大的趋势。

第三阶段
晶圆表面抛光 (Lapping&Polishing)
切割后的晶圆需要进行加工,以使其像镜子一样光滑。这是因为刚切割后的晶圆表面有瑕疵且粗糙,可能会影响电路的精密度,因此需要使用抛光液和抛光设备将晶圆表面研磨光滑。加工前的晶圆就像处于没有穿衣服的状态一样,所以叫做裸晶圆(Bare wafer)。经过物理、化学多个阶段的加工后,可以在表面形成 IC。经过加工阶段后,会成为如下形状。


1.晶圆(Wafer):晶圆是半导体集成电路的核心材料,是一种圆形的板。
2.晶粒(Die):很多四边形都聚集在圆形晶圆上。这些四边形都是集成电子电路的 IC 芯片。
3.分割线(Scribe Line):看上去各个晶粒像是粘在一起,但实际上晶粒和晶粒之间具有一定的间隙。该间距称为分割线。在晶粒和晶粒之间设置分割线的是为了在晶圆加工完成后将这些晶粒一个个割断,然后组装成芯片,也是为了留出用金刚石锯切割的空间。
4.平坦区(Flat Zone):平坦区是为区分晶圆结构而创建的区域,是晶圆加工的标准线。由于晶圆的晶体结构非常精细并且无法用肉眼判断,因此以这个平坦区为标准来判断晶圆的垂直和水平。
5.凹槽(Notch):如今也出现了具有凹槽的晶圆。和平坦区晶圆相比,凹槽晶圆可以制造更多的晶粒,因此效率很高。
半导体产业包括生产晶圆的晶圆产业以及以晶圆为材料设计和制造的晶圆加工产业——制造行业(Fabrication,FAB)。另外,还有组装产业,它将加工过的晶圆切割成晶粒,并包装好以防止受潮或受压。
来源:三星
原文链接:https://semiconductor.samsung.com/cn/support/tools-resources/fabrication-process/eight-essential-semiconductor-fabrication-processes-part-1-what-is-a-wafer/

