受益于消费电子、5G、汽车电子、IoT 等需求拉动,全球半导体材料市场行业规模整体呈上升趋势,半导体封装的重要性进一步提高,行业对载板和晶圆制程金属化产品的需求进一步扩大。
由于摩尔定律在7nm以下的微观科技领域已经难以维持之前的发展速度,优异的后端封装工艺对于满足低延迟、更高带宽和具有成本效益的半导体芯片的需求变得越来越重要。

而扇出型封装因为能够提供具有更高I/O密度的更大芯片,大幅减少系统的尺寸,正成为应对异构集成挑战的不二之选。
扇出型封装主要分为扇出型晶圆级封装(FOWLP)和扇出型面板级封装(FOPLP)。
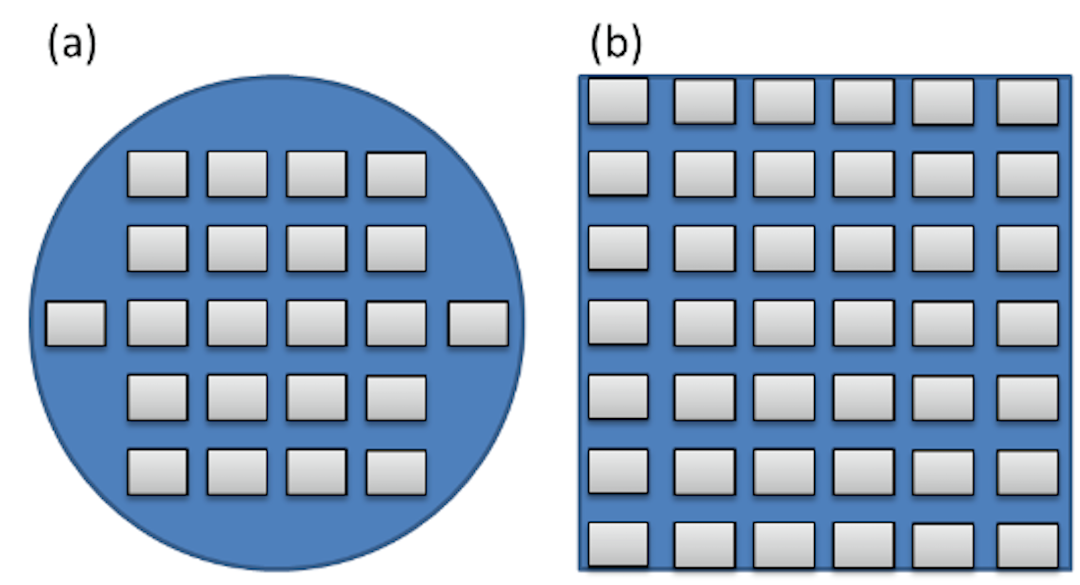
FOPLP虽然出现较晚,但是潜力巨大。FOPLP有更大的面板尺寸和更高的制造效率,封装的单个成本更低,先进程度更好。相较于其他封装技术,其可以减少绕线层数,同时满足降低成本和封装先进晶圆的要求,非常适合大型封装的批量生产。
根据权威报告,FOPLP未来全球3年的年复合成长率可高达30%,2025年全球产值预期可达4亿美元。
但是提高FOPLP的镀铜性能一直都是挑战。关键是如何形成高均匀性的膜厚和高解析度的铜线路,尤其针对RDL工艺的同面性要求更高。
纳鼎新材料已经成功研发出高品质的板级封装镀铜工艺REM-9500系列产品。专业的技术服务团队,稳定优异的产品,为您的板级封装工艺保驾护航。

原文始发于微信公众号(纳鼎新材料 NDNM):【纳鼎新材料- 半导体篇】扇出型面板级封装(FOPLP)镀铜工艺

