TGV(Through Glass Via,玻璃通孔)作为一种关键的先进封装技术,正逐渐引领半导体行业迈向新的高度。在当今的科技浪潮中,玻璃基板封装技术凭借其在提升芯片性能、减少形变与集成度方面的卓越表现,成为应对 AI(人工智能)与 Chiplet(芯粒)趋势的有力解决方案,而 TGV 技术则是实现这些封装形式的核心工艺之一。

一、全球玻璃基板&TGV专利申报大幅增长
据 Knowmade 统计,在先进封装领域,玻璃中介层及玻璃基板相关专利数量已突破 300 项。英特尔与 Absolics 作为主要参与者,二者所申请专利数加起来占据了近乎半数比例。除此之外,全球还有 70 多家实体参与了专利申请,这些实体合计申请的专利数量也超过了 150 项,该领域的专利布局呈现出多主体竞争的态势。

图:近些年关于玻璃基板申请专利统计(图源于Knowmade统计)
英特尔:在专利数量上处于领先地位,掌控着最庞大的专利申请集群,其专利布局全面覆盖玻璃核心基板及玻璃中介层两大技术板块,呈现出均衡且深入的研发布局,稳居行业技术创新的前沿阵营。
Absolics:深耕玻璃核心基板领域,专利申请总量位居行业第二,成为英特尔在全球专利竞争中最具威胁的强劲对手,展现出在该专业细分赛道深耕细作的技术积累与研发定力。
除英特尔和 Absolics 外,该领域还有 70 多个实体参与专利申请,整体呈现出较为分散的布局态势。在这些实体中,包括 TOPPAN、康宁、肖特、格罗方德、台积电、旭硝子、三星、高通、Unimicron、京东方、华进半导体、厦门云天、安捷利美维、广东佛智芯等知名企业(排名不分先后),它们在玻璃基板产业专利布局版图中同样具有一席之地。
从各公司专利申请趋势的角度来看,英特尔在专利布局方面起步较早,自 2004 年起便率先开启了对相关专利的持续申请与积累之路,而在近几年,其专利申请数量更是迎来了爆发式增长。而到了 2019 - 2024 年期间,众多企业纷纷察觉到该领域的发展潜力,开始大举涌入。
二、玻璃基板技术研究的热点
当前专利申报的热门技术领域主要集中在玻璃基板、中阶层、封装集成以及通孔填充等多个关键方面。从技术效果应用矩阵图来看,大部分专利的主要技术效果集中体现在提升可靠性、简化处理流程、削减成本以及优化电学性能等关键方面。

图:玻璃基板相关的技术效果应用矩阵(仅供参考)
针对热门和关键的技术领域头部企业有不同应对的专利解决方案:
1、康宁:一种包含多孔导电材料的通孔及用于制造通孔的方法(专利号:CN118140306A)
在2.5D芯片叠层架构中,玻璃中介层的热机械挑战导致热循环期间的高应力,造成裂痕、通孔排空和侧壁脱层等问题,影响电气性能和可靠性。康宁通过在贯穿玻璃通孔中形成多孔导电材料,利用至少三个水平的金属化层,中央层的孔隙度大于末端层的孔隙度,并通过热均压压力调节孔隙度和表面粗糙度,形成高导电性和高热膨胀系数的通孔结构。
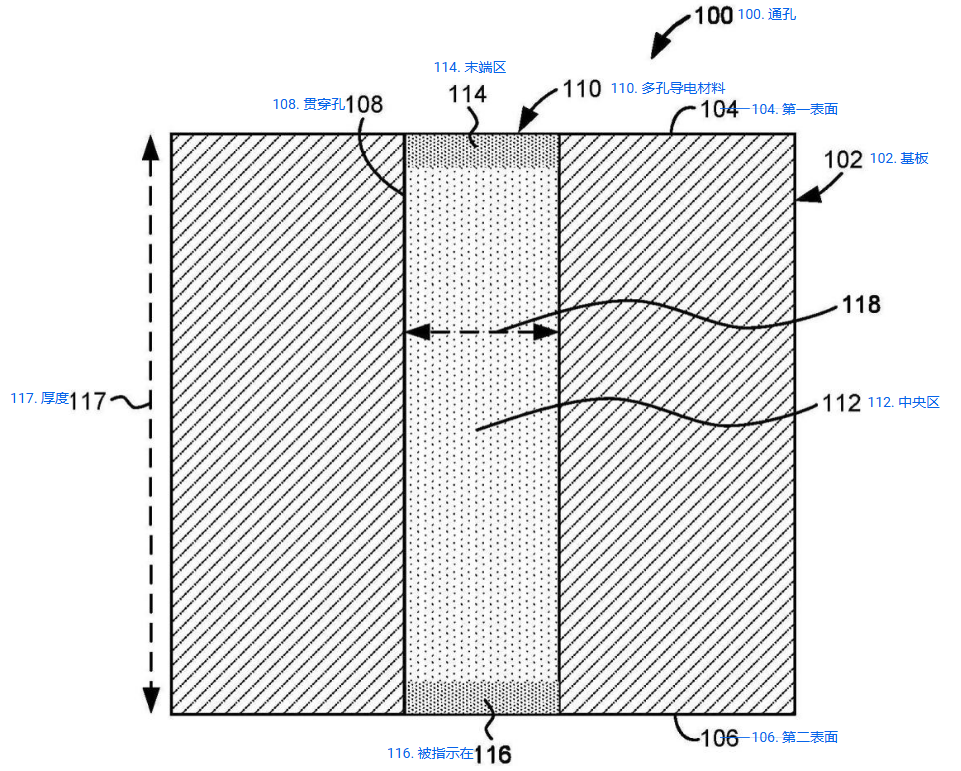
图:范例通孔的剖面视图
2、Absolics Inc(SK集团):半导体封装用基板及其制造方法以及半导体封装件(专利号为CN118136594A)
现有半导体封装件在配备加热元件时由于热膨胀系数差异导致翘曲现象,且传统方法增加了封装件厚度以解决散热问题,未能完美解决热稳定性问题。Absolics Inc设计一种包括导热材料热过孔的半导体封装用基板和封装件,通过在基板上形成凹入面和侧壁,并在其中填充导热材料,减少热膨胀引起的翘曲,并通过蚀刻液形成过孔和凹入面以提高散热效果。实现了在不增加封装件厚度的情况下,提升散热效果并减轻热膨胀导致的翘曲现象,提高了半导体封装件的热稳定性和性能。
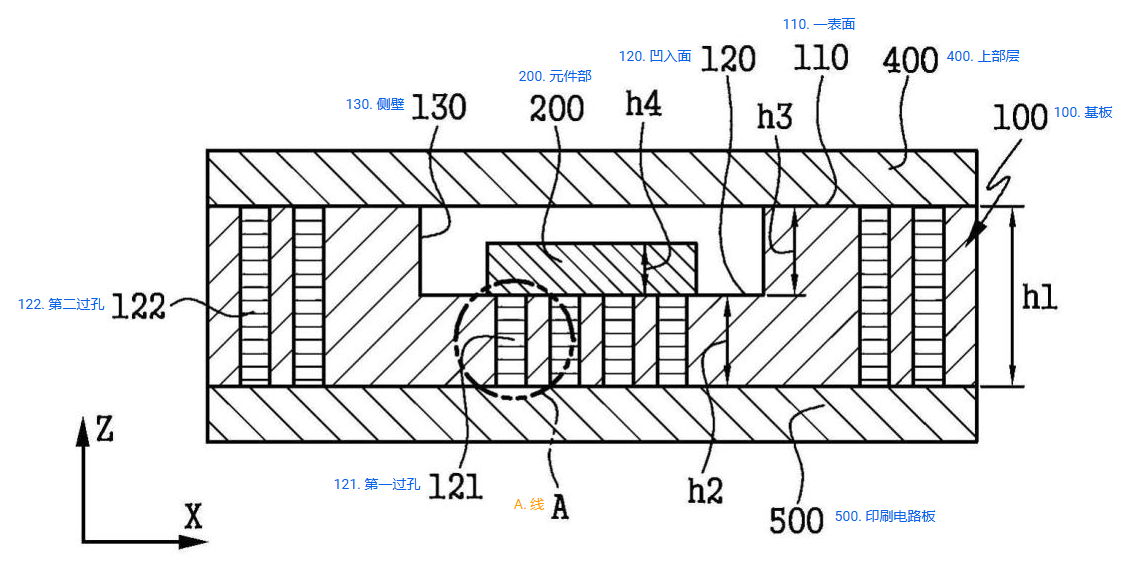
图:半导体装置的剖视图
3、英特尔:基于玻璃的空腔和通道,用于使用玻璃芯封装基板冷却嵌入式芯片和 3D 集成模块(专利号:WO2022265714A1)
当前的电子封装架构不足以进行高功率计算系统的热管理,因为它们主要依赖于通过硅进行的顶部散热,而由于封装基板的导热率较低并且需要 容纳信号和电力传输路径。英特尔提出将基于玻璃的封装基板与使用激光辅助蚀刻形成的嵌入式流体通道和通孔相结合,允许从芯片下方通过基板进行热管理,从而实现与传统方法相比直径和间距更小的冷却通道和通孔的高密度集成 。能有效增强了散热能力,通过封装基板提供额外的散热路径,实现高功率架构的充分冷却,从而改善多层系统的热管理。
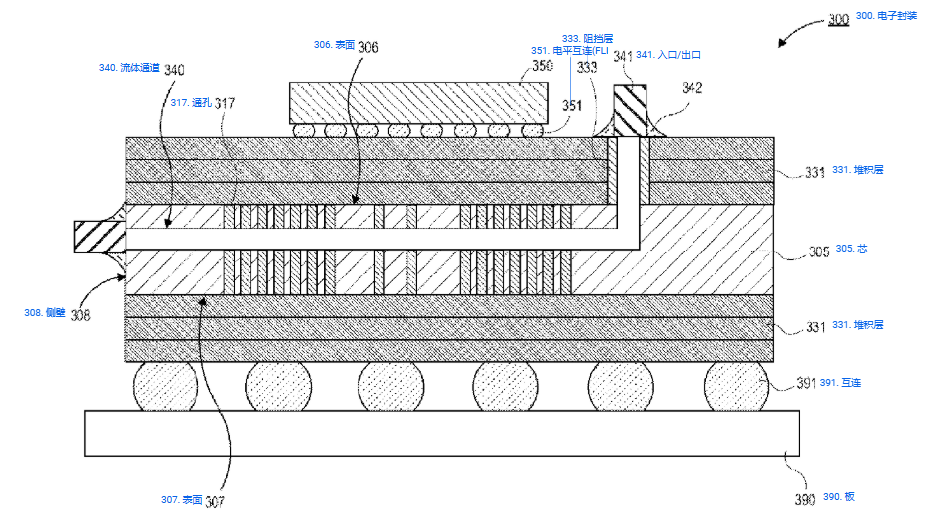
图:具有冷却通道的电子封装的横截面图
4、三星:玻璃芯基板的半导体封装及其制造方法(专利号:US20240321755A1)
由于现有技术在实现电子元件的高效率、小型化和多功能化方面面临挑战,因此需要一种能够最大限度地减小硅中介层的尺寸并减少封装基板的翘曲,同时保持有效的芯片间连接的半导体封装。三星提出一种半导体封装设计,包含具有空腔的玻璃芯基板、多层布线层以及嵌入空腔内的硅桥中介层,其连接至少两个半导体器件并利用低热膨胀性最小化中介层的尺寸 玻璃的系数和高刚性可减少翘曲并提高信号完整性。
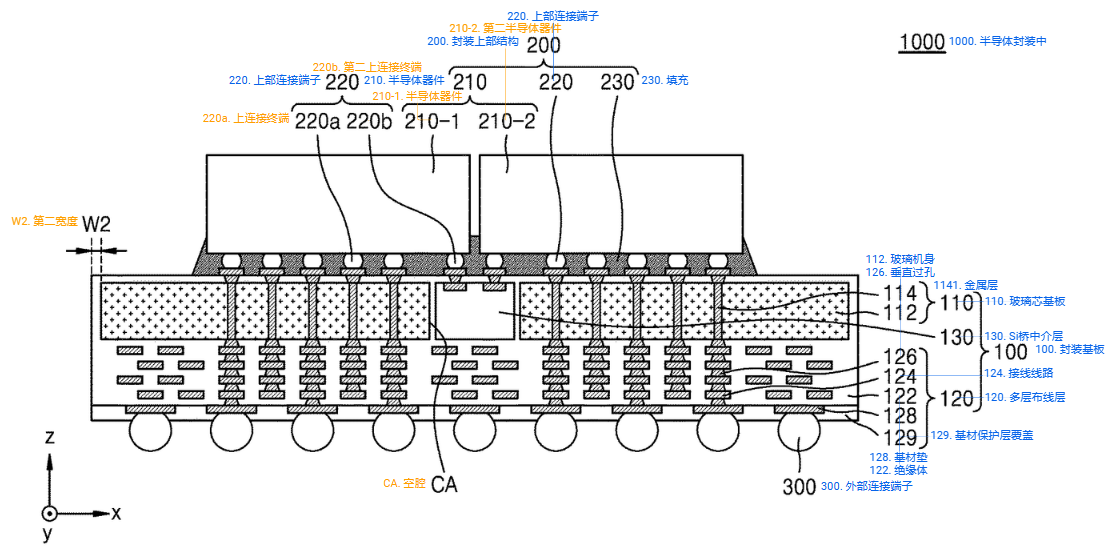
图:玻璃芯基板的半导体封装件的剖视图
5、旭硝子:用于中介层的中间产品的制造方法和用于中介层的中间产品(专利号:US9674956B2)
由于通孔强度降低,用于制造半导体 3D 封装中介层的薄玻璃基板很容易出现裂纹和缺陷,从而给处理和转移带来挑战。旭硝子通过一种层压体,包括具有通孔的玻璃基板、支撑基板和树脂层,该树脂层通过提供刚性和脱模特性来增强强度,从而在加工过程中更容易分离并减少缺陷。提高了玻璃基板的强度,最大限度地减少了搬运和加工过程中出现裂纹和缺陷的风险,同时还确保了通孔中导电材料的均匀填充,从而提高了中介层的质量。
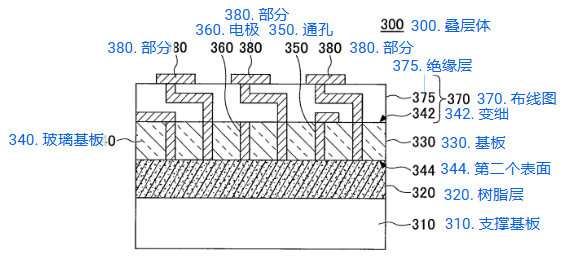
图:三层叠体的截面示意图
三、湖南越摩玻璃基板先进封装产品发展情况
在摩尔定律逼近物理极限的背景下,玻璃基板将引领半导体封装技术进入“超越摩尔”的新纪元。其核心价值不仅在于替代传统有机基板(如ABF载板)和硅中介层,更在于为AI芯片、光模块、车载电子等前沿领域提供高可靠性的三维集成方案。当前部分国际巨头已明确将玻璃基板纳入技术路线图,计划于2年后实现规模化量产;中国台湾地区凭借成熟的半导体产业链,通过钛升科技、群创光电等企业的技术创新与联盟协作(如E-Core大联盟),正加速突破TGV工艺的效率瓶颈,推动玻璃基板从研发迈向商业化落地。中国大陆企业亦积极布局,依托政策支持与产业集群优势,逐步缩小与国际领先水平的差距,预计2025年后国产化率将显著提升。
在高性能计算(HPC)与人工智能(AI)蓬勃发展、势不可挡的大趋势下,封装技术的重要性日益凸显。越摩先进凭借其玻璃基板解决方案与多物理场仿真技术平台的双轮驱动,正以创新者的姿态引领行业变革,为高密度封装领域注入全新动能。其首颗超大尺寸玻璃基板样品成功试制完成,为高密度封装领域提供了兼具超低翘曲特性和轻质化优势的先进解决方案,助力解决行业面临的封装难题,如 GPU 封装尺寸增大、互联密度要求提高等;越摩先进2.5D+TGV封装模组以微型化互连与高精度布线双重优势,大幅提升系统级封装的集成度和信号传输性能。
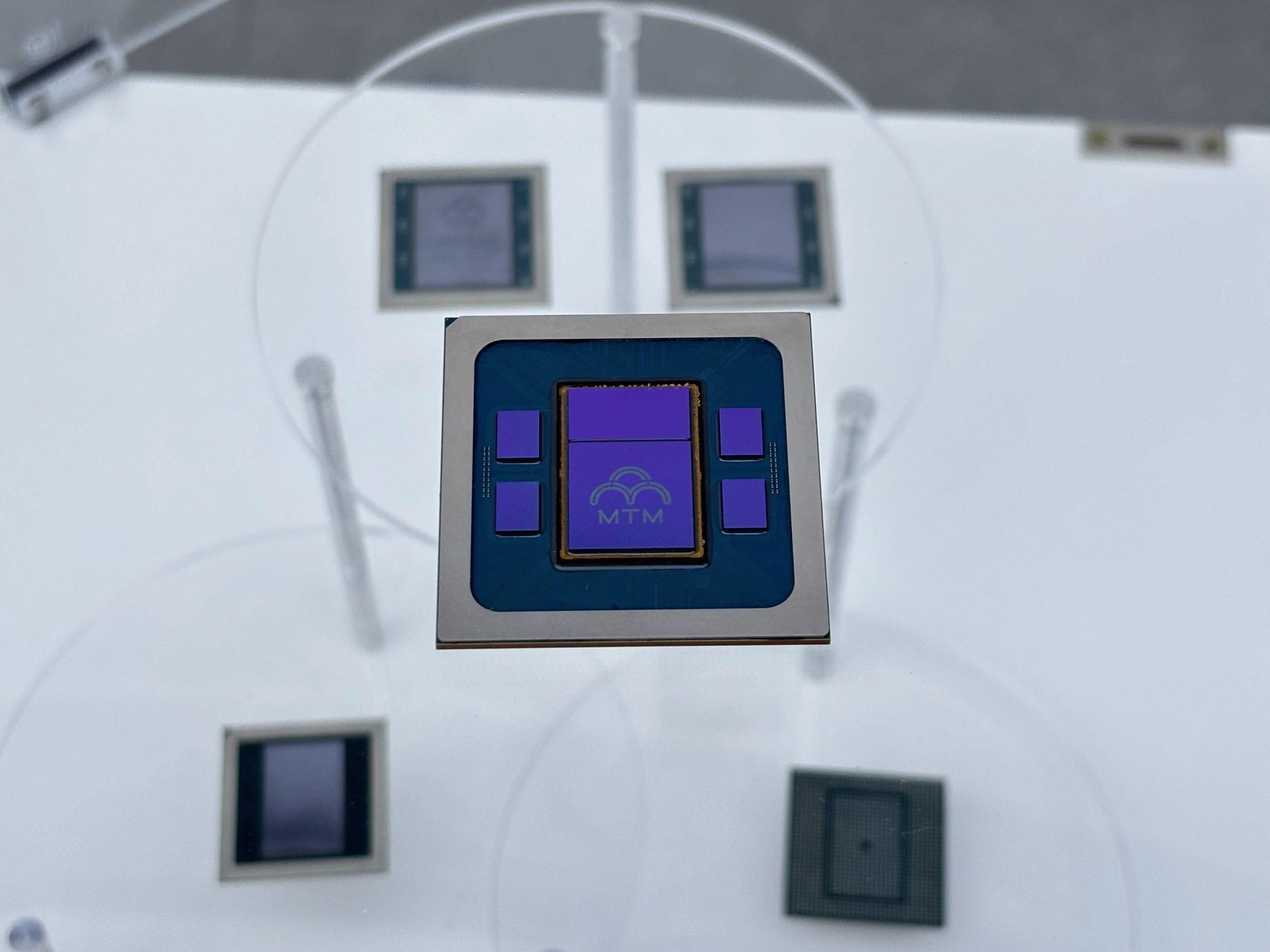
图:越摩先进多款大尺寸Chiplet封装产品
了解具体内容请点击此链接:
越摩先进:聚焦玻璃基 2.5D Chiplet 先进封装解决方案
面对复杂封装工艺中的热-力-电多物理场耦合挑战,越摩先进构建了行业领先的自动化仿真平台,能够快速精准地完成过程开发、材料选型、工艺优化、可靠性验证和问题溯源等复杂任务,极大提高了芯片封装设计的效率和质量,缩短了产品研发周期,降低了研发成本。

图:越摩先进“先进封装多物理场仿真自动化平台”
越摩先进在株洲总部拥有51000㎡的先进封装产线,覆盖Chiplet、SiP、FCBGA等多元工艺,并联合上下游企业构建了涵盖材料、设备、设计的生态联盟。通过控股股东兴橙资本的资源(如晶圆厂、EDA/IP公司)及与AI、自动驾驶客户的深度合作。



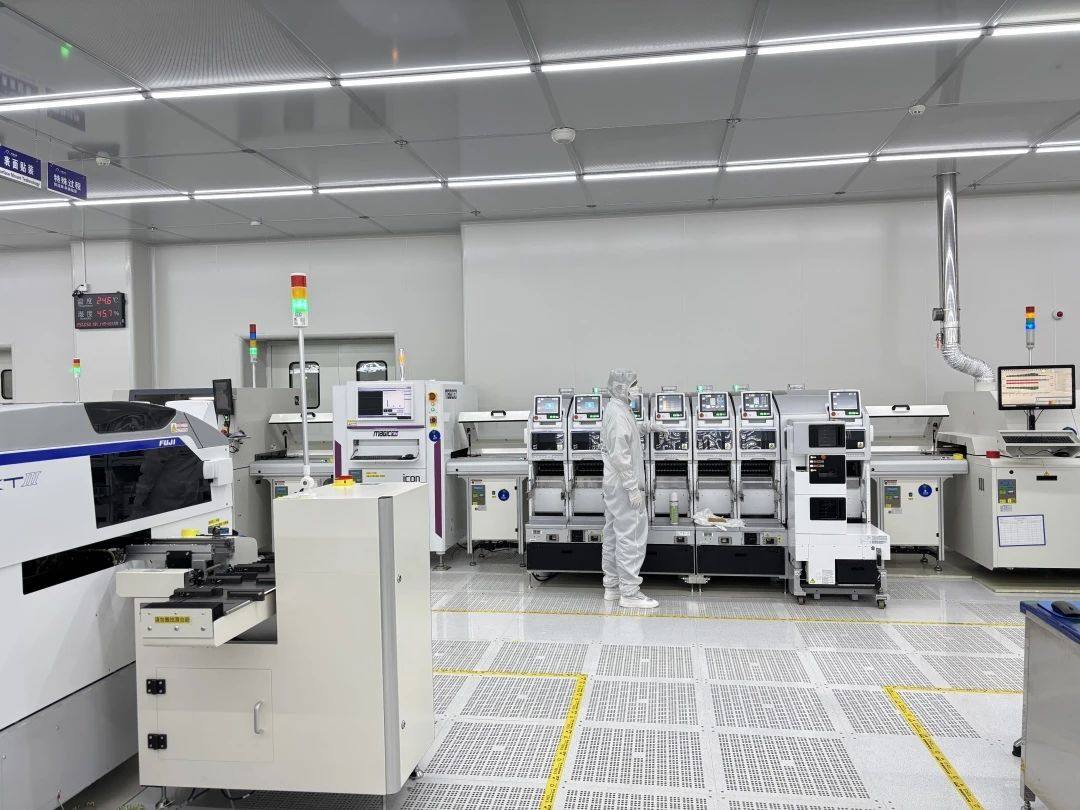

图:越摩先进无尘生产车间现状
站在2025年的技术拐点,越摩先进正以“材料+工艺+仿真”三位一体的创新体系,重塑半导体封装的未来图景。这种创新不仅体现在技术参数的突破,更在于其构建了“仿真-设计-制造-验证”的完整技术范式,这一范式不仅涵盖了半导体封装研发的全流程,还实现了各环节的深度协同与优化,为整个行业的技术发展提供了一种全新的、极具引领性的解决方案。


湖南越摩先进半导体有限公司(简称:越摩先进)成⽴于2020年10⽉,注册资⾦4.66亿元,是⼀家专注于封装⾏业的技术创新型企业。公司的核⼼研发团队拥有15年以上的先进封装⾏业从业经历,拥有行业领先的多物理场联合设计、仿真、先进封装⼯艺研发及量产加工能力。越摩先进秉承服务客户为宗旨,以技术推动行业发展,产品领域包括算力产品、北斗导航、汽车电子、工业控制、新能源、存储、生物医疗、可穿戴、物联网和射频等。越摩先进一期厂房面积51000+㎡,目前已经建成QFN/DFN、CSP/BGA/LGA、fcBGA、SiP、Chiplet 等多条先进封装生产线。
越摩先进在企业发展过程中,先后荣获了一系列荣誉,包括国家级高新技术企业、湖南省专精特新中小企业、湖南省省级企业技术中心、湖南省创新创业大赛一等奖等。




