
中介层和基板正在经历深刻的转变,从中介体转变为负责最先进计算系统中的配电、热管理、高密度互连和信号完整性的工程平台。
这一转变是由人工智能、高性能计算 (HPC) 和下一代通信技术推动的,这些领域对异构集成的需求正在挑战封装技术的极限。尽管晶体管尺寸已缩小至个位数纳米范围,但传统 PCB 技术仍然局限于 20 至 30μm 的线宽——这一差距跨越了三个数量级。
传统封装技术无法跟上硅片尺寸缩小的步伐,在性能和集成密度方面造成了关键瓶颈。因此,中介层和先进基板正在快速发展,以实现:
随着行业向更大的基于芯片组的架构发展,硅中介层正逐渐被有机中介层取代,从而实现更大的封装尺寸和更高密度的互连。与此同时,玻璃基板正逐渐成为有机材料的可扩展替代品,提供机械稳定性和超精细的RDL功能。
Promex首席执行官Dick Otte表示:“先进封装技术发展迅速,迫使我们不断调整工艺流程。无论是新的基板材料还是新颖的键合方法,能够快速调整和优化工艺流程如今已成为一项关键能力。”

1、弥合互连差距
长期以来,半导体行业一直依赖重分布层 (RDL) 在芯片和外部接口之间路由信号。但随着封装需求的不断增长,RDL 技术正在突破传统材料和制造方法的极限。如今,新型基板材料和工艺创新对于实现人工智能、高性能计算和 5G 应用所需的互连密度至关重要。
这一转变的关键在于从硅中介层转向有机和玻璃基解决方案。有机中介层使用玻璃载体作为结构支撑,为需要硅通孔 (TSV) 和深度蚀刻工艺的硅中介层提供了一种可扩展的替代方案。随着基于芯片组的架构不断扩展,有机中介层能够支持更大的封装尺寸,同时保持细间距互连。
与此同时,玻璃芯基板和玻璃中介层正逐渐成为有机材料的替代品,它们具有机械稳定性、更低的介电常数和更精细的再分布层 (RDL)。然而,制造和处理方面仍然存在挑战,尤其是在翘曲控制、电镀均匀性和缺陷检测方面。
“如今中介层面临的挑战不仅仅是缩小线宽,” Lam Research先进封装总经理 Chee Ping Lee 表示,“关键在于确保我们拥有稳定、可制造的基板,以支持这些更精细的特性。随着我们从硅到有机中介层,再从有机基板到玻璃的转变,我们必须解决电镀、翘曲和处理方面的新问题。”
玻璃中介层的另一项重大发展是矩形玻璃载体的推广,与传统的圆形晶圆载体相比,矩形玻璃载体提高了处理和加工效率。“如今,玻璃载体都是圆形的,但整个行业正在迅速转向中介层采用矩形玻璃载体。”Lee说道。
与此同时,重新分布层 (RDL) 技术正在不断发展,以支持 1μm 线宽/线距分辨率,接近芯片间互连所需的尺寸。Brewer Science与imec合作,展示了半加成工艺 (SAP) 如何在生产环境中实现 2μm/2μm 的线宽/线距分辨率,并在受控环境中推进 1μm/1μm 的先进研究。
在 Brewer Science 和 imec 的 Alice Guerrero 提交的白皮书中,研究人员演示了如何“通过在目标晶圆顶部集体键合多层芯片,将芯片到晶圆的集体键合流程从 N=2 层扩展到 N=3 和 N=4 层”。这证明了先进堆叠技术的可行性,该技术“能够实现芯片到目标晶圆的对准,且大多数芯片的精度低于 +/-2µm”。
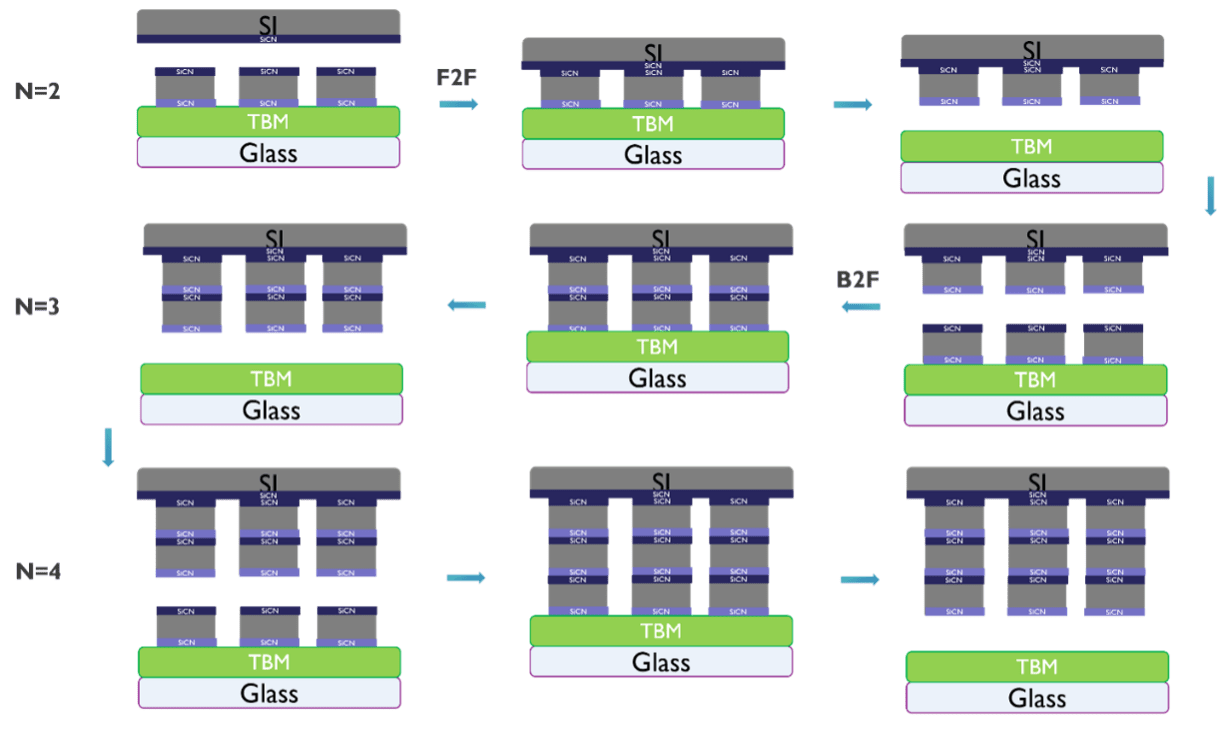
图 1:N=2、N=3 和 N=4 集体芯片到晶圆转移的简化流程。来源:imec
这对于扇出型面板级封装 (FOPLP) 尤为重要,因为它能够实现经济高效的大规模高密度集成。然而,面板级制造带来了新的良率和工艺控制挑战。
Lee 表示:“FOPLP 通过在大型面板中封装更多芯片,比其他方法具有潜在的成本优势。然而,FOPLP 在某些应用中也存在一些挑战,可能会抵消其潜在的成本节约,包括初始设备成本、有限的供应链以及大尺寸面板带来的加工良率问题。”
尽管面临诸多挑战,FOPLP 仍正在成为 AI 处理器和 HPC 加速器等大批量、高性能芯片的关键推动因素。随着制造商不断改进面板级工艺,例如电镀均匀性、细线光刻和翘曲控制,标准化面板格式的采用有望加速 FOPLP 在主流半导体制造中的应用。
2、克服制造挑战
随着中介层和基板变得越来越复杂,保持纳米级精度已成为一项重大挑战。向异构集成和细间距互连的转变要求芯片放置、材料沉积和键合技术具有极高的精度。即使是过去可以容忍的轻微错位,现在也会降低电气性能、可靠性并影响散热。
Otte 表示:“基板和中介层组装的主要挑战在于始终如一地实现共面性。由于这些基板变得越来越薄且精密,因此在芯片与基板键合过程中保持精确对准至关重要。任何轻微的错位或偏差都可能对性能产生重大影响。”
最紧迫的问题之一是向面板级工艺 (PLP) 的过渡。尽管晶圆级工艺 (WLP) 已受益于数十年的标准化发展,但 PLP 在大尺寸基板的处理、对准和良率管理方面引入了新的变量。材料膨胀、翘曲和工艺均匀性的差异性带来了巨大的工程挑战。
“全面板均匀性是FOPLP最难的方面之一,”Lee说道。“多层细线重分布层(RDL)需要高度的均匀性,从光刻到电镀。如果达不到要求,翘曲和形貌问题可能会干扰后续层,并降低良率。”
玻璃芯基板带来了另一系列制造和缺陷检测挑战。与硅或有机中介层不同,玻璃中介层中的电路以基板内部的凹槽形式形成。这增加了因裂缝导致电路断裂的风险。
TASMIT 的一位代表表示:“由于玻璃中介层中的电路以凹槽形式形成,裂缝可能导致电路断裂,从而增加产品缺陷的风险。在玻璃广泛应用于先进封装领域之前,更精密的制造工艺和更先进的缺陷检测工具必不可少。”
另一个挑战是向混合中介层过渡,其中选择性地组合不同的材料组合——有机、硅和玻璃——以实现成本效益和电气性能。然而,这些材料之间的热膨胀不匹配带来了新的机械可靠性问题。
Ansys片上电磁仿真产品经理 Kelly Damalou 表示:“有机和无机中介层与小型硅桥的结合,带来了完全不同的热膨胀系数。这些差异带来了巨大的机械挑战,常常导致先进封装解决方案的可靠性问题。”
中介层微缩过程中一个尤为困难的方面是高纵横比特征的电镀工艺,例如有机中介层中环绕嵌入式硅桥的细长柱。如何在不增加工艺时间的情况下对这些结构进行均匀电镀,是一项巨大的挑战。
“要嵌入硅桥,你需要在其周围设置类似TSV的结构,以连接底部和顶部。这些‘巨型柱’非常高(>100µm),很细,而且很难均匀电镀,”Lee说道。“降低电镀速度会有所帮助,但没有人想要一个每片晶圆需要200分钟的工艺。”
对速度和精度的需求迫使制造商采用人工智能驱动的工艺控制和实时监控技术。统计工艺控制 (SPC) 在芯片贴装、电镀和键合过程中变得至关重要,以确保高密度中介层设计的一致性和良率。
Promex 的 Otte 表示:“实施严格的统计过程控制至关重要。随着基板和中介层变得越来越复杂,SPC 能够实时检测并纠正偏差。”
为了克服这些挑战,人工智能驱动的计量和自适应过程控制正在被整合到生产线中。通过利用高分辨率成像、机器学习算法和实时反馈回路,制造商可以检测到细微的错位或工艺偏差,防止其蔓延到缺陷产品。
如今,制造工艺面临的挑战不仅仅是追求更精细的尺寸,还需要工艺控制来跟上步伐。正因如此,随着中介层设计规模的扩大,人工智能驱动的检测和自适应工艺调整对于保持低缺陷率至关重要。

3、热管理
随着半导体封装的发展,热管理已成为制约器件微缩的关键因素之一。中介层和基板曾经是封装中的无源元件,如今在散热方面发挥着积极作用,以维持高性能计算、AI加速器和多芯片模块的可靠性。更高的功率密度、更大的基于芯片组的架构以及更精细的互连间距,都加剧了对高效散热解决方案的需求。
Ansys 产品营销总监 Marc Swinnen 表示:“当使用边长四五英寸的中介层时,会形成显著的热梯度。这些梯度会导致机械变形和翘曲,对数千个微尺度键施加应力。这些应力会反馈到硅片的电气性能上,从而影响整体可靠性。”
如今,先进中介层设计中的有效热管理与电气性能息息相关。随着基板密度的不断提升,高效散热并保持电气完整性需要新的方法,尤其是集成散热路径。
这个问题在多芯片封装中尤为突出,因为热量必须通过日益密集的互连结构进行散热。随着功率水平的提高,传统的散热解决方案(例如散热器和热界面材料)已显得力不从心。因此,制造商正在转向将热管理直接集成到中介层和基板设计中的新型解决方案。
为了应对这些挑战,制造商正在研究在中介层内嵌入微流体冷却通道、在峰值负载下吸收热量并逐渐释放的相变材料,以及基于碳纳米管的先进热界面材料,这些材料比传统焊膏的热阻显著降低。此外,混合金属有机散热器也正在开发中,以在控制成本和重量的同时改善散热性能。这些新型热管理策略的成功将决定下一代中介层能否扩展以满足人工智能和高性能计算的需求。
4、新材料创新
随着半导体性能需求的不断提高,传统有机基板已达到其根本极限。为此,制造商正在转向新材料,例如玻璃芯复合材料、陶瓷和有机-无机杂化结构,以提高热性能、电性能和机械稳定性。
玻璃芯中介层因其介电常数较低(约为4.0)而备受关注,远低于硅的11.7,从而减少了信号损耗,非常适合5G、6G和其他毫米波通信等高频应用。玻璃还比有机基板具有更好的尺寸稳定性,从而减少了翘曲并提高了面板级封装的良率。尽管具有这些优势,但制造方面仍然存在挑战,尤其是在玻璃通孔的精密激光钻孔、通孔填充以及玻璃材料固有的脆性方面。
“玻璃基板非常平整,机械强度高,使我们能够将封装尺寸扩展到120毫米 x 120毫米以上,这使得非常细线的RDL集成成为可能,这对于高密度中介层和基板至关重要。”Lee说道。
除了玻璃之外,在有机中介层中融入硅桥的混合基板也越来越受到青睐。这些结构将有机材料的成本效益与硅的电气性能优势相结合,创造出一种用途更广的封装解决方案。
“先进封装的关键挑战之一是控制由于材料热膨胀系数 (CTE) 差异而导致的翘曲,”Otte 说道,“即使是微小的不匹配,也可能导致这种规模的良率和可靠性问题。”
热膨胀失配会导致热循环过程中出现分层、开裂和翘曲,因此更需要建立预测模型,以便在这些影响成为制造问题之前进行预测。随着半导体封装不断突破材料集成的极限,确保准确的材料表征和仿真正成为一项关键要求。
“随着频率的增加和基板温度的升高,材料特性变得至关重要,”Swinnen 补充道。“准确模拟这些材料在实际条件下的行为至关重要。在中介层和基板层面对材料行为的错误描述会严重影响器件的可靠性。”
尽管这些新材料前景光明,但制造过程依然存在相当大的复杂性。虽然玻璃和陶瓷基板具有优异的电气性能,但它们也带来了加工困难、成本问题和供应链限制,这些都必须解决才能完全取代传统的有机材料。与此同时,混合解决方案提供了一种折衷方案,但需要精心设计以平衡电气、热和机械性能。
5、先进的键合技术
随着中介层和基板设计日益复杂,传统的微凸块键合技术已达到其实际应用的极限。由于微凸块间距通常限制在 40µm 或更大,它们难以满足现代芯片架构的细间距要求。因此,混合键合技术应运而生,成为一种颇具前景的替代方案,通过结合电介质-电介质键合和金属-金属键合技术,实现了 10µm 以下的互连间距。然而,这种转变带来了新的制造挑战,尤其是在表面处理、缺陷缓解和工艺均匀性方面。
联华电子发言人表示:“混合键合是下一代高密度中介层技术的核心。在晶圆或基板层面实现稳定、均匀的键合至关重要。大型基板表面键合均匀性的差异是该行业目前面临的最大障碍之一。”
为了确保可靠的混合键合,制造商必须创建原子级光滑的表面,以防止形成空隙和电气不连续性。这需要精确的表面活化技术,例如等离子处理和化学功能化,以增强介电键合强度。实现一致的金属间接触还需要严格控制材料去除速率,尤其是在直接铜-铜键合中,氧化和界面污染会降低键合的可靠性。
除了混合键合之外,人们正在探索直接铜互连技术作为微凸块的替代方案,从而消除对焊料的需求并进一步降低电阻。通过去除中间材料,直接铜键合技术可以提高信号完整性和热性能,使其特别适合高速人工智能和高性能计算 (HPC) 应用。然而,该工艺也存在一系列挑战,包括如何防止键合过程中的氧化以及如何控制形成可靠互连所需的高压。
向更细间距键合技术的转变对建模和仿真工具提出了新的要求,这些工具必须跟上日益复杂的中介层和基板架构。随着混合键合和直接铜互连规模的扩大,确保准确的工艺建模和缺陷预测对于实现高良率至关重要。
Ansys 首席产品经理 Lang Lin 表示:“随着基板和中介层组件日益复杂,仿真工具的容量成为一项重大挑战。决定高保真模型的放置位置以及近似值可接受的位置至关重要。AI 驱动的自适应网格划分有助于管理这种复杂性,将计算资源集中在关键热点上。”
扩大混合键合和铜互连以实现大批量生产仍然是整个行业的挑战。
Lam Research 的 Lee 说道,“如今制造业面临的挑战不仅仅是如何实现更精细的尺寸,还在于确保工艺控制能够跟上。随着中介层设计规模的扩大,人工智能驱动的检测和自适应工艺调整对于保持低缺陷率至关重要。”

6、增强纳米级可靠性
随着中介层和基板技术日益复杂,确保长期可靠性需要从传统的基于规则的设计方法转向人工智能驱动的预测建模。高密度互连和混合材料集成引入了新的故障机制,必须在设计过程的早期进行预测和缓解。先进的仿真工具现已集成多物理场分析,使工程师能够在设计进入制造阶段之前预测电迁移、热梯度和机械应力等问题。
联华电子发言人表示:“使用预测仿真和人工智能驱动的分析已变得至关重要。仿真使我们能够预测中介层上的电迁移和热效应,这直接影响着长期可靠性。随着基板复杂性的增加,这种能力至关重要。”
然而,这些模型的准确性取决于输入数据的质量,尤其是对于缺乏大量实证测试的新型材料而言。随着中介层从有机基板转向混合基板和玻璃基板设计,材料特性的精确表征变得至关重要。任何对热膨胀系数、介电常数或机械应力的错误表征都可能对器件可靠性产生重大的后续影响。
Ansys 的 Swinnen 表示:“随着频率的增加和基板温度的升高,材料特性变得至关重要。准确模拟这些材料在实际条件下的行为至关重要。在中介层和基板层面对材料行为的错误描述会严重影响器件的可靠性。”
除了仿真之外,缺陷检测方法也必须不断发展,以跟上下一代封装的复杂性。传统的光学和电气测试方法通常无法捕捉到基板层面的细微缺陷,因此需要人工智能驱动的检测技术。机器学习算法正在被部署用于分析高分辨率图像数据,以识别传统检测流程可能遗漏的缺陷。
谷歌故障分析主管 Lesly Endrinal 表示:“机器学习对于在最终组装之前检测细微的基板级缺陷至关重要。传统的检测方法会遗漏这些缺陷,但基于人工智能的图像处理和分析技术可以显著改善缺陷检测,从而提高中介层的整体可靠性。”
为了进一步提高可靠性,制造商正在将可测试性设计 (DFT) 和嵌入式传感技术直接集成到中介层和基板架构中。这些进步使得在制造过程中实时监控关键性能参数成为可能,从而能够及早发现并解决缺陷。
Modus Test 首席执行官 Jack Lewis 表示:“测试基板和中介层是否存在细微的电气缺陷已变得越来越具有挑战性。高密度互连使传统的测试方法变得复杂,需要新的方法,尤其是在晶圆和面板层面。”
通过在中介层结构中嵌入诊断功能,制造商能够在生产周期的早期发现并解决潜在故障。这种主动方法对于面板级封装中使用的大幅面基板尤其有用,因为良率优化至关重要。
这些AI增强的测试和仿真策略提高了先进封装架构的首次良率,并降低了长期故障率。随着中介层和基板在计算堆栈中成为越来越活跃的组件,确保其可预测性和可靠性将成为扩展基于芯片的架构和高性能计算应用的关键。
7、有源中介层和智能基板
随着中介层和基板从无源布线层演进为智能系统组件,研究人员和制造商已开始探索有源中介层设计,即将晶体管、电源管理电路甚至光互连直接嵌入中介层。这一转变代表着半导体封装的根本性变革,能够实现更智能的信号布线、自适应电源管理和本地化处理。
“随着人工智能工作负载的增长,降低数据传输中的功耗至关重要,”Lee 说道。“有源中介层可以集成嵌入式电路,用于中介层上的信号调节和功率调节,从而提高规模效率。”
该领域最重要的进步之一是将光互连集成到中介层中。传统的铜互连在更高的数据速率下面临着越来越大的挑战,尤其是在人工智能和高性能计算 (HPC) 应用中,最大限度地降低功率损耗并最大化带宽至关重要。
基于硅光子学的中介层正逐渐成为一种解决方案,它能够实现芯片到芯片的光通信,而无需转换到电域。最近的演示已实现每通道超过 200 Gbps 的数据速率,这预示着传统电互连的潜在变革。
Lee说道,“最终,所有封装方向都将集中在光互连上,业界已经开始转向硅光子技术,将其作为高速数据传输的终极解决方案。”
然而,有源中介层的采用带来了新的散热挑战。更高的功率密度和嵌入式晶体管会产生额外的热量,必须有效地散热。研究人员正在开发用于瞬态热缓冲的相变材料、嵌入式微流体冷却通道以及高导热性热界面材料,以缓解这些挑战。这些解决方案旨在平滑温度波动、消散局部热量,并提高高功率AI和HPC应用的长期可靠性。
尽管有这些令人鼓舞的进展,有源中介层的商业可行性仍取决于克服若干制造挑战。确保嵌入式晶体管和光学元件的高良率制造是一个主要障碍。开发经济高效的工艺流程以扩大生产规模也同样重要。此外,业界必须建立稳健的中介层集成电路设计和验证方法,以确保其长期可靠性。
要将有源中介层推向主流,需要封装、芯片架构师和系统设计师之间建立更完善的协同设计方法。这种转变不仅仅涉及制造工艺的突破,更是行业对集成思维方式的彻底转变。
8、结论
半导体行业正在进入一个新时代,中介层和基板不再仅仅是无源结构元件,而是先进计算架构的重要推动因素。随着摩尔定律的放缓以及基于芯片集的集成成为行业标准,这些组件正在演变为复杂的功能化平台,直接影响性能、功率效率和可靠性。
艾邦建有玻璃基板与TGV技术交流群,可以加强产业链的合作,促成各企业的需求对接,同时您也可以与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验,欢迎您的加入。

|
议题 |
公司 |
|
TGV集成三维互联核心材料技术 |
华中科技大学温州先进制造研究院 |
|
涂布、干燥、贴膜工艺设备于玻璃基板及扇出型封装的应用趋势与挑战 |
群翊工業李志宏副總经理 |
|
Evatec先进封装基板FOPLP刻蚀和溅射方案 |
Evatec China 技术市场总监 陆原博士 |
|
TGV玻璃通孔激光加工中的基础问题和极限探究 |
南方科技大学教授徐少林 |
|
基于SLE(选择性激光蚀刻)工艺的精密玻璃加工——机遇、挑战与解决方案 |
Workshop of Photonics/凌云光技术股份有限公司 (VP of Business Development and Innovation) Martynas Dagys |
|
基于Holotomography(HT)的玻璃基板三维无损检测与良率提升策略 |
韩国Tomocube 销售经理 金泳周 |
|
玻璃基板封装关键工艺研究 |
中科岛晶产品经理徐椿景 |
|
Next in Advanced Packaging: Why Glass Core Substrates is emerging |
YOLE Bilal HACHEMI |
|
玻璃基板原材料的技术及其应用 |
拓科达科技(深圳)有限公司/NEG 日本电气硝子 |
|
应用于三维封装的PVD 系统 |
深圳市矩阵多元科技有限公司董事长张晓军 |
|
高精度非接触测量机在玻璃基板已经ABF载板行业中的应用 |
Mitutoyo/三丰精密量仪(上海)有限公司 营业技术部部长 李斌 |
|
TGV导电互连全湿法制备技术 |
深圳大学教授符显珠 |
|
议题拟定中 |
广东汇成真空科技有限公司 |
|
议题拟定中 |
芯和半导体科技(上海)有限公司 |
|
玻璃芯基板:新一代先进的封装技术(待定) |
拟邀安捷利美维电子(厦门)有限责任公司 |
|
议题拟定中 |
成都奕成科技股份有限公司 |
|
议题拟定中 |
希盟科技(3个议题) |
|
议题拟定中 |
牛尾贸易(上海)有限公司 |
|
议题拟定中 |
芯和半导体科技(上海)有限公司 |
|
议题拟定中 |
施密德集团公司SCHMID Group N.V. |
加微信李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100255?ref=172672



