技术原理与发展趋势
FOPLP 基本原理与优势: FOPLP是在扇出型封装的基础上,将传统圆形晶圆基板改为方形面板基板来进行晶片封装。由于面板的可用面积远大于晶圆,同等面积下可放置的晶片数量大幅增加,可提高约7倍的利用率。事实上,FOPLP 封装基板的方形基板利用率可达约95%,并具备容纳更多I/O接点、更小体积、更高性能以及更低功耗等优势。传统的扇出型晶圆级封装(FOWLP)自2009年商业化,台积电在2016年率先将其InFO(整合扇出)技术应用于iPhone 7 A10处理器,加速高I/O数、高性能晶片采用FOWLP。FOPLP 则将此概念延伸到更大的方形面板上,在同样单次制程中处理更多晶片,提升生产效率并降低单位成本。根据Yole Group 的分析,面板级封装相较晶圆级封装可节省约20%~30%的成本,特别适用于高产能需求的应用。这些成本优势主要来自于大面积基板减少切割浪费和单位面积内可同时封装更多晶片。艾邦建有半导体先进封装之FOPLP交流群,欢迎大家申请加入。

与其他先进封装的比较:目前先进封装技术可大致分为Flip-Chip 覆晶封装、2.5D/3D IC 封装(如硅中介层的CoWoS)、以及扇出型封装等类型。扇出型封装透过在晶粒周围重布线路(RDL)向外扇出电路,可突破扇入型封装I/O 数量受限的瓶颈,提升I/O密度。传统FOWLP 基于圆形晶圆进行封装,而FOPLP 则以大型方形面板作为基板。相较之下,2.5D/3D 封装(如CoWoS)是在硅中介层上垂直堆叠多颗晶片,以极细微间距互连,能提供最高的讯号密度和性能,适合高阶AI 加速器、HPC 处理器等。然而2.5D/3D 封装成本高昂,制程复杂且材料(如硅中介层)昂贵。FOPLP 则提供了成本与性能的折衷:它虽然目前在线宽/线距等指标上尚不及FOWLP 与CoWoS(难以达到2.5D 硅中介层的精细线宽),但藉由大面积处理提升了经济效益。在实际封装密度上,FOPLP 目前可实现的重布线宽/线距约15μm等级,适合中等I/O密度的晶片。相比之下,FOWLP(如台积电InFO)已可达更细的线宽线距,用于手机应用处理器等高密度晶片,而2.5D CoWoS 硅中介层线宽更细(几微米以内),能支援HBM 高频宽记忆体等超高I/O整合。总体而言,FOPLP 在封装尺寸和I/O密度上介于传统FOWLP 与2.5D 封装之间,但具有单位成本低、面板尺寸可大幅扩充的特色,是对高成本先进封装的一种平衡。

技术挑战与演进:由于面板尺寸远大于晶圆,FOPLP 面临的主要技术挑战在于面板的翘曲变形、制程均匀性与对位精度。初期许多厂商尝试FOPLP 时,因大型基板热应力难控,导致封装良率不佳。例如,面板越大翘曲越严重,使RDL 对位困难、压焊接合不良等问题频出,曾一度限制了FOPLP 的商业化进程。近年来,随着材料改良(如低热膨胀系数的基板材料或玻璃载板引入)、制程优化和装备升级,业界逐步克服了翘曲及对位难题。封装龙头日月光在历经十年研发后,成功控制了面板翘曲并完成试产,现在已将面板规格从早期的300×300mm拓展至600×600mm,同时保持良率在可接受范围。为确保大面板的良率,业者也导入了例如In-situ单元测试(如力成的InPUT® 技术)来及早筛检不良晶片,以提升整体良率。随技术进步,FOPLP 开始具备高良率的商业化优势。
未来发展趋势:在AI 与高效能运算需求爆发的背景下,FOPLP 技术正重新受到瞩目,被视为次世代先进封装的关键选项。全球多家大厂(台积电、英特尔、三星、日月光等)都在投入相关研发,预期未来几年FOPLP 的技术将趋于成熟。台积电高层曾在2024年表示持续关注FOPLP,估计再过约三年技术可趋于成熟。根据TrendForce 调查,FOPLP 封装的导入将呈现三种模式发展:(1) 传统OSAT封测厂将消费性晶片封装由传统封装转为FOPLP,以降低成本;(2) 晶圆代工与封测厂协力,将高阶AI GPU 等产品的2.5D 封装由晶圆级转为面板级,以扩大单次可封装面积;(3) 面板厂商跨足半导体,利用面板产线封装消费性IC。目前因FOPLP 的线宽线距仍不足以匹敌最先进的FOWLP/CoWoS,因此近期应用将以成熟制程、成本敏感的产品为主,如电源管理IC(PMIC)、中低阶射频元件等。预计自2024年下半年起至2026年,这类消费性IC的FOPLP 封装将逐步量产;而大型AI GPU等高阶应用则有望在2027~2028年开始走向量产。
届时,FOPLP 封装尺寸更大、成本更低的优势将为业界带来新的机遇,例如可用于封装整合更多晶粒的超大晶片模组。展望更长远的未来,FOPLP 还可能结合玻璃基板技术,以利用玻璃材料低热膨胀、高尺寸稳定的特性来进一步提高良率和互连密度。市场研究机构DSCC 预测,在多家龙头厂力推下,含玻璃基板封装在内的全球FOPLP 市场将以29%的年复合成长率成长,达到约29亿美元规模。总体而言,FOPLP 已从早期的概念验证阶段走向产业化门槛,随AI、5G 等驱动晶片尺寸日益庞大,FOPLP有望接棒成为未来先进封装的新主流。

Manz RDL多项制程设备,应用于FOPLP以及TGV生产制程流程,助攻面板级封装量产进程

各家公司在FOPLP 领域的技术能力与布局
本次重点分析日月光(ASE)、群创光电(Innolux)、力成科技(PTI)、东捷科技、友威科技这五家公司的布局。这些公司在封装制造与设备领域各有所长,涵盖了从封装代工到设备供应的完整生态。以下分别说明其在FOPLP 方面的研发投入、产能布局与技术特色:
日月光(ASE)
作为全球最大的半导体封装测试代工厂,日月光深耕FOPLP 已逾十年。早在台积电InFO 问世后,日月光即投入扇出型面板级封装的研发,目标提供更低单位成本的先进封装方案。经过长期技术攻关,日月光已克服面板翘曲等关键难题,取得显著进展。日月光在早期以300×300mm规格试产FOPLP,获得不错的良率表现;目前已将面板规格推进到600×600mm,并认为若600mm级产品的良率符合预期,将有客户导入,届时600×600mm 可望成为FOPLP 主流规格。日月光集团于2023年底宣布大举扩张:投资2亿美元(约新台币66亿元)在高雄厂区建置FOPLP 量产线,计画2025年第二季设备进驻,第三季开始试量产。根据日月光营运长吴田玉于2025年2月的说明,该产线将于2025年底前完成试产,2026年起送样予客户进行产品认证。此意味着日月光将在2026年正式承接客户订单,为市场提供商业化的面板级封装服务。
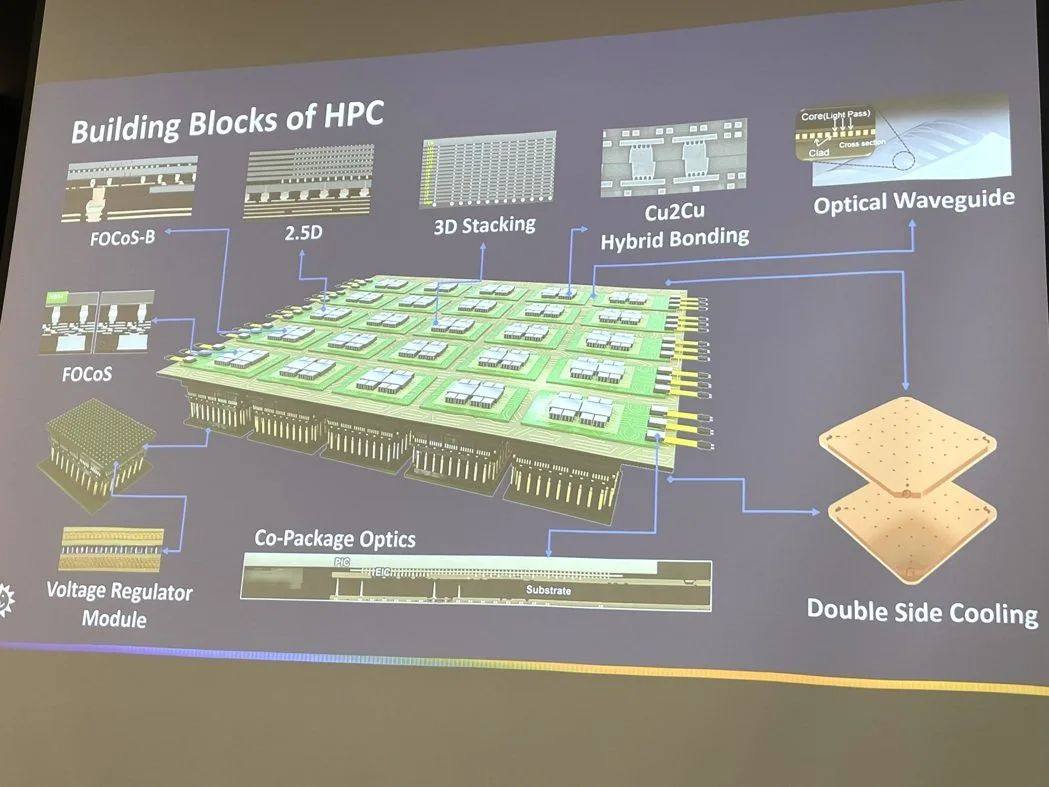
2月18日,日月光宣布决定斥资2亿美元在高雄建置FOPLP量产线,年底试产,明年送样。图源:经济日报
技术能力方面,日月光强大的研发实力与自动化产线是其优势之一。集团自主开发了控制大尺寸封装翘曲的关键技术,并导入高度自动化制程,以确保面板级封装的精度和良率。此外,日月光积极与终端晶片设计公司合作开发新产品。根据TrendForce,AMD 已与日月光接洽讨论以FOPLP 封装PC 处理器,Qualcomm(高通)则与日月光洽谈将电源管理IC(PMIC)采用FOPLP。这显示国际大厂对日月光FOPLP 能力的认可,应用范围从高阶PC CPU到类比PMIC皆有涉及。尽管目前高阶AI/HPC晶片大多仍采用台积电CoWoS 等2.5D封装,日月光预期透过FOPLP提供更大封装尺寸、较低成本的解决方案,未来可望分食部分高效能晶片封装市场。值得注意的是,市场传出台积电可能在2026年建立FOPLP试产线,且规格倾向与日月光的300×300mm接轨。虽然双方未证实此传闻,但若台积电与日月光在规格上协调,将有助于建立产业标准,推动生态系发展。
群创光电(Innolux)
群创光电是台湾面板产业的龙头之一,近年积极寻求转型,在FOPLP 领域扮演颠覆者角色。群创自2017年在经济部技术处A+计划支持下投入FOPLP 研发。利用多年制造大尺寸面板的经验,群创提出 More than Panel(超越面板)的转型策略,将先进封装视为重要的新事业。经过约八年的研发累积(2017~2025),群创已掌握了超大面板封装制程,是目前业界面板尺寸最大的FOPLP 生产者。

群创的FOPLP 面板尺寸高达700mm×700mm,远超其他业者常见的300~600mm规格。该公司内部订下目标,要在2025年上半年率先达成FOPLP量产。为此,群创已展开第二期产能扩充,试量产产线月产能约达1000片超大面板,并已送样给多家海内外客户验证。市场消息指出,群创已获得欧系IDM大厂恩智浦(NXP)和意法半导体的订单,今年5月26日有消息传群创传获SpaceX晶片封装订单。应用方面,群创切入的产品包括消费性电子(智慧手机相关晶片)以及车用电子等成熟制程晶片。
技术能力上,群创将显示面板制造的工艺优势延伸至半导体封装。许多显示技术(例如大型玻璃基板处理、精密曝光制程等)与FOPLP 有高度重叠,使群创在切入先进封装时别具优势。目前群创揭露了三阶段的制程蓝图:首先Chip First(先晶片)制程在2025年导入量产,用于较低I/O的产品;接着规划RDL First(重布线先行)制程,针对中高阶产品,预计1~2年内量产;最后是TGV玻璃通孔制程,难度最高,群创将与合作伙伴共同开发,预估2~3年后(约2026–2027年)投入量产。这表示群创不仅着眼于当前成熟制程芯片封装,也在研发玻璃基板技术以应对未来更高密度、高性能封装需求。为了支撑半导体布局,群创还启动「半导体快轨计画」,计划招募培训500名半导体专业人才,并与群创大学合作强化研发人力。在产业合作方面,群创与国内设备厂紧密合作:例如东捷科技长期为群创供应雷射加工设备,友威科技技则成为群创FOPLP 产线电浆蚀刻设备的重要供应商。总体而言,群创透过政府产业计划加持、内部积极转型,已成功由传统面板厂转身为先进封装的新势力,其大尺寸面板级封装领先业界,预期将在手机、车用等市场打开局面。
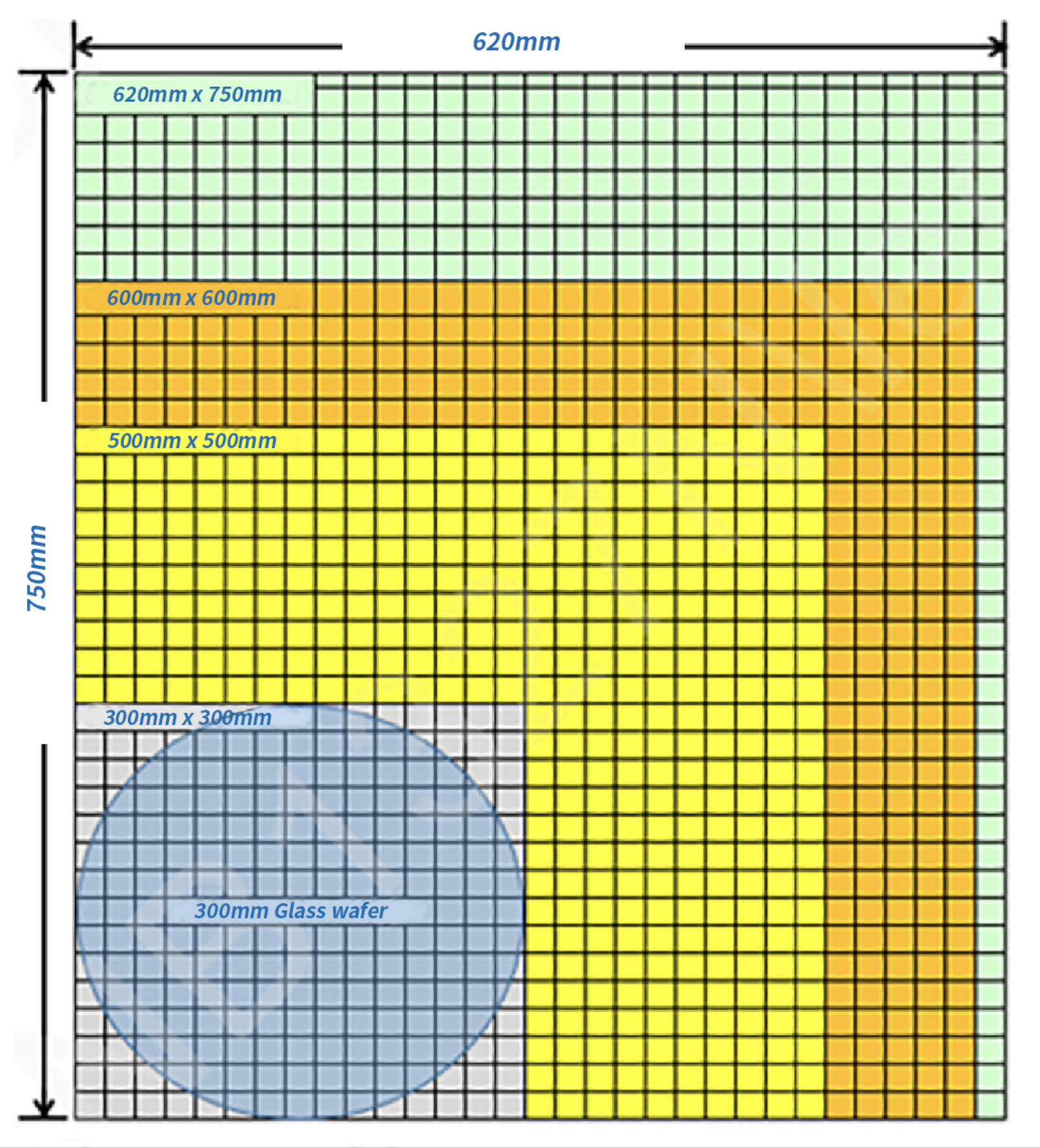
G3.5 FOPLP Glass Panel production area ,图源官网
力成科技(PTI)
力成科技是台湾记忆体封测的龙头厂之一,同时也是最早投入FOPLP 的OSAT 厂商之一。力成对面板级封装的研发可追溯到约2015~2016年:2016年即建置了FOPLP试产线,2018年在新竹湖口投资兴建全球第一座FOPLP 生产基地,雄心宣示FOPLP 将改变封装产业未来。经过近十年的研磨,力成已取得重要成果。截至2025年,力成已经完成面板级封装产能的布建,并率先进入量产阶段。业界指出,力成抢在台积电、日月光之前,与国际IDM大厂联手小量生产FOPLP新品,虽目前占营收比重有限,但随先进封装市场朝面板级发展,力成有望快速拓展新商机。事实上,力成FOPLP 已于近期开始小量出货,并且有重量级客户的高阶产品正进入验证阶段。据公司透露,该客户使用先进的2nm制程系统单晶片(SoC)搭配12颗HBM 高频宽记忆体晶片,整体封装成本高达25,000美元,是业界罕见的超高价值封装设计。

嵌入式面板级封装(ePLP®)平台

力成在技术研发上打造了自己的品牌与解决方案,包括嵌入式面板级封装(ePLP®)平台和多项商标技术,如ePLB®(嵌入式面板级BGA)、BF2O®(无凸块扇出封装)、CHIEFS®(Chip First 封装)等。其中BF2O® 主打单晶片且I/O数较少的封装(如电源管理、音讯IC),不需晶圆凸块且制程简化,而CHIEFS® 属于Chip First 流程,强调较Chip Last 方案具成本优势,可用于应用处理器、基频晶片、记忆体等需要较高集成度的情境。力成目前可提供最大510×515mm 面板规格的封装,对应其应用方向类似台积电CoWoS-L(大型有机中介层)的架构。由此推测,力成正瞄准高运算密度晶片(如HBM整合、Chiplet大晶片)需求,以有机/面板基板来实现类似硅中介层的大尺寸封装,同时降低成本。
展望未来,力成管理层表示预计2027年起FOPLP 可逐步对高阶CPU/AI应用贡献营收。这与TrendForce预期的时间表吻合:FOPLP 2027~2028年可望在AI GPU等领域真正量产。
东捷科技
东捷科技是一家以平面显示器生产设备起家的厂商,近年转向提供半导体先进封装相关的设备解决方案。东捷长期以来就是群创等面板厂的设备供应商,累积了大型基板加工的丰富经验。面对FOPLP 的兴起,东捷顺势将雷射加工技术导入封装制程,推出一系列针对面板级扇出封装的雷射应用方案。其中包含重布线路(RDL)雷射线路修补设备和雷射切割机等,并搭载自动光学量测系统,能快速精准地修复RDL 金属微小缺陷。这种设备在FOPLP 制程中相当关键:由于大面板上同时布设许多细微电路,一旦某区域有缺陷,传统方法可能报废整片面板,而东捷的解决方案可用雷射修补瑕疵,提升整体良率。据报导,东捷已深耕此类机台多年,并且已有实际交货实绩,其FOPLP 相关设备已被国内外客户采用。

在FOPLP 热潮带动下,各大厂扩产将使东捷直接受惠。尤其群创的大尺寸FOPLP 量产计划让相关设备需求激增,东捷与其关系密切,可望拿下多项订单。除了群创,日月光的高雄新产线也需要先进雷射加工设备,有助于东捷开拓新的客户。东捷本身也积极研发新功能,例如开发结合AOI(自动光学检测)的修补技术,以因应更精密的封装线宽线距要求。在国际竞争方面,由于面板级封装属新兴市场,专注于此领域的设备商不多,东捷有机会凭借先发优势取得一定的市场占有。
友威科技
友威科技也是一家源自面板产业的设备厂,专精于水平式电浆蚀刻设备。在FOWLP/FOPLP 制程中,电浆蚀刻技术应用广泛,例如去除再布线层介电材料、刻蚀封装孔洞、制作通孔等步骤。友威科技针对这些需求提供了独特的解决方案,使其成为面板级封装制程的核心设备供应商之一。该公司已成功打入群创的FOPLP 产线供应链,为其提供关键蚀刻机台。更值得一提的是,友威科技同时也是台积电CoWoS 封装制程的协力设备厂,参与了全球最先进的2.5D封装产线。能够同时服务于台积电和群创,显示友威科技产品在精度、稳定性和产能上达到了高标准,横跨高阶HPC封装与消费性晶片封装两大领域。

水平式电浆蚀刻设备
友威科技已将设备销售拓展至国外:某欧系车用晶片大厂已采用其FOPLP 设备,并规划新产线,友威科技有望持续接单。这意味友威科技的市场触角延伸到了欧洲先进封装生产线。在研发方面,友威科技深知大型面板制程的一些瓶颈,例如传统垂直式蚀刻在大面板上可能出现不均,因此其水平式电浆蚀刻设计有助于处理尺寸更大的基板并控制均匀度。长期而言,友威科技积极在FOWLP/FOPLP 领域申请相关专利,并透过与龙头客户协作来保持技术领先。它的双重市场定位(先进封装的CoWoS + 面板级封装设备)让公司在不同景气循环中都有支撑:当HPC 封装需求旺盛时,有台积电等订单;当消费/车用封装扩张时,有群创、欧系IDM订单。因此,友威科技在先进封装设备链中具备相当抗风险与成长潜力。

各家专利与研发投入情况
FOPLP 领域的竞争不仅是产能与良率的较量,更是专利布局与研发实力的比拼。日月光、群创、力成、东捷、友威科技这五家公司各自在研发布局上有不同侧重,合作伙伴网络也有所差异。下面将从专利、研发投入和合作关系三方面比较。
日月光: 作为全球封测龙头,日月光在先进封装领域的研发投入不遗余力,每年研发支出数十亿元新台币,拥有大批相关专利。针对FOPLP,日月光经过十年研发累积了大量制程专利,包含面板翘曲控制、超大型RDL布线、面板级自动化设备接口等。早在2019年左右,日月光就完成了试产线建置并申请多项Panel FO 专利,据北美智权报资料,日月光于2020年已开始量产部分面板级扇出封装应用在RF前端模组(此显示其专利技术当时已到实用阶段)。在合作方面,日月光的策略是紧密连结终端IC设计公司和IDM。
除了前述AMD、高通等直接合作开发,日月光也与晶圆代工龙头台积电保持微妙的合作竞合关系。尽管双方商业上是竞争对手(台积电也发展自有InFO与可能的面板封装线),但有传言指台积电和日月光正携手推进FOPLP 标准化,例如采用相同的面板规格。综合来看,日月光凭借雄厚的研发资本、广泛的专利布局和产业链影响力,在FOPLP 领域的长期竞争力最为深厚。一旦市场起飞,日月光有实力快速扩充产能并垄断高端订单来源。
群创光电: 群创作为新进玩家,其专利和研发着重于大型面板制程的半导体化。在政府支持下,群创累计投入不少于数十亿元经费于先进封装研发,据报导其团队包含上百位研发人员,并透过群创大学培养相关人才。群创已取得或申请多项超大尺寸封装相关专利,例如700×700mm面板设计、玻璃通孔(TGV)制程、面板级封装结构等,这些专利在传统半导体公司中相对稀缺,是群创的独特资产。
此外,群创非常重视产学研合作与联盟:除了政府计划外,也与工研院等研究单位协作攻关高难度技术(如TGV)。设备伙伴方面,群创基本绑定了在地的供应链,如东捷(雷射设备)、友威科技(蚀刻设备)、晶彩科等,这种产业合作集群有利于解决技术问题并实现快速量产。在国际上,群创则与IDM 客户形成紧密合作,NXP、ST 等在研发阶段即与其共同定义封装规格,甚至传出SpaceX 旗下供应链公司也在关注群创的FOPLP能力。这说明群创正透过商业合作换取技术成长:在量产订单的驱动下快速爬升经验曲线。从长期看,群创的挑战在于半导体封装产业经验较浅,专利数量和深度尚不及传统封装厂,但其优势是领先的面板制程Know-how无人能及。如果未来大尺寸封装成为主流,群创将凭借这一领域的专利与经验坐收果实,竞争力不容小觑。
力成科技: 力成在FOPLP 领域属厚积薄发型选手。早期的大胆投入让力成收获了丰富的专利成果——力成已为其各种FOPLP方案注册多个商标(如ePLP®, ePLB®, FOiP®, BF2O®, CHIEFS® 等),每一项背后通常对应一系列技术专利。因此可以说,力成已构筑起完整的FOPLP技术专利堡垒,涵盖从材料、制程到结构设计的方方面面。研发投入方面,力成相对于规模更大的日月光可能略逊,但其采取开放式创新策略弥补了资源不足。力成与美国大型客户联合开发产品,过程中共同攻克技术难关,等于部份研发由客户埋单并分享成果。
在合作伙伴关系上,力成的客户包括国际IDM 和一线IC设计公司。另外,力成也与材料厂商、中科院校保持合作来研发新材料和封装结构。值得注意的是,力成曾表示采行技术授权+服务模式,即愿意将部分自有FOPLP技术授权给策略伙伴,一方面扩大影响力,另一方面透过合作量产分润。这种灵活模式意味力成未来不仅自己做封装代工,也可能成为技术供应方,增加营收来源。长期而言,力成在FOPLP 的先发专利优势和灵活的商业合作模式使其具有强竞争力。随着2027年后高阶产品放量,力成有潜力取得相当市占。
东捷科技: 在专利与研发上,东捷的定位是专用设备技术的领先。该公司继承了面板设备时期的大量雷射加工专利,涵盖激光切割、微修补、光学检测等技术。转战FOPLP 后,这些专利基础让东捷能快速研发出封装用的雷射修复设备,形成一定的技术壁垒。尽管相较整体封装制程,设备厂的专利布局范围较窄,但在自己的利基领域东捷已处于国际先进水准。研发投入方面,东捷每年研发经费虽不及大型封测厂,但其研发效率高,产品开发针对性强——例如为群创量身订做700mm面板雷射修线设备等。
合作关系上,东捷与群创等面板厂是紧密盟友,双方协同开发符合生产需求的新机台。东捷也积极拓展客户至封测厂,如日月光可能需要的设备它也具备供货能力。长远来看,东捷的竞争力取决于FOPLP 市场对专用雷射设备的需求持续性。只要面板级封装产线在全球扩张,东捷有望凭借先发专利优势拿下可观市占。
友威科技:友威科技的专利与研发着力点在电浆蚀刻与清洗技术。该公司累积了多项水平蚀刻机台的发明专利,如如何在水平腔体中均匀去除大面积基板材料等,在专业领域属全球少数掌握者之一。它的研发投入虽然规模不大,但胜在高效专精,研发团队深入了解先进封装制程需求。例如,友威科技研发的新一代蚀刻设备可以对应CoWoS 封装中极细间距、极薄介电层的刻蚀,也可转用于FOPLP 的大面积均匀蚀刻。这种一机多用特性得益于公司对电浆源、流场控制的深厚研发底蕴。
合作伙伴方面,友威科技最重要的两大伙伴无疑是台积电和群创:前者让它参与全球最先进的封装工艺,后者则让它在新兴的面板封装展拳脚。此外,友威科技与欧洲IDM(如恩智浦、英飞凌等可能客户)互动增多,通过实际订单建立信任。友威科技的长期竞争力可从两方面来看:其一,它在CoWoS 供应链中的角色使其短期业绩有保障,技术能力也不断提升;其二,在FOPLP 这片新蓝海中,它已抢得部分市场先机,待更多竞争者进入时,它已有产品实绩和专利护城河。
总体评估:这五家公司在FOPLP 生态中扮演着不同角色,各有所长。日月光与力成代表封测厂的技术力与执行力,有深厚的专利池和量产经验,长期竞争力强劲。群创则以创新的姿态切入,拥有独特的大面板Know-how和政府/产业支持,竞争力来自差异化优势。东捷、友威科技作为设备商,凭借对本地市场的理解和先发研发,牢牢占据关键制程环节。同时,他们间也存在合作与竞争:例如日月光、力成在争取客户订单上竞争,但共同做大外包封装市场;群创、日月光可能成为不同应用领域的领导者;设备商东捷、友威科技则服务于上述所有厂商。
来源:https://vocus.cc/article/684851affd89780001944d2d,侵删
资料来源
1.Yole Group Fan-Out Packaging: Market and Technology Trends 2024
2.TrendForce 2025 Advanced Packaging Market Update
3.Counterpoint Research / DSCC — Panel Level Packaging & Glass Substrate Packaging Market Report
4.日月光(ASE) 2024Q4 法说会、2025年法人说明会简报、新闻稿(投资高雄FOPLP 产线、2026 量产规划)
5.群创光电(Innolux) 2024Q4 法说会简报、公司新闻稿(A+计划、700mm x 700mm 面板级封装)、媒体采访报导
6.力成科技(PTI) 2025 法说会简报、新闻稿(510mm x 515mm FOPLP 大面板良率突破)、技术白皮书(ePLP®, CHIEFS®, BF²O® 技术简介)
7.东捷科技(TST Group)公司法说会、新闻稿(FOPLP 雷射修线设备量产出货)、面板客户合作案例(群创)
8.友威科(UVECO)公司公告、法说会(水平式电浆蚀刻设备应用于CoWoS / FOPLP 量产案例)、欧洲客户设备采用新闻报导
9.工商时报、经济日报、财讯快报FOPLP 技术进展、各公司投资动态、日月光/ 群创/ 力成产线进度、国际客户合作消息
10.DIGITIMES / DIGITIMES Research FOPLP 与CoWoS 竞合分析、台系设备商布局、未来高阶封装发展预测
11.IEEE 会议论文— Recent Advances in Fan-Out Panel Level Packaging
12.工研院技术专题台湾FOPLP 技术发展现况、群创TGV 技术联盟合作、玻璃基板封装技术研究
艾邦建有半导体先进封装之FOPLP交流群,欢迎大家申请加入。

报名方式一:
加微信李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100255?ref=172672



