FOPLP(扇出型面板级封装)是近来非常受瞩的先进封装技术。 《日经亚洲》报导,传出台积电面板级装技术(Panel-level packaging,简称PLP)的开发已经进入尾声,这项技术将能够提高运算性能满足AI时代的新需求,被认为是封装领域迈向新技术的关键一步,预计2027年可以逐步进入量产阶段。艾邦建有半导体先进封装之FOPLP交流群,欢迎大家申请加入。

台积电此举不仅是技术上的突破,更意在为面板级封装设定行业标准,引导从设备制造商到材料供应商的整个芯片供应链进行调整,以适应方形基板的生产。
但FOPLP技术到底是什么?为何市场传出台积电已订定以「方」代「圆」目标,甚至有它是「下一个CoWoS」的说法传出?针对FOPLP,《数字时代》以下为您解密产业关键词,并盘点FOPLP受惠台厂名单!
一、FOPLP为何是先进封装新希望?
AI热潮正夯!而为发展如ChatGPT等大型语言模型(LLM),全球云端巨头无不广设数据中心,准妥「算力军火库」。然而,要打造具备生猛效能的AI芯片,先进封装就是个中关键!
先进封装意味着将不同种类的芯片,包括逻辑芯片、存储器、射频芯片等,透过封装及堆叠技术整合在一起,以提升芯片性能、缩小尺寸、减少功耗。例如,台积电针对7纳米制程以下的CoWoS技术,就是代表性的先进封装技术。
而FOPLP接棒台积电CoWoS备受关注的原因,在于透过「方形」基板进行IC封装,可使用面积可达「圆形」12吋晶圆的7倍之多,达到更高的利用率!白话来说,就是同样单位面积下,能摆放的芯片数量更多。

二、FOPLP和CoWoS差在哪?
现阶段的先进封装技术可分为「覆晶封装」、「2.5D/3D IC封装」、「扇出型封装」等类型:
-「覆晶封装」(Flip-Chip)透过把芯片翻转倒置,将IC直接与基板上的接点相互连接;
-「2.5D/3D IC封装」在中间层上垂直堆叠各类芯片,由此缩小接点间距,减少所需空间及功耗,CoWoS便是属于此类;
-「扇出型封装」(Fan-Out Packaging)则是相对于「扇入型封装」(Fan-In Packaging),两者在芯片设计的重分布层(Redistribution Layer,RDL)布线方式有所不同,扇入型为向内布线,讯号输出及输入的「I/O接点」数量受到限制;扇出型则是向内、向外布线皆可,从而提升I/O接点的数量及密度。
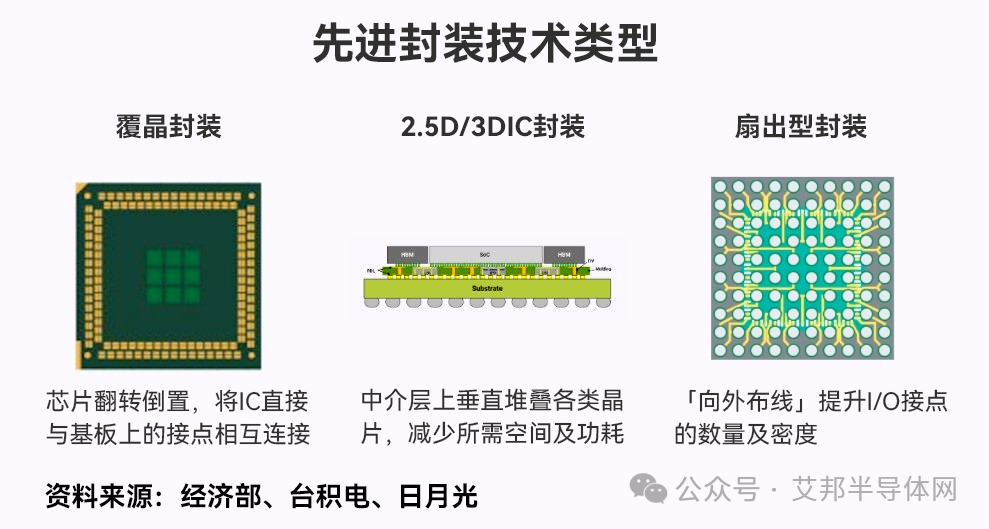
扇出型封装可再细分为两种分支,分别是已投入应用多年的扇出型「晶圆级」封装(Fan-Out Wafer-Level Packaging, FOWLP),以及本文主题的扇出型「面板级」封装(Fan-Out Panel-Level Packaging,FOPLP)。
垂直堆栈的CoWoS封装,目前主要运用在先进制程的AI运算芯片、AI服务器处理器的晶片封装,而FOPLP就各业者现阶段的描述,主要用于成熟制程为主的车用、物联网的电源管理IC等,两种封装技术的应用有所不同。

台积电积极布局先进封装,扇出型面板级封装(FOPLP)有望成为生力军。图/台积电
三、FOPLP优势|方形基板利用率高
「晶圆级」扇出封装的FOWLP,自2009年开始商业化量产,2016年,台积电率先将「整合扇出型」(Integrated Fan-Out,InFO)封装运用于苹果iPhone 7处理器,加速了高I/O数、功能强大的处理器采用FOWLP的趋势。
「面板级」的FOPLP则奠基于FOWLP基础,将封装基板从圆形改为方形,如此在同样面积的基板上,能摆放更多的晶片,不仅生产效率提升,切割过程中浪费的材料也更少,成本相对降低。
FOPLP以面板产线进行IC封装,方形基板利用率可达到95%,具备「容纳更多的I/O数」、「体积更小」、「效能更强大」、「节省电力消耗」等技术优势。
不过,FOPLP技术还在发展中,尚未大规模量产,面临的困难主要来自于面板翘曲、均匀性与良率等问题,有待相关厂商与设备商合力优化,短期内要挑战台积电CoWoS封装的地位,并不那么容易。
四、FOPLP相关企业
群创
面板大厂群创自2017年即开始投入FOPLP研发,近三年群创推动「More than Panel」(超越面板)转型,并定调今年是跨足半导体的「先进封装量产元年」。
因应庞大需求,群创今年迈入FOPLP第二期扩产阶段,已送样海内外多家客户验证,目前试量产产线月产能约1,000片,今年下半年可望量产。市场消息并传出已拿到荷兰半导体巨头恩智浦半导体(NXP Semiconductors)、意法半导体(STMicroelectronics)订单,FOPLP产能已满载。

图/群创提供
力成
记忆体封测大厂力成在FOPLP布局甚早,于2018年便兴建全球第一座FOPLP生产基地,当时并喊出FOPLP将改变未来封装产业。
日月光
封测龙头日月光也投入FOPLP,研调机构Trendforce先前指出,国际大厂包括超微(AMD)、高通(Qualcomm)针对FOPLP,分别洽谈PC CPU、电源管理IC等产品为主。
东捷
面板设备大厂东捷为FOPLP提供雷射应用方案,包括切割机、线路修补机等,长期是群创设备供应商。
友威科
同为面板设备大厂的友威科,则针对FOWLP、FOPLP,提供「水平式电浆蚀刻设备」。
鑫科
中钢旗下材料厂鑫科,近年拓展半导体材料布局,据传所生产的特殊合金载板,已开始供应群创及欧系IDM大厂供应链。
封装厂商:华天科技通过盘古半导体启动多芯片FOPLP项目,2024年完成厂房封顶;华海诚科实现FC/FOPLP封装材料客户验证。设备企业:盛美上海推出600×600mm清洗设备,获国内订单;材料端加速国产替代,但高端基板仍依赖进口。更多产业链动态将在后续更新,欢迎添加管理员微信aibang360001。



Nico 肖:136 8495 3640(同微信)
邮箱:ab012@aibang.com

方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名:
https://www.aibang360.com/m/100230?ref=172672
点击阅读原文即可报名玻璃基板论坛!


