LTCC 英文全称 Low Temperature co-fired Ceramic,叫做低温共烧陶瓷技术。LTCC 技术是将流延后的陶瓷材料按需求叠层在一起,同时内部印刷互联导体、元件和电路,最终烧结成一个集成式陶瓷多层材料。HTCC 英文全称 High Temperature co-fired Ceramic。
低温共烧陶瓷(LTCC)和高温共烧陶瓷(HTCC)工艺流程相似,包括 : 流延、打孔、填孔、叠层、切片、共烧、检验等步骤。

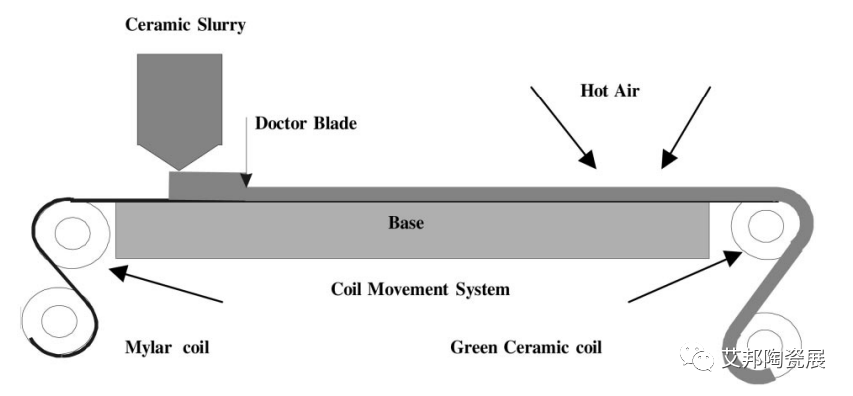
流延的目的是把陶瓷粉料转变为后续加工用的生瓷带。在陶瓷粉料中加入适当的粘合剂,经过球磨混料后形成高粘度浆料。其中粘合剂是流延工艺中的关键材料,粘合剂通常包括树脂、增塑剂、润湿剂、溶剂等成分,它的含量控制了浆料的粘度以及生瓷带的强度和塑形。流延工艺的关键参数为生瓷带的致密性、厚度的均匀性和强度。
打孔是多层陶瓷基板制造中极为关键的工艺技术,打孔的孔径大小、位置、精度等,直接影响基板内部走线的通断、布线密度、基板质量以及成品率。生瓷带的打孔主要有3种方法:钻孔、冲孔和激光打孔。孔径的大小可根据设计者而定,若用数控冲床打孔,根据冲头大小的不同一般孔径为 4 mil、6 mil、8 mil、10 mil几种;如用激光打孔,孔径能达到 50 um甚至更小。
填孔是利用填孔机底部气囊加压将掩模填充板上的填充浆料挤压到相应的生瓷片通孔内,经干燥后,完成生瓷的金属化过程。填孔有三种方式:厚膜印刷、丝网印刷和导体生片填孔。
丝网印刷是通过丝网印刷机机头带动刮板头将网版上的电子浆料均匀地填充到基板或生瓷片上开好的通孔内部,以获得完整的印刷图形或填孔。丝网印刷制作导带时,最细的线宽可达 100μm,最小的线间距可达 150μm。
导体生片填充法是将厚度略大于生瓷带的导体生片冲进通孔以达到金属化。导体生片采用流延工艺生成。此法可提高多层基板的可靠性,但现有的工艺不够成熟,对填充通孔的浆料粘度和流变需要严格的控制,如果选择填充浆料不当则不利于盲孔。
共烧导电体的印刷可采用传统的厚膜丝网印刷和计算机直接描绘。丝网导电体印刷技术简单易行,投资少,可获得很高的分辨率,线宽可达 100μm,线间距可达 150μm。计算机直接描绘是应用计算机控制布线,用导体浆料直接描绘出导电带的形状,无需制版和印刷对位,方便灵活。但对导电浆料的粘度和干燥速度有较高的要求,设备投资大,操作复杂,效率低。
叠片是将印刷后的生瓷按照设计的层数和次序依次叠到一起,在一定的温度和压力下,使生瓷紧密粘连,形成一个完整的多层基板坯体。叠片时需要保证层与层之间的对准精度。在形成生瓷坯后,要进行热压。热压温度一般在60~120℃,压力为50~300 kg/c㎡。热压主要有两种方式:单轴向热压和均衡热压。
单轴向热压是将叠放的生瓷带放置在热压炉内直接进行热压。此种工艺压力是从单一方向施加的;因此热压到一半时需要将叠层的瓷片进行180° 的翻转。此种方法会产生气孔、开裂和较大的伸缩率等现象,尤其是在边缘和单层时z方向的收缩率尤为明显。
均衡热压是将叠放完成的生瓷带在真空下密封在铝箔中,然后放于热水中加压,这种工艺的生瓷胚体的受力是各向相等的。水温和施压的时间条件同单轴向热压相同;施加的压力要高于单向热压。压力的均匀一致性是叠层热压工艺的关键,直接影响基板烧结的伸缩率。基板烧结的伸缩率随着压力的增大而减小。压力太大,会引起基板分层;压力太小将导致伸缩率加大,收缩率一致性差。
切片是将层压后的生瓷坯按设计尺寸要求切割成生瓷块 (独立的电路单元基板),可由3种方法来实现:①运用钻石轮划片机,这是一种最普通的方法,对矩形形状的切分最为有效,可减小外形尺寸的误差,边界质量很高;②运用超声切割机,切成部件的误差很小,适用于各种不规则形状的切割,但处理过程很慢且费用昂贵;③应用激光进行切割,误差较小,但边界质量很差。
将层压、切片后的生瓷块放到烧结炉内的支架上,在适当的曲线和气氛条件下将生瓷块烧结成合格的基板。烧结分为两个过程:排胶和共烧。排胶的目的是将有机粘合剂汽化和烧除,排胶不充分,基板烧结后会起泡、变形或分层;排胶过量,又可能使金属化图形脱落或基板碎裂。在排胶后升高一定的温度开始共烧,此时坯体内部玻璃相生成、润湿氧化铝颗粒,磁体和金属导体烧结及基板尺寸收缩定型。
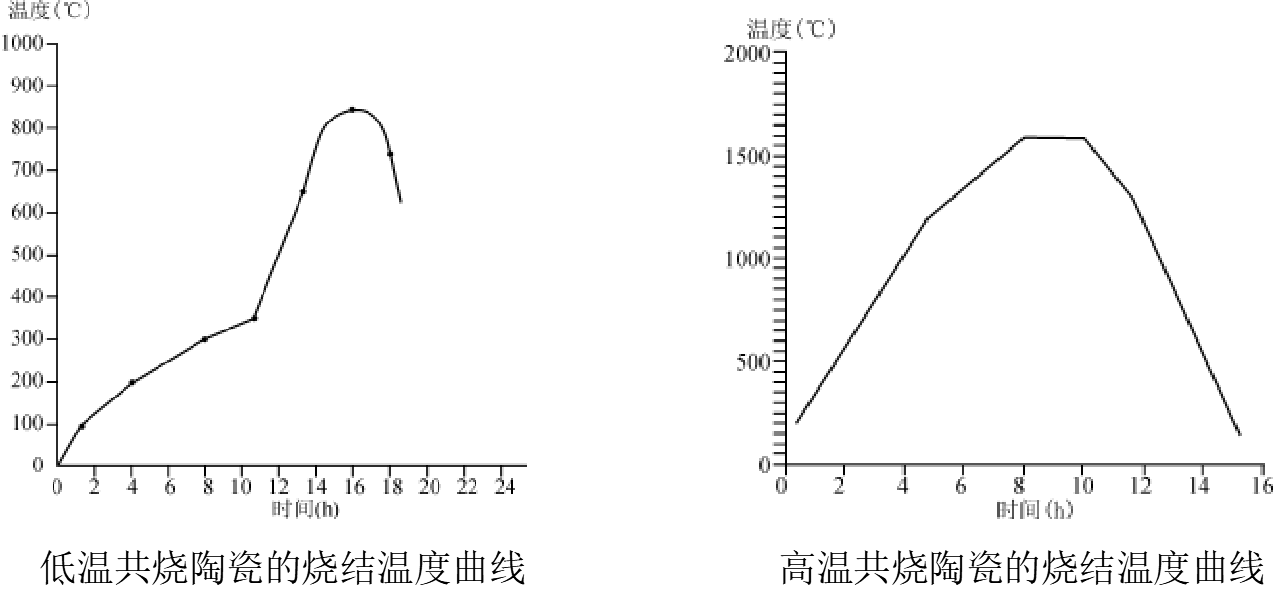
检验是判别基片优劣的依据。检验分为目检和测试,目检主要检测外观,如平整度、一致性、导带是否光滑等。测试利用测试仪在测试软件支持下,验证基板布线的连接性,判断LTCC基板电性能是否合格。
陶瓷封装产业链从芯片、陶瓷封装产品(陶瓷外壳、基板及覆铜板等)、封装环节到最终封装成型的电子产品,如光通信元件、汽车 ECU、激光雷达、图像传感器、功率半导体等;设备方面包括装片机、固晶机、塑封机、键合机、检测设备等;材料包括氧化铝、氮化铝、氮化硅、金属浆料、引线框架、包封材料、键合丝等;艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游扫码加群与我们交流。
长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
The 7th Ceramic Packages Industry Forum
更多议题征集中,演讲&赞助请联系王小姐:13714496434(同微信)
方式一:加微信
王小姐:13714496434(同微信)邮箱:wanghuiying@aibang.com
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100179?ref=196271
原文始发于微信公众号(艾邦陶瓷展):LTCC/HTCC陶瓷共烧技术