文|爱集微
图源|爱集微

现今在扩展摩尔定律的经济性方面,先进封装技术扮演着举足轻重的角色。它有助于克服日益增长的制造成本和电源管理问题,同时实现与每个新晶体管节点的单片设计相关的速度提升效能。
先进封装技术有几种分类方法,整个行业的定义也并不一致。一般来说,它们包括扇出晶圆级封装(FOWLP),2.5D、3D IC和系统级封装(SiP);此外,WLCSP、FCBGA和FCCSP通常也被包括在Yole集团的市场调查范围中。虽然目前大多数(>70%)的芯片封装仍然使用打线接合的方式组装,但高性能产品向倒装芯片封装过渡的趋势正在加速,预计在未来几年将迎来像2.5D、3D和SiP封装一样高的市场增长率。
使用芯片封装方法能够组装不同设计节点上具有分立功能的多个芯片,以提供一个集成的模块级性能。如图1和图2所示,人们可以考虑采用各种技术来满足特定的布线功能规格;然而受物理特性、加工条件和设计规则的限制,材料的选择在每个个案中都有所不同。当封装布线密度增加时,衬底材料组合的使用也就会发生转变;而这种转变受到几个因素的影响,如光刻工具、网纹尺寸以及最重要的材料物理特性和加工温度等级。
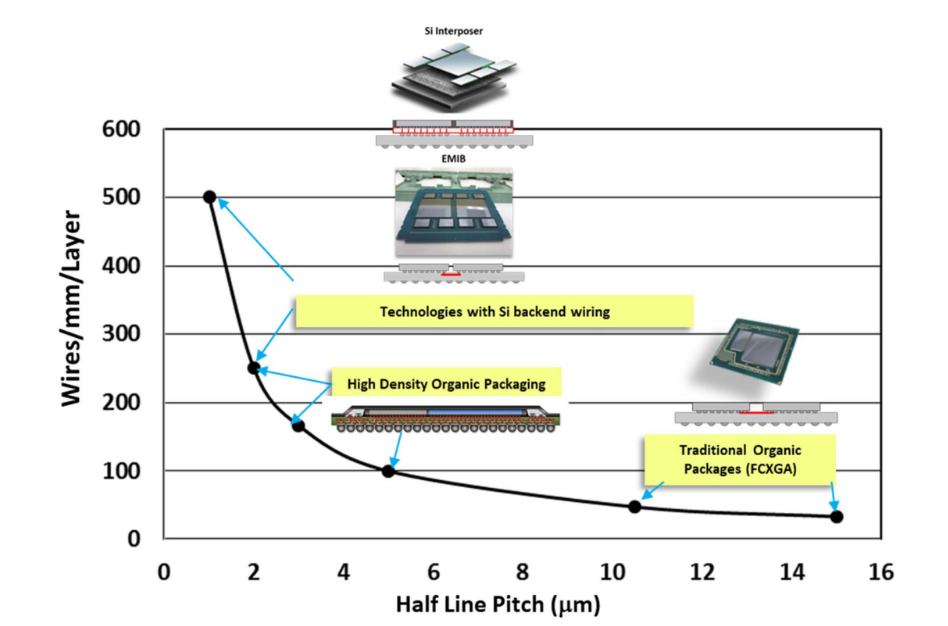
图1. 不同布线功能的技术(HIR 2021版)

图2. 先进封装类型概览(Synopsys)
高效能计算(HPC)、2.5D和3D封装使用硅插板进行异构集成,已被业界广泛采用。移动计算方面,受限于尺寸和封装高度,则采用PoP组装,将应用处理器、存储器、传感器、无源元件等互连起来,建立一个子系统或系统级模块。各种方法都被用来实现封装与封装之间的连接,其中包括焊接凸点、TMV(穿模孔)、铜柱(例如台积电的Through-InFO-Via TiV)、粘接孔阵列(BVA)、独立铜线等。
要建造上述复杂的结构需要许多材料的配合。这也包括与工艺有关的间接材料,如光刻胶、粘合膜、焊剂、用于临时粘合的玻璃和金属载体晶圆等。为了完成封装中的各种互连方案,业界已经开发了一系列关键的直接材料,包括光敏RDL(再分布层)材料、应力缓冲涂层、建立膜、焊膏、基材、mSAP Cu、焊接掩模等,以满足高密度封装的要求。
以焊接凸点连接为例,倒装芯片封装已经从高熔点的无α粒子排放的锡/铅焊料转移到无铅的SAC(Sn/Ag/Cu)和锡/银(Sn/Ag)合金。铜-铜混合焊接工艺现在已被用于实现硅层面的细间距焊接,如芯片到芯片、晶圆到晶圆的连接。铟(In)和铋(Bi)合金被用于连接对温度敏感的设备,如用于低温接合工艺。
另外,倒装芯片的底部填充物能提供保护与可靠性;主要通过减少热循环期间硅芯片和载体之间的CTE(热膨胀系数)不匹配所引起的焊接凸点连接的机械应力来完成。配方通常以环氧树脂或氰酸酯热固性树脂为基础,需要加载一种填充材料来控制材料的CTE和模量。液体底层填料最先是使用液体环氧树脂和低α熔融石英混合物开发而成。沿着模具边缘分散后,树脂通过毛细力在芯片下移动,能够在模具周围形成漂亮的圆角,以便检查。随后,树脂通过热固化的方式硬化,以完成这一过程。由于填充物的几何形状、数量和使用的耦合剂会影响流动特性,后来的工作涉及使用混合尺寸的合成硅球来控制CTE和优化流动特性。更多的开发工作让不流动的底部填充物(不导电浆料,NCP)、不导电薄膜(NCP)、晶圆级B阶段的底部填充物、可返工树脂等能够满足各种先进的封装需求。模塑底部填充(MUF)将模塑和倒装芯片封装结合在一个步骤中,省去了树脂分配和固化的环节。因它具有提高生产效率的优势而获得业界的认可;为了提高板级的可靠性,底部填充树脂也被广泛运用到一些CSP和BGA的连接工艺中。
提供封装设计选择的最佳材料,需要考虑到多项材料的特性;除了硅之外,被用作电路布线基础的还另有三种有机树脂基材料。图3说明了一个两片式FOWLP封装。FO材料组合由硅片、环氧树脂模塑料(EMC)和聚酰亚胺RDL层组成,由激光钻孔的通孔连接。底部的有机载体由3个ABF(味之素堆积膜)堆积层组成;其核心由8层BT-环氧玻璃预浸料构成,具有机械钻孔的PTHs(电镀通孔)。
表1显示了用于建造该封装材料的主要特性,并条列出每种材料的典型值。然而,物理特性会随材料成分不同而有所变动,这些材料皆须通过微调才能满足特定的加工和封装性能要求。

图3. BT基板上的多芯片FOWLP--ASE FOCoS (HIR, 2021版)


表1 封装材料性能*Tg的DSC(NIST,INVACU,供应商数据)
成长快速的FOWLP是一种用于高阶应用的封装类型。它源于英飞凌在2000年代首次披露并投入生产的WLCSP概念。STATS ChipPAC(现在是JCET的子公司)后来成为OSATs中首位大批量产制造的公司。与传统的晶圆级封装(WLP)不同,扇出型(FO)封装需要个别的材料和设备组合;因其重分布层(RDL)的连接面积大于芯片规模,而这与硅衬垫方法相比,扇出型晶圆级封装(FOWLP)为多芯片互连提供了一个成本较低的选择。
新发展同时也带来了工艺变体,以产生适合高阶封装集成的扇出型晶圆级封装(FOWLP)组合。同时它提供了一些优势,比如更小的尺寸、更低的成本、消除凸起工艺、布线的灵活性,这些都有利于集成到高阶封装中。
详细检查上述封装方式后,人们可能会注意到:以硅和EMC为基础的扇出型晶圆级封装(FOWLP)上的电路线/空间特征要比建立在BT-环氧树脂层压板上的有机芯片载体上的特征小很多。图1和图2也清楚展示了这一重大差异。
要形成具有精确多层配准的细间距布线,需要使用尺寸稳定的载体。在这方面,如先前的例子所示,硅相比有机基材是较优良的选择,这是因为各种复杂的因素本质上影响着有机BT基材的尺寸稳定性;这些因素可能包括树脂配方、层压板的热力学性能、加工条件和环境影响。我们将在下文更详细地探讨相关主题。
BT基材
A. 树脂配方
BT是双马来酰亚胺-三嗪树脂(Bismaleimide-Triazine)的缩写。它是一种热固性配方,由两部分组成:双马来酰亚胺和氰酸酯树脂。化学结构如图4所示。-三嗪树脂是指氰酸酯在热固化后通过环化反应的还原产物。
A.

B.
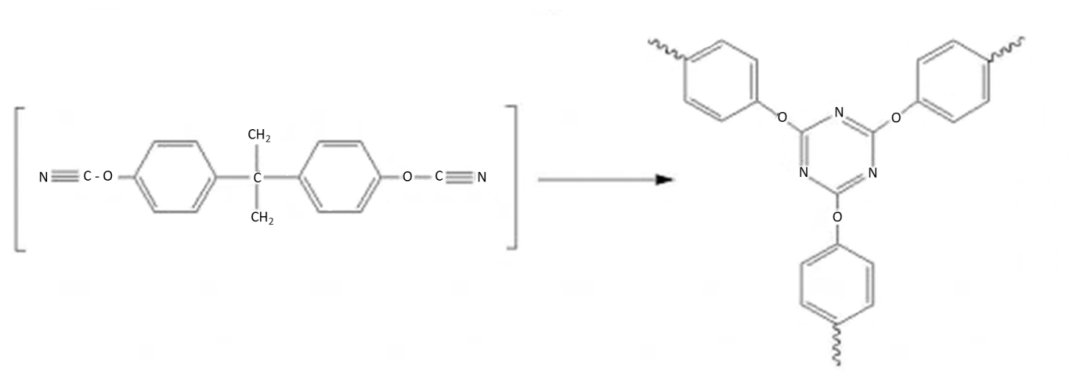
图4. BT树脂成分-双氰酸酯形成的双马来酰亚胺-三嗪树脂
I. 双马来酰亚胺树脂
双马来酰亚胺是一种聚酰亚胺,具有已经醯亚胺化的化学结构,在固化过程中不产生挥发物。由于它优异的耐热性表现,并可使用与传统热固性材料相同的设备进行加工,这类树脂已被配制成二胺固化剂,并用于航空与航天高级复合材料和印刷电路板的应用。
II. 氰酸酯树脂
氰酸酯树脂技术的发展始于1960年代。芳香族酚类化合物最先成功合成出单体。双酚A中提取的双氰酸酯最常被使用,它也是许多环氧树脂的原料。第一个双氰酸酯树脂,Traizine A,在1970年代中期被引入电路板行业。氰酸酯树脂可与各种热固性材料混合,如环氧树脂、双马来酰亚胺或丙烯酸酯,形成兼容的混合物。
此外,这款树脂类型的电气性能表现优于环氧树脂固化后树脂的介电常数和损耗系数比FR-4低。现已开发各种以氰酸酯为基底的配方,并专门应用于封装领域,其中包括:底部填充物、涂层、粘合剂、封装剂、芯片载体基材、积层介质膜、印刷电路板(PCB)、光刻胶等。它们也已被纳入先进复合材料行业的各种应用配方中。
III. BT层压板
通过与亚甲基二苯胺双马来酰亚胺的混合,三菱瓦斯化学公司开发了一种基于氰酸酯的BT树脂系统。BT基材延伸自印刷电路层压板技术,在基本配方占比中,环氧树脂基本超过一半。
BT-环氧树脂混合物在有机溶剂中呈现出良好的溶解性,如用于浸渍加工的甲乙酮(MEK)。而用于芯片载体应用的BT基材,是一种具有玻璃纤维作为加固的复合层压板,与传统的FR-4相比,BT-环氧树脂因为有高Tg(玻璃转化温度)和较佳的热阻,使材料能够承受高温组装加工和高热操作环境。这些关键特性使它们更适合应用于芯片基材。
其制造过程遵循传统的PCB生产流程。关键步骤是浸渍、B阶段、预浸料层压和电路化。鉴于多层结构,BT基材能够加入嵌入式模具和无源元件,如有源器件、插板模具、电容器、微机电(MEMS)器件等。
在建造BT-环氧树脂层压板时,所使用的多种材料和工艺步骤会不可避免地引起机械应力,需要特别注意和控制其对材料尺寸稳定性的影响。
B.Tg和CTE
一般来说,热固性树脂的Tg是随着固化曲线而产生的,并在达到高度转化后稳定下来。因此,加工条件会影响材料的最终Tg,通常在最终固化温度之下或附近。
根据其化学结构,纯氰酸酯树脂在完全固化后很容易表现出超过280℃的Tg。因而无法使用传统的PCB工厂的压力机(通过加压水加热,最高工作温度约为180℃)来进行层压和完成完全固化。为此,常见的配方方法是通过添加各种级别的环氧树脂来降低Tg,同时改变树脂的可加工性和调整性能,如机械性能、可燃性等。较高的Tg层压板通常需要使用高温层压或后固化来发展材料的全部性能。
如前所述,热固性树脂在完成交联反应后达到稳定的Tg。当温度高于其Tg时,固化的树脂会经历一个从无定形到橡胶状态的相变。这种自由体积的转变导致了树脂的模量、伸长率和CTE的急剧变化,影响了尺寸稳定性,并在各种界面上产生了热不匹配的应力。
在玻璃纤维加固的帮助下,刚性层压板表现出接近铜的X-Y平面CTE(17ppm/℃)。这一特性可最小化基材和电路之间的界面热失配。由于平面内的约束,基材的Z轴CTE通常超过40 ppm/°C;因此,在热循环过程中会在PTH中产生界面应变。将低CTE填料混合到基体树脂中,进一步降低了各个方向的CTE;尽管如此,这种类型的配方往往带来更多的变量,在生产中需更加留意。
BT-环氧树脂的铜剥离强度难足够,但略低于FR-4的剥离强度。然而,这个值受到几个变量的影响,如表面预处理、电路化方法和所用铜箔的类型。
C.玻璃织物和尺寸控制
大多数BT层压板都是由E玻璃纤维制成的。其他等级的玻璃纱,如S-玻璃、D-玻璃和熔融石英,具有较低的CTE和介电常数,生产量较小。它们在化学成分和物理特性上有所不同。机织物有多种不同厚度、重量和纱线结构可供选择。由细纱制成的轻质织物可以生产出最终压制厚度为15-30微米的预浸材料。
玻璃纤维是预浸料制造的关键要素。生产前期使用处理机(涂布机)将玻璃纤维与树脂溶液浸渍在一起。再通过加热挥发树脂饱和织物中的溶剂,使其干燥、固化树脂部分,形成B阶段的预浸料。需要控制的几个关键参数包括树脂含量、粘度流量和低于树脂凝胶点的固化程度。
三种树脂成分之间的交联反应复杂而难以特征化。过去为建立树脂混合物的结构-性能关系已进行各种尝试。一些研究小组已经对可能的机制进行了各种光谱模型研究并提出了建议。
一层或多层预浸材料在加热和加压的情况下被铜箔夹住,形成铜芯(CCL),用于进一步电路化。由薄型轻质织物制成的预浸料中的树脂含量一般高于60%(重量)。
在硅载体上制造前端设备和RDL层时,会以多步骤工艺依序建立电路层。与此不同的是,层压工艺能让多层布线在一步骤中同时组装进电路化芯子。内部电路平面的互连则是通过导通孔(via)和电镀通孔(PTH)完成的。
作为一种层压复合材料,BT-环氧树脂基材在制造、暴露于湿度或热循环中容易发生尺寸变化。为了维持稳定的布线连接,必须有精确的内层配准。因此,需要仔细控制浸渍和层压步骤中会影响材料尺寸稳定性的因素。织布时产生的残余应力、张力下的浸渍、树脂固化收缩和预浸料层压都会造成层压板一定程度的尺寸移动和翘曲。
通常情况下,由于玻璃纤维引起的应力,单层板的翘曲机率较高、尺寸稳定性也较差。所以,如果厚度要求符合规格,交叉铺设均匀的预浸料层系中和该缺点的方法之一。当选择了一套材料后,重要的是要了解哪些因素控制了最低程度的材料移动,以及其移动的一致性和可重复性,才能用光刻工艺做出相应的改善。
D.湿度敏感性
尽管氰酸酯树脂拥有一些优于环氧树脂的特性,但对湿度却相当敏感。在预浸料制造、储存和处理过程中,排除湿度对树脂化学反应的影响至关重要。在有机金属盐的催化下,芳香族氰酸酯三聚体会形成一个稳定的氰尿酸酯、s-三嗪环状结构。然而,若有水份参与反应,芳基氰酸酯很容易水解成氨基甲酸酯分子,在加热时释放二氧化碳气体。这种副反应会引起层压板起泡,并降低最终材料的性能。
通过适当的控制,完全固化的BT-环氧树脂层压板具有良好的防潮和分层性能。树脂/玻璃纤维界面的存在和固体树脂中的自由体积能防止水分向层压板扩散。织物上耦合剂的处理则增加了玻璃纤维/树脂的附着力,以此提升防潮性。吸湿性遵循典型的Fickain Ⅱ型曲线;通过加热完成解析。影响层压板尺寸稳定性的湿热影响包括X-Y平面内移动和平面外翘曲。由于层压板中包含多个组件,基材的翘曲特性相当复杂,且会直接影响其在载体表面的细线图案能力。这一特性需要适当控制,以减少在电路化步骤中出现不必要的产量损失。
众所周知,BT-环氧树脂能有效防止导电性阳极细丝(CAF)的形成。CAF系多层电路层压板中的不良现象,由金属丝从镀铜孔或PTH沿玻璃纤维纱线生长而造成的相邻Cu平面电短路。该现象受到湿度、离子杂质、电偏置、玻璃纤维/树脂界面附着力强弱和高温的影响。CAF最常发生于机械钻孔时,因其中弱化的纤维/树脂界面给予细丝生长的空间。
BT-环氧树脂基材已被广泛应用,从单芯片到高阶封装,如FO基板、PoP、SiP、嵌入式设备/组件、多芯片HI和2.5/3D堆叠产品。现已发展出各式各样的基板设计。以存储器产品为例,目前大量的商品DDR4是通过线键连接到窗口FBGA(BOC)BT-环氧树脂封装上的,只使用单层电路;而早在几年前,某些DDR2已采用RDL布线,并使用铜柱连接到特殊应用的基板。
细线图案制作需要平整、尺寸稳定的表面,BT-环氧树脂基板作为一种复合材料确实在一定程度上受限于其物理性质。这些特性在上述讨论中已经说明了。因此,硅和玻璃等材料可以通过薄膜沉积工艺形成细间距电路,尽管成本更高,但能成为高密度布线的替代性解决方案。
E.基板市场
集成电路基板涵括在市值800多亿美元的PCB原板市场内。在HPC、移动、5G、汽车和芯片整合需求的推动下,基板销售在过去几年正以每年20%以上的速度增长(图5)。BT基板供应链集中在亚洲。主要供应商包括欣兴电子(Unimicron)、景硕科技(Kinsus)、南亚电路板(NYPCB)、日月光(ASE)、鼎基(Zing Ding)、乐金伊诺特(LG Innotek)、鑫研通(SimmTek)、三星电机(SEMCO)、大德电子(Daeduck)、香农科技(Shannon)等。

图5. IC基板市场的增长 * FCCSP/FC-BOC, WB PBGA/CSP, 模组
(AT&S演讲2022/23年第一季度,Prismark)
封装尺寸和层数的增加有望带动BT基板市场成长(图6),图中说明了几个关键驱动因素。图7显示了一个封装天线(AiP)/SiP封装的例子。5Gmm波段相关的手机应用是推动基板使用需求增加的主要细分市场之一。它的发展趋势侧重于更小、更薄的封装,以满足更高频率和多频段的应用。正如JCET在其5G SiP路线图中强调,能实现5G的封装技术所在多有。另一带动市场增长的助力来自于存储器产品中越来越高的基板使用量。用于HBM、eMMC和DDR5的FCCSP的基板将受益于更高的ASP。随着中国的长江存储和合肥长鑫进入扩张周期,台湾BT基板市场也有望进一步扩大。

图6. 英国电信基板市场成长预测 (高盛全球投资研究11/2022)

图7. 华硕ZenFone 4 Pro在FEM中的AiP实现(Yole Group)
先进的封装允许在不同的技术节点组装具有不同功能的芯片(Chiplets),以实现封装级的系统集成。基板技术正不断发展,并成为趋势和市场成长的关键推动力。
(校对/范蓉) 责编:刘洋
更多重磅新闻,
请点击进入爱集微小程序 阅读
或下载爱集微APP阅读

点击下载爱集微APP
打开半导体新闻阅读新方式
原文始发于微信公众号(半导体投资联盟):集微咨询:BT基板将助推先进封装的进程




