SiP系统级封装产品按工艺或材料通常分为:塑料封装SiP、陶瓷封装SiP和金属封装SiP几种类型和各自的特点。其中陶瓷封装SiP也简称为陶封SiP,美国航空航天局NASA,欧洲太空局ESA采用的SiP基本上均为陶瓷封装SiP。目前,国内领先的航空航天和军工领域的研究所都开始研究和应用SiP技术,他们也不约而同地选择陶瓷封装作为首选的SiP产品封装。
陶封SiP密封性好,散热性能好,对极限温度的抵抗性好,容易拆解,便于问题分析,相对于金属封装体积小,适合大规模复杂芯片。有了这些优点,陶封SiP确实最适合在极限苛刻环境中应用的航空航天等军工领域。在陶封SiP设计中,有一个最明显的特征就是:陶封SiP中基本都采用了腔体结构。
1 什么是腔体?
在《SiP系统级封装设计与仿真》一书中,我这样写道:“腔体Cavity是在基板上开的一个孔槽,通常不会穿越所有的板层(在特殊情况下的通腔称之为Contour)。腔体可以是开放式的,也可以是密闭在内层空间的腔体,腔体可以是单级腔体也可以是多级腔体,所谓多级腔体就是在一个腔体的内部再挖腔体,逐级缩小,如同城市中的下沉广场一样。”下图是城市中常见的下沉广场,底部区域供人们活动,台阶可以当看台或者坐下休息。

城市中常见的下沉广场
下图是陶封SiP中常见的腔体结构,底部区域安装芯片,多级腔体的台阶上可以放置键合指Bond Pad。两者唯一的区别就是下沉广场多为圆形,而陶封SiP中的腔体多为方形,当然也不排除有些项目中采用了圆形腔体。
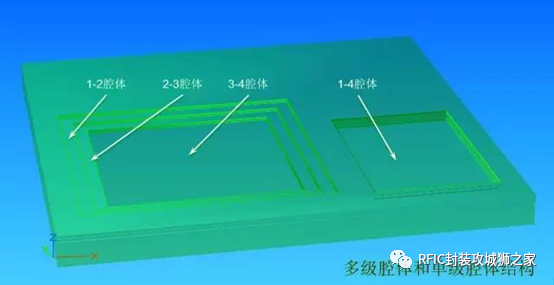
陶封SiP中常用到的腔体结构
2 陶封SiP为何基本都会采用腔体?
搞明白了腔体的定义后,我们再来看看陶封SiP为何基本都会采用腔体?根据亲自参与的多个陶封SiP实际项目,我总结了一下,大致有以下三种原因:
- 腔体结构有利于键合线的稳定性
对于复杂的芯片,常常要采用多层键合线,键合指的排列经常有3-4排,这样外层键合线就会很长,跨度很大,不利于键合线的稳定性,而腔体结构则能有效改善这种问题。从下面两张图就可以明显地看出腔体结构大大减小了键合线的长度,从而有效地提高了键合线的稳定性。
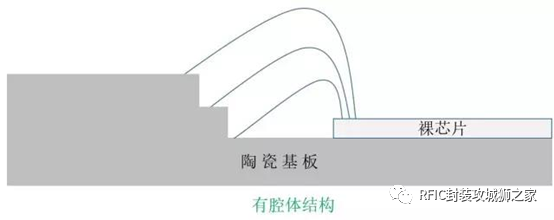
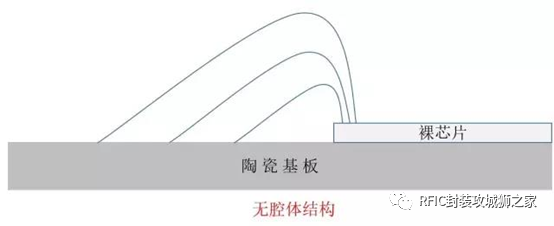
- 腔体结构有利于陶瓷封装的密封
采用腔体结构的陶瓷基板,芯片和键合线均位于腔体内部,只需要用密封盖板将SiP封装密封即可。如果无腔体结构,则需要专门焊接金属框架来抬高盖板的位置,这样就多了一道焊接工序,其焊缝的气密性也需要经过严格考核才能达到气密性要求。
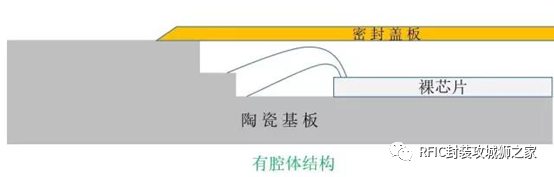
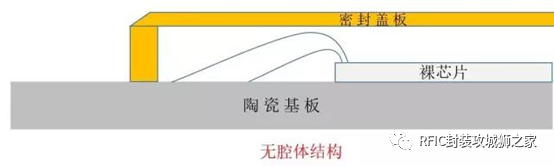
- 腔体结构有利双面安装元器件
现在的SiP复杂程度很高,需要安装的器件很多,在基板单面经常无法安装上所有器件,需要双面安装器件。这时候,腔体结构也就大有用武之地,通过腔体可以将一部分器件安装在SiP封装的底面,在封装底面外侧设计并植上焊接球,如下图所示。
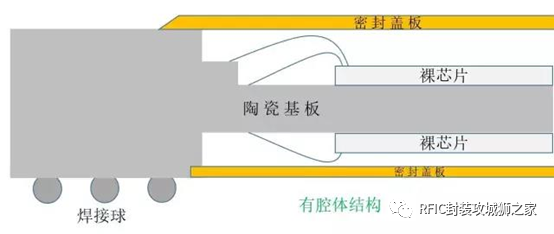
如果没有腔体结构,就无法在背面安装器件,如下图所示:

如果将器件完全安装在顶面,不可避免要扩大封装的面积,和SiP小型化的概念是背道而驰的。
最后,我们来看一款实际的陶瓷封装SiP项目的Expedition设计截图:此项目为国内第一款采用双面腔体的陶封SiP项目,完全在一颗SiP中实现了航天计算机的所有功能,并达到军品级要求。该项目在世界上也处于领先地位,目前已经成功应用到多个航空、航天等重点工程中。

文章节选自《SIP系统封装设计与仿真》,RFIC封装攻城狮之家公众号
原文始发于微信公众号(艾邦半导体网):陶瓷封装SiP腔体结构介绍


