激光辅助键合封装技术介绍
作者:Semicon Solutions & 树先生
本文主要参考长电科技韩国研究所的一篇文章"Characterization of laser beams: theory and application in laser-assisted bonding process"
本文要讲的是长电科技率先开发并已经量产的激光辅助键合技术,该技术为了解决汽车领域特别是开发具备高可靠性标准的电动汽车和自动驾驶相关封装技术中无芯衬底材料和工艺FCBGA产品。由于产品非常薄,普通的回流焊键合技术已经不能满足需求。为解决基板翘曲等导致的BUMP Bridge及接触不良等问题,长电开发了一种新的互连技术-激光辅助键合(LAB),并已应用于大规模量产,而更难能可贵的是该技术得研发投入的产出已对公司2021年的营收与盈利增长有大幅贡献,并将在未来公司的业绩增长上继续取得显著效果。
长电科技成立于1972年,是全球领先的集成电路制造和技术服务企业,拥有3200多项专利。长电科技在中国、韩国和新加坡设有六大生产基地和两大研发中心,遍布全球的23000余名员工。长电科技在全球十大封装代工厂位列第三,中国大陆第一,是一家名副其实的具备全球视野的高科技企业。
那什么是LAB(激光辅助键合)技术呢?LAB技术是指将激光束照射到芯粒或需要焊接的器件上使芯粒及器件数秒内由室温升至焊接温度,将其焊接在基板、interposer或堆叠的另外一个芯粒上。LAB整个系统由高功率二极管激光源、光纤、准直仪、以及产生平顶激光束的均化器四部分组成。激光源在连续波模式中工作,采用近红外波长为980nm,其最大功率为2kW,光束大小为9至45毫米,焦距为240毫米,具体示意图如图1所示。
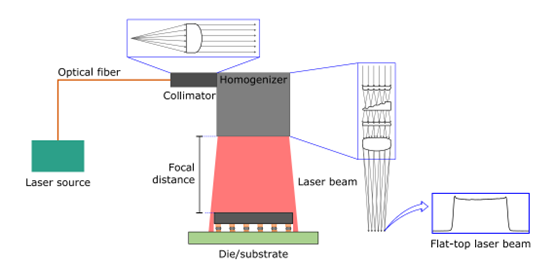
图1:示意图 Laser Source: 激光源; Optical Fiber:光纤;Collimator:准直仪;Homogenizer: 均化器; Focal Distance: 焦距; Laser Beam: 激光束
在整个工艺中,激光束的功率密度分布和空间特性异常重要。如下图2所示,如果功率分布不均则会导致温度不均一,从而产生BUMP 桥接或接触不良的缺陷。在部分区域由于没有接收到足够功率的照射,会导致焊接温度不足产生的接触不良缺陷。而在另外一部分区域由于接收到过高功率的照射,则会产生BUMP桥接的缺陷。在一些极端情况下,甚至可能将芯粒或设备烧坏。因此整个工艺的难点就是如何使需焊接部件均匀受热。当然在C4/DIE BUMP区域加热均匀也是LAB工艺优于回流焊工艺之处。
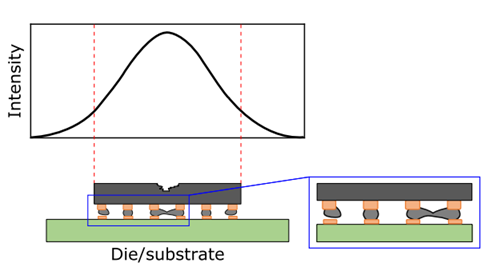
图2 LAB工艺缺陷产生原理图
既然能量的稳定性及可控性这么重要,那我们可以继续讨论到底当前业界可以做到什么样的水平。图3及图4就是长电科技文章中发布的实验数据,根据图中数字我们可以看到均匀度非常不错,在右下角芯片焊接区域的能量差异值非常微小。
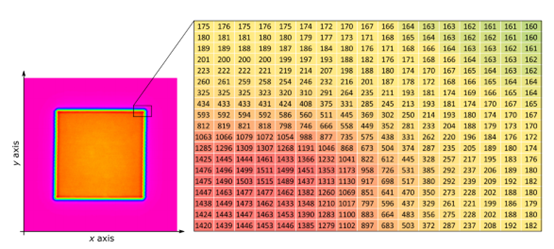
图3 在LAB加工工艺中能量密度分布图 每个数值代表单个像素点上测量出的模拟数值
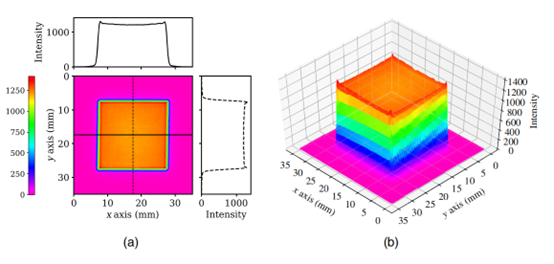
图4 在LAB加工工艺中能量密度分布图在X Y及Z方向分布
其实除了长电科技很多业界领头公司也都做过类似的尝试来解决焊接工艺中由于基板越来越薄,翘曲越来越严重等导致的焊接缺陷。但是最终大部分都停留在了理论研究中。长电科技将该工艺量产实属不易!最后根据专家Semicon Solutions的见解,为了更好的控制芯粒及Substrate在焊接过程中的翘曲,未来最优的方案将是在LAB的工艺中,激光即热的同时用透明的压盖给芯粒一定的压力,确保焊接过程中的翘曲得到外力的控制。



