高密度陶瓷封装外壳是一种应用于集成化、小型化要求的封装形式,具备较多的输入和输出端口,端口间距窄,为生产制造带来诸多难点。高密度陶瓷封装外壳在装配钎焊过程中不可避免地存在异质沾污,电镀镍金时容易在键合间形成金层,严重时可能导致键合间连通,外壳失效,这就是所谓的涨金问题。
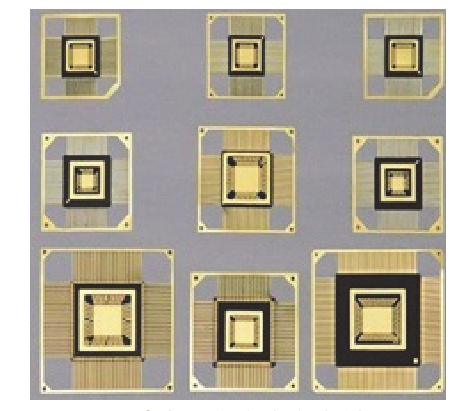
几种常见高密度陶瓷封装外壳
1.电镀涨金问题分析
高密度陶瓷封装外壳按照常规工艺电镀后,产品的镀层厚度和可靠性都满足技术要求,但在采用高倍显微镜观察时发现存在较大比例的涨金失效问题,涨金位置在陶瓷键合指之间的陶瓷表面。
高密度陶瓷封装外壳的涨金问题与装配和钎焊过程中引入的异质沾污有密切关联,这些沾污可能是有机物或石墨污染,并且C含量越高,其去除难度越高。因此,解决外壳涨金问题的关键在于规避异质污染物的引入和寻找可高效地将其去除的方法。
2.电镀涨金问题的解决方案
镀覆前对陶瓷件进行退火和等离子清洗
镀覆前,先在200°C下对陶瓷件退火处理5~10min,以便将瓷件吸附或者装架钎焊过程中带来的污染物氧化,令污染物在后续的化学清洗过程中更容易被去除。
在退火后,增加O2和Ar气氛的等离子清洗,利用O2的氧化性同时对污染物进行物理轰击和进一步的化学氧化,继而利用Ar的大原子结构特性对污染物及生成的氧化物进行物理轰击,使得陶瓷件表面更加洁净。
3.等离子清洗作用
等离子是正离子和电子密度大致相同的电离气体,等离子清洗机通过对氧气,氩气进行电离,产生的等离子体通过电磁场加速,击打在高密度陶瓷封装外壳在表面,可以有效的去除表面的有机物、氧化物、微颗粒物等沾污物,有效的提高高密度陶瓷封装外壳表面的活性,从而令涨金比例大幅下降,并且不影响外壳绝缘电阻、引线抗疲劳等可靠性指标。
来源:东信高科
先进封装设备类似前道晶圆制造设备,供应商受益先进封测产业增长。随着先进封装的发展,Bumping(凸块)、Flip(倒装) 、TSV 和 RDL(重布线)等新的连接形式所需要用到的设备也越先进。以长球凸点为例,主要的工艺流程为预清洗、UBM、淀积、光刻、焊料 电镀、去胶、刻蚀、清洗、检测等,因此所需要的设备包括清洗机、PVD 设备、光刻机、 刻蚀机、电镀设备、清洗机等,材料需要包括光刻胶、显影剂、刻蚀液、清洗液等。为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体先进封装产业链交流群。




