华润微电子有限公司封测事业群总经理吴建忠以《功率半导体特色封装与先进封装技术》为题,介绍了功率模组特色封装技术、Copper Clip特色封装技术、PLP面板级扇出先进封装技术。
功率半导体行业现状概况 功率半导体包括两部分:功率器件和功率IC。功率器件是功率半导体分立器件的简称,是实现能量转换的关键器件, 可以承受较大电流和电压, 在半导体产业中仅次于大规模集成电路的另一大分支。功率IC则是将功率半导体分立器件与驱动、控制、保护、接口、监测等外围电路集成而来。
功率半导体应用于5G建设、电动汽车和充电桩、LED照明、新能源/智能电网、轨道交通等领域。其中,功率半导体在新能源汽车中价值显著体现。功率半导体几经迭代,向低阻抗、高功率、高频率特性演变,要求在高温高频、高功率、高辐射等恶劣环境下的高稳定性和高可靠性需求发展。 功率半导体全球市场规模 功率半导体国内市场规模
功率模组特色封装技术
模组主要材料为基板,基板分传统框架、IMS基板、DBC基板,应用领域分布在小功率、中功率和中大功率,具有散热性较好、易于批量化生产、成本低等优点。 基板 键合材料 焊接技术 清洗技术 银烧结原理 DTS(Die Top System)技术
Copper Clip特色封装技术
薄片处理技术:减薄后带来Wafer变形、碎片、应力、贴膜划片、传输、装片及焊接一系列封装问题。 薄片处理技术 薄片划片技术 薄片装片技术 Copper Clip互联技术 双面散热封装技术
PLP面板级扇出先进封装技术
扇出型封装分为晶圆级与面板级扇出封装两个方向。其中,板级扇出封装技术因为其生产效率更高,材料利用率更高,从而有效降低产品的封装加工成本。基于产业数据分析可以发现,如果板级封装良率达到了90%,那么板级扇出封装相比于晶圆级扇出封装的总成本可以降低50%。
SiPLP封装结构及特点 无键合点、无焊接点、无粘结材料、无需框架和基板,利用临时窄板,可以进行DFN封装、LGA封装、BGA封装,并满足高集成度、大功率、高散热、高可靠的需求。SiPLP自主研发 PSIP 模组封装技术,采用全包封塑封结构可靠性可以通过MSL1级,通流散热能力均优于PCB嵌埋结构。 SiPLP模组封装技术
案例1:无线充数模混合器件:解决互连阻抗与散热问题 无线充数模混合器件 充电头数模混合器件 充电头GaN器件 多芯片合封技术
关于华润微电子封测事业群 华润微电子封测事业群价值链 华润微电子封测事业群功率封装解决方案


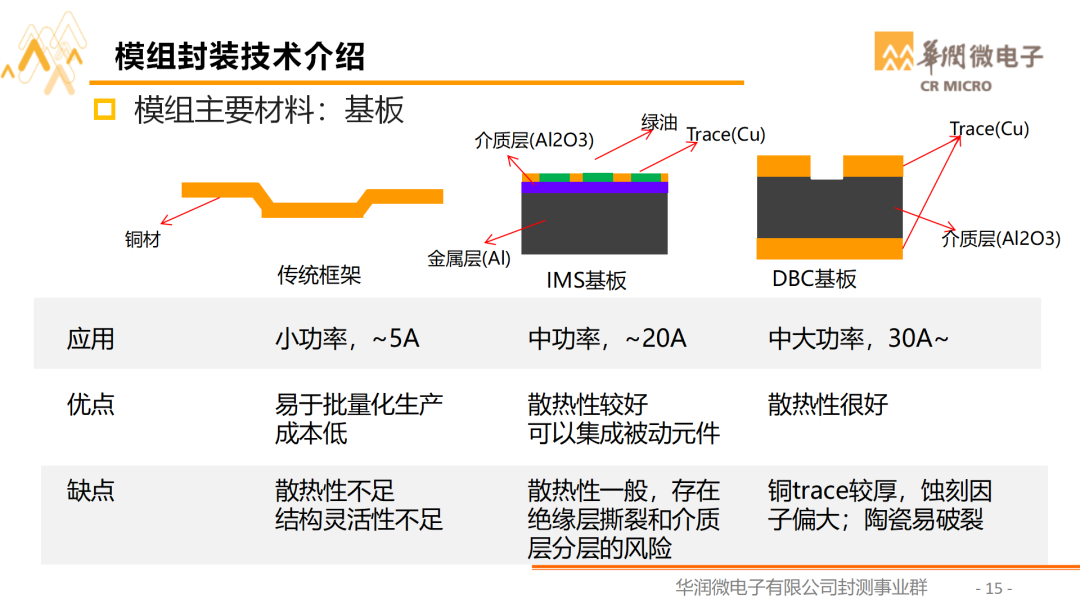



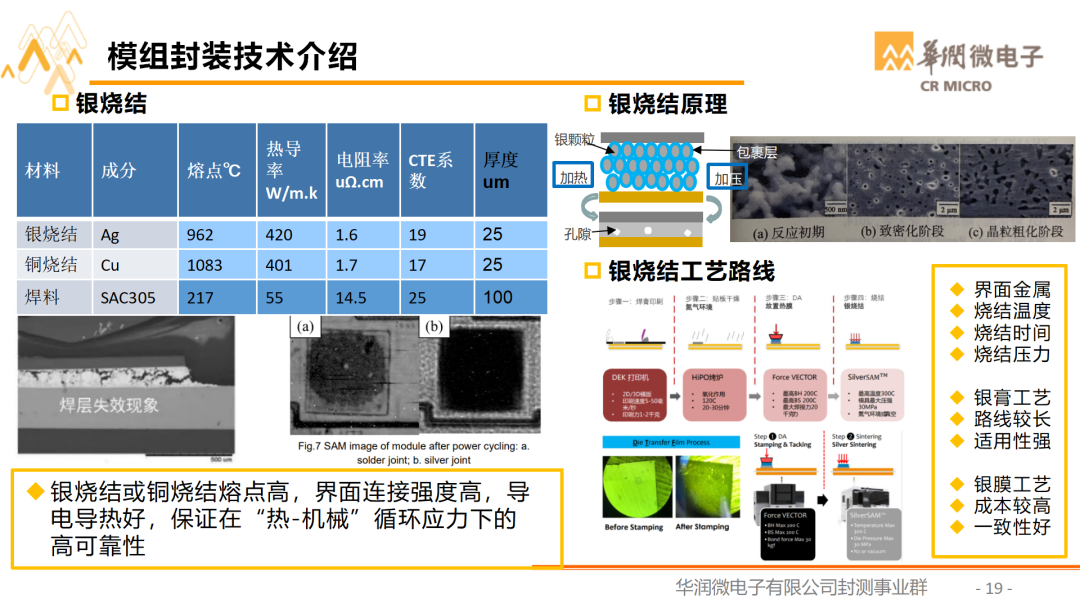

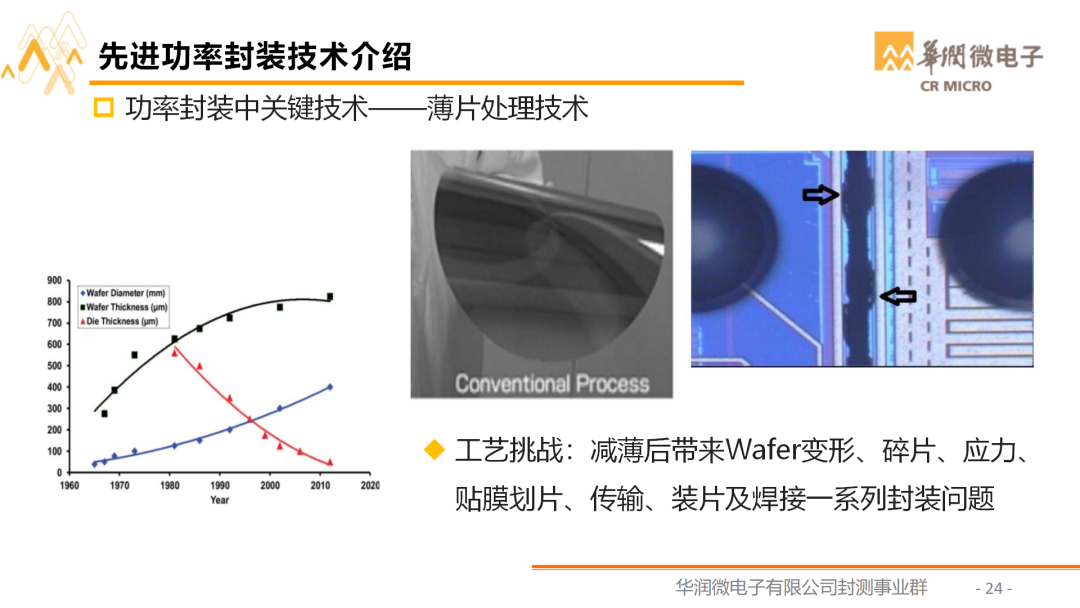
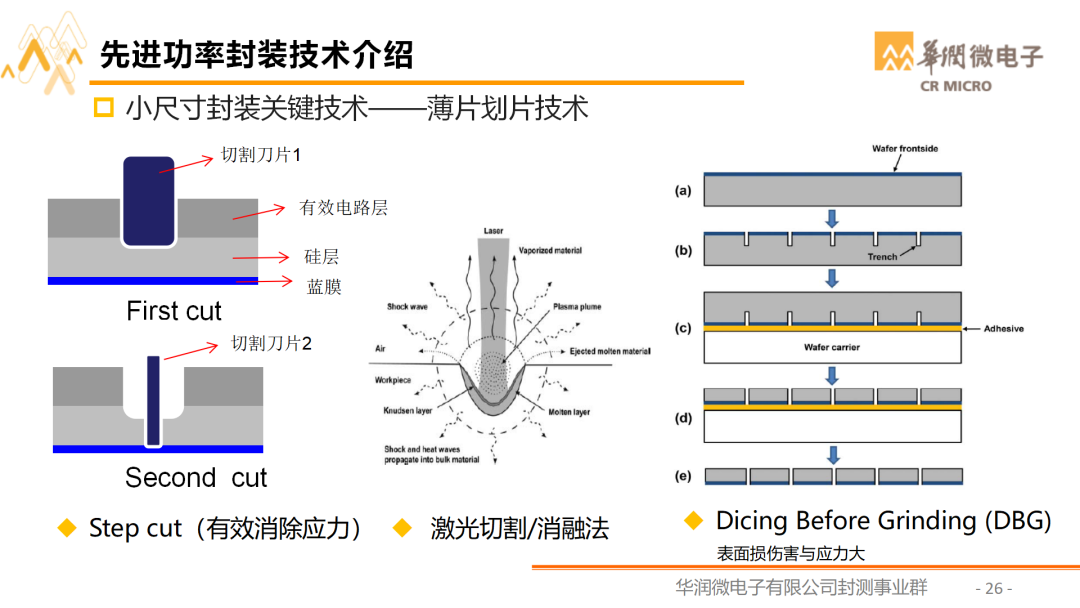
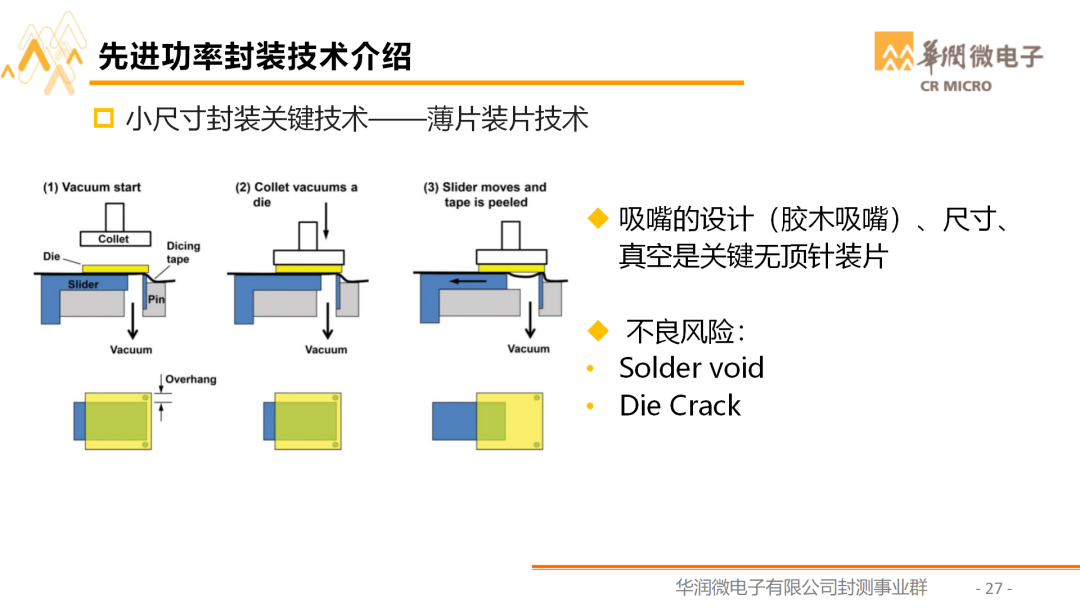

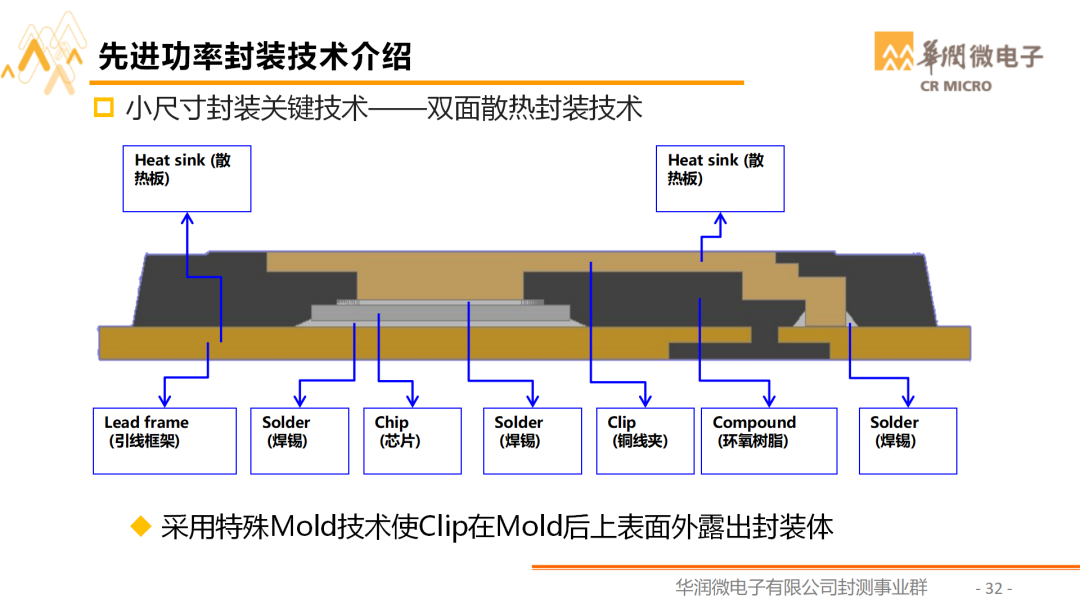
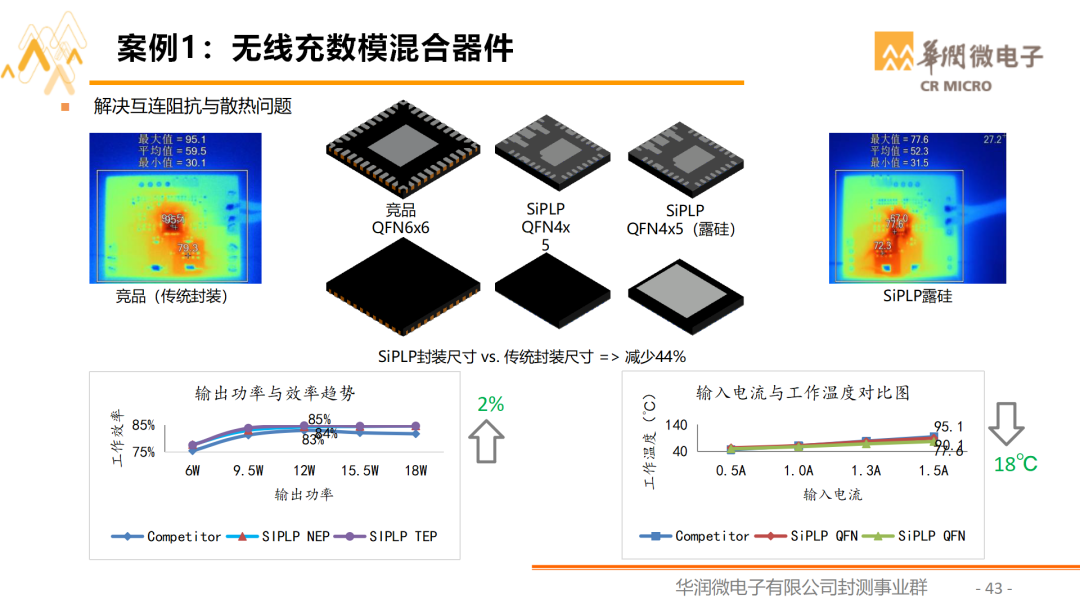
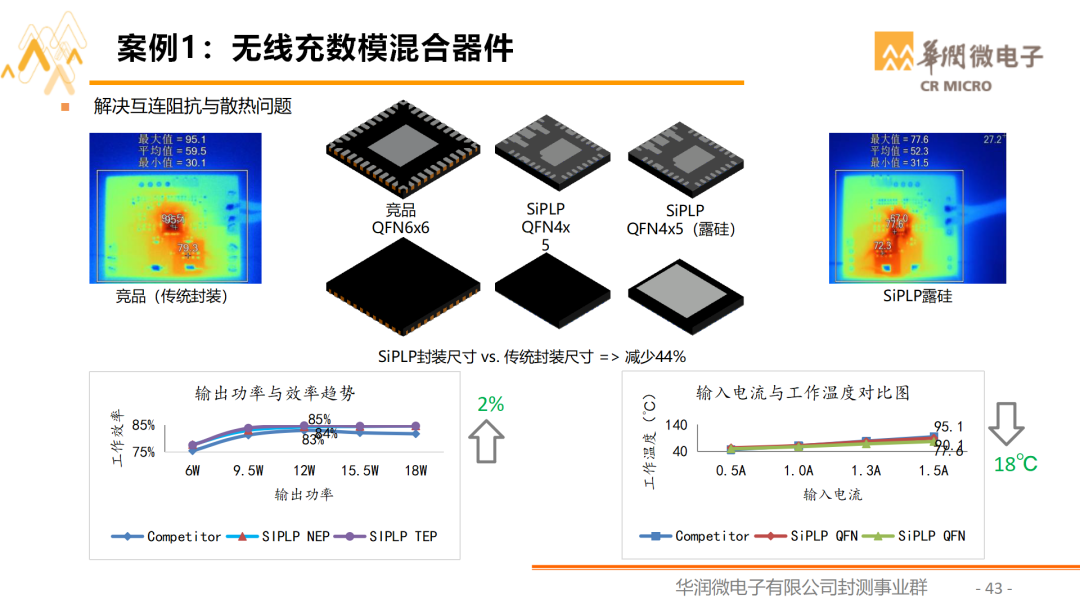
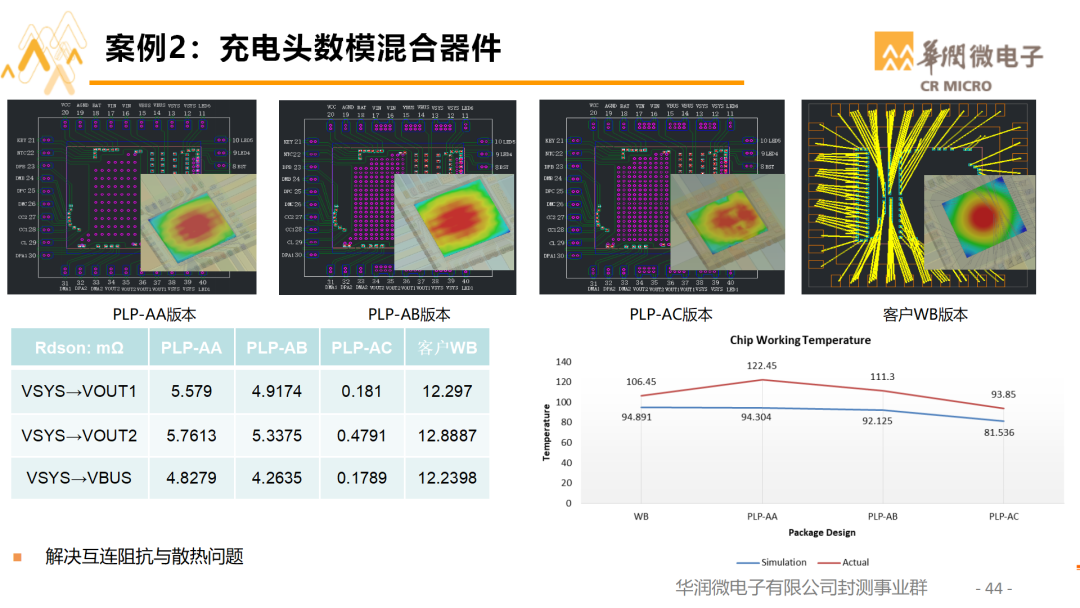
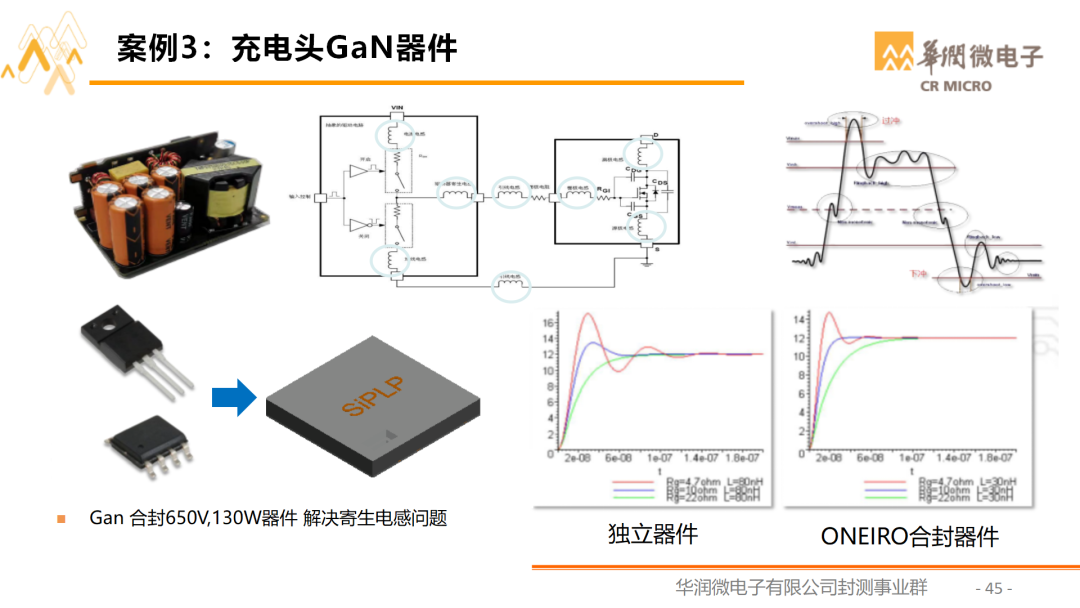



为加快产业上下游企业交流,艾邦建有IGBT产业链交流,欢迎识别二维码加入产业链微信群及通讯录。

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
成员: 5306人, 热度: 153517
陶瓷 天线 通讯 终端 汽车配件 滤波器 电子陶瓷 LTCC MLCC HTCC DBC AMB DPC 厚膜基板 氧化铝粉体 氮化铝粉体 氮化硅粉体 碳化硅粉体 氧化铍粉体 粉体 生瓷带 陶瓷基板 氧化铝基板 切割机 线路板 铜材 氮化铝基板 氧化铍基板 碳化硅基板 氮化硅基板 玻璃粉 集成电路 镀膜设备 靶材 电子元件 封装 传感器 导电材料 电子浆料 划片机 稀土氧化物 耐火材料 电感 电容 电镀 电镀设备 电镀加工 代工 等离子设备 贴片 耗材 网版 自动化 烧结炉 流延机 磨抛设备 曝光显影 砂磨机 打孔机 激光设备 印刷机 包装机 叠层机 检测设备 设备配件 添加剂 薄膜 材料 粘合剂 高校研究所 清洗 二氧化钛 贸易 设备 代理 其他 LED


