
晶圆封装与常规IC封装有何不同?
常规封装(如WB 即引线键合封装)
第一步,切片 通过物理方法将晶片切割下来。

第二步,将晶片正面朝上贴置于引脚盘上,然后通过引线逐一连接晶片的焊点与引脚盘的引脚
最后 通过塑封将晶片和引线埋入塑料内起到保护作用,封装完成
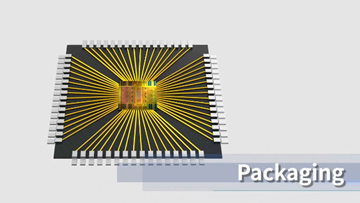


晶圆级封装
在晶圆上直接生成引线图案层,然后再最外层置球,完成封装
最后切割,生成独立的成品

什么是扇入型晶圆级封装
晶圆来料
在晶圆上原位制备RDL(重布线)层,新RDL层的焊点将于主板适配,由于生成的RDL层,与晶片尺寸相同,被称为扇入型,以区分后面的扇出型
晶圆背面研磨以露出预制铜柱的顶部在生成的RDL最外层预置铜柱上置球
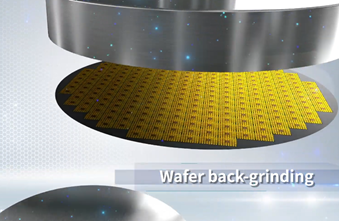


最后切割生成独立的成品个体
什么是扇出型晶圆级封装
晶圆来料
将晶圆切割成晶片
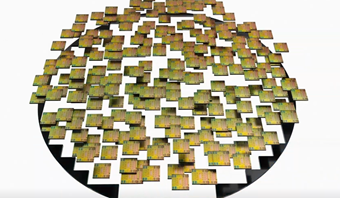
切割后的晶片正面朝上,按照预增的尺寸间隔,重新贴置于新的晶圆载具上
经表面处理后,将晶片正面朝下放置
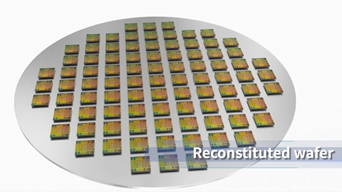
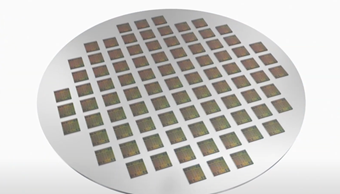
灌胶塑封
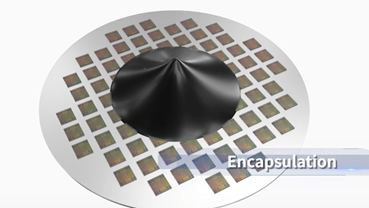
移除临时载具
制备RDL层(重布线层,以匹配主板焊接点阵)由于RDL层尺寸大于晶片尺寸,故又称为扇出型
晶圆背面打磨以露出预制铜柱的顶部
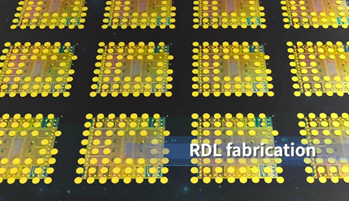


RDL最外层置球以完成最后的封装
切割生成晶片成品



先进封装设备类似前道晶圆制造设备,供应商受益先进封测产业增长。随着先进封装的发展,Bumping(凸块)、Flip(倒装) 、TSV 和 RDL(重布线)等新的连接形式所需要用到的设备也越先进。以长球凸点为例,主要的工艺流程为预清洗、UBM、淀积、光刻、焊料 电镀、去胶、刻蚀、清洗、检测等,因此所需要的设备包括清洗机、PVD 设备、光刻机、 刻蚀机、电镀设备、清洗机等,材料需要包括光刻胶、显影剂、刻蚀液、清洗液等。为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体先进封装产业链交流群。




