新冠疫情以来,中国市场因持续释放发展的动力、潜能和韧性展现出对外吸引力。日前中国贸促会发布的《2022年第三季度中国外资营商环境调研报告》显示,中国已经成为诸多外资企业全球业务发展的动力与引擎,绝大多数外资企业看好在华长期发展前景。

在中德建交50周年之际,作为最早进入中国市场的德国企业之一,贺利氏电子在中国合资企业贺利氏招远(常熟)电子材料有限公司(简称“常熟公司”)也迎来了二十周年庆。“常熟公司就像一面镜子,是中国工业在过去20年里飞速发展的见证。从最开始将国外研发好的产品拿到中国销售,随后在本地建立起了制造的技能,到现在已经成为一个达到全球水准的生产基地,并与国际接轨。”贺利氏电子中国销售副总裁兼中国合资公司副总经理沈仿忠在常熟公司20周年庆典上表示,“当前半导体行业正处于黄金时代,低碳化和数字化着驱动市场进一步迅猛发展。”
第三代半导体走向主流,功率模块封装材料迎接新挑战
在国内5G通信、新能源汽车、人工智能、工业互联网、大数据、光伏等行业快速发展的大趋势下,以及“碳达峰、碳中和”绿色低碳战略不断推进,随着双碳战略的不断推进,提升能源利用效率和能源转换效率已经成为各行各业的共识,新能源汽车、光伏发电等市场迎来新一轮的快速发展时期。
沈仿忠指出,在此趋势下,以碳化硅、氮化镓为代表的宽禁带半导体(第三代半导体)成为市场炙手可热的新赛道,而其规模化应用进一步推动了功率模块中封装材料的变革。“宽禁带功率器件相比硅基功率器件功率要大得多,因而通常伴随着较高的工作温度,在封装过程中同样需要能满足更高熔化温度,更强抗疲劳强度,高热导率并且低电阻率的连接材料,以保证器件良好的散热性能、可靠性和使用寿命。”他指出,“这一变化使得功率器件,无论是起支撑作用的电路板(金属绝缘基板)、起电气连接作用的互连材料(烧结银焊接),还是起散热作用的界面热导材料等整个材料体系都需要创新的解决方案。”
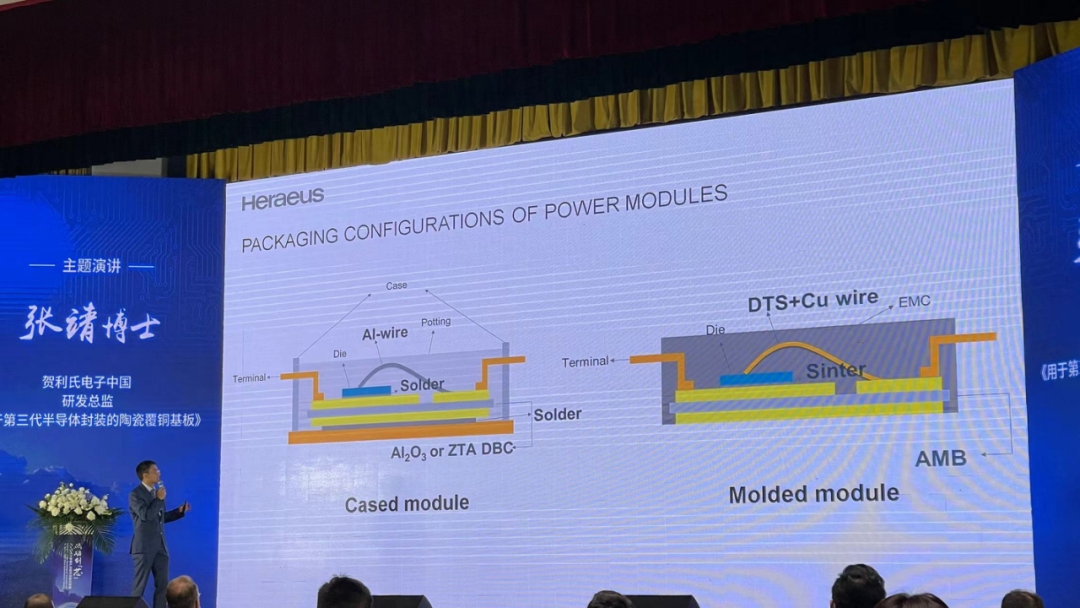
比如硅基IGBT通常使用氧化铝陶瓷基板热导率相对低,韧性低,与硅的热膨胀系数匹配不好,并不适合作为高功率模块封装材料,因而碳化硅MOSFET转向各类氮化铝、氮化硅等复合陶瓷基板,覆铜板从直接覆铜工艺(DBC)转向活性金属焊接工艺(AMB);焊料方面,传统功率器件所使用的软焊料和锡膏就很难满足低工艺温度、高工作温度,很好的导电性和散热性能等要求,为此具备优越热导率和更长使用寿命的无铅烧结银技术应运而生。此外,新能源汽车、光伏发电以及工业等应用环境特别严苛的领域,对能够赋予电路和元器件更佳质量和可靠性的厚膜技术需求越来越多。
贺利氏电子中国研发总监张靖总结说,走向第三代半导体材料的功率器件,要在功率、频率等性能瓶颈上实现突破,不管是工作温度、散热性能,还是可靠性,都需要相关封装材料来解决。
中国新能源汽车进入新阶段,创新材料解决方案日益紧迫
中国作为全球新能源汽车和光伏太阳能产业发展最为迅猛的地区,越来越多的本土制造商正在凭借出色的产品力获得国外市场的认可,例如比亚迪、蔚来、上汽、红旗等中国新能源汽车品牌,纷纷吹响出海的号角,最近德国汽车租赁公司Sixt一口气下单10万辆比亚迪电动汽车更是轰动了全球汽车行业。
“我认为这标志着中国新能源汽车品牌发展已经进入新的阶段,新能源车巨大的市场前景,特别是最核心的动力电池实现全球领先,加之在汽车智能化方面的快速进步,成为中国新能源汽车品牌出海的底气。”张靖表示,“新能源汽车的蓬勃发展无疑将打开碳化硅功率器件的巨大应用市场。Yole的数据显示,2019年~2025年期间功率模块市场将以9.1%的年复合增速进入快速增长阶段,未来碳化硅功率模块将成为新能源汽车的主流方案。相应的功率模块封装材料市场也将迎来激增,市场规模从2019年的14.7亿美元增长至2025年的27.1亿美元,年复合增速达10.7%。其中基板市场增速最为迅猛,年复合增速达到12.6%,2025年将达到6.15亿美元。”

围绕第三代半导体,贺利氏电子着力于研发除了晶圆以外的整体封装解决方案,包括烧结银材料和各类金属陶瓷基板等出色的封装产品和解决方案。更重要的是,在改善芯片性能方面,贺利氏电子推出了独有的Die Top System(DTS)材料解决方案系统,通过材料的创新,充分优化电力电子模块的性能,还能简化工业化生产,很大程度提高盈利能力,加快客户新一代电力电子模块的上市步伐。此外,贺利氏电子还提供工程服务,确保客户可以快速导入最新的材料解决方案,并迅速做出产品原型,以抓住瞬息万变的市场的机会。
“伴随着中国新能源汽车产业的迅速崛起,越来越多的本土厂商找到贺利氏电子,希望我们与之进行相关的合作开发,或者将我们创新的材料解决方案尽快导入到他们的产品中,在这方面中国厂商的引领趋势已然十分瞩目。”沈仿忠指出,为此贺利氏电子近几年一直加大中国市场布局,未来还将继续在电力电子和功率半导体方面加大投资,同时作为国内客户的创新合作伙伴,凭借完善的应用与测试服务、广泛的专业知识和全面现场帮助他们缩短产品上市时间。
数字化推动芯片异构集成,封装材料走向多元化创新
数字化潮流下,5G、AIoT、物联网等新兴产业发展推动了短时间内数据呈现爆炸式增长,向计算提出了巨大的挑战。面对海量的多样化数据,突破算力瓶颈,提升算力与降低功耗之间的矛盾,令异构集成正在成为提升芯片算力的重要发展方向,对封装技术带来了多样化的创新途径以及前所未有的挑战。
张靖表示,随着半导体技术的发展,越来越多前道工艺被引入后道工艺当中,两者的界限变得越来越模糊。随之而来的是,越来越多超越传统封装理念的先进封装技术被提出。异构集成的封装技术演进道路上,从FC、SiP、WLP再到2.5D/3D封装以及近来大热的Chiplet,在微型化趋势下,先进封装中的元件数量不断增加,带来的功耗、散热挑战越来越大,与此同时,原材料成本和激烈的市场竞争也令芯片厂商对总体成本有了更多的顾虑,这些都对封装材料提出了更高的要求。
“由于在越来越小的空间中集成了更多的功能,先进封装面临的热管理需求与日俱增,散热性能严重关乎芯片乃至终端产品的使用寿命。材料供应商需要通过系统化的创新,提供系统级的解决方案,在不断降低总体拥有成本的同时帮助客户将产品性能和功能发挥到极致。”他指出。
为满足越来越严苛的应用要求,贺利氏电子加快创新步伐,带来了很多深受行业信赖的封装产品和解决方案。例如面对新能源汽车或消费电子中大功率电子设备的散热需求,贺利氏推出了mAgic™系列烧结银材料;面对从引线键合封装到FC封装,管脚间距需要更细的焊粉,贺利氏电子Welco™技术已更新至8号粉,可满足线间距小于50μm的倒装芯片需求;对于传统的引线键合封装,贺利氏电子新一代的金线替代品AgCoat® Prime镀金银线提供兼具高可靠性和性价比的创新方案;为应对环保及可持续发展需求,贺利氏电子还推出了采用100%再生黄金制成的键合金线和100%再生锡制成的Welco™系列焊锡膏版本。
“二十年间,常熟公司伴随着中国半导体产业的发展成长成为中国电子封装领域领先的材料制造商,到如今我们服务的本土客户在部分领域已处于世界领先水平,包括5G、新能源汽车、新能源发电(光伏、风电等),还有mini LED、micro LED等产业,中国已经走在了全球前列。”张靖强调,如今贺利氏电子在本土研发出的成品不仅可以在本土市场适用,甚至已走向全球,真正见证了贺利氏电子从“在中国,为中国”到“在中国,为世界”的转变。
在沈仿忠看来,发生这种转变的内在原因,一是国内对知识产权的保护、创新环境发生了巨大的变化,其次是这里有最大的市场,巨大的需求,反过来也成为技术创新的最好的沃土。
材料创新从一个想法到产品并导入市场可能需要十年时间,即使是对现有成品进行一些小的调整,有时候也需要花上几年,因此贺利氏作为材料供应商,需要在非常早期的阶段就了解客户的需求,从而才能更好的在客户产品中导入材料,实现差异化的竞争力。“而贴近市场,尤其走在行业前端的领域,能更快、准、狠地将客户最为迫切的需求,转换成对产品的要求,最终转化成符合市场趋势的高品质产品。”
“行稳致远,依托于强大的研发实力,在保证产品先进性的同时,我们也深入挖掘客户的实际需求,在产品之外提供了诸如共同研发、工程服务,整合解决方案的多种服务,使我们能够更加贴近客户,也希望和客户一起在未来携手发展,共创辉煌。”沈仿忠表示。
*本文转载自集微网 作者朱秩磊
END

原文始发于微信公众号(贺利氏电子):从引进产品到输出创新,贺利氏常熟公司20周年见证中国半导体巨变
成员: 5306人, 热度: 153517
陶瓷 天线 通讯 终端 汽车配件 滤波器 电子陶瓷 LTCC MLCC HTCC DBC AMB DPC 厚膜基板 氧化铝粉体 氮化铝粉体 氮化硅粉体 碳化硅粉体 氧化铍粉体 粉体 生瓷带 陶瓷基板 氧化铝基板 切割机 线路板 铜材 氮化铝基板 氧化铍基板 碳化硅基板 氮化硅基板 玻璃粉 集成电路 镀膜设备 靶材 电子元件 封装 传感器 导电材料 电子浆料 划片机 稀土氧化物 耐火材料 电感 电容 电镀 电镀设备 电镀加工 代工 等离子设备 贴片 耗材 网版 自动化 烧结炉 流延机 磨抛设备 曝光显影 砂磨机 打孔机 激光设备 印刷机 包装机 叠层机 检测设备 设备配件 添加剂 薄膜 材料 粘合剂 高校研究所 清洗 二氧化钛 贸易 设备 代理 其他 LED
