凭借高功率、高频工作环境下的优良性能,氮化镓(GaN)正在快速崛起,无论是在功率,还是射频应用领域。由于大尺寸硅(Si)基板具备低成本优势,且对现有CMOS工艺兼容,使得硅基氮化镓(GaN-on-Si)成为市场主流。
对于硅基氮化镓的外延来说,假如直接在硅片的表面进行氮化镓的外延,硅(Si)会和镓(Ga)发生反应,形成回熔(melt-back)效应,因而往往会在生长氮化镓之前,先在硅衬底上生长一层氮化铝(AIN)薄膜,以避免该现象的产生。同时,氮化铝与氮化镓有非常接近的晶格常数和热膨胀系数,可以减少晶格失配所带来的应力问题。因此,高质量的氮化铝种子层对于外延氮化镓来讲至关重要。
但是如果采用MOCVD的方法生长氮化铝种子层,由于设备腔体中残余的镓原子会扩散到高阻硅中,造成射频损耗,对GaN-on-Si射频器件的功率增益和功率输出有不利影响。为了解决这个问题,采用PVD物理气相沉积工艺制备氮化铝可以有效防止镓-硅回熔现象的发生。然而,用溅射AIN在Si衬底上获得高质量且无裂纹的GaN层是一个关键难题。
近日,北京大学物理学院宽禁带半导体研究中心沈波、杨学林课题组采用化合积电制备的高质量硅基氮化铝(AIN on Si),成功在AlN/Si模板上生长了1.5 μm厚的无裂纹氮化镓层,晶体质量可与传统GaN生长在具有复杂缓冲的Si衬底上相媲美。更重要的是,溅射AIN种子层有效防止Ga/AI扩散到Si衬底,基于此,在10 GHz时实现了0.20 dB/mm的射频损耗。
(a) PVD-AlN 和 MOCVD-AlN 样品在 Si 衬底中的 Al 和 Ga 浓度分布
(b) 在 PVD-AlN 和 MOCVD-AlN 上生长的 GaN 层的射频损耗
化合积电采用PVD物理气相沉积工艺制备出高质量的氮化铝种子层,为有效生长高质量的氮化镓打下良好基础,同时,显著降低了射频损耗。这一重要研究成果,以“Low radio frequency loss and buffer-free GaN directly on physical-vapor-deposition AlN/Si templates”为题,发布在Applied Physics Express期刊上。论文第一作者是北京大学博士生刘丹硕,共同作者有北京大学沈波教授、杨学林教授及化合积电联合创始人/CEO张星等。
APEX审稿人高度评价:“本文报道了一种用溅射AlN生长GaN/AlN/Si结构的方法,解决了用MOCVD制备GaN/AlN/Si结构时Ga和Al向Si衬底扩散和通量低的问题。通过控制溅射AlN的表面形貌和降低GaN晶粒的聚结速率,作者成功地生长出无裂纹的厚GaN薄膜。本文充分指出了以往在硅衬底上生长GaN的研究中存在的问题,并提出了一种新的生长方法来解决这些问题。我相信这篇论文值得在APEX发表。”
原文链接:
https://iopscience.iop.org/article/10.35848/1882-0786/ac7ddb

化合积电致力于推动金刚石和氮化铝等宽禁带半导体材料的产业化和规模化发展,围绕着氮化铝材料,现已有蓝宝石基氮化铝、金刚石基氮化铝和硅基氮化铝等成熟产品,产品高质量比肩世界一流水平。其中,硅基氮化铝XRC<0.8°,表面粗糙度Ra<1.5nm,助力氮化镓实现高质量外延生长。值得一提的是,采用PVD法生长硅基氮化铝,成本更低,利于规模化量产。化合积电基于氮化铝薄膜多年工艺技术积累,未来将在BAW滤波器、传感器等应用领域发挥更大的作用。
硅基氮化铝·表征检测结果
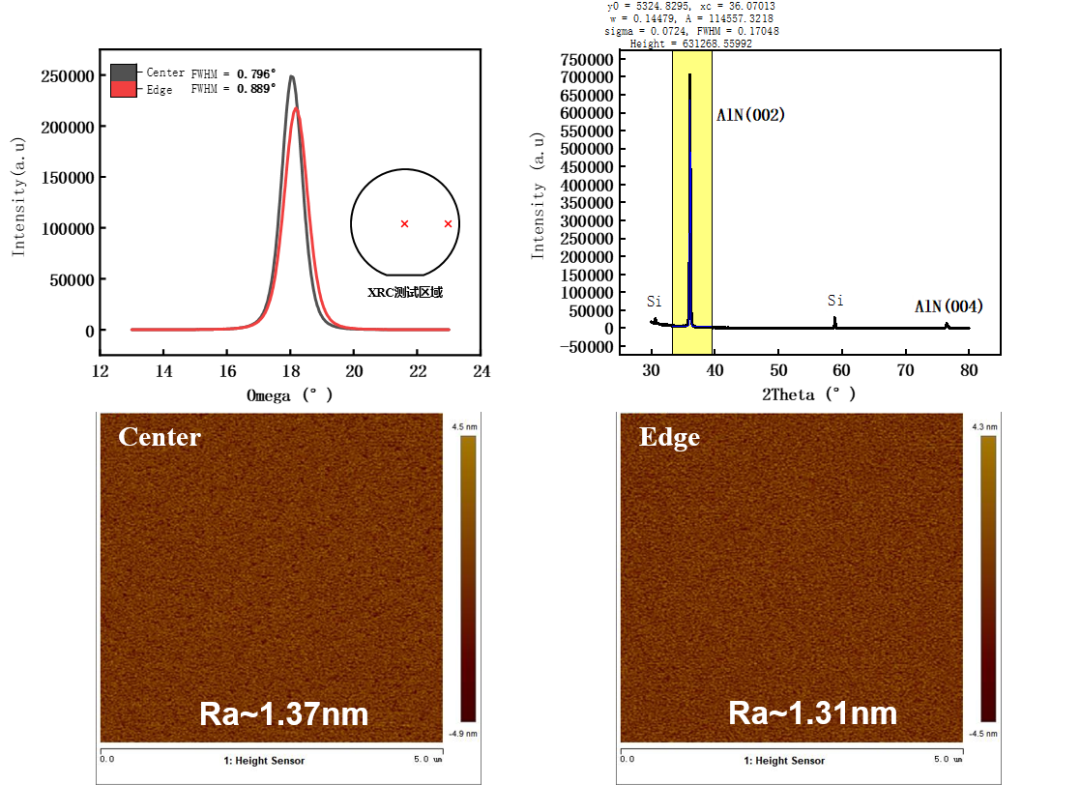
硅基氮化铝·产品参数
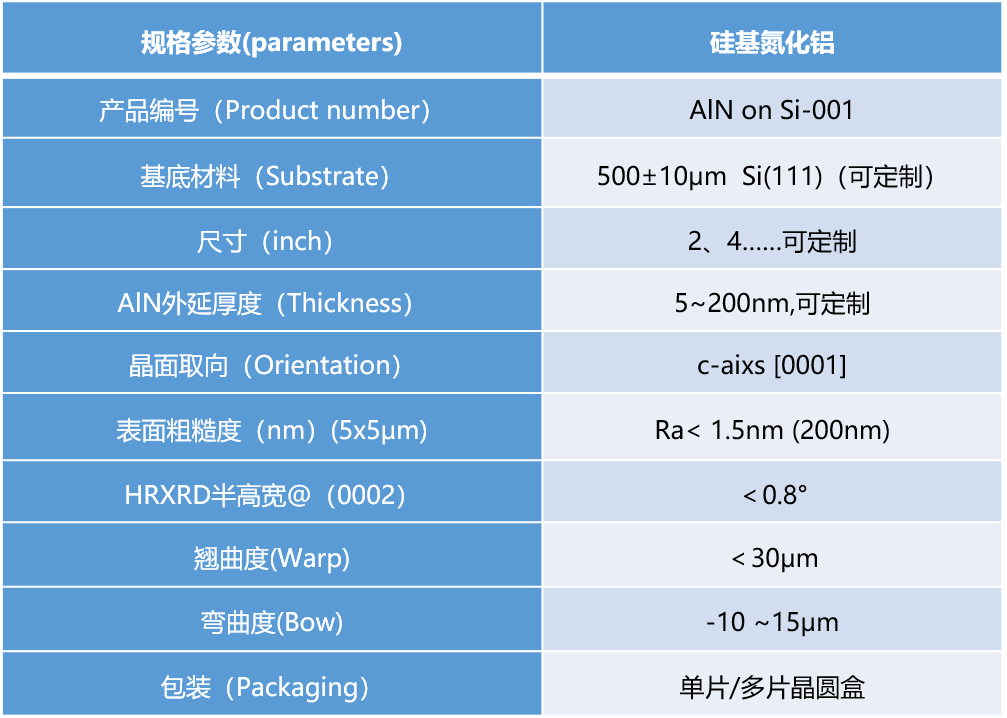

· 关注我们 ·
公司官网|www.csmc-semi.com
联系邮箱|sales@csmh-semi.com
联系电话|0592-3756998 13859969306
联系地址|福建省厦门市集美区灌口大道253号10号楼
原文始发于微信公众号(化合积电):重大突破 | 北京大学采用化合积电高质量氮化铝薄膜破解GaN-on-Si制备关键难题!

