
从PC+互联网时代发展至移动+社交媒体时代,到将来的AI+大数据时代,不断增长和多样化的系统需求推动着许多新型封装类型和技术的发展。在摩尔定律步伐放缓的大背景下,晶圆级封装技术更是向着高密度、超薄、超小和更高性能的方向突破,如PoP、扇出型(Fan out)集成以及采用TSV的2.5D和3D集成等封装技术。
随着上述封装技术的蓬勃发展,行业内对超薄器件晶圆的拿持问题提出了新的需求和挑战,如在封装体叠层和III-V族化合物半导体制程中,由于超薄器件晶圆具有柔软性和易碎性,因此需要一种拿持系统和支撑系统确保薄晶圆可以在工艺设备上进行加工;在扇出型集成封装工艺中,重构的塑封料晶圆翘曲较大,也需要临时支撑系统来提高封装精度。临时键合和解键合工艺作为晶圆拿持和支撑技术的关键解决方案,能够和现有的半导体工艺很好地融合,并且技术难度和成本都得到了一定程度的降低,因此在实际生产过程中广泛应用。
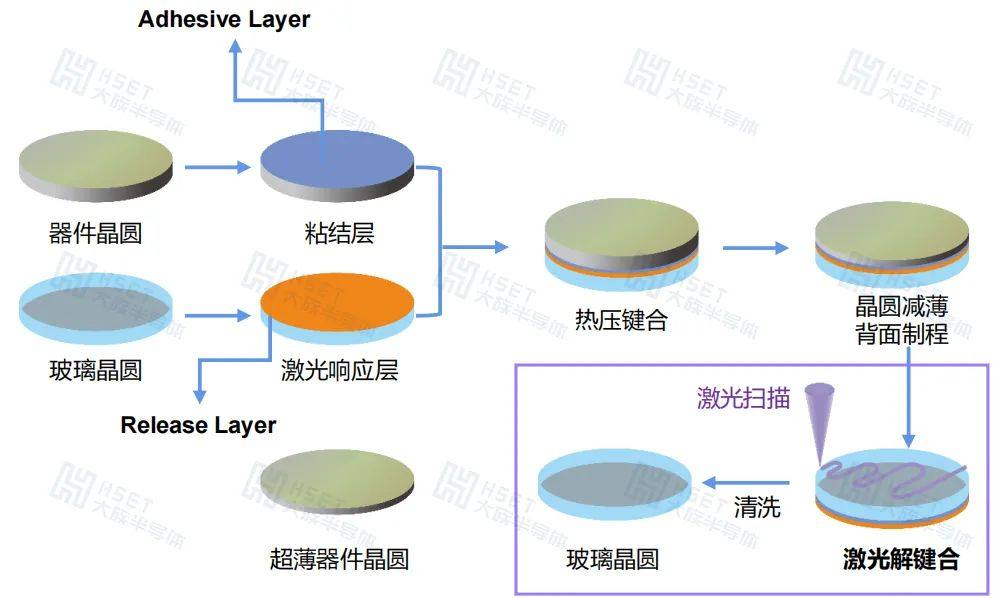
临时键合/解键合工艺流程
大族半导体洞悉市场需求,凭借多年积累的技术优势和行业经验,早在2017年就推出紫外激光解键合的解决方案,并成功自主研发出国产首台激光解键合设备。

多种解键合技术对比
为了满足封装技术飞速发展的需求,大族半导体不断进行技术创新和迭代,并于2020年推出国产首台兼容分离、清洗一体化的全自动激光解键合设备DSI-S-DB661,目前此设备已通过多家行业龙头封装客户的工艺验证,并成功导入产线,实现规模化应用。

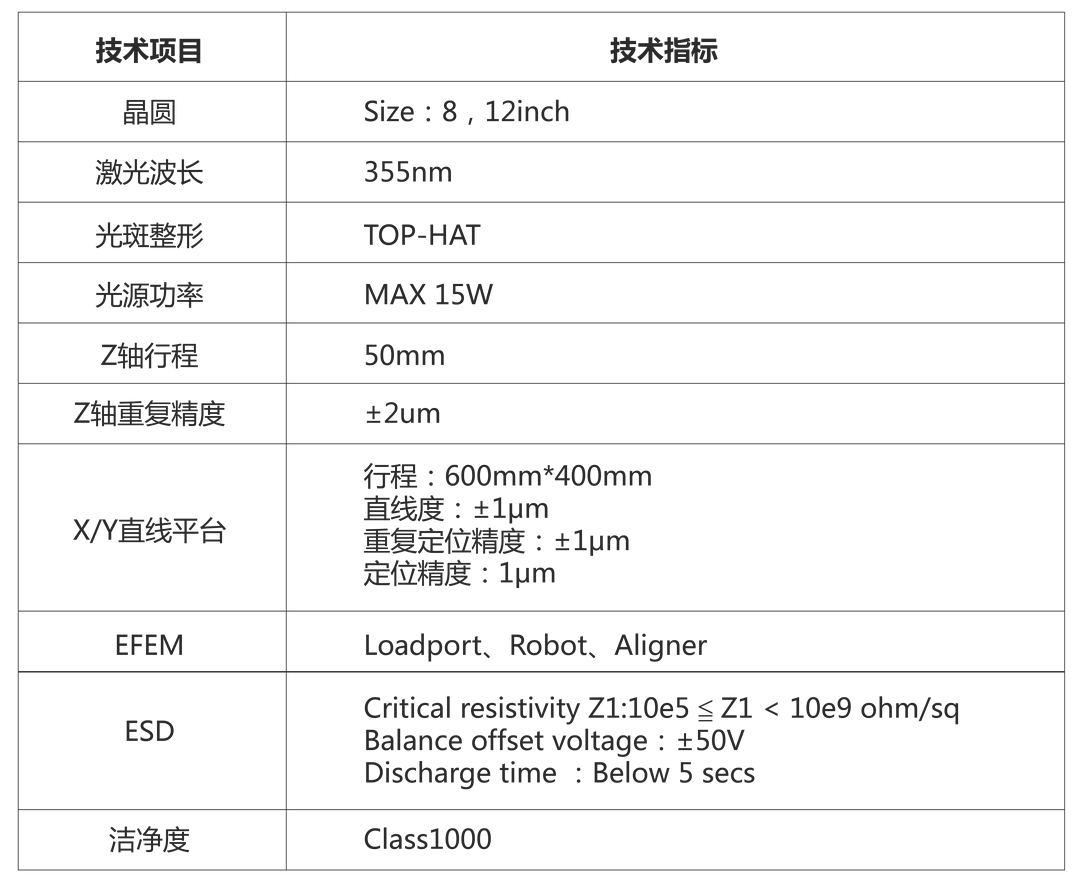
未来,随着半导体技术的发展以及新应用的出现,也会对封装技术提出更多应用需求。大族半导体已做好充分准备,持续聚焦后摩尔时代,发挥企业创新技术优势,以先进技术推动集成电路产业突破性发展。
原文始发于微信公众号(HSET大族半导体):后摩尔时代下如何突破超薄晶圆拿持难题?
一颗芯片的制造工艺非常复杂,需经过几千道工序,加工的每个阶段都面临难点。欢迎加入艾邦半导体产业微信群:

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊

