
氮化镓射频器件因其优异性能,在高新技术产业中发挥举足轻重的作用,已成为全球半导体领域的研究焦点和世界各国竞相抢占的战略制高点。近期,西安电子科技大学郝跃院士和马晓华教授团队在高功率密度氮化镓毫米波功率器件、低损伤氮化镓增强型射频器件关键技术、低压高效率氮化镓射频功率器件、超高频氮化镓器件等技术方向取得一系列新的突破。相关成果分别发表于IEEE Transactions on Electron Devices、Applied Physics Letters、Science China Information Sciences等电子器件领域的国际权威期刊。上述系列成果的主要完成人还包括华山特聘教授祝杰杰、华山准聘副教授宓珉瀚以及部分在读研究生。研究工作得到了科技部国家重点研发计划、国家自然科学基金、产学研合作等项目的支持。

氮化镓毫米波器件在大容量超高速移动通信、高分辨成像雷达等领域具有广阔应用前景。但是随着器件工作频率提高,不仅需要解决尺寸等比例缩小、小尺寸栅制作、高频寄生损耗抑制等关键技术,还面临非均匀分布的强电场效应、沟道输运热电耦合等科学难题和挑战,这对毫米波器件功率和效率的进一步提升至关重要。团队针对毫米波器件强电场引起的非理想表面和沟道输运问题,发明了堆叠结构和富硅SiN表面钝化方法,大幅抑制了表面漏电和电流崩塌,同时有效改善了器件沟道结温和高温动态特性,使得器件的功率附加效率提升5个百分点以上,实现了当前国内最高输出功率密度的氮化镓毫米波器件(Pout=8.7W/mm @30GHz),连续波输出功率和效率综合指标处于国际领先水平。

图1 (a)高效率高功率毫米波器件创新结构示意图;(b)富硅SiN钝化对电流崩塌和热稳定性的改善效果;(c)Ka波段毫米波功率性能与国内外水平的对比情况
相关成果分别以“Improved Power Performance and the Mechanism of AlGaN/GaN HEMTs Using Si-Rich SiN/Si3N4 Bilayer Passivation”和“8.7 W/mm output power density and 42% power-added-efficiency at 30 GHz for AlGaN/GaN HEMTs using Si-rich SiN passivation interlayer”为题发表在IEEE Transactions on Electron Devices、Applied Physics Letters期刊上,重点实验室博士研究生刘捷龙为第一作者。
论文链接:
https://ieeexplore.ieee.org/abstract/document/9660374
https://aip.scitation.org/doi/full/10.1063/5.0080120

低损伤氮化镓增强型射频器件关键技术
增强型器件在电路系统应用中具有减小系统功耗、简化电路设计复杂度、提高安全性等方面的优势,但传统的氮化镓器件因其极化效应通常工作在耗尽型模式。对于高频小尺寸器件发展所需的强极化异质结构,等离子体刻蚀高铝组分势垒层材料带来的表面损伤和沟道载流子输运特性退化现象则更为突出,制约着高频增强型氮化镓器件的发展。团队针对InAlN/GaN HEMTs器件栅下氯基刻蚀带来的表面形貌恶化和跨导反常退化问题,提出了一种刻蚀后原子层表面修复方法,基于O2/BCl3原子层刻蚀工艺原理修复干法刻蚀表面形貌,刻蚀后表面粗糙度RMS值由1.39nm减低到0.62nm。提出的强极化材料原子层刻蚀和自限制氧化方法,使凹槽绝缘栅氮化镓射频器件的载流子场效应迁移率退化量由39.5%减小到6.9%,并实现了栅长170nm、峰值跨导大于450mS/mm(同批次耗尽型器件值小于430mS/mm)、最高振荡频率大于100GHz的氮化镓增强型射频器件。
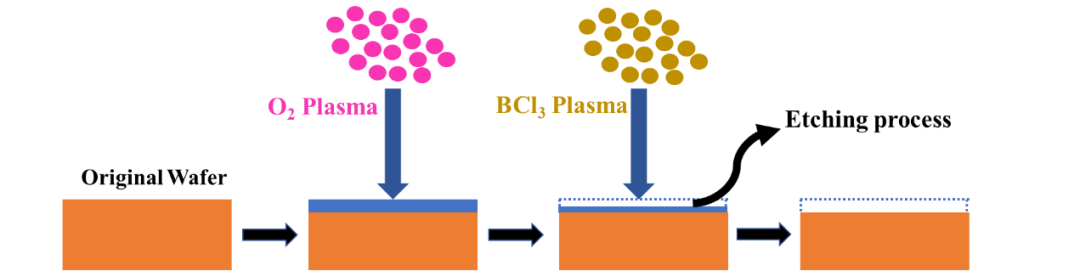
图2 氮化镓半导体的原子层刻蚀方法
相关成果“Improved transport properties and mechanism in recessed-gate InAlN/GaN HEMTs using a self-limited surface restoration method”已被Science China Information Sciences录用并已在期刊的公众号在线发表,成果“Normally-off Millimeter-Wave InAlN/GaN HEMTs Fabricated by Atomic Layer Etching Gate Recess”被the 36th International Conference on Compound Semiconductor Manufacturing Technology(CS MANTECH)录用为口头报告论文,重点实验室博士研究生刘思雨为第一作者。
论文链接:
https://mp.weixin.qq.com/s/fiqXmRCeesBwzx9f3pGSXg

低压高效率氮化镓射频功率器件
随着移动通信发展对高性能射频前端芯片的新需求,氮化镓技术的高频率、大带宽、高效率、可与硅集成等优点可在终端等低压低功率应用中带来射频器件性能、模组和系统架构、芯片尺寸和成本等多方面的巨大潜在优势。但是,GaN HEMT在低电压下效率急剧降低、硅基GaN器件低阻欧姆接触等是目前亟待解决的科学难题和技术挑战。团队深入研究了串联寄生损耗和低场区沟道电子输运对膝点电压和效率的限制机理,利用低方阻的强极化异质结构实现3V低压下功率附加效率仍然高达65%的氮化镓射频功率器件,其与原有方法相比低压时效率提升15个百分点。为了减小硅基氮化镓器件的欧姆接触损耗,提出具有低成本、低热预算、高导电性优点的MOCVD二次外延n+InGaN低阻欧姆接触方法,实现高铝组分异质结器件的欧姆接触电阻由0.5Ω·mm降至0.11Ω·mm的国际领先水平,利用二次外延欧姆接触后sub-6GHz下低压氮化镓器件的功率附加效率进一步提升至70%以上,30GHz频率下工作电压为6V时器件功率附加效率达到52%,功率密度达到1.2W/mm。这是国内首次报道面向通信终端应用的氮化镓射频功率器件,实现了低压工作模式下氮化镓射频功率器件的又一次创新。
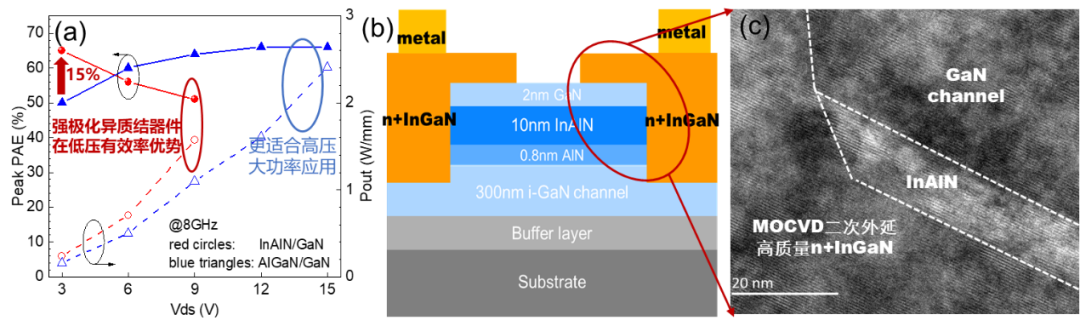
图3 (a)强极化异质结HEMT在低压下表现出高效率优势;(b)InAlN/GaN HEMT的低阻欧姆接触结构示意图及(c)高质量MOCVD二次外延材料的TEM图
成果“Analysis of Low Voltage RF Power Capability on AlGaN/GaN and InAlN/GaN HEMTs for Terminal Applications”和“High performance millimeter-wave InAlN/GaN HEMT for low voltage RF applications via regrown Ohmic contact with contact ledge structure”分别发表在IEEE Journal of the Electron Devices Society、Applied Physics Letters期刊,重点实验室博士生周雨威为第一作者。
成果“Regrown Ohmic contact based on MOCVD and effect of interdiffusion on the channel in InAlN/GaN heterostructures”被the 36th International Conference on Compound Semiconductor Manufacturing Technology(CS MANTECH)录用为口头报告论文,重点实验室博士研究生郭静姝为第一作者。
论文链接:
https://ieeexplore.ieee.org/document/9509586
https://aip.scitation.org/doi/full/10.1063/5.0079359

高品质因数氮化镓毫米波功率器件
随着5G通信技术的发展,更大功率密度,更高频率以及更高击穿通讯芯片的发展逐步引起半导体行业的关注,氮化镓基HEMT器件因其优异的性能在现代通讯系统中具有广阔的应用前景。但是为了满足更高工作频率的需求,器件尺寸被不断缩小,栅脚电场峰值急剧增大,击穿电压下降,同时短沟道效应加剧,严重限制器件的输出功率和效率。为了解决超高频器件的工作电压受限,输出功率较低的问题。团队设计并提出了具有栅下缓变场板的浮空T型栅结合超薄势垒AlGaN/GaN MISHEMT器件结构,在保证器件优异频率特性的前提下,大幅抑制了栅下峰值电场,击穿电压得到明显改善。使得毫米波GaN HEMT的品质因数(fT·VBK / fmax·VBK)达到16/36 THz·V, Ka波段下峰值PAE达到52.5%, 该指标在国际上fT在170GHz左右的器件中处于先进水平。

图4 (a)高品质因数毫米波器件创新结构示意图;(b)品质因数与国内外水平的对比情况
相关成果以“Demonstration of 16 THz V Johnson’s figure of merit and 36 THz·V fmax·VBK in ultrathin barrier AlGaN/GaN HEMTs with slant-field-plate T-gates”为题发表在Applied Physics Letters期刊上,重点实验室博士研究生王鹏飞为第一作者。
论文链接:
https://doi.org/10.1063/5.0080320
原文始发于微信公众号(宽禁带半导体教育部重点实验室):宽禁带半导体重点实验室在氮化镓毫米波功率器件领域取得系列重要进展
一颗芯片的制造工艺非常复杂,需经过几千道工序,加工的每个阶段都面临难点。欢迎加入艾邦半导体产业微信群:

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊


