铜晶粒对覆铜陶瓷基板性能影响的探究
上期与大家一起共同探讨了铜晶粒的定义(Definition)、测量方法(Measuring Method)及晶粒尺寸对于覆铜陶瓷基板基础性能的影响,那么本期HEXCERA® 基板小课堂将与大家一起探讨铜表面晶粒尺寸对于客户端模块封装的影响以及影响铜结晶粒度的制程因素。
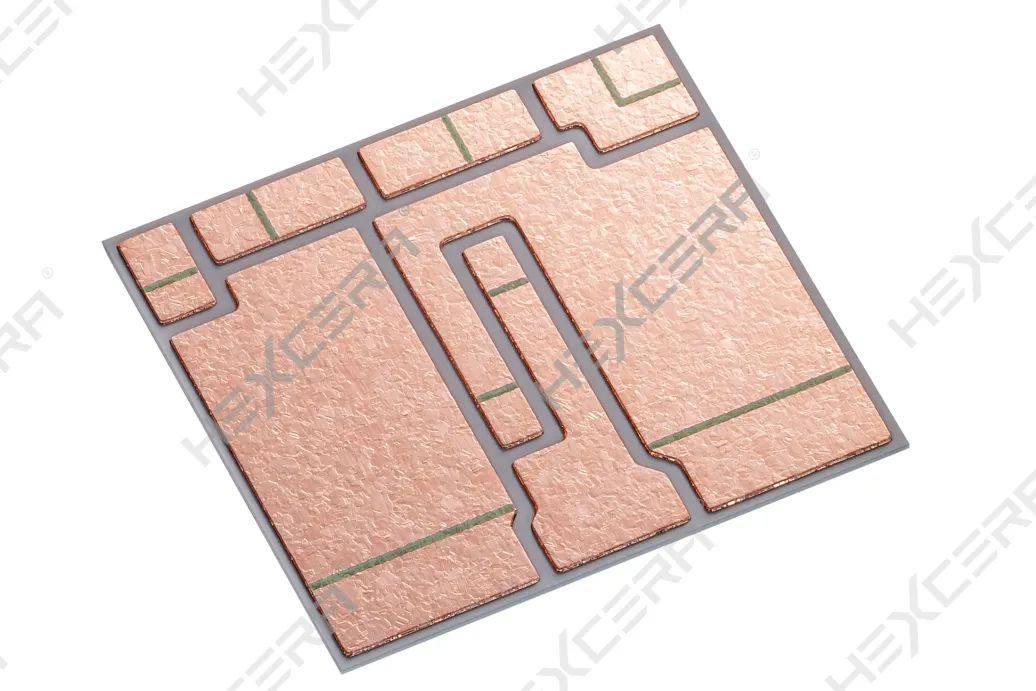
CCD眩光干扰:模块制造厂在封测过程中往往需要运用到照相定位系统和自动光学检验系统,以光学手段完成对基板的定位及检测。铜表面晶粒由于漫反射缘故,光照在特定角度下可能会产生眩光现象,从而对部分设备的CCD识别产生干扰。
微观注塑抗剪切性能:为提升功率模块的寿命,多元化的封装理念层出不穷,如银烧结、DTS、树脂压注技术等。其中,树脂压注技术可以取消或降低铜底板大面积的焊接层,其可靠性不光与树脂与芯片、绑定线的CTE有关,也与其衬板铜表面的粗糙度有关。其中主要机理为树脂对铜面的微观注塑。上期推文已提及,树脂更易于疏松的晶界处聚集铆合,在一定程度上能够增强结合面对抗剪切的性能,因此对于铜表面晶粒较大或粗糙度相对较高的基板表面进行树脂封装时,经过一定次数冷热循环后,树脂与铜表面分层失效会大大降低,增加模块整体可靠性寿命,如下图1所示。
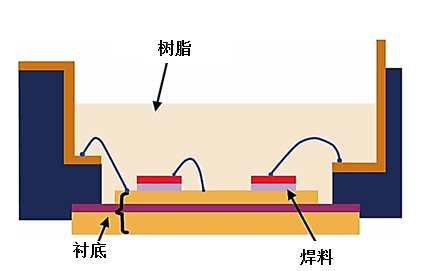
图1 树脂压注封装示意图
此外,业界研究表明,粗晶的增加对于小晶粒的生长能起到抑制作用,因粗晶生长是靠吞噬周围的细晶进行,增加粗晶数目会使得该区域内的细晶生长受到抑制,因此降低混晶对于制备均匀的小晶粒铜面有利。下图2为铜晶粒随退火时间的生长模拟示意图。异常晶粒AGG(Abnormal Grain Growth)也被称为行业内需要共同克服的难点。
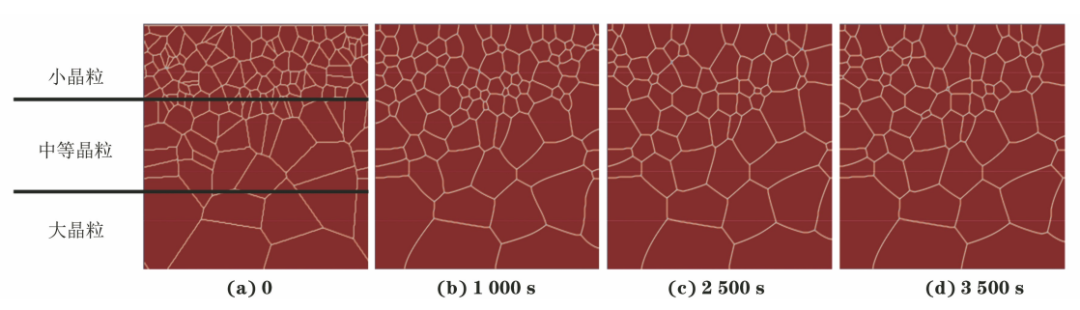
图2 模拟晶粒随退火时间的生长示意图
综上,如果能将铜晶粒调控到合适尺寸,将逐渐趋向于晶粒尺寸一致化,避免异常的粗晶生长,对形成均匀的晶粒度有举足轻重的影响。自HEXCERA®成立以来,致力于提高覆铜陶瓷基板性能与可靠性方面的研究,为客户端提供性能最优的解决方案。在铜材方面,始终采用99.99%的高纯度OFHC铜(Oxygen Free High Conductivity),并通过一系列工艺调控手段对晶粒尺寸进行调控,以满足不同客户不同工艺的需求。
对于覆铜陶瓷基板来说,如果将铜晶粒调控到合适尺寸,那么不管是对基板性能还是封装后模块的整体可靠性都会有不错的提升。HEXCERA®研发团队致力于从提高产品性能,提高客户的适配性和可靠性方面,对覆铜陶瓷基板进行研究,从而给客户专业的优化建议与不同的解决方案,帮助客户提升产品性能。
原文始发于微信公众号(瀚思瑞半导体):HEXCERA®基板小课堂(第二期):铜晶粒对覆铜陶瓷基板性能影响的探究
成员: 5306人, 热度: 153517
陶瓷 天线 通讯 终端 汽车配件 滤波器 电子陶瓷 LTCC MLCC HTCC DBC AMB DPC 厚膜基板 氧化铝粉体 氮化铝粉体 氮化硅粉体 碳化硅粉体 氧化铍粉体 粉体 生瓷带 陶瓷基板 氧化铝基板 切割机 线路板 铜材 氮化铝基板 氧化铍基板 碳化硅基板 氮化硅基板 玻璃粉 集成电路 镀膜设备 靶材 电子元件 封装 传感器 导电材料 电子浆料 划片机 稀土氧化物 耐火材料 电感 电容 电镀 电镀设备 电镀加工 代工 等离子设备 贴片 耗材 网版 自动化 烧结炉 流延机 磨抛设备 曝光显影 砂磨机 打孔机 激光设备 印刷机 包装机 叠层机 检测设备 设备配件 添加剂 薄膜 材料 粘合剂 高校研究所 清洗 二氧化钛 贸易 设备 代理 其他 LED
