Achievements 科研新进展 近日,厦门大学电子科学与技术学院于大全、钟毅老师团队与华为、厦门云天团队合作,在先进封装玻璃转接板集成芯片-金刚石散热技术领域取得突破性进展,相关成果以“Heterogeneous Integration of Diamond-on-Chip-on-Glass Interposer for Efficient Thermal Management”为题发表在微电子器件封装制造领域的国际权威期刊IEEE Electron Device Letters上,并被选为当期封面文章(Front cover)及编辑精选文章(Editors’ Picks)。 图1 2024年第3期IEEE Electron Device Letters期刊封面 高性能芯片的散热一直是电子产品服役中的突出难题。随着先进封装技术的快速发展,多芯片系统(Chiplets)的集成度和功耗不断提升,导致芯片散热问题极为严峻。尤其是在“后摩尔时代”,先进封装多芯片系统的功率和热流密度急剧增加,芯片热点的热流密度甚至可达到核弹爆炸级别的kW/cm2。因此,如何实现先进封装集成芯片的高效散热已成为突破高性能芯片功耗、算力和集成度瓶颈的关键。 于大全教授团队与华为团队合作开发了基于反应性纳米金属层的金刚石低温键合技术(该成果已发表在Journal of Materials Science & Technology, 188, 37-43, 2014),克服微凸点保护、晶圆翘曲等行业难题,成功将多晶金刚石衬底集成到2.5D玻璃转接板(Interposer)封装芯片的背面,并采用热测试芯片(TTV)研究其散热特性。利用金刚石的超高热导率,在芯片热点功率密度为~2 W/mm2时,集成金刚石散热衬底使得芯片最高结温降低高达24.1 ℃,芯片封装热阻降低28.5%。先进封装芯片-金刚石具有极为优越的散热性能,基于金刚石衬底的先进封装集成芯片散热具有重大的应用前景。 图2 多晶金刚石衬底集成到玻璃转接板封装芯片背面 及其散热性能表征 这项研究将金刚石低温键合与玻璃转接板技术相结合,首次实现了将多晶金刚石衬底集成到玻璃转接板封装芯片的背面。该技术路线符合电子设备尺寸小型化、重量轻量化的发展趋势,同时与现有散热方案有效兼容,成为当前实现芯片高效散热的重要突破路径,并推动了金刚石散热衬底在先进封装芯片集成的产业化发展。 该项工作由我院与华为公司、厦门云天半导体科技有限公司合作完成,钟毅助理教授为论文第一作者兼共同通讯作者,2020级硕士生包舒超为第二作者,2021级硕士生江小帆为第五作者。该研究工作得到了国家自然科学基金、校长基金等科技计划资助。厦门大学为成果的第一完成单位。 这是课题组近两年来连续在IEEE Electron Device Letters上发表的第6篇文章,团队系统研究了玻璃衬底天线、滤波器、电容等无源器件技术,玻璃转基板及其金刚石衬底集成散热技术,为高性能、高集成度、低成本的微系统三维集成提供理论和实践支撑。 论文链接: https://ieeexplore.ieee.org/abstract/document/10387492

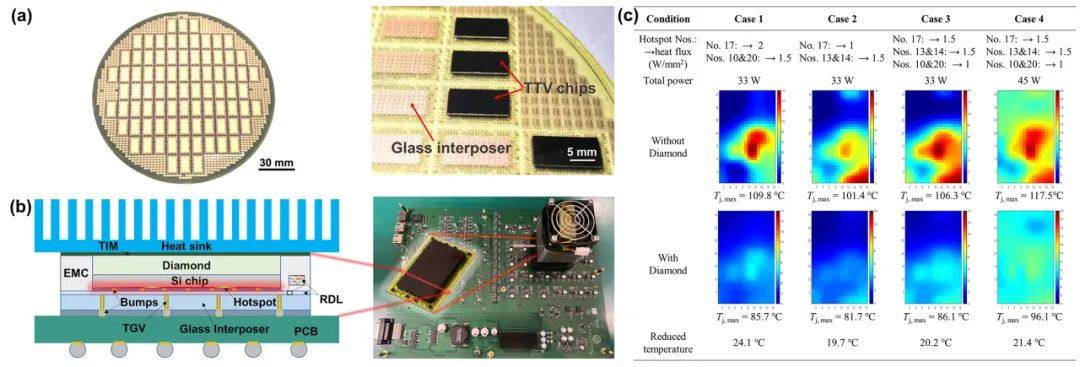
图文丨钟毅 厦门大学电子科学与技术学院 (国家示范性微电子学院)
原文始发于微信公众号(厦大电子人):科研新进展丨电子学院于大全教授团队与华为团队合作在先进封装金刚石散热技术领域取得突破



