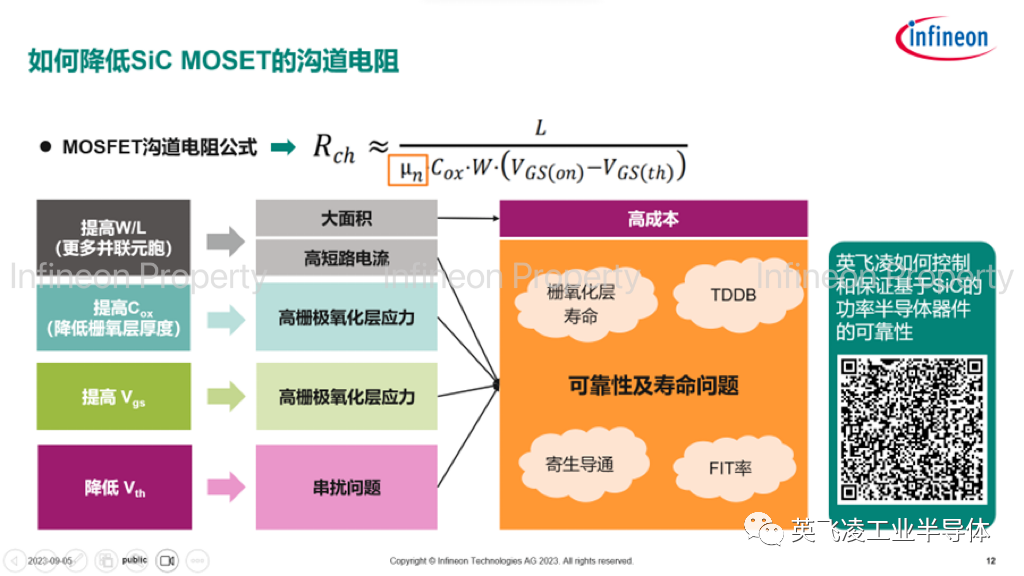
碳化硅MOSFET在材料与器件特性上不同于传统硅,如何保证性能和可靠性的平衡是所有厂家需要面对的首要问题,英飞凌作为业界为数不多的采用沟槽栅做SiC MOSFET 的企业,如何使用创新的非对称沟槽栅既解决栅极氧化层的可靠性问题、又提高了SiC MOSFET 的性能? 增强型M1H CoolSiC™芯片又“强“在哪里?英飞凌零碳工业功率事业部高级工程师赵佳女士,在2023英飞凌工业功率技术大会(IPAC)上,发表了《增强型M1H CoolSiC™ MOSFET的技术解析及可靠性考量》的演讲,深入剖析了CoolSiC™ MOSFET的器件结构,以及M1H芯片在可靠性方面的卓越表现。点击视频可观看回放。
对于不方便看视频的同学,小编还帖心地准备了图文版,为大家梳理了整个演讲的架构和重点。

1
(a) SiC是宽禁带半导体,它的带隙宽度约是Si的3倍,由此带来的好处是SiC的临界场强约是Si的10倍。对于高压Si基MOSFET来说,漂移区电阻占总导通电阻的主要分量。SiC临界击穿场强高,要达到相同的耐压,可以使用更薄以及更高掺杂的漂移区,从而大大降低了导通电阻。

(b) IGBT是双极性器件,电子和空穴同时参与导电,关断时空穴复合产生拖尾电流,增加了关断损耗。而SiC MOSFET是单极性器件,没有拖尾电流,相比Si IGBT节省至多80%开关损耗。SiC材料大大拓展了MOSFET的电压等级,最高电压可到3300V以上,重新定义了MOSFET的应用范围。
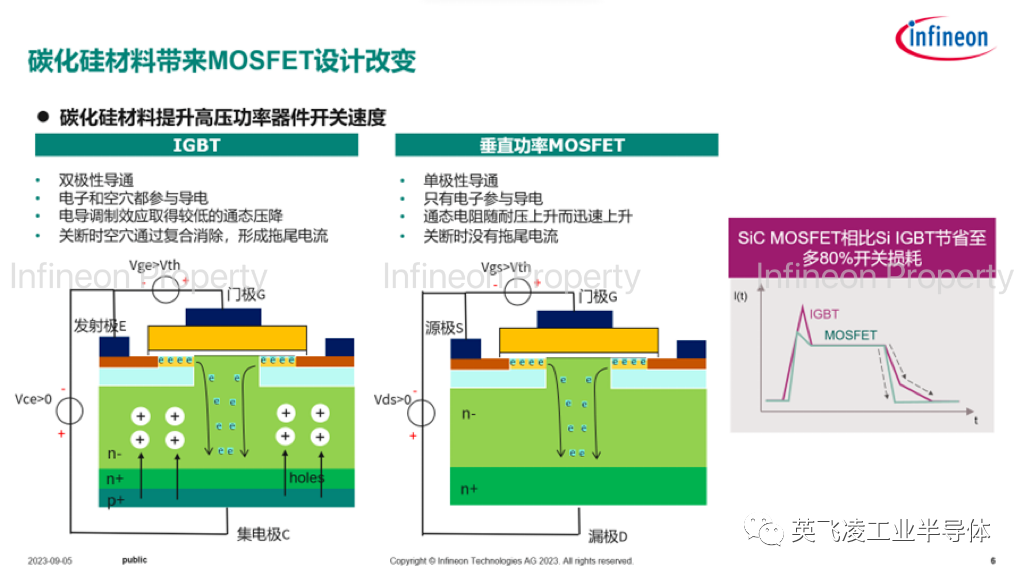
(c) SiC材料为器件设计即带来了机遇也带来了挑战。最大的挑战在于栅氧化层界面SiC-SiO2存在较高的缺陷密度和界面电荷,可能导致早期击穿、阈值漂移、导通电阻上升等问题,最终威胁到器件的寿命和可靠性。

2
(a) SiC材料的应用使得MOSFET漂移区非常薄,因此沟道电阻就成为了降低总电阻的关键。
(b) 根据沟道电阻的公式,可以采用以下手段,但是会加大可靠性风险:
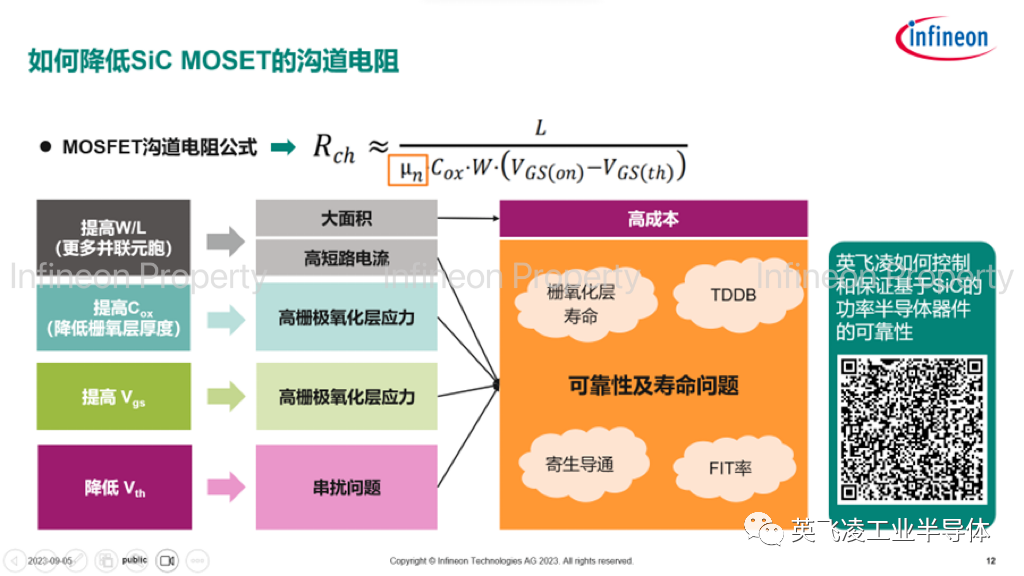
(c) SiC-SiO2界面态密度和缺陷远大于Si-SiO2界面,SiC MOSFET沟道载流子迁移率相比IGBT偏低。沟道载流子迁移率低会导致沟道电阻和损耗上升。SiC是各向异性晶体,垂直晶面上的氧化层缺陷密度小于水平晶面。可以利用这一特性解决上述难题。
(d) 比较沟槽栅和平面栅两种技术,如果要保持同等栅氧可靠性,平面与沟槽需同时使用同样厚度的栅氧化层,平面型MOS面积要显著大于沟槽栅;如果要保持相同的芯片面积,为了维持低导通电阻,平面型需要更薄的栅极氧化层,栅氧应力高,可靠性差。
(e) 英飞凌CoolSiC™ MOSFET采用非对称沟槽栅结构,有如下技术点:
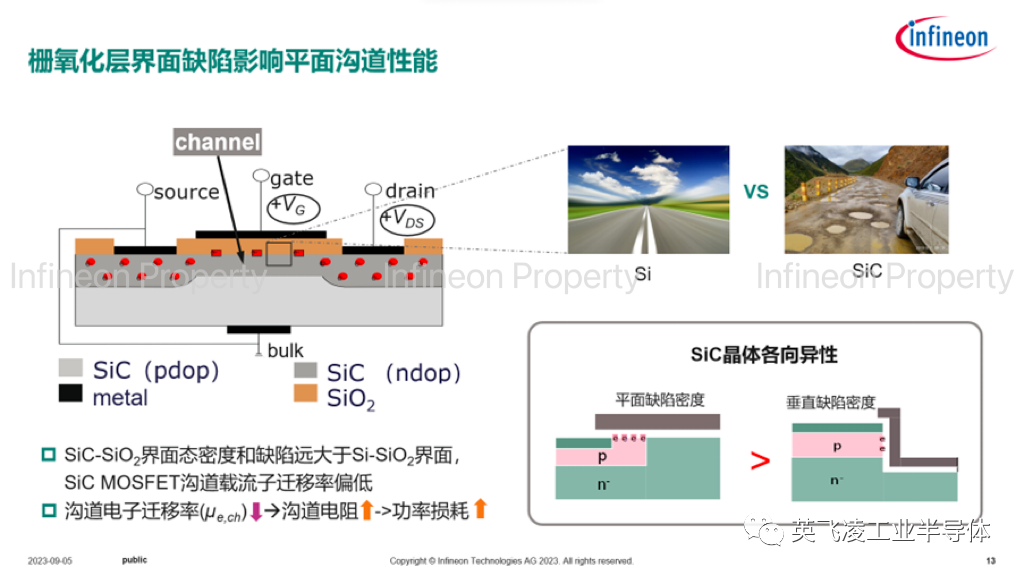

3
(a) 英飞凌SiC MOSFET栅氧化层厚度与Si 器件栅氧化层厚度相当。而平面型SiC MOSFET 栅氧化层厚度普遍低于沟槽栅。栅氧化层的电压应力与厚度成反比,过高的电场应力使得器件经时击穿的风险增加。可通过施加门极阶跃电压的方式来评估栅氧化层可靠性。英飞凌CoolSiC™ MOSFET拥有最低的失效率,并且与Si IGBT的失效特性相似。
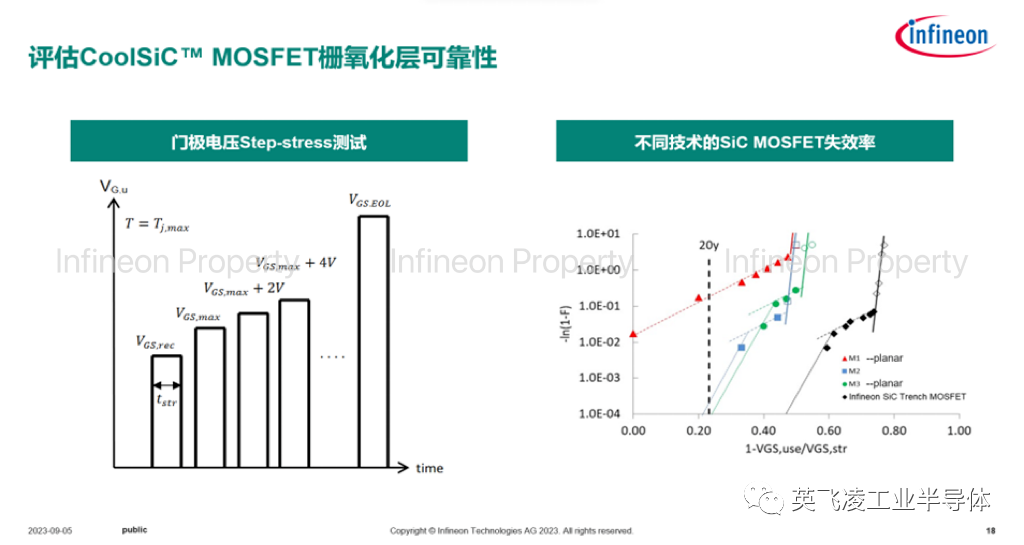
(b) 在长期的开关过程中,SiC MOSFET会出现阈值漂移的现象。这是平面型器件与沟槽型器件都需要共同面对的难题。英飞凌最早发现并研究了这一现象。最新的M1H芯片,进一步改善了栅氧化层质量,使得阈值漂移可以忽略不计。当到达预期目标寿命时,导通电压为18V时,预计25°C时的RDS(on)的相对变化小于6%,175°C时小于3%。
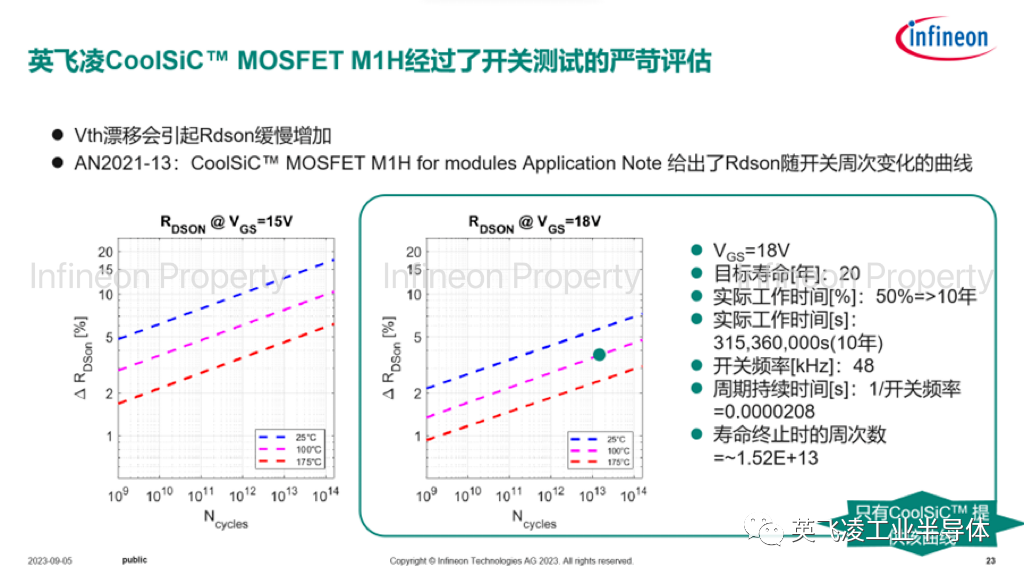
(c) M1H芯片的阈值电压约4.5V,高于其他竞争对手,并且具有非常低的米勒电容。高阈值电压能够有效抑制寄生导通现象。
4
(a) 大部分SiC MOSFET不承诺短路能力。CoolSiC™是唯一承诺短路能力的SiC MOSFET。在门极15V电压下,单管具有3us的短路时间,EASY模块具有2us的短路时间。

(b) SiC MOSFET在短路时具有电流饱和的特性,但短路时间往往低于IGBT。这是因为SiC MOSFET具有更高的短路电流密度,更小的面积以及更薄的漂移区,使得热量更加集中,从而降低了短路时间。
5
英飞凌M1H CoolSiC™ MOSFET非对称沟槽栅提供性能与可靠性的最优折衷设计

原文始发于微信公众号(英飞凌工业半导体):增强型M1H CoolSiC™ MOSFET的技术解析及可靠性考量

