6月29日,2023年 IGBT 产业论坛,将在昆山金陵大饭店举行。华润微电子,翠展微电子,芯能半导体,日机装株式会社,巴斯夫,比亚迪,中车,广林达,正业科,正业科技、安世半导体等企业代表将出席。报名联系张小姐:13418617872 (同微信)。
聊到混合键合(Hybrid Bonding), 我们在之前的一篇文章《先进封装之混合键合(Hybrid Bonding)的前世今生》已经对其进行了简要介绍,此处不再赘述。阅读文章前,欢迎扫描下方二维码加入半导体封装交流群。

Hybrid Bonding从最初量产便首先应用于图像传感器上,直到现在除了一些先进处理器在应用该技术外,其在图像传感器CIS(CMOS image sensors)上仍然在不断的发展,最终产品常被用于高端手机相机、数码相机和数码单反相机的堆叠背照式CMOS图像传感器(BI-CIS)。
今天,我们聊聊日本Sony发布的一种BI-CIS技术,其目的是将图像传感器(CIS)和图像信号处理器(ISP)连接在一起。如图1(左)所示,传统的BI-CIS采用TSV技术将像素阵列和逻辑电路在芯片外围区域实现6微米间距,2万个铜-铜连接。图1(右)采用了铜-铜混合键合的BI-CIS器件则是实现了的更小的互联间距(5微米间距)和更大规模的互联,达到150万个铜柱连接。更高的密度甚至可以做到3微米和300万个铜柱连接。

图1,传统堆叠BI-CIS(左)
和带有铜-铜连接的新堆叠BI-CIS(右)
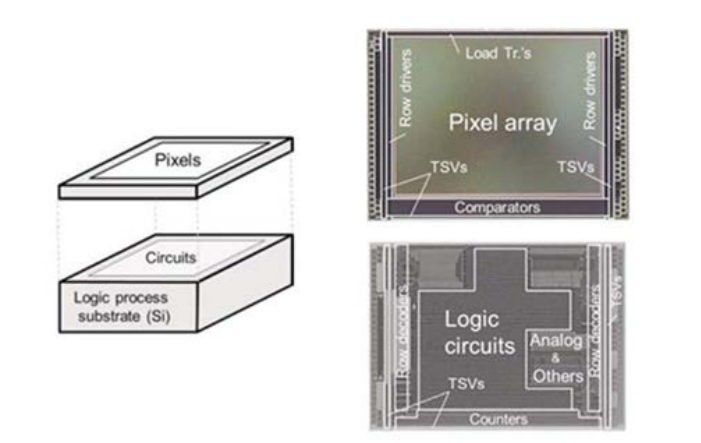
图2,传统堆叠BI-CIS实物图,采用TSV技术

图3,新的采用铜-铜混合键合的BI-CIS侧面图及其最终产品拍出的夜景图
传统TSV技术与铜-铜混合键合的主要差异如图4所示。明显可以看出铜-铜混合键合技术中单个连接单元占用空间更小。从布局灵活性的角度来看,与传统的芯片堆叠技术(如通过硅通孔技术)相比,铜-铜连接具有许多优点。我们可以将铜-铜连接放置在上/下芯片的外围区域以及中央区域这样就增加了电路设计的灵活性。键合步骤示意图如图5所示。
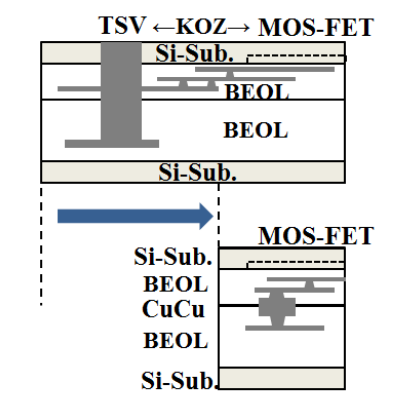
图4,带有TSV的键合基板的示意图(上)
和带有混合键合的键合基板的示意图(下)
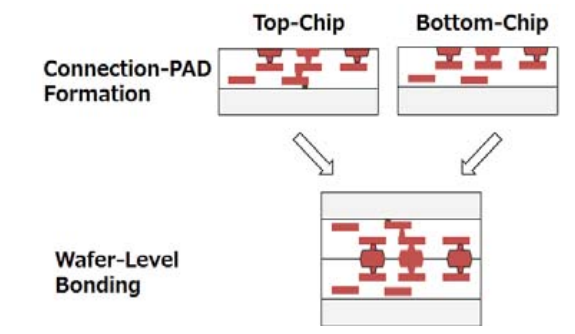
图5,铜-铜混合键合示意图
这么小的间距,势必要求更高的贴装精度,图6为传统键合工艺(左)和最新键合工艺(右)制造中的错位比较。可以看到0.5微米以下的错位是完全可以做到的。
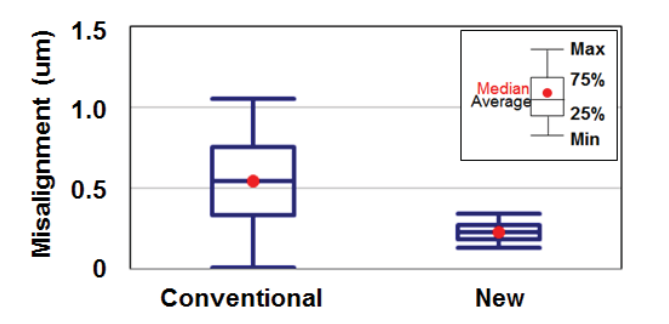
图6,传统键合工艺(左)
和最新键合工艺(右)制造中的错位比较
这些是不是已经够复杂了?还有更为复杂更先进的封装技术应用于CIS产品。业界提出了具有两种类型的3D堆叠结构:同质芯片堆叠和异质芯片堆叠。当然,在任何结构中,具有高密度连接的三个或更多芯片将是突破传统设备的关键。
在3D堆叠器件中,正面对正面的铜-铜混合键合和正面面对背面的铜-铜混合键合为我们提供了三维集成的灵活性。相比传统的微凸点技术,晶圆级铜-铜混合键合可以在极高密度下电连接上下芯片。

图7,堆叠式BI-CIS的演进
图8,展示了一个三层堆叠结构的示例。其具体加工流程如图9所示。首先,在top wafer和middle wafer的顶部BEOL层上制作铜连接BUMP。将top wafer和middle wafer进行面对面的铜-铜混合键合后,middle wafer的背面通过减薄以制作TSV。最后,通过位于middle wafer背面和bottom wafer顶部BEOL层上制作的铜连接bump,实现middle wafer和bottom wafer的铜-铜混合键合。
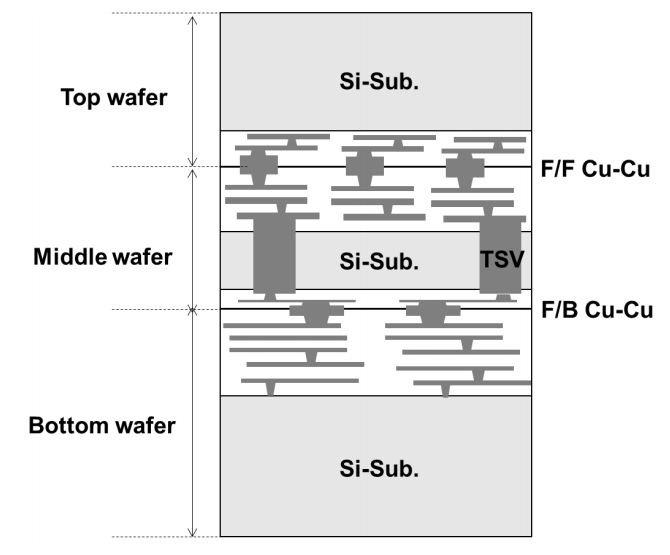
图8,三层堆叠结构的示例

图9,具体的三片晶圆堆叠模块的工艺流程和典型工艺步骤
本文介绍的技术当前主要来自于日本Sony公司,国内同行对相关技术的报道还不多。希望国内封装巨头们,也抓紧赶上。欢迎感兴趣的封装人士加入艾邦半导体微信群。

参考文献:
1. The Scaling of Cu-Cu Hybrid Bonding For High Density 3D Chip Stacking Y. Kagawa , S. Hida etc.
2. Novel Stacked CMOS Image Sensor with Advanced Cu2Cu Hybrid Bonding Y. Kagawa , N. Fujii,etc.
3. An Advanced CuCu Hybrid Bonding For Novel Stacked CMOS Image Sensor Y. Kagawa, N. Fujii, etc.
4. Impacts of Misalignment on 1μm Pitch Cu-Cu Hybrid Bonding Y. Kagawa, H. Hashiguchi, etc
5. Development of face-to-face and face-to-back ultra-fine pitch Cu-Cu hybrid bonding Yoshihisa Kagawa, Takumi Kamibayashi, etc.
半导体成为人们日常生活最重要的组成部分。为促进行业发展,互通有无,欢迎芯片设计、晶圆制造、装备、材料等产业链上下游加入艾邦半导体封装产业链交流群。



原文始发于微信公众号(艾邦半导体网):先进封装之图像传感器混合键合(CMOS Hybrid Bonding)



