2023年3月20日,大日本印刷株式会社(DNP)宣布开发出用于下一代半导体封装的"TGV(Through Glass Via)玻璃芯基板"。它是一种将 FC-BGA(倒装芯片-球栅阵列)等传统树脂基板替换为玻璃基板的产品,高密度 TGV 可以提供比传统技术更高性能的半导体封装。此外,通过调整面板制造工艺,可以实现高效率和大面积。
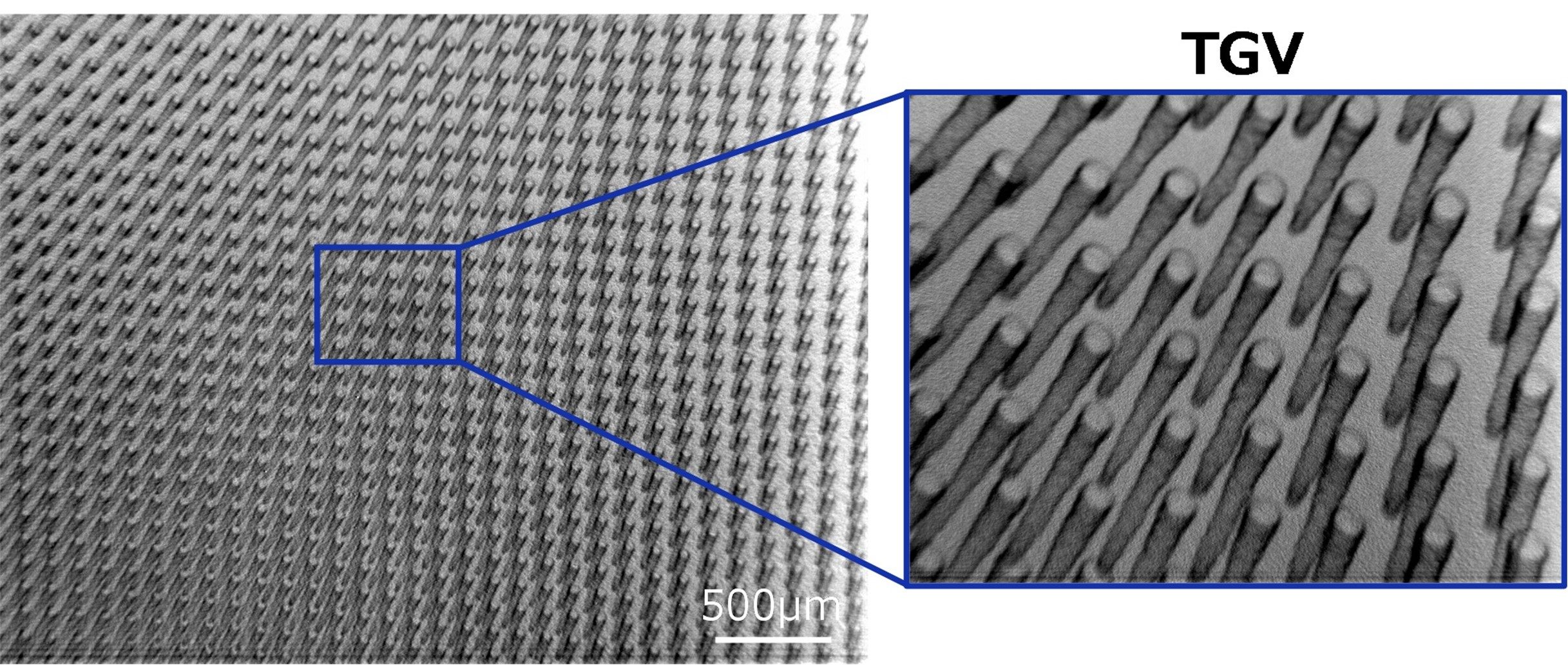
图 已开发玻璃芯基板的通孔 (TGV) X 射线图像
随着数字化转型(DX)的推进,分发的数据量急剧增加,需要进一步提高支持社会基础设施的半导体的性能和可靠性。为此,通过在单个基板上高密度安装多个具有不同功能的半导体芯片来提高处理速度的下一代半导体封装正引起人们的关注。但是,在GIP(Glass Interposer)等封装中继基板的中介层*1的电极形成技术中,难以实现极窄布线的精细间距和封装面积的增大。
为了应对这些挑战,DNP 专注于将玻璃作为半导体封装的基础材料,我们开发了一种具有高纵横比(玻璃厚度除以通孔直径的比率)的玻璃芯基板,并且具有与微间距兼容的精细贯通电极。
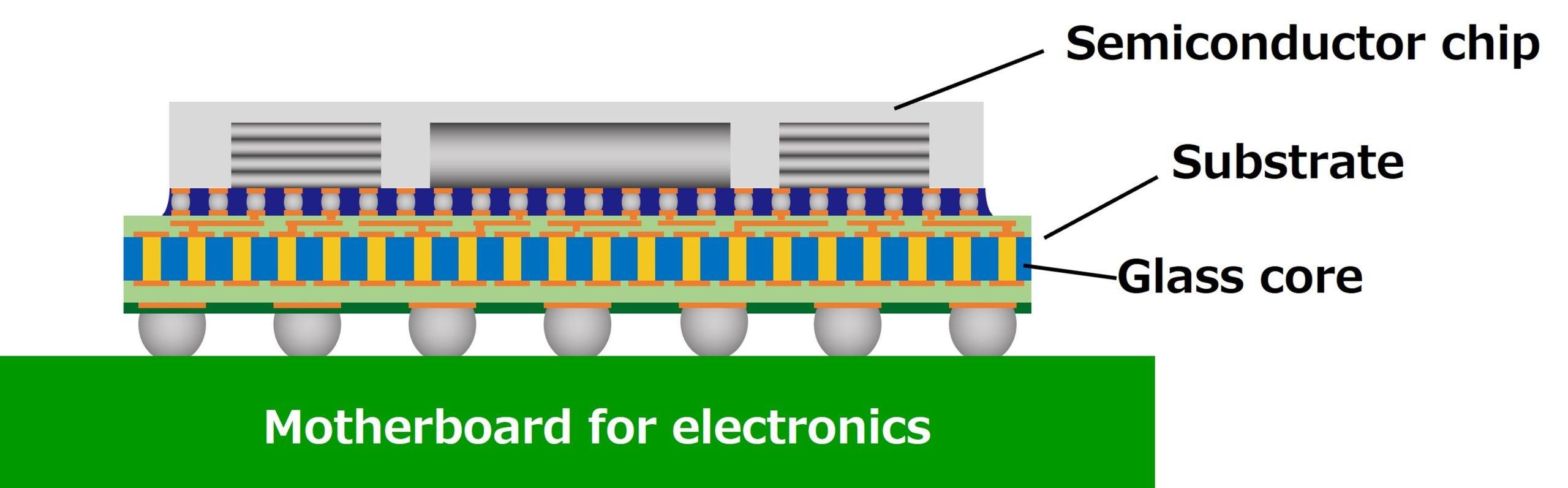
图 使用玻璃芯基板的位置
DNP开发的玻璃芯基板的特点
1. 实现细间距和高可靠性
DNP开发的玻璃芯基板具有电连接形成于玻璃正反面的精细金属布线所必需的TGV型。DNP 开发的新制造方法增强了玻璃和金属之间的粘合,这在以前是困难的,并实现了精细间距和高可靠性。
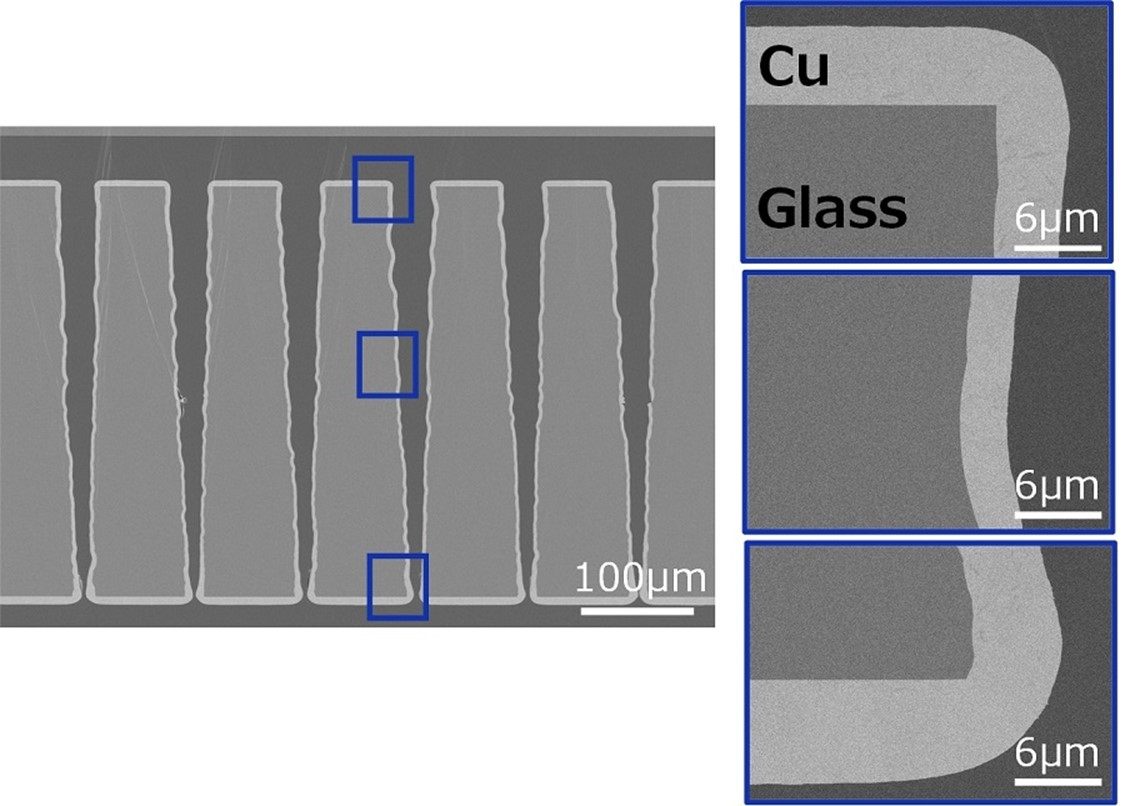
图 玻璃芯基板的横截面图像。您可以看到附着在玻璃上的金属层(Cu:铜)
2. 实现高纵横比和大面积
有限区域的大容量信号传输需要高纵横比的硅通孔。新开发的玻璃芯基板的纵横比为9以上,具有足以形成微细布线的密合性。此外,由于对所用玻璃芯基板的厚度限制较少,因此在翘曲、刚性和平整度方面的设计自由度增加,采用面板制造工艺可以容纳更大的封装。
除了已经开发的用铜填充玻璃通孔的"填充型"之外,DNP 还着手将新开发的"共形型"玻璃芯基板放大到 510 x 515mm 的面板尺寸。目标是实现年销售额50亿日元。
DNP利用其应用和开发印刷工艺的核心技术"微细加工技术",开发了用于半导体和MEMS(微机电系统)代工服务的光掩模。这次,应用其通过这些业务培养的独特的面板制造工艺技术和处理大面积玻璃的处理技术,开发了玻璃芯基板。今后,DNP将利用在 P&I(印刷和信息)方面的优势,例如将这些电子元件与信息安全等 IT 优势相结合,提供支持舒适信息社会的解决方案。
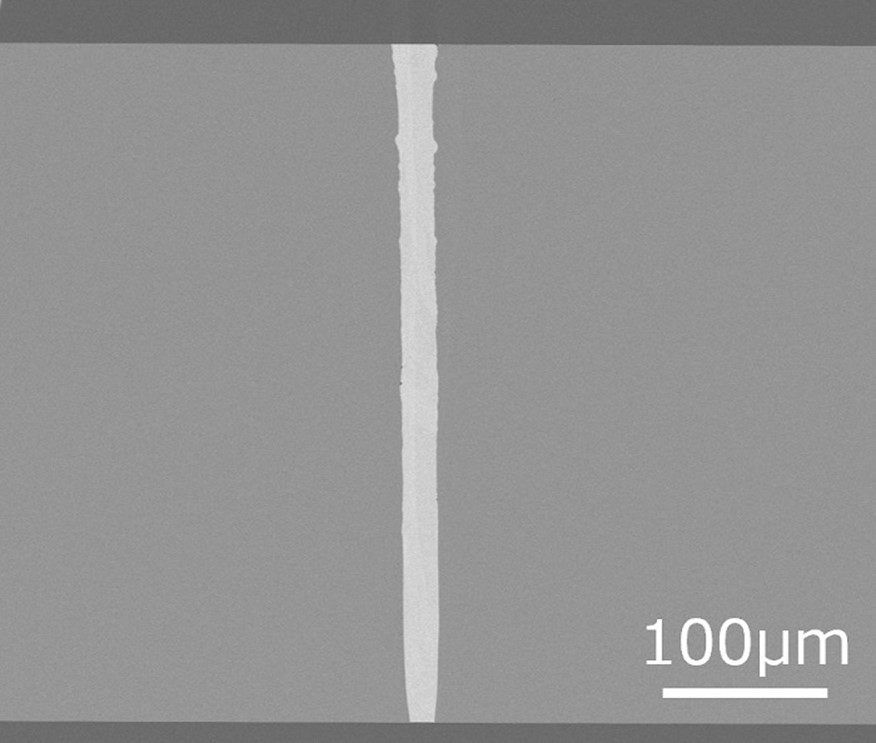
图 填充型玻璃截面图





