根据笔者的经验,题目越复杂,应用层面的创新度越高。题目越简单则原理性创新度越高。今天的题目仍然符合以上规律。我们在艾邦半导体公众号中已经对扇出型封装,RDL及面板级封装都已经有介绍。但是至今还没有介绍过混合基板的概念。
本文主要引用来自台湾欣兴电子股份有限公司的研究。欣兴电子是联电集团的成员之一,PCB的制造经验达30年。特别近几年,每年约40%快速成长,串升至全国第三大厂。欣兴共有10个厂其中4个在大陆,6个在台湾。欣兴电子在混合基板方面有较为全面的研究。
什么是混合基板?在回答该问题前要先回答什么是基板?从图1中可以看出,当特征尺寸超过50微米后可以采用的连接方式主要是封装基板及实装基板(业界通常讲的PCB板)。图2为不同类型的封装基板针对不同的下游应用。相信通过图1及图2,您已经将身边所接触的基板与业界的基板划分进行了对照,并有了较为清晰的认识。

图1. 不同特征尺寸所用的连接方式
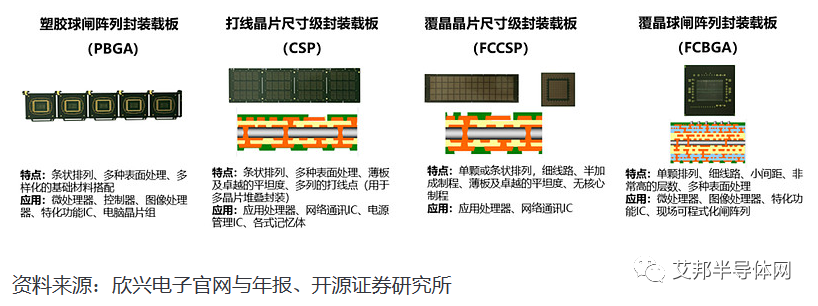
图2. 不同类型的封装基板针对不同的下游应用
混合基板就是指将制备好具有扇出型RDL的连接层与Substrate基板连接。具体实物如图3所示,相信大家可以有一个感性的认识。混合基板即拥有RDL又包含普通的Substrate,且两者之间通过BUMP连接,混合基板剖面图如图4所示。
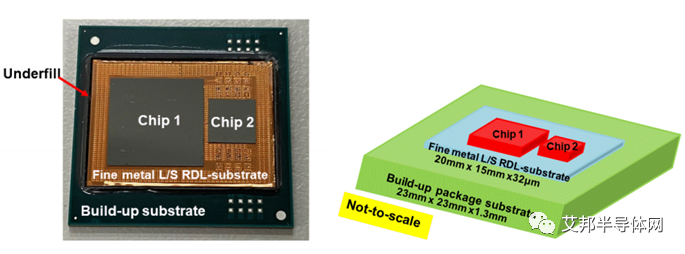
图3. 混合基板制备的具有两个大小DIE的芯片
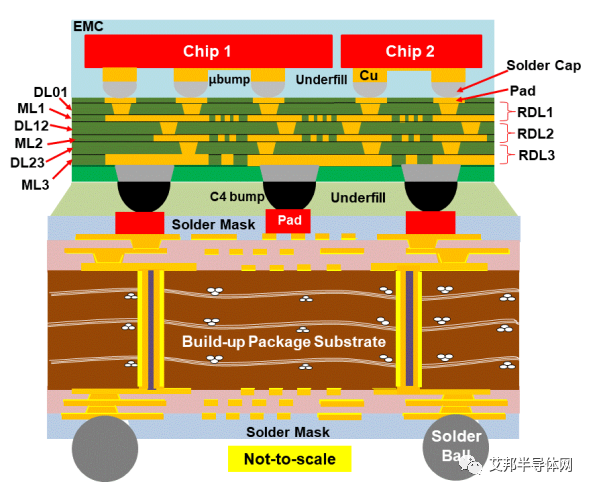
图4. 混合基板剖面图
混合基板就是指将制备好具有扇出型RDL的连接层与Substrate基板连接。具体实物如图3所示,相信大家可以有一个感性的认识。混合基板即拥有RDL又包含普通的Substrate,且两者之间通过BUMP连接,混合基板剖面图如图4所示。
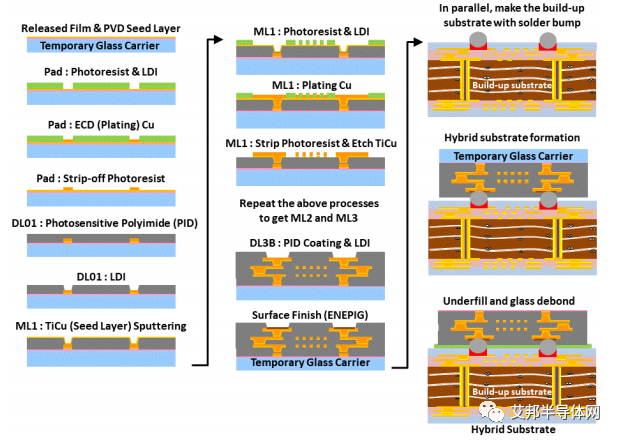
图5. 混合基板制备工艺流程
混合基板封装中遇到最难的问题之一便是翘曲。可以看出玻璃基板在动态翘曲控制方面较为突出,这也是业界用玻璃作为载板的主要原因之一。

图6. Shadow Moire法测量的基板随温度的动态翘曲曲线,分别为普通Substrate 基板(BU),RDL层在玻璃基板上的翘曲RDL(G),以及RDL层在普通有机基板上的翘曲RDL(O)
最后,我们聊聊国内外厂家的大致情况。国内相关研究较少,国内龙头企业主要精力放在晶圆级RDL封装,至今能够实现面板级RDL并封装大芯片的报道还没有看到。在扇出型面板级封装的市场争夺中,半导体OSAT(外包半导体组装测试厂商)、IDM(集成器件制造商)、晶圆代工厂(Foundry)等来自不同领域的制造商都加入了其中,且斥资巨大。如图7所示,三星、日月光、力成科技、群创、华润微、奕斯伟、Nepes等都已切入扇出型面板级封装,他们的整体策略是向下游整合,以能提供整颗芯片封装完成为有利的商业模式。当然如果您对此有兴趣希望深入了解,欢迎入群交流。

图7. 全球面板级封装厂商(来自MAZN)
参考文献:
1.Hybrid Substrate by Fan-Out RDL-First Panel-Level Packaging John H. Lau; Chang-Fu Chen; Jones Yu-Cheng Huang etc.
2.百度百科
3.Development of High-Density Hybrid Substrate for Heterogeneous Integration Chia-Yu Peng; John H Lau; Cheng-Ta Ko; Paul Lee; Eagle Lin etc.
4.https://xueqiu.com/6471314274/222789750
5.https://www.sohu.com/a/616906813_121118998
原文始发于微信公众号(艾邦半导体网):混合基板扇出型 RDL-First 面板级封装



