氮化镓(GaN)基电子器件具有高频、高效、耐高温及抗辐射等卓越特性,是下一代高效电力电子与射频电子系统的核心支撑器件,已在 5G/6G 通信、智能消费电子等领域凸显出优异的应用优势。GaN基器件主要基于异质外延材料制作,由于外延衬底与GaN基外延层(如AlGaN/GaN异质结构)间严重的晶格失配和热失配,GaN基异质结构外延薄膜不可避免地存在高密度线性位错(约10⁸ cm⁻²),远高于Si和SiC等半导体材料。螺位错、刃位错以及两者的混合位错是GaN基异质外延中最主要的位错类型,这些位错诱导的漏电与可靠性退化问题是制约GaN基电子器件向更高电压和更大功率应用拓展的关键挑战之一。
针对上述问题,中国科学院微电子研究所GaN基功率电子器件研发团队联合北京大学、香港科技大学、剑桥大学、武汉大学、中国科学院半导体所和苏州能讯高能半导体有限公司等单位,首次澄清了GaN异质外延中螺位错(open-core)和刃位错对GaN基功率电子器件的关键可靠性-动态导通电阻退化的影响机理,构建了“双通道位错输运”模型,明确了GaN外延层中螺位错和刃位错可分别充当电子与空穴的独立传输路径,对器件漏电和动态电阻的退化产生相反的影响。
团队基于课题组前期开发的创新模式深能级瞬态谱(DLTS)测试系统、低温光致发光(PL)、导电/电势原子力显微镜(c-AFM/EFM)等多种先进表征方法,结合第一性原理计算,从原子层级明确了螺位错在其开核(open-core)侧壁诱导形成纵向连通的超浅能级电子态,同时在位错核心区域形成电子势阱,形成贯穿外延层的“电子通道”;而刃位错则在其周围诱导形成连续分布的空穴陷阱,这些陷阱与碳掺杂GaN缓冲层中的CN型缺陷耦合,形成“空穴通道”。团队在650-V 级GaN基HEMT器件上进行了电学测试验证,发现即便总位错密度较低,螺位错主导的器件在高压开关应力作用下,其动态导通电阻退化幅度显著高于刃位错主导器件。该现象印证了螺位错易导致电子泄漏、电荷堆积与电流崩塌,而刃位错辅助的空穴再分布则有助于缓解缓冲层电子积累,从而减轻动态性能衰退。研究提示,通过外延工艺调控螺位错与刃位错的比例,有望在保持整体晶体质量的前提下,实现GaN功率器件在漏电与动态可靠性之间的最优平衡。该成果为GaN器件中的“缺陷工程”开辟了新思路,创新提出将位错视为可工程化的一维载流子管道,而非单纯的有害结构缺陷。该策略有望推广至其他半导体材料体系,为构建“位错电子学” 理论体系奠定基础。
研究成果以 “Dislocation-Assisted Electron and Hole Transport in GaN Epitaxial Layers” 为题发表在 Nature Communications(DOI: 10.1038/s41467-025-61510-w)。中国科学院微电子研究所姚毅旭助理研究员为论文第一作者,黄森研究员、刘新宇研究员、北京大学沈波教授和香港科技大学 Kevin J. Chen 教授为论文的共同通讯作者。研究工作得到了国家自然科学基金重点、面上及青年基金项目,中国科学院-香港裘搓基金以及 “中国科学院微电子研究所-香港科技大学微电子联合实验室” 等项目的资助。
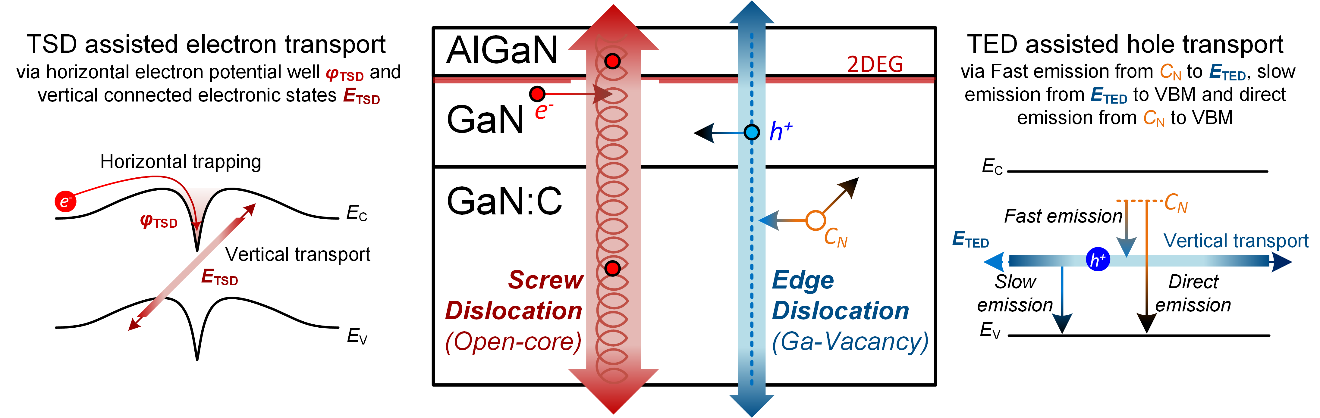
图1 GaN外延中位错电子-空穴双通道输运模型:电子在螺位错(TSD)辅助下,经由 ETSD浅电子能级和φTSD 电子势阱共同作用实现输运;空穴则在刃位错(TED)的辅助下,于刃位错引入的能级ETED 与碳掺杂引入的碳替氮位 CN 之间通过快速、慢速和直接发射三类路径完成输运。

