
随着电子产品向小型化、便携化发展,器件集成度不断提高,I/O引脚数进一步增多、引线间距进一步缩小,Sn/Pb共熔合金焊料已经不足以满足微电子组装和封装技术发展的需要。近来,导电胶在集成电路、混合集成电路、多芯片模块(MCM)、电子组件等粘接互连方面得到广泛的应用。目前市场上哪些片式多层瓷介电容器的端头类型适用导电胶进行粘接呢?
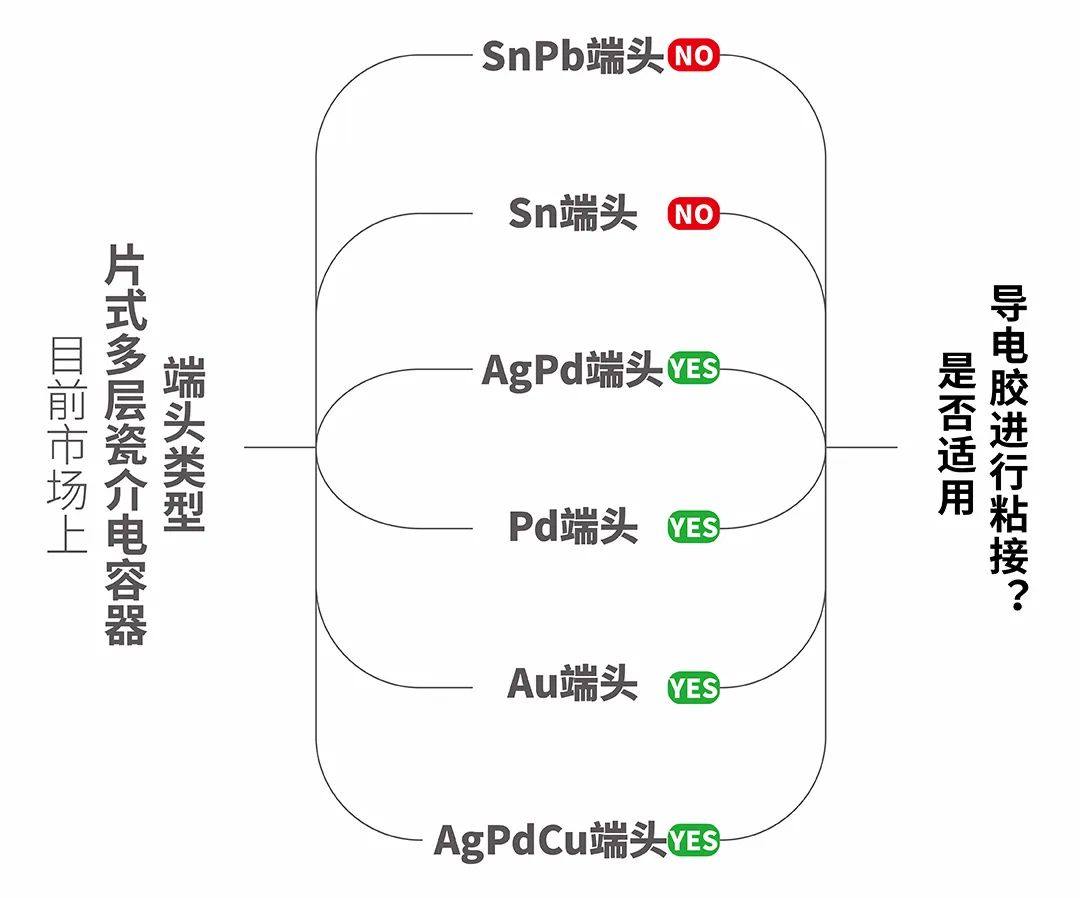
Sn或SnPb端头的片式多层瓷介电容器因何不推荐使用导电胶进行粘接?主要基于以下4个原因:
END
原文始发于微信公众号(火炬电子):导电胶粘接片式多层瓷介电容器探讨

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入MLCC交流群。
资料下载成员: 5306人, 热度: 153517
陶瓷 天线 通讯 终端 汽车配件 滤波器 电子陶瓷 LTCC MLCC HTCC DBC AMB DPC 厚膜基板 氧化铝粉体 氮化铝粉体 氮化硅粉体 碳化硅粉体 氧化铍粉体 粉体 生瓷带 陶瓷基板 氧化铝基板 切割机 线路板 铜材 氮化铝基板 氧化铍基板 碳化硅基板 氮化硅基板 玻璃粉 集成电路 镀膜设备 靶材 电子元件 封装 传感器 导电材料 电子浆料 划片机 稀土氧化物 耐火材料 电感 电容 电镀 电镀设备 电镀加工 代工 等离子设备 贴片 耗材 网版 自动化 烧结炉 流延机 磨抛设备 曝光显影 砂磨机 打孔机 激光设备 印刷机 包装机 叠层机 检测设备 设备配件 添加剂 薄膜 材料 粘合剂 高校研究所 清洗 二氧化钛 贸易 设备 代理 其他 LED
