一、激光诱导深度蚀刻是什么?
激光诱导深度蚀刻,英文名 Laser-Induced-Deep Etching,缩写LIDE。
LIDE工艺仅需两个步骤。
第一步,根据设计图形对加工玻璃进行选择性激光改性。在LIDE工艺中,单次激光脉冲即足以产生对全厚度的改性效果,超高的效率适用于大批量的生产需求。
Step 2:
第二步,改性区域通过湿化学蚀刻法,其被蚀刻速度远远高于未被改性过的材料。
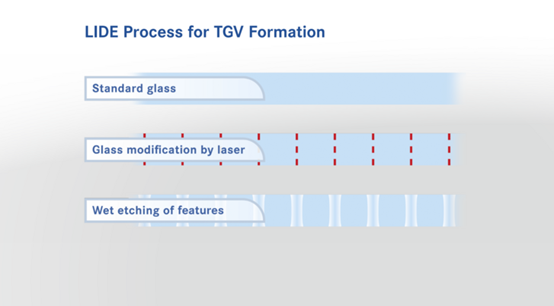
其特点是以前所未有的加工效率,经济可靠的制作径厚比大于1:10的结构。最小可以加工小于5 μm的超微孔。
二、激光诱导深度蚀刻制作玻璃通孔(Through Glass Vias,TGV)
使用传统的掩模湿法蚀刻方式, 虽然也不会产生微裂隙。 但各向同性的蚀刻工艺所产生的孔径板厚比永远大于1, 无法制作微孔。 普通的激光直接在玻璃上钻孔工艺不但产能低,有隐藏的微裂隙以及热应力残存,这些会造成良率损失,甚至是灾难性的最终产品失效。
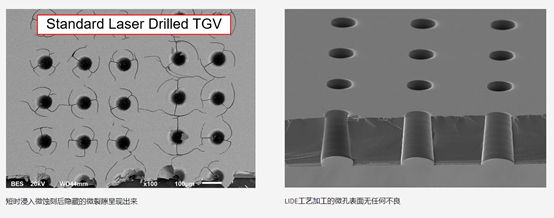
与传统钻微孔工艺相比,LIDE制作的玻璃通孔无微裂隙、无碎屑、无热应力残存。另外,LIDE加工的玻璃通孔不但品质高,而且精度和一致性都很高。
LIDE工艺除了这些的基本优点,该技术制作的玻璃通孔还有很多特别优势:
1.最小孔直径可达10 µm,一般来说,同一基板上所有的微孔直径相同。多种直径的微孔可通过多次蚀刻工艺实现
2. 通常,孔径板厚比一般在1:10的范围内,但对于某些种类的玻璃,板厚比可以高达1:50。
3. LIDE制作的微孔侧壁平滑,无微裂隙,无碎屑,无应力,有利于高可靠性的孔金属化制程。锥度在0.1°-30°。
4.LIDE制成微孔通常呈沙漏状。在预改性后的玻璃进行单侧蚀刻会产生V形孔。
5. 各种标准晶圆尺寸(直径): 100mm、150mm、200mm、300mm、450 mm
玻璃面板尺寸:小于510 x 510 mm²
玻璃厚度:小于 0.9 mm
来源:vitrion





