共烧多层陶瓷元器件及组件可分为高温共烧多层陶瓷(HTCC)和低温共烧多层陶瓷(LTCC)两种。HTCC是指在 1450℃以上与熔点较高的金属一并烧结的具有电气互连特性的陶瓷。随着通信向高频高速发展,为了实现低损耗、高速度和高密度封装的目的,LTCC应运而生,烧结温度在900℃左右。弗劳恩霍夫陶瓷技术和系统研究所(Fraunhofer IKTS)开发了超低温共烧陶瓷ULTCC,可在400°C~700°C的极低温度下烧结,适合用于元器件的集成。
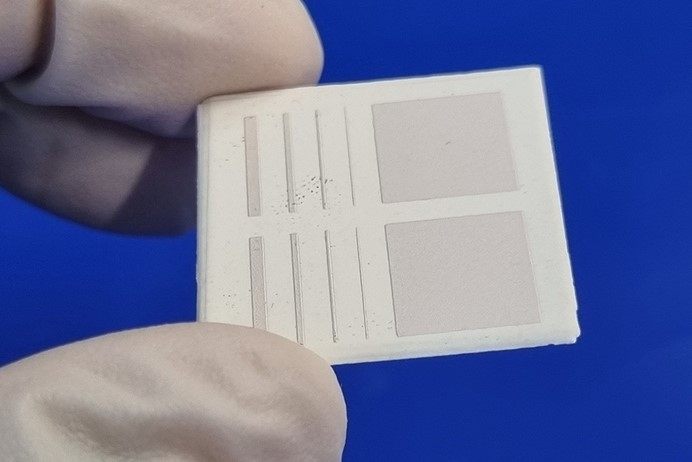
ULTCC 基板
超低温共烧陶瓷技术(Ultra Low Temperature Co-fired Ceramics,ULTCC)是具有众多优点的新型多层陶瓷。一方面,ULTCC 可以在400°C~700°C的极低温度下烧结,使其制造过程非常节能。另一方面,低烧结温度允许更广泛的导体材料用于功能化,使技术混合(半导体工艺、基于聚合物的微电路制造)成为可能。
ULTCC可以将电路和封装嵌入和烧结到陶瓷中。这降低了制造成本,从而显著扩展了 ULTCC 组件的应用范围。ULTCC 组件非常适合用作电子组件的重新布线载体,用于外壳和封装技术,或用作天线、滤波器和循环器等高频技术应用的基板。

ULTCC 基板的显微图像
Fraunhofer IKTS基于玻璃陶瓷复合材料 (GCC) 开发定制的符合 RoHS 和 REACH 标准的 ULTCC 材料和生瓷带,该复合材料由低熔点玻璃和合适的陶瓷填料组成。玻璃类型与所选填充材料相结合,决定了材料特性,例如热膨胀、导热性、绝缘性以及电气参数(绝缘电阻、介电常数、介电损耗)。相关的金属化浆料基于银和铝。其挑战在于调整粘合剂和浆料系统以及制造工艺,以使材料在上述温度范围内可共烧结。

ULTCC 基板上的烧结银
ULTCC技术特点:
- 烧结温度范围为 400 °C~700 °C(密度= 4.2 g/cm3,烧结温度 600–650 °C);
- XYZ 收缩率:15–17 %;
- 孔隙率 < 1 vol. % 和吸水率 < 1 vol. %;
- 高频特性:εr为4–50,tanδ 为0.005–0.0001 (< 30 GHz);
- 热性能:热膨胀系数3-10 ppm/K; 导热系数 1–20 W/mK;
- 导体 (Ag/Al) 和半导体元件 (Si/SiC) 的集成;
- 适应材料特性的高度自由度;
- 符合 RoHS 和 REACH 标准的材料和工艺。
来源:Fraunhofer IKTS

