
2022年7月7日,上海讯
近年来先进封装(Advanced Package)成为了高性能运算客制化芯片(High Performance Computing ASIC)成功与否的关键。随着市场需求不断升级,世芯电子致力于投资先进封装关键技术,将其更有效率的整合到芯片设计供应链中, 以实现全客制化的合作模式。
随着高阶应用市场的发展,科技系统大厂开始必须透过软硬体系统整合来实现创新,使其产品达到更强大的功能与强化的系统效能。也因为如此,现今各个系统大厂与OEM对客制化芯片(ASIC)的需求呈现高度成长。特别是在高性能运算系统芯片(SoC)领域,IC设计本身非常复杂且成本已经相当昂贵,如果再加上后端设计包含封装,测试,供应链整合等等会是更大规模的投资。在成本及效率的考虑下,各大企业选择与专业高阶ASIC设计公司合作已是必然的趋势。
高性能运算IC的成功关键取决于先进封装技术
高阶应用市场的高性能运算系统芯片成长强劲,伴随的是前所未有对先进封装技术的依赖。由台积电所研发的先进封装技术CoWoS 及InFO 2.5D/3D封装对于成功部署当今的HPC SoC ASIC至关重要。CoWoS封装可以实现把数个小芯片(Chiplets)黏合在同一中介片(Interposer)同一封装基板(Substrate)上,以达到“系统级微缩”的境界,大大提升了SoC之间互连密度和性能,是科技史上的一大突破。
另一先进封装技术为多芯片模组(Multi-Chip-Module,简称MCM)也是类似概念。与传统封装不同,先进封装需要与电路设计做更多的结合,加上必须整合产业的中下游,对设计整合能力是一大挑战,也是门槛相当高的投资。
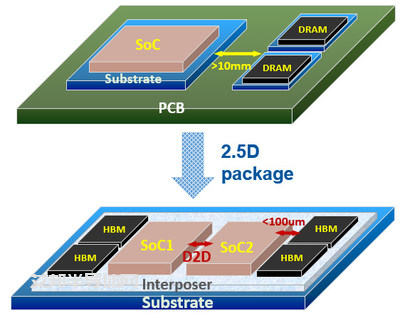
先进封装CoWoS, 2.5D Package - 世芯的高性能运算设计解决方案能无缝整合系统芯片设计和先进封装技术, 进而提升互连密度和性能
世芯看到了高性能系统运算ASIC设计服务市场对先进封装需求的急速成长。“如今,各个科技大厂正大量投资于IC前端设计,以求跟自家产品完美结合以最大程度区别市场差异性及市场领先地位。他们此刻需要的是与杰出的专业ASIC设计服务公司合作,才不会让他们的大量投资及时间成本付诸流水。”世芯电子总裁兼首席执行官沈翔霖说到。
世芯是客户在高性能运算市场客制化芯片的重要伙伴
世芯电子提供的高性能运算设计方案能无缝整合高性能运算系统芯片设计和先进封装技术。世芯的MCM 于2020年量产,CoWoS 于2021 年量产。现有大尺寸系统芯片几乎是光罩的最大尺寸(Reticle Size,800mm2)。
中介片(Interposer)设计为 3~4倍于光罩最大尺寸(3~4X Reticle Size),而先进封装尺寸甚至达到 85x85mm2是现有封装技术的极限。这都是经过多项客户产品成功量产验证过的。也证明了世芯的高性能运算设计方案满足高性能运算IC市场需求,是其取得市场领先地位的重要关键。

原文始发于微信公众号(世芯电子):世芯电子提高先进封装研发投资以满足高性能运算IC市场需求
成员: 5306人, 热度: 153517
陶瓷 天线 通讯 终端 汽车配件 滤波器 电子陶瓷 LTCC MLCC HTCC DBC AMB DPC 厚膜基板 氧化铝粉体 氮化铝粉体 氮化硅粉体 碳化硅粉体 氧化铍粉体 粉体 生瓷带 陶瓷基板 氧化铝基板 切割机 线路板 铜材 氮化铝基板 氧化铍基板 碳化硅基板 氮化硅基板 玻璃粉 集成电路 镀膜设备 靶材 电子元件 封装 传感器 导电材料 电子浆料 划片机 稀土氧化物 耐火材料 电感 电容 电镀 电镀设备 电镀加工 代工 等离子设备 贴片 耗材 网版 自动化 烧结炉 流延机 磨抛设备 曝光显影 砂磨机 打孔机 激光设备 印刷机 包装机 叠层机 检测设备 设备配件 添加剂 薄膜 材料 粘合剂 高校研究所 清洗 二氧化钛 贸易 设备 代理 其他 LED


