近日,炬光科技发布了预制金锡AIN陶瓷衬底AMC产品系列及金锡薄膜制备服务。预制金锡薄膜键合材料是保证光电子器件长期可靠使用的关键技术。与传统铟、锡铅、锡铋等键合材料相比,金锡键合贴片的器件在耐用性、抗氧化能力和抗热疲劳能力上有更优异的表现。金锡除了主要应用于光电芯片的贴片封装之外,用于器件外壳封装时可显著提高密封性,用于光学元件封装时可避免传统胶工艺在温度影响下发生的位置变化现象,大大增强光学元件的封装对位精度。根据应用环境不同,金锡可以被预制在AIN、铜钨、碳化硅、玻璃、CVD金刚石以及铜金刚石等不同衬底材料之上。
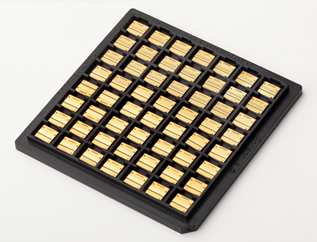
炬光科技是预制金锡薄膜工艺和金锡共晶键合贴片工艺的技术领导者,在此领域拥有超过10年的技术沉淀。同时炬光科技也是预制金锡衬底材料的供应商,提供各种预制金锡衬底材料产品和金属薄膜化制备服务。
此次,炬光科技推出预制金锡AIN陶瓷衬底AMC产品系列及金锡薄膜制备服务,预制金锡工艺采用物理气相沉积工艺,厚度可以做到10微米以内,公差为+/-1微米,厚度均匀性可以达到3%左右,在应用时大大增加了芯片封装界面焊料铺展的均匀性,降低封装界面空洞,再结合高精度表面加工水平,更加满足高功率芯片键合的需求。
目前三款标准品的参数如下表:

如有其它特殊需求,我们也可提供定制服务
产品特点
炬光科技预制金锡AIN陶瓷衬底AMC产品系列具备如下特点:
1. 低热阻
凭借多年对产品共晶键合技术能力的经验,炬光科技从应用需求出发,优化了整个AMC产品各层材料的最佳热管理设计,实现低热阻封装应用,保证器件的更高功率输出。

使用炬光科技FL-AMC产品封装25W芯片
在40A下测试极限功率热翻转数据
2. 低应力
炬光科技AMC产品系列在研发阶段就优化了各材料层的厚度设计和材料的热膨胀系数(CTE)匹配设计,最终使得产品整体的CTE与芯片的CTE尽可能接近,实现低应力封装,大大增强器件的长期使用寿命。

使用AMC产品封装25W芯片
在25A下测试寿命数据

炬光科技其他预制金锡材料产品封装80W器件的
寿命数据超过18000h
3. 成熟的预制金锡技术
炬光科技采用物理气相沉积工艺,在材料上表面预制一层均匀的金锡薄膜,用于满足客户芯片金锡共晶键合应用的需求。由于预制金锡为整个产品的核心工艺环节,炬光科技使用完善的质量管理体系以保证预制金锡性能的可靠性和大批量生产制造的一致性。
4. 大批量生产制造能力
AMC产品系列采用“从wafer加工到单颗”的批量化模式,大大提高了产品一致性和生产效率,专业面向大批量化光电子器件封装市场。
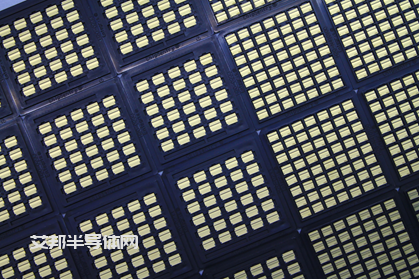
AMC产品系列
除此之外,炬光科技可以给客户带来更加快速响应的服务,利用高功率芯片共晶键合和测试的技术经验给与客户更多应用的支持。如有其它特殊需求,我们也可提供定制服务。
原文始发于微信公众号(炬光科技):新品发布 | 预制金锡氮化铝(AlN)陶瓷衬底AMC产品系列及金锡薄膜制备服务
成员: 5306人, 热度: 153517
陶瓷 天线 通讯 终端 汽车配件 滤波器 电子陶瓷 LTCC MLCC HTCC DBC AMB DPC 厚膜基板 氧化铝粉体 氮化铝粉体 氮化硅粉体 碳化硅粉体 氧化铍粉体 粉体 生瓷带 陶瓷基板 氧化铝基板 切割机 线路板 铜材 氮化铝基板 氧化铍基板 碳化硅基板 氮化硅基板 玻璃粉 集成电路 镀膜设备 靶材 电子元件 封装 传感器 导电材料 电子浆料 划片机 稀土氧化物 耐火材料 电感 电容 电镀 电镀设备 电镀加工 代工 等离子设备 贴片 耗材 网版 自动化 烧结炉 流延机 磨抛设备 曝光显影 砂磨机 打孔机 激光设备 印刷机 包装机 叠层机 检测设备 设备配件 添加剂 薄膜 材料 粘合剂 高校研究所 清洗 二氧化钛 贸易 设备 代理 其他 LED

