玻璃中介层(Glass Interposer)与玻璃基板(Glass Substrate)是半导体先进封装中的两种关键材料,均以玻璃为核心,但在功能定位、技术结构及应用场景上存在显著差异。
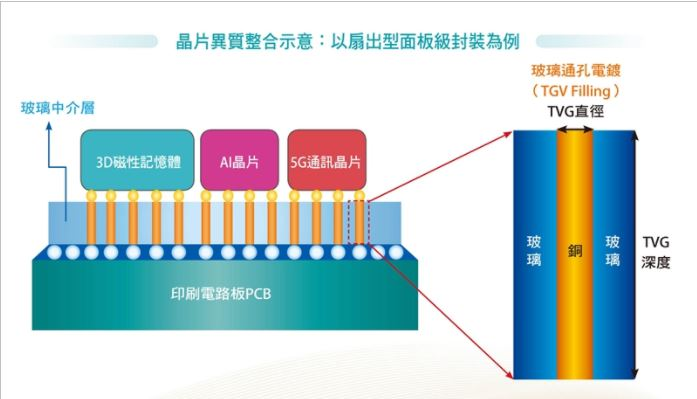
图源工业技术研究院
以下从多个维度解析二者的区别:
一、功能定位与层级差异
1. 玻璃中介层(Glass Interposer)
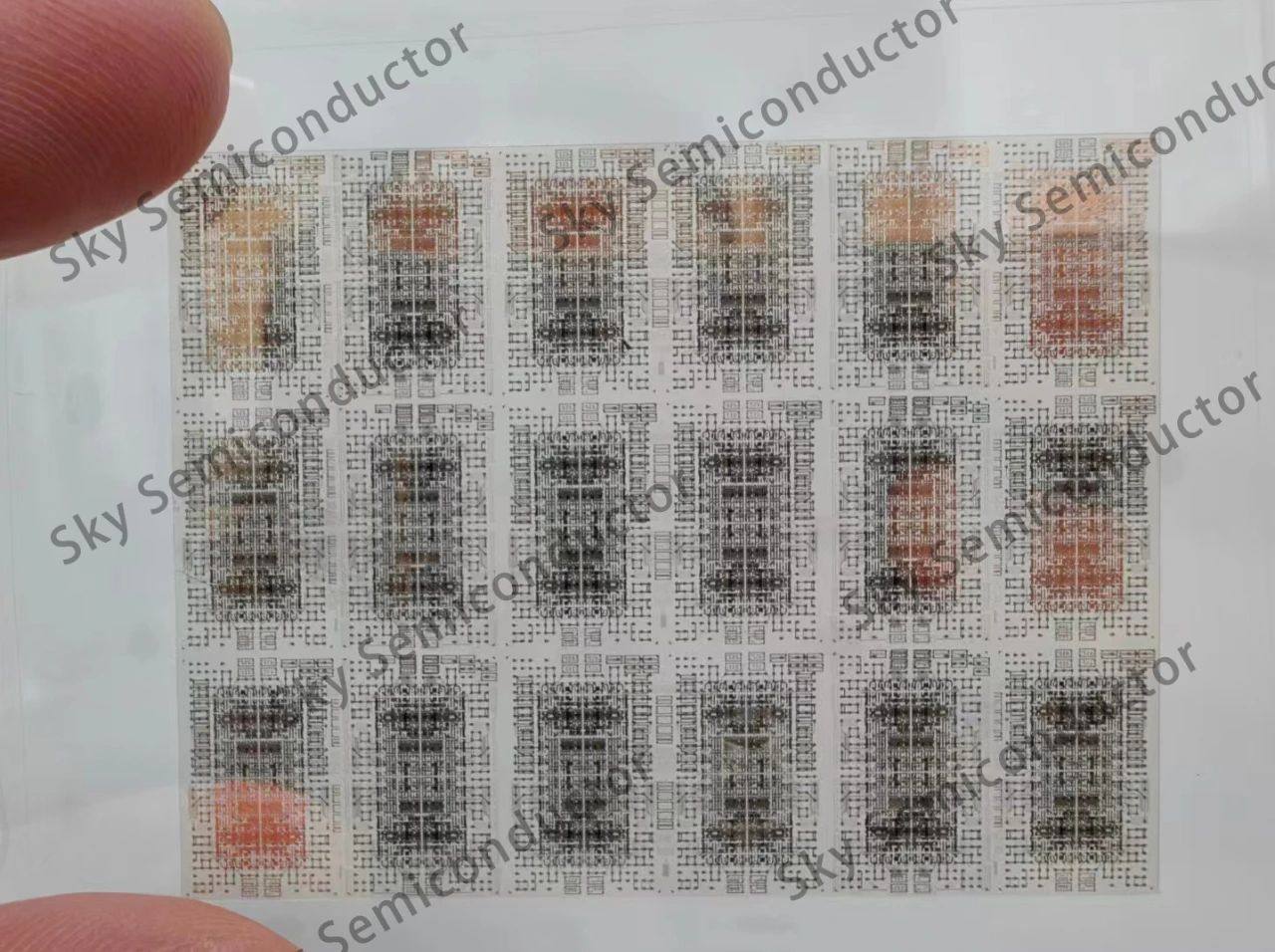
图 封装面积为2700mm2的TGV转接板 图源:云天半导体官网
a. 核心作用:作为芯片与封装基板之间的 中间连接层 ,实现高密度互连。例如,在2.5D封装中,它通过玻璃通孔(TGV)连接GPU与高带宽内存(HBM),缩短信号路径,降低延迟。
b. 替代对象:传统硅中介层(TSV),解决硅材料的高成本、热膨胀系数(CTE)失配问题。
2. 玻璃基板(Glass Substrate)

任意铸造玻璃基板原型,图源:Anycasting
a. 核心作用:作为封装结构的支撑底座,直接承载芯片或中介层,提供系统级电气连接和物理支撑。例如,英特尔玻璃基板可集成多个芯粒(Chiplet),替代有机基板(如ABF)。
b. 替代对象:有机印刷电路板(PCB)或有机封装基板,解决大尺寸封装中的翘曲、散热瓶颈。
二、技术实现与结构特点
|
维度 |
玻璃中介层 |
玻璃基板 |
|
核心技术 |
TGV(玻璃通孔):微米级钻孔+铜填充,实现垂直互连 |
玻璃芯材+高密度布线层(RDL),无需TSV/TGV |
|
结构特征 |
薄型(100–400μm),多层细间距布线(线宽≤2μm) |
厚(400–1100μm),支持10–20层高密度布线,表面超平坦(纳米级) |
|
制造工艺 |
激光蚀刻+湿法化学处理,面板级(Panel-Level)加工 |
大尺寸切割(可达600×650mm),结合封装级RDL工艺 |
|
核心优势 |
低介电损耗、高频信号完整性、CTE匹配有机基板 |
超高尺寸稳定性(翘曲降低50%)、散热优化、支持超大芯片(250×250mm) |
三、应用场景与市场定位
1. 玻璃中介层
a. 适用场景:高性能计算(HPC)芯片中GPU与HBM的互连;
- 5G/6G射频模块,依赖其低信号损耗特性;
-
Chiplet异构集成,如三星计划2028年量产用于AI芯片。
b. 商业案例:三星联合Chemtronics开发71×71mm玻璃中介层,面板级量产效率比硅中介层高4倍。

HBM与GPU集成在一起 来源:美光官网
2. 玻璃基板
a. 适用场景:超大AI芯片封装(如英伟达120×120mm以上芯片);
- 扇出型面板级封装(FOPLP),解决有机基板翘曲问题;
-
未来玻璃PCB替代,实现芯片-基板-CTE统一(如华为、AMD布局)。
b. 商业案例:英特尔玻璃基板将功耗降低50%,互连密度提高10倍,目标2026–2030年量产。
四、产业链布局与代表企业
|
技术方向 |
代表企业及动态 |
|
玻璃中介层 |
三星(2027年量产)、通快-SCHMID(激光蚀刻工艺)、京东方(2025年试点线) |
|
玻璃基板 |
英特尔(2026量产)、三星电机(2027量产)、SKC Absolics(试产)、沃格光电(10万㎡产能) |
五、小结:核心区别与协同趋势
-
本质差异:中介层是互连桥梁,基板是承载底座;前者聚焦芯片间高速通信,后者解决系统级封装稳定性。
-
协同演进:未来可能整合为“玻璃中介层+玻璃基板”一体化方案(如三星世宗试验线),直接替代有机PCB,实现从芯片到系统的全玻璃互连。
玻璃技术正重塑半导体封装:中介层攻“互连密度”,基板破“尺寸极限”。两者虽分工不同,但共同指向更高效、更集成的AI芯片未来。
艾邦建有玻璃基板与TGV技术交流群,可以加强产业链的合作,促成各企业的需求对接,同时您也可以与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验,欢迎您的加入。

|
8月26号(玻璃基板TGV) |
||
|
时间 |
议题 |
演讲嘉宾 |
|
10:00-10:25 |
玻璃芯基板:新一代先进的封装技术 |
安捷利美维电子(厦门)有限责任公司技术专家黄双武教授 |
|
10:25-10:50 |
TGV集成三维互联核心材料技术 |
华中科技大学温州先进制造研究院研究员李运钧 |
|
10:50-11:15 |
议题拟定中 |
江苏芯德半导体科技股份有限公司研发副总经理张中 |
|
11:15-11:40 |
Next in Advanced Packaging: Why Glass Core Substrates is emerging |
YOLE Dr. Bilal HACHEMI |
|
11:40-12:05 |
玻璃基板原材料的技术及其应用 |
拓科达科技(深圳)有限公司/NEG 日本电气硝子 技术总监 蔡岱峯 |
|
12:05-13:00 |
中午休息 |
|
|
13:00-13:25 |
议题拟定中 |
苏州锐杰微科技集团有限公司先进研究院院长张龙博士 |
|
13:25-13:50 |
基于SLE(选择性激光蚀刻)工艺的精密玻璃加工——机遇、挑战与解决方案 |
Workshop of Photonics/凌云光技术股份有限公司 (VP of Business Development and Innovation) Martynas Dagys |
|
13:50-14:15 |
TGV导电互连全湿法制备技术 |
深圳大学教授符显珠 |
|
14:15-14:40 |
磁控溅射深孔镀膜在TGV领域的应用 |
广东汇成真空科技股份有限公司项目经理吴历清 |
|
14:40-15:10 |
基于Holotomography(HT)的玻璃基板三维无损检测与良率提升策略 |
韩国Tomocube 销售经理 金泳周 |
|
15:10-15:35 |
基于微镜阵列的超高速变焦显微成像技术在TGV产业的应用 |
季华实验室/广东佛山超聚锐视科技有限公司 特聘研究员 金哲镐 博士 |
|
15:35-16:00 |
TGV3.0通孔结构控制和金属化协同驱动封装新突破 |
三叠纪(广东)科技有限公司研发总监李文磊 |
|
16:00-16:25 |
玻璃基板封装关键工艺研究 |
中科岛晶产品经理徐椿景 |
|
8月27号(板级封装) |
||
|
10:00-10:25 |
面向大算力应用的硅基光电融合先进封装技术 |
华进半导体封装先导技术研发中心有限公司副总经理刘丰满博士 |
|
10:25-10:50 |
应用于三维封装的PVD 系统 |
深圳市矩阵多元科技有限公司董事长张晓军 |
|
10:50-11:15 |
化圆为方:面板级封(PLP)实现异构集成芯未来 |
亚智系统科技(苏州)有限公司Manz亚智科技事业开发部副总经理 简伟铨 Adam |
|
11:15-11:40 |
Evatec先进封装基板FOPLP刻蚀和溅射方案 |
Evatec China 技术市场总监 陆原博士 |
|
11:40-12:05 |
蓝宝石晶圆在先进封装与功率半导体领域的发展与挑战 |
天通银厦新材料有限公司副总经理康森 |
|
12:05-13:00 |
中午休息 |
|
|
13:00-13:25 |
FOPLP应用工艺可靠性挑战及封装板级协同设计解决方案 |
上海艾为电子技术股份有限公司芯片封装首席专家史洪宾博士 |
|
13:25-13:50 |
高精度非接触测量机在玻璃基板以及ABF载板行业中的应用 |
Mitutoyo/三丰精密量仪(上海)有限公司 营业技术部部长 李斌 |
|
13:50-14:15 |
涂布、干燥、贴膜工艺设备于玻璃基板及扇出型封装的应用趋势与挑战 |
群翊工業副總经理李志宏 |
|
14:15-14:40 |
TGV&PLP封装中的聚合物材料以及国产化前景 |
深圳先进电子材料国际创新研究院研发工程师林志强博士 |
|
14:40-15:05 |
EDA 加速玻璃基器件设计与应用 |
芯和半导体科技(上海)股份有限公司黄晓波博士 |
|
15:05-15:30 |
议题拟定中 |
天芯互联科技有限公司器件产品线总监宋关强先生 |
|
15:30-15:55 |
玻璃基板光电合封的挑战 |
厦门云天半导体科技有限公司董事长于大全博士 |
|
15:55-16:20 |
议题更新中 |
|
加微信李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100255?ref=172672




