陶瓷封装外壳具备高气密性,高导热,高强度,与芯片材料适配的热膨胀系数等优点,广泛应用在航空航天、军事装备、地面雷达、光通信、医疗器械和传感器等有高可靠性需求的诸多行业。根据 Semiconductor Insight 最新报告数据,2022年全球陶瓷封装市场价值为29.223亿美元,预计到2029年将达到41.582亿美元,复合年增长率为5.2%。

图 陶瓷四边无引线封装外壳(CQFN),摄于航科创星展台
陶瓷封装外壳主要包括具有窗口和支撑件结构的外壳围框、陶瓷馈通组件、盖板、散热底板,如图1所示。盖板设于外壳围框顶部,将外壳围框上部开口封闭;外壳围框侧墙上开设有多个窗口,在窗口内装载有陶瓷件,陶瓷件位于外壳围框外侧的一端设有焊接区,焊接区连接有引线,陶瓷件位于外壳围框内侧的一端设有可供内部封装芯片和外部电路键合的键合区,焊接区与键合区电连接;散热底板位于外壳围框底部;零部件通过预制成型焊片焊接组装在一起。部分陶瓷封装管壳产品例如红外探测器封装外壳、光通信封装外壳等设置光窗。
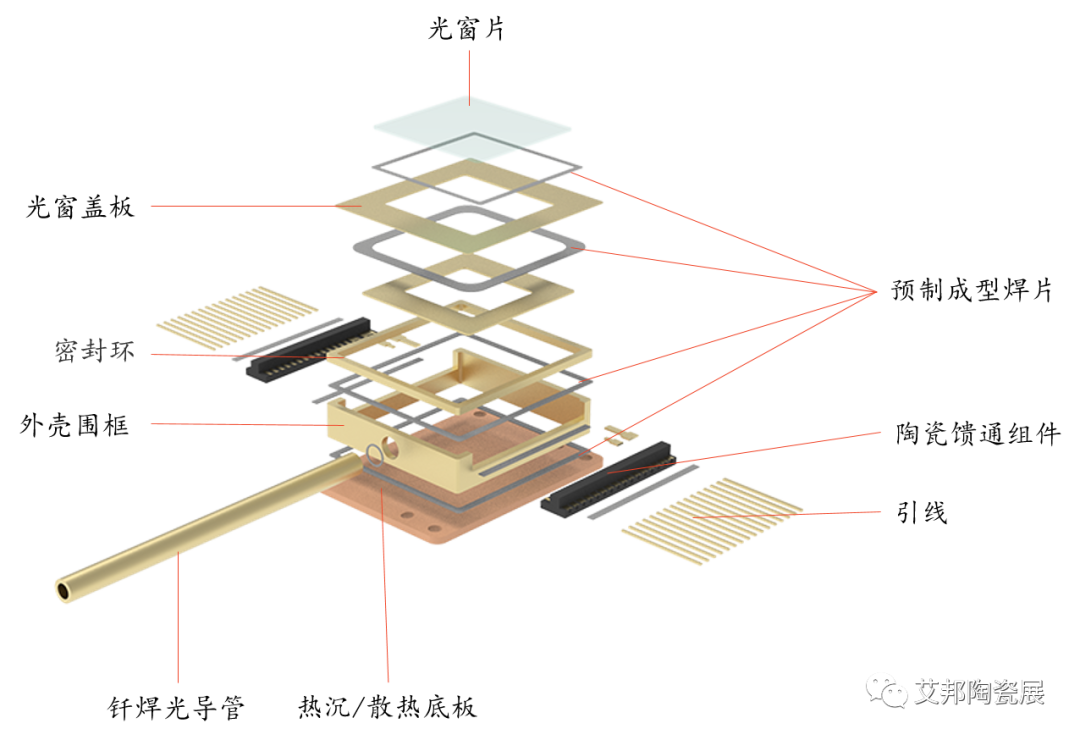
图1 非制冷型红外探测器封壳结构示意图,来源:中航天成
如图2所示,多层陶瓷封装外壳制造技术包括原材料制备、流延、冲孔冲腔、金属化印刷、层压、热切、烧结、镀镍、钎焊、镀金等技术;光通信用陶瓷封装外壳还会焊光窗。其封装过程涵盖外壳清洗、装片、清洗、引线键合、封盖、外引线处理、打标、检测等。
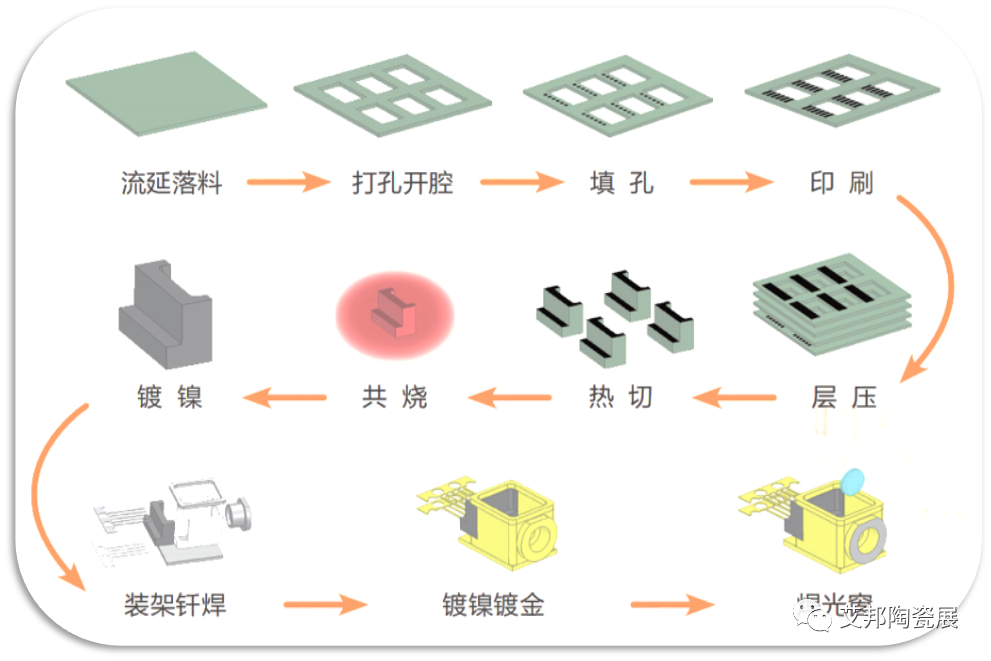 图2 陶瓷封装管壳工艺流程
图2 陶瓷封装管壳工艺流程
所涉及的原材料及耗材主要包括:
-
陶瓷材料:氧化铝、氮化铝、莫来石等材料; -
匹配的金属化浆料:钨浆、钼锰浆料等; -
金属零部件(围框、盖板等):可伐合金(铁镍钴合金)、铁镍合金等; -
接合材料:预制成型焊片(AgCu、金锡)、B-stage 粘接剂; -
封壳散热底板采用CPC、CMC、钨铜、钼铜等高散热材料,热导率最高260W/m.K。若采用铜金刚石(Cu-Dia)材料,其热导率可达580W/m.K; -
光窗:硅、锗、硒化锌、蓝宝石等材料; -
耗材:氰化亚金钾电镀液、添加剂、膜带、耐火材料等。

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
|
序 号 |
暂定议题 |
拟邀请企业 |
|
1 |
半导体陶瓷封装外壳仿真设计 |
拟邀请仿真设计专家 |
|
2 |
多层陶瓷集成电路封装外壳技术发展趋势 |
拟邀请陶瓷封装企业 |
|
3 |
光通信技术的发展及陶瓷封装外壳的应用趋势 |
拟邀请光通信企业 |
|
4 |
多层陶瓷封装外壳的生产工艺和可靠性设计 |
拟邀请陶瓷封装企业 |
|
5 |
多层陶瓷高温共烧关键技术介绍 |
拟邀请HTCC企业 |
|
6 |
电子封装用陶瓷材料研究现状 |
拟邀请材料企业 |
|
7 |
多层共烧金属化氮化铝陶瓷工艺研究 |
拟邀请氮化铝企业 |
|
8 |
HTCC陶瓷封装用电子浆料的开发 |
拟邀请导电浆料企业 |
|
9 |
多层共烧陶瓷烧结关键技术探讨 |
拟邀请烧结设备企业 |
|
10 |
陶瓷封装外壳的焊料开发 |
拟邀请焊材企业 |
|
11 |
电子封装异质材料高可靠连接研究进展 |
拟邀请陶瓷封装企业 |
|
12 |
厚膜印刷技术在陶瓷封装外壳的应用 |
拟邀请印刷相关企业 |
|
13 |
高精密叠层机应用于多层陶瓷基板 |
拟邀请叠层设备 |
|
14 |
陶瓷封装管壳表面处理工艺技术 |
拟邀请表面处理企业 |
|
15 |
激光技术在陶瓷封装管壳领域的应用 |
拟邀请激光企业 |
|
16 |
陶瓷封装钎焊工艺介绍 |
拟邀请钎焊设备企业 |
|
17 |
半导体芯片管壳封装及设备介绍 |
拟邀请封焊设备企业 |
|
18 |
全自动高速氦检漏系统在陶瓷封装领域的应用 |
拟邀请氦气检测设备企业 |
|
19 |
芯片封装壳体自动化测量方案 |
拟邀请检测设备企业 |
|
20 |
等离子清洗在高密度陶瓷封装外壳上的应用 |
拟邀请等离子清洗企业 |
更多议题征集中,演讲&赞助请联系王小姐:13714496434(同微信)
方式一:加微信

注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
原文始发于微信公众号(艾邦陶瓷展):陶瓷封装外壳的主要生产材料及设备


