名古屋大学和旭化成于12月14日宣布,已成功制造出在氮化铝(AlN)基材料中表现出理想特性的p-n结,该材料有望用作下一代半导体材料。该成果是名古屋大学未来材料与系统研究所須田淳教授、天野浩教授和旭化成联合研究小组的成果。
"超宽带隙"(UWBG)半导体的带隙(禁带宽度)比目前主要的半导体材料硅(Si)和砷化镓(GaAs)大4至5倍以上,新一代半导体材料,世界范围内的研究正变得更加活跃。如果UWBG半导体的研究得到发展,相信它将能够为更高频率的设备做出贡献,这将提高设备的通信速度,并减少功率设备的损耗,从而进一步节省能源。 然而,UWBG半导体的一个常见技术问题是难以实现作为半导体器件基础的理想p-n结。

因此,研究团队通过在高质量的AlN单晶衬底上使用化学成分(含有数%至30%的AlN的氮化镓(GaN)),开发了一种AlN基材料,它是UWBG半导体之一,通过使用一种称为分布式偏振掺杂(DPD)的方法,该方法可以在空间上改变氮化物的量(混合),研究人员旨在创建具有优异性能的基于 AlN 的 p 层和 n 层。 此外,为了实现理想的DPD,需要高质量的薄膜晶体生长技术,因此该技术的研发也同时取得进展。
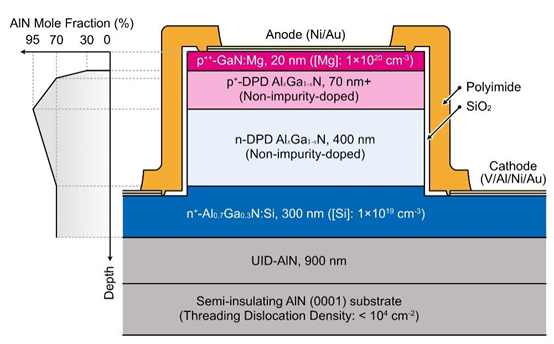
研究中,采用金属有机化合物气相外延(MOVPE)方法在高质量AlN(0001)衬底上形成未掺杂的AlN层和高浓度n型Al0.7Ga0.3N层后,逐渐增加AlN的摩尔分数(n型DPD层)、逐渐减少AlN的摩尔分数的层(p型DPD层),最后形成高浓度的p型GaN层。 然后,在顶部高浓度p型GaN层和底部高浓度n型Al0.7Ga0.3N层上形成电极,形成pn结二极管。
由此制造的AlN基p-n结由于电流注入而表现出理想的电流-电压特性、电压-电容特性和发光特性。特别是电流-电压特性显示出优异的耐高电压性。关于其高耐压特性,确定介电击穿场强为7.3MV/cm,这是AlN基p-n结介电击穿场强的世界最高测量值。这是传统Si半导体的约25倍,是具有优异介电击穿电场强度的宽带隙WBG半导体碳化硅(SiC)和GaN的约2倍。据称,AlN基p-n结的实现满足所有这些优良性能在世界上是前所未有的。此外,在本研究中,没有采取措施提高耐压,因此预计在未来的研究中将进一步提高相同的值。
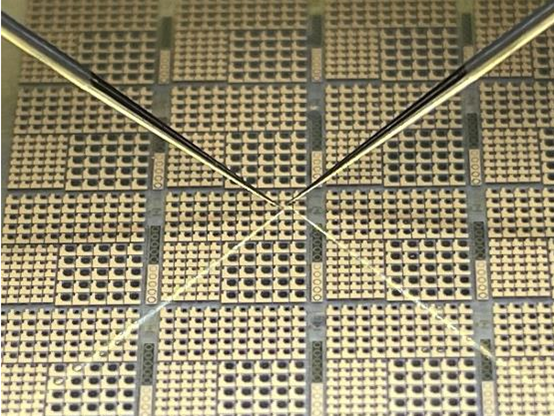
这项研究的成果是"利用高质量的AlN单晶基板基材"、"实现理想的DPD层形成的精细薄膜晶体生长技术(外延生长技术)"、"器件(pn这是通过"结型二极管(结型二极管)制造技术"的结合而实现的。 其中使用的AlN单晶基板基材是旭化成的技术,其余两项是名古屋大学与旭化成共同研究的成果。
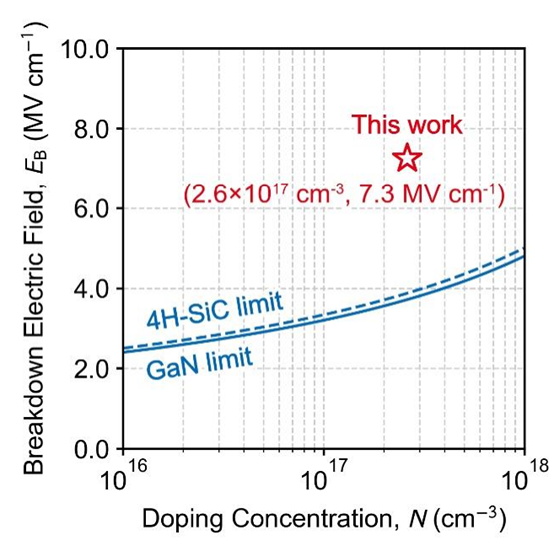
在这项研究中,实验表明,通过使用分布式极化掺杂作为杂质掺杂的替代方案,即使在 AlN 基半导体中也可以实现良好的 p-n 结。 此外,AlN材料最重要的物理性能值——介电击穿场强,经实验证明至少是传统WBG半导体的两倍。 研究小组预计,这项研究结果将刺激对AlN基材料的研究,并扩大利用DPD的各种设备的研究和开发。
一颗芯片的制造工艺非常复杂,需经过几千道工序,加工的每个阶段都面临难点。欢迎加入艾邦半导体产业微信群:

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊

