多层陶瓷外壳以其优良的性能被广泛应用于航天、航空、军事电子装备及民用电子产品的集成电路和电子元器件的封装。常用的陶瓷外壳有集成电路陶瓷外壳,如 D 型 (DIP )、F (FP )、G 型 (PGA )、Q 型 (QFP )、C 型 (LCC )、BGA 型等;混合集成电路陶瓷外壳;光电器件陶瓷外壳;微波器件陶瓷外壳;声表面波器件陶瓷外壳;晶体振荡器陶瓷外壳;固体继电器 陶瓷外壳及各种传感器(如霍尔传感器)用陶瓷外壳等等。
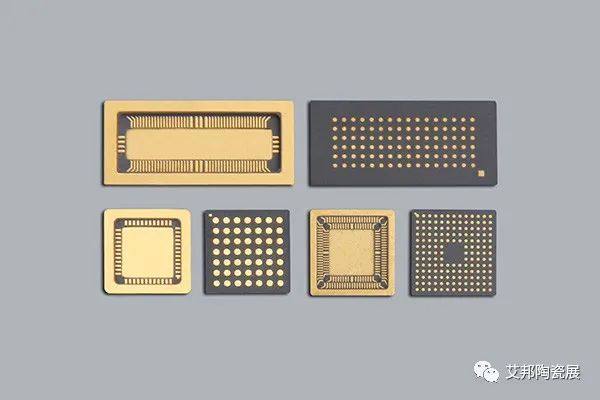
图 CQFP,图源宜兴电子器件总厂
多层陶瓷外壳采用多层陶瓷金属化共烧工艺进行生产。多层陶瓷外壳分为高温共烧陶瓷外壳(HTCC)和低温共烧陶瓷外壳(LTCC)两类。多层陶瓷外壳由于其体积小、导热性好、密封性好、机械强度高,因其封装可靠性高而得到广泛应用。但是,在使用中仍然会出现失效。本文就HTCC高温共烧多层陶瓷外壳的失效模式、失效机理进行分析介绍。艾邦建有陶瓷封装全产业链微信群,欢迎陶瓷封装产业链上下游扫码加群与我们交流。

一、多层陶瓷外壳的失效模式
多层陶瓷外壳在生产和使用中出现的失效模式通常有以下几种:
(1)在机械试验中出现陶瓷底座断裂失效;
(2)在使用中出现绝缘电阻小于标准规定值,出现失效;
(3)在使用中外壳出现断、短路失效;
(4)在使用中出现外壳外引线脱落,或无引线外壳的引出端焊盘与外电路连接失效;
(5)使用中出现电镀层锈蚀失效;
(6)使用中出现密封失效;
(7)键合和芯片剪切失效;
(8)使用不当造成失效。
二、多层陶瓷外壳的失效机理分析
1、陶瓷底座的断裂失效
其主要失效机理如下:
(1)由于所采用的陶瓷材料的抗弯强度不足;
(2)在生产过程中偏离了规定的工艺参数。例如:层压中未将各层生陶瓷片压成一个整体,降低了陶瓷底座的机械强度;在烧结过程中,由于烧结温度过高或过低而造成陶瓷底座过烧或生烧,从而降低了陶瓷底座的机械强 度所致;
(3)由于结构设计错误,在设计外壳底座的底板时,底板取值太小,使底板 过薄。因此,产品在机械试验时,造成外壳芯腔部位应力集中,从而出现 外壳底座断裂失效。
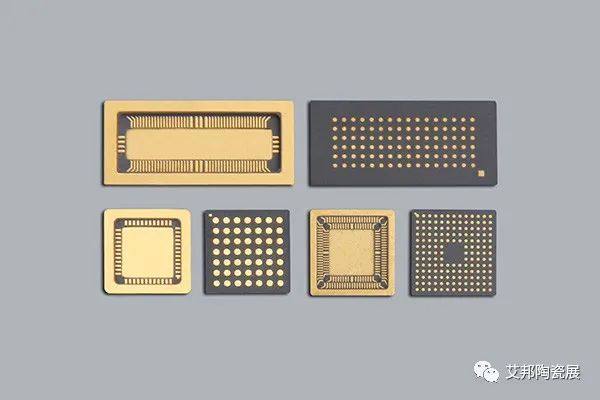
图 CLGA封装,图源宜兴电子器件总厂
2、绝缘电阻失效
其主要失效机理如下:
(1)所采用的陶瓷材料的体积电阻率和绝缘强度不够,使产品的绝缘电阻达不到标准规定的要求;
(2)在印刷生产过程中,偏离了规定的工艺参数,例如金属浆的黏度不符合规定或印刷机的工艺参数不对,使印刷线条之间发生短路或接近短路,导致绝缘电阻失效;
(3)在印刷生产过程中,由于操作者不注意工艺卫生,造成印刷线条之间发生短路或接近短路,导致绝缘电阻失效;
(4)在电镀后的清洗过程中,由于未充分清洗干净,残留的镀液电介质导致绝缘电阻值下降,导致绝缘电阻失效。
3、断、短路失效
1)有引线外壳的断、短路失效
(1)层间互连失效造成了外壳的断路失效:例如:互连孔金属化填料不足,层压时工艺参数不符合规定,形成分层现象,造成上下层之间不能连接,造成层间互连断路失效;
(2)印刷金属化线路时,线间短路,引起了外壳短路失效。例如:金属浆的黏度不符合规定或印刷机的工艺参数不对;操作者不注意工艺卫生,造成 印刷线条之间发生短路,从而引起了外壳短路失效。
2)无引线外壳的断、短路失效
(1)在平面印刷时,印刷线路与引出端通孔连接断路;在引出端通孔孔壁金属化时,引出端通孔内壁挂浆不连续;在印刷底面引出端焊盘时,焊盘未与引出端通孔的金属浆连接;在层压时,由于层压工艺参数控制不当,使引出端通孔内分层使引出端通孔金属化产生断裂,因而造成了外壳的断路失效。
(2)印刷金属化线路时,线间短路,引起了外壳短路失效。
4、外引线脱落失效或无引线外壳的引出端焊盘与外电路连接失效
1)有引线外壳的外引线脱落失效
(1)钎焊引线的金属化焊盘的金属化强度不够,而造成这一问题的原因:
①金属化配方本身的金属化强度低,
②金属化层的厚度偏薄造成金属化强度低,
③外壳陶瓷底座在烧结时温度过高或过低造成金属化强度低;
(2)陶瓷底座在钎焊前进行化学镀镍时,镀镍层偏薄,使焊料与金属化焊盘的浸润性差,导致引线的抗拉强度差;
(3)钎焊工艺不符合要求,造成这一问题的原因:
①钎焊装配模具不符合要求使引线的装配偏离焊盘或未与焊盘接触到位,
②钎焊温度过高造成焊料流失或温度过低焊料熔融不够,这些问题均会造成外引线的抗拉强度差;
(4)钎焊引线的焊料量不足,造成引线不能与焊盘完全钎焊好,降低了外引线的抗拉强度。
2)无引线外壳的引出端焊盘与外电路连接失效
(1)引出端金属化焊盘的金属化强度不够,而造成这一问题的原因:
①金属化配方本身的金属化强度低,
②金属化层的厚度偏薄造成金属化强度低,
③外壳陶瓷底座在烧结时温度过高或过低造成金属化强度低;
(2)在电镀中,由于镀金和镀镍层偏薄,使用户在钎焊时,金和镍很快与焊料熔为合金,导致焊料与金属化焊盘的浸润性差,从而使焊盘与外电路连 接失效。
5、电镀层锈蚀失效
其主要失效机理如下:
(1)电镀配方选择不当或所用化学药品质量差,使镀液的杂质含量高,造成 镀层内的杂质含量高,镀层的孔隙率高,抗腐蚀能力差;
(2)电镀工艺或工艺控制不当,造成镀层孔隙率高或镀层的均匀性差,造成 电镀层失效;
(3)电镀用纯水质量差,造成镀液中杂质含量高或清洗不干净,使电镀层质量及表面质量差,造成了电镀层失效;
(4)镀层厚度设计不合理,使镀镍层和镀金层的抗腐蚀能力差、可焊性差、可键合性不好,造成电镀层失效。
6、密封性失效
其主要失效机理如下:
(1)布线印刷时,金属浆厚度太厚,层压时金属浆两边不能压密实,内引线两边漏气,造成密封失效;
(2)层压前印刷好的生陶瓷片太干,使正常的层压工艺不能将产品压成一个密实的整体,层间漏气,从而造成密封失效;
(3)层压工艺参数控制不当,使产品不能压成一个密实的整体,形成层间漏气,从而造成密封失效;
(4)由于封接环表面平整度差,在采用焊料封盖时焊料不足以填满焊缝造成漏气,电镀质量差,焊料与封接环浸润性差造成漏气;
(5)平行缝焊用盖板采用的材料厚度不当、退火工艺控制不好、电镀工艺控制不当,从而造成用户平封时,采用正常的平封工艺封盖时发生密封失效。
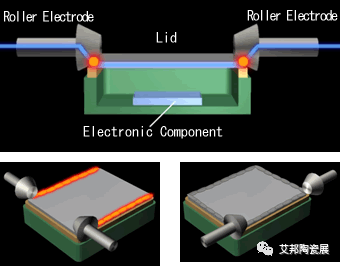
图 平行缝焊
7、键合和芯片剪切失效
其主要失效机理如下:
(1)由于金属化强度低,在键合时,金属化层受到破坏,导致键合点剥离失效;其次,由于内引线和腔底的金属化表面平整度差,导致键合和芯片粘结强度差,引起失效;
(2)由于外壳在电镀时,镀层厚度偏薄或镀层的均匀性差,使键合强度和芯片粘结强度差,造成键合和芯片剪切失效;
(3)由于用户在使用中,键合工艺参数不当,造成键合失效;在芯片粘结时,焊料选用不当或粘结工艺参数不当造成芯片粘结强度差,造成失效。
8、使用不当造成失效
其主要失效机理为:用户在使用过程中,由于对外壳的性能及使用要求了解不够,在储存、使用过程中工艺控制不当;在检测、试验过程中,方法不当,对外壳造成破坏性失效。例如:在使用过程中,直接用手接触外壳,手上的油污沾染在外壳上,从而造成绝缘电阻、镀层等失效;在试验过程中,由于使用的夹具不当,造成外壳机械强度失效等等。
多层陶瓷外壳的主要失效模式有以下几种:陶瓷底座断裂失效,绝缘电阻失效,断、短路失效,外引线脱落失效,电镀层锈蚀失效,密封失效,键合和芯片剪切失效和使用不当失效,根据其失效机理,在外壳的制造和使用过程中采取措施,以防止多层陶瓷外壳失效的发生。
文章来源:汤纪南.多层陶瓷外壳的失效分析和可靠性设计[J].电子与封装, 2006,6(10):22-26.

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
推荐活动:【邀请函】第七届陶瓷封装产业论坛(11月30日·苏州)
苏州汇融广场假日酒店
(虎丘区城际路21号 近高铁苏州新区站)
| 时间安排 | 议题 | 演讲单位 |
| 08:45-09:00 | 开场致辞 | 艾邦创始人 江耀贵 |
| 09:00-09:30 | 多层陶瓷高温共烧关键技术介绍 | 佳利电子 副总 胡元云 |
| 09:30-10:00 | 氮化铝HTCC封装材料现状及技术发展趋势 | 中电科43所/合肥圣达 研究员 张浩 |
| 10:00-10:30 | 茶 歇 | |
| 10:30-11:00 | 三维电镀陶瓷基板(3DPC)及其封装应用 | 华中科技大学/武汉利之达 教授/创始人 陈明祥 |
| 11:00-11:30 | HTCC氢氮气氛烧结窑炉 | 北京中础窑炉 副总经理 付威 |
| 11:30-12:00 | 多层共烧陶瓷的增材制造技术 | 中南大学 教授 王小锋 |
| 12:00-13:30 | 午 餐 | |
| 13:30-14:00 | 微波大功率封装外壳技术发展 | 中电科55所 研究员 庞学满 |
| 14:00-14:30 | HTCC陶瓷封装用配套电子材料的匹配性问题研究 | 泓湃科技 CEO 陈立桥 |
| 14:30-15:00 | 芯片管壳等温空腔封装 | 佛大华康 总经理 刘荣富 |
| 15:00-15:30 | 高速高精度HTCC全工艺流程视觉检测应用介绍 | 深圳禾思 CEO 杨泽霖 |
| 15:30-16:00 | 精密激光在LTCC/HTCC加工中的关键技术及发展趋势 | 德中技术 战略发展与市场总监 张卓 |
| 16:00-16:30 | 茶 歇 | |
| 16:30-17:00 | 多层陶瓷封装外壳的生产工艺和可靠性设计 | 宏科电子 副厂长 康建宏 |
| 17:00-17:30 | 低温共烧LTCC和高温共烧HTCC烧结中的关键因素 | 苏州阿尔赛 总经理 王笏平 |
| 17:30-18:00 | 多层共烧陶瓷生产线装备与系统 | 中电科2所 高级专家 郎新星 |
| 18:00-18:30 | PVD技术在封装用陶瓷基板上的应用 | 中国科技大学 教授 谢斌 |
| 18:30-19:00 | 高温共烧陶瓷(HTCC)封装与系统集成 | 福州大学 副教授 韩国强 |
| 19:00-20:30 | 晚 宴 | |

赞助及支持企业

方式一:加微信

邮箱:lirongrong@aibang.com
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名

原文始发于微信公众号(艾邦陶瓷展):高温共烧多层陶瓷外壳的失效机理分析

