
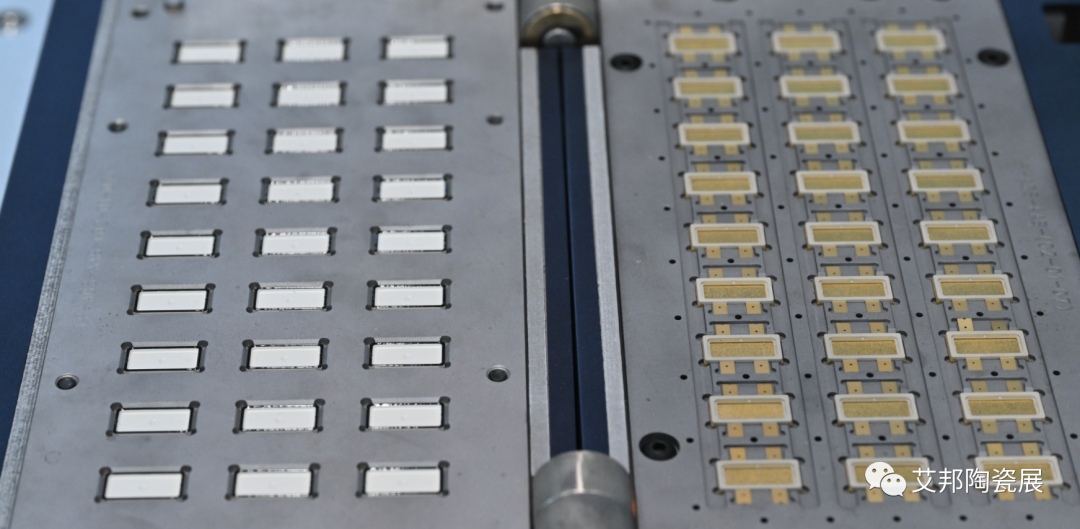
1、环氧胶粘盖工艺技术


2、B-stage粘接工艺的特点

|
项目 |
胶水粘接 |
平行封焊 |
|
工艺路线 |
组装——烘烤固化 |
组装——焊接 |
|
设备投入 |
上盖机 |
平行封焊机 |
|
材料表面处理 |
无 |
需金属化 |
|
UPH |
高,大批量一同固化 |
低,需逐个封焊 |
|
工艺窗口 |
大 |
工艺、材料对气密性影响大 |
|
最大持续工作温度 |
200℃ |
低于金属件熔点即可 |
|
二次返工 |
对粘接面要求较低,容易返修 |
返修质量难以控制 |
|
材质要求 |
可实现不同材质件的粘接 |
仅限于金属件 |
|
抗振性 |
较好,胶水可充当缓冲层 |
一般,振动可能会导致焊接位置出现应力和松动 |
|
气密性 |
≤5×10-8Pa·m³/s |
≤1.3×10-9Pa·m³/s |
|
综合成本 |
低 |
高 |

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
|
序 号 |
暂定议题 |
拟邀请企业 |
|
1 |
半导体陶瓷封装外壳仿真设计 |
拟邀请仿真设计专家 |
|
2 |
多层陶瓷集成电路封装外壳技术发展趋势 |
拟邀请陶瓷封装企业 |
|
3 |
光通信技术的发展及陶瓷封装外壳的应用趋势 |
拟邀请光通信企业 |
|
4 |
多层陶瓷封装外壳的生产工艺和可靠性设计 |
拟邀请陶瓷封装企业 |
|
5 |
多层陶瓷高温共烧关键技术介绍 |
拟邀请HTCC企业 |
|
6 |
电子封装用陶瓷材料研究现状 |
拟邀请材料企业 |
|
7 |
多层共烧金属化氮化铝陶瓷工艺研究 |
拟邀请氮化铝企业 |
|
8 |
HTCC陶瓷封装用电子浆料的开发 |
拟邀请导电浆料企业 |
|
9 |
多层共烧陶瓷烧结关键技术探讨 |
拟邀请烧结设备企业 |
|
10 |
陶瓷封装外壳的焊料开发 |
拟邀请焊材企业 |
|
11 |
电子封装异质材料高可靠连接研究进展 |
拟邀请陶瓷封装企业 |
|
12 |
厚膜印刷技术在陶瓷封装外壳的应用 |
拟邀请印刷相关企业 |
|
13 |
高精密叠层机应用于多层陶瓷基板 |
拟邀请叠层设备 |
|
14 |
陶瓷封装管壳表面处理工艺技术 |
拟邀请表面处理企业 |
|
15 |
激光技术在陶瓷封装管壳领域的应用 |
拟邀请激光企业 |
|
16 |
陶瓷封装钎焊工艺介绍 |
拟邀请钎焊设备企业 |
|
17 |
半导体芯片管壳封装及设备介绍 |
拟邀请封焊设备企业 |
|
18 |
全自动高速氦检漏系统在陶瓷封装领域的应用 |
拟邀请氦气检测设备企业 |
|
19 |
芯片封装壳体自动化测量方案 |
拟邀请检测设备企业 |
|
20 |
等离子清洗在高密度陶瓷封装外壳上的应用 |
拟邀请等离子清洗企业 |
更多议题征集中,演讲&赞助请联系王小姐:13714496434(同微信)
方式一:加微信

邮箱:wanghuiying@aibang.com
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100179?ref=196271
原文始发于微信公众号(艾邦陶瓷展):B-stage 粘接工艺在管壳封装中的应用


