封装工艺流程 一般可以分为两个部分,用塑料封装之前的工艺步骤成为前段操作,在成型之后的工艺步骤成为后段操作。基本工艺流程包括:硅片减薄、硅片切割、芯片贴装、成型技术、去飞边毛刺、切筋成型、上焊锡打码等工序,下面就具体到每一个步骤:
一、前段:
背面减薄(back grinding):刚出场的圆镜(wafer)进行背面减薄,达到封装需要的厚度。在背面磨片时,要在正面粘贴胶带来保护电路区域。研磨之后,去除胶带。
圆镜切割(wafer Saw):将圆镜粘贴在蓝膜上,再将圆镜切割成一个个独立的Dice,再对Dice进行清洗。
光检查:检查是否出现废品
芯片粘接(Die Attach):芯片粘接,银浆固化(防止氧化),引线焊接。
二、后段:
注塑:防止外部冲击,用EMC(塑封料)把产品封测起来,同时加热硬化。
激光打字:在产品上刻上相应的内容。例如:生产日期、批次等等。
高温固化:保护IC内部结构,消除内部应力。
去溢料:修剪边角。
电镀:提高导电性能,增强可焊接性。
切片成型检查废品。
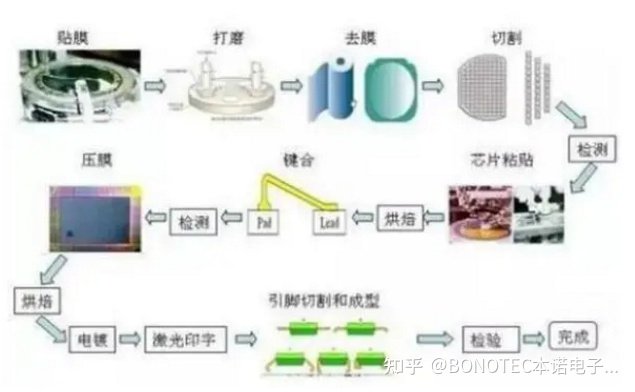
这就是一个完整芯片封测的过程。芯片封测技术我国已经走在世界前列,这为我们大力发展芯片提供了良好的基础。
未来几年,芯片行业的整体增速将维持在30%以上。这是一个非常可观的增速,意味着行业规模不到3年就将翻一番。如此高速的增长,芯片行业3大细分领域——设计、制造、封装与测试(简称“封测”)均将受益。相信在国人的努力下,我们的设计和制造水平也会有一天能够走向世界,引领时代。
来源:本文来源于网络 , 如果有任何异议,欢迎联系本诺电子材料,手机微信同号:17701718841,谢谢!
上海本诺电子材料有限公司是一家专注于胶粘剂方案的研发、生产、销售、服务的高新企业,在半导体封装测试、LED、CMOS、光纤通讯、LCD、智能卡、电池等领域批量应用服务于市场。详细产品资料及应用请联系我司销售,联系电话:021-52272688。
原文始发于:芯片封测的流程


