在我们生活中的某些时刻,我们可能曾不慎掉落过水杯,或是碰倒过一件玻璃吹制的小摆件,只能眼睁睁看着它们摔得粉碎。从小我们就知道玻璃质地易碎。然而,如果玻璃如此易碎,为何制造商还要采用玻璃芯基板呢?
这是个很好的问题,而且答案已然明确。
玻璃能够满足先进逻辑节点和先进封装所要求的、更为密集的互连线间距新规格——1.5µm及以下。其次,相较于有机基板,玻璃芯更适用于大尺寸封装(见图 1)。与半导体行业之外的人们可能的认知不同,玻璃基板相较于有机基板,具备更出色的机械强度。
就当前情况而言,有机基板在先进封装领域仍将具有一定的应用价值。但在不久的将来,玻璃基板可能会成为高性能应用的首选基板(见图 1)。

图 1:有机与玻璃芯基板发展路线图
玻璃通孔(TGV)是贯穿玻璃基板的关键垂直电气连接结构,其加工需要极高的精度。遗憾的是,每一个加工步骤都可能使工艺产生诸多潜在缺陷。尤其是裂纹问题,影响极大。在工艺初期出现的微小裂纹,有可能在后续制造过程中发展成为更大的、具有严重破坏性的缺陷,进而影响最终产品的性能与可靠性。
然而,这些挑战并非仅局限于裂纹。TGV 的位置精度对于确保玻璃基板正反两面之间可靠的电气连接至关重要。即使是极其细微的偏差,也可能引发信号完整性问题,甚至导致器件失效。此外,通孔的形状与尺寸也是需要重点关注的方面。因此,这些通孔的关键尺寸(CD)必须得到严格控制。TGV 的顶部、底部以及腰部直径之间的关系,决定了通孔的锥角和轮廓形状。如果侧壁过于陡峭或呈内凹状(底部更窄),就会影响电镀工艺,导致通孔金属填充不完全或出现空洞,进而影响最终器件的电气信号性能与可靠性。
随着玻璃芯基板的应用日益广泛,TGV 工艺正迅速发展,整个工艺过程中的工艺控制面临诸多挑战。合理的工艺控制涵盖多个方面,包括确保原材料裸玻璃的洁净度、确定玻璃的厚度均匀性,以及在从激光改性、化学蚀刻到金属填充的每一步工艺之后,对关键尺寸进行测量。对这些环节的精准把控,对于维持最终产品的质量完整性以及提高良品率至关重要。
在本篇文章,我们将深入探讨如何综合运用计量工具、检测工具以及软件分析技术,来助力 TGV 工艺的开发。具体内容将从裸玻璃的检测入手,接着探讨玻璃厚度的测量方法,最后聚焦于通孔关键尺寸的测量。
裸玻璃、玻璃厚度与关键尺寸在 TGV 制造工艺正式启动之前,确保玻璃面板无缺陷至关重要(见图 2)。毕竟,没有人希望在初始阶段就使用存在夹杂物缺陷或裂纹的面板。借助基于激光的扫描成像光学技术与传感技术,制造商能够可靠地检测裸玻璃上纳米级别的缺陷,如颗粒、划痕、凹坑以及污渍等。
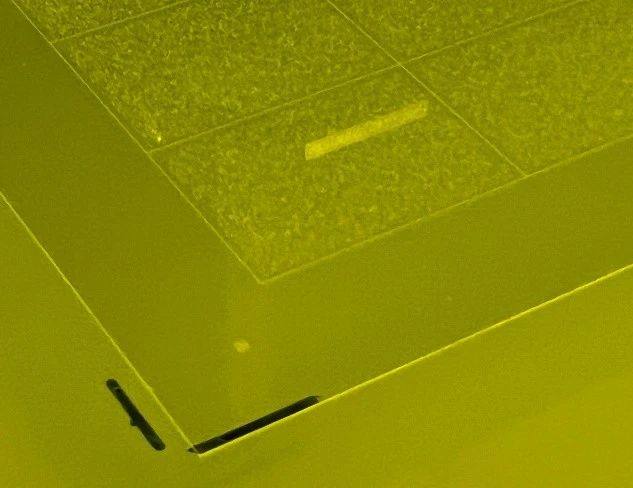
图 2:带有 TGV 的玻璃面板
在开启 TGV 工艺之前,测量玻璃的厚度同样不可或缺。玻璃面板的厚度均匀性是关键因素。以一个极端情况为例:假设一块玻璃面板一端的厚度为 400 µm,而另一端为 300 µm。虽然这只是一个极端示例,但不难想象,这种厚度差异会对整个面板上的 TGV 高度产生影响,进而给采用该玻璃基板制造的任何器件的性能带来严重后果。
尽管在制造工艺开始前对玻璃进行检测以及测量玻璃厚度十分关键,但在整个 TGV 制造与金属化过程的多个特定工艺步骤中,关键尺寸测量与缺陷检测同样不容忽视。
在激光改性和蚀刻工艺完成后,制造商需要对通孔顶部、腰部以及底部的关键尺寸进行测量。借助高分辨率、高通量的光学面板检测与计量系统,可以对面板上每一个 TGV 的这些参数进行测量,从而实现对蚀刻工艺的精确监测。此外,能否准确检测出诸如蚀刻不完全、单个 TGV 上的微裂纹、多个 TGV 之间的较大裂纹,以及玻璃表面的凹坑和压痕等缺陷,对于工艺优化起着关键作用。
在金属化和平整化步骤中,检测系统能够持续监测诸如残留物、镀层过厚/过薄、抛光过度/不足以及表面粗糙度等缺陷,这些缺陷中的任何一种都可能影响整体的电气性能。
艾邦建有玻璃基板与TGV技术交流群,可以加强产业链的合作,促成各企业的需求对接,同时您也可以与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验,欢迎您的加入。

|
8月26号(玻璃基板TGV) |
||
|
时间 |
议题 |
演讲嘉宾 |
|
10:00-10:25 |
玻璃芯基板:新一代先进的封装技术 |
安捷利美维电子(厦门)有限责任公司技术专家黄双武教授 |
|
10:25-10:50 |
玻璃TGV金属化核心材料与技术 |
华中科技大学温州先进制造研究院研究员李运钧 |
|
10:50-11:15 |
超高端封装技术为高速运算芯片带来多方位解决方案 |
江苏芯德半导体科技股份有限公司研发副总经理张中 |
|
11:15-11:40 |
Next in Advanced Packaging: Why Glass Core Substrates is emerging |
YOLE Dr. Yik Yee |
|
11:40-12:05 |
TGV玻璃原材開發現況與展望 |
NEG 日本电气硝子 技术总监 蔡岱夆 |
|
12:05-13:00 |
中午休息 |
|
|
13:00-13:25 |
高可靠3D IS(Integrated System)集成系统与3D IC先进封装关键技术研究 |
锐杰微科技研究院院长/总经理 张龙 博士 |
|
13:25-13:50 |
基于SLE(选择性激光蚀刻)工艺的精密玻璃加工——机遇、挑战与解决方案 |
Workshop of Photonics/凌云光技术股份有限公司 (VP of Business Development and Innovation) Martynas Dagys |
|
13:50-14:15 |
TGV导电互连全湿法制备技术 |
深圳大学教授符显珠 |
|
14:15-14:40 |
磁控溅射深孔镀膜在TGV领域的应用 |
广东汇成真空科技股份有限公司项目经理吴历清 |
|
14:40-15:10 |
基于Holotomography(HT)的玻璃基板三维无损检测与良率提升策略 |
韩国Tomocube 销售经理 金泳周 |
|
15:10-15:35 |
基于微镜阵列的超高速变焦显微成像技术在TGV产业的应用 |
季华实验室特聘研究员金哲镐博士 |
|
15:35-16:00 |
TGV3.0通孔结构控制和金属化协同驱动封装新突破 |
三叠纪(广东)科技有限公司研发总监李文磊 |
|
8月27号(板级封装) |
||
|
10:00-10:25 |
光电融合先进封装技术 |
华进半导体封装先导技术研发中心有限公司副总经理刘丰满博士 |
|
10:25-10:50 |
应用于三维封装的PVD 系统 |
深圳市矩阵多元科技有限公司董事长张晓军 |
|
10:50-11:15 |
化圆为方:面板级封(PLP)实现异构集成芯未来 |
亚智系统科技(苏州)有限公司Manz亚智科技事业开发部副总经理 简伟铨 Adam |
|
11:15-11:40 |
Evatec先进封装基板FOPLP刻蚀和溅射方案 |
Evatec China 技术市场总监 陆原博士 |
|
11:40-12:05 |
蓝宝石晶圆在先进封装与功率半导体领域的发展与挑战 |
天通银厦新材料有限公司副总经理康森 |
|
12:05-13:00 |
中午休息 |
|
|
13:00-13:25 |
FOPLP应用工艺可靠性挑战及封装板级协同设计解决方案 |
上海艾为电子技术股份有限公司芯片封装首席专家史洪宾博士 |
|
13:25-13:50 |
高精度非接触测量机在玻璃基板以及ABF载板行业中的应用 |
Mitutoyo/三丰精密量仪(上海)有限公司 营业技术部部长 李斌 |
|
13:50-14:15 |
涂布、干燥、贴膜工艺设备于玻璃基板及扇出型封装的应用趋势与挑战 |
群翊工業副總经理李志宏 |
|
14:15-14:40 |
板级扇出封装在功率芯片及模组上的应用 |
深圳中科四合科技有限公司市场总监赵铁良 |
|
14:40-15:05 |
玻璃通孔电镀:单片制程平台 |
鑫巨(深圳)半导体科技有限公司CTO 马库思·郎 |
|
15:05-15:30 |
EDA 加速玻璃基器件设计与应用 |
芯和半导体科技(上海)股份有限公司黄晓波博士 |
|
15:30-15:55 |
板级封装在高功率密度集成模块上的应用研究 |
天芯互联科技有限公司器件产品线总监宋关强先生 |
|
8月28号(板级封装) |
||
|
10:00-10:25 |
面向多芯粒异构先进封装的全玻璃多层互联叠构载板技术 |
沃格集团湖北通格微沃格光电半导体SBU总经理 魏炳义 |
|
10:25-10:50 |
TGV&PLP封装中的聚合物材料以及国产化前景 |
深圳先进电子材料国际创新研究院研发工程师林志强博士 |
|
10:50-11:15 |
玻璃基板光电合封技术 |
厦门云天半导体科技有限公司高级经理伍恒 |
|
11:15-11:40 |
玻璃基板封装关键工艺研究 |
中科岛晶产品经理徐椿景 |
加微信李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

扫码添加微信,咨询会议详情
注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名

或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100255?ref=172672




