玻璃芯技术即玻璃通孔TGV;能制作极度微型化和集成度的高性能电子元器件,也可用作玻璃转接板、智能玻璃基板和微结构玻璃基板。

TGV由高品质硼硅玻璃、石英玻璃为基材,通过种子层溅射,电镀填充,CMP平坦化,RDL在布线,bump工艺引出,实现3D互联。这样就提供芯片与封装互连的低损耗输出端,以及比传统硅基转接板更低的成本。
通过工艺整合可以定制不同结构的产品,进而实现多样化功能,具有成本低,损耗低,集成高,响应快,信赖性可靠,加工灵活度大等明显优势,是新一代微电子需求的理想之选。
玻璃芯技术路线

肖特AF32,D263BF33康宁EXG石英

通孔/盲孔形成各向同性刻蚀

厚度0.3-0.7 表面Ra<10nm 通孔/盲孔 锥度<8度 孔径>30um

通孔填充 CMP工艺 表面多层布
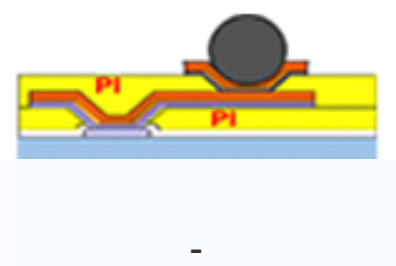
表面多层布线 Cu Pillar Solder Bump

Glass Via

Cu Via
应用领域
广泛应用于微波通信,射频前端,生物检测,激光雷达,芯片封装等。

汽车MEMS传感器

5G射频前端无源器件

主动图像与激光雷达
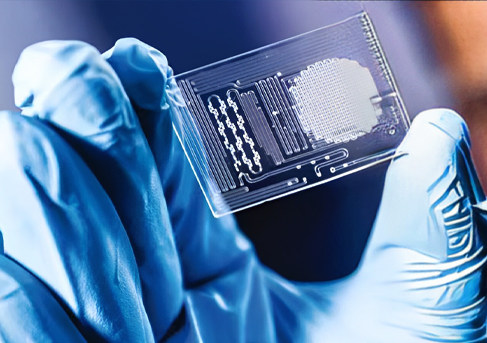
医疗微流控
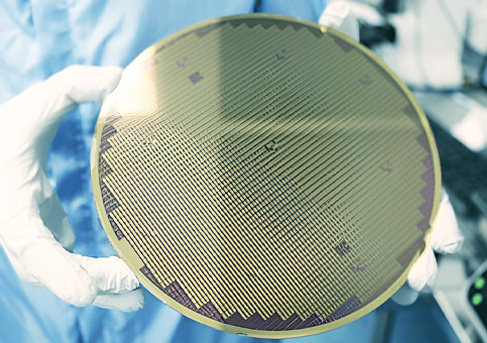
TGV MEMS WAFER

射频集成器件
森丸电子为消费电子、5G物联网通信、HPC和AI服务器、智能汽车等领域提供晶圆级无源器件、IPD射频集成方案及量产制造服务。
资料来源:森丸电子
我们诚邀您加入“玻璃基板与TGV技术交流群”,与行业精英共同探讨玻璃基板及TGV技术的前沿动态,共享资源,交流经验。在这里,您可以第一时间获取技术革新信息,深入解析行业趋势,与行业领袖面对面交流,共同推动技术革新,探索无限商机。




