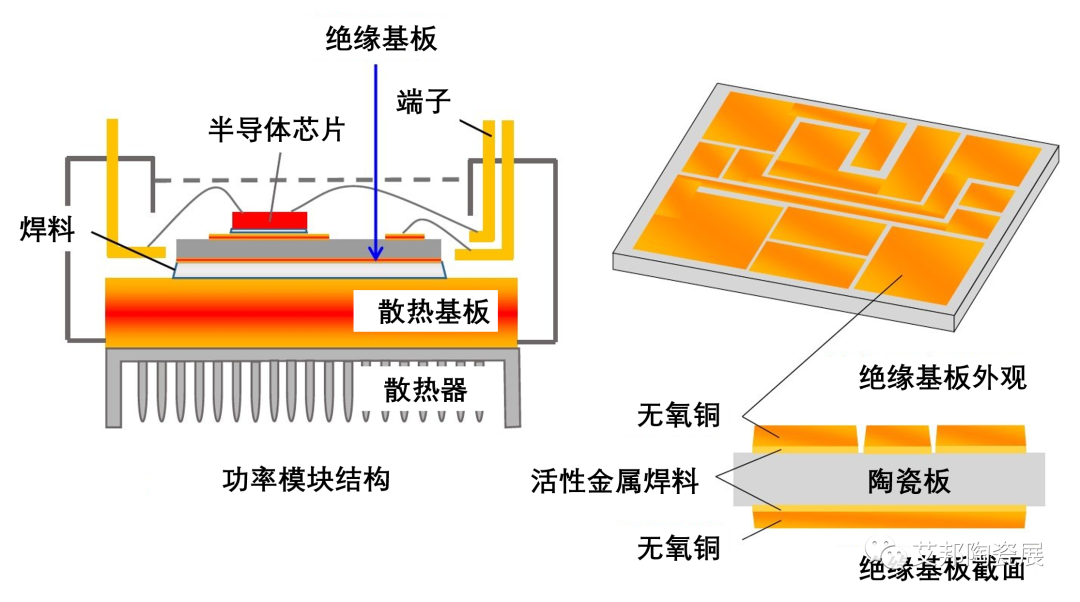
随着功率器件技术发展,与此相适应的电子封装与基板材料的开发趋势要求材料具有高纯度、低应力、低热膨胀、高热传导和高耐热性等特征。今天我们一起来了解半导体功率器件陶瓷覆铜板用铜带。
1.陶瓷覆铜板对铜带要求高
陶瓷覆铜板 AMB 和 DBC 工艺均需要无氧铜带。以 DBC 为例,DBC 工艺流程为:首先将无氧铜板贴合在陶瓷板单侧或双侧,然后在接近铜熔点的高温和含微量氧气的气氛下,使无氧铜板表面形成Cu+Cu2O 共晶熔体薄层,保温一段时间后,共晶熔体充分浸润进无氧铜板和陶瓷板中,形成两者之间的牢固结合。
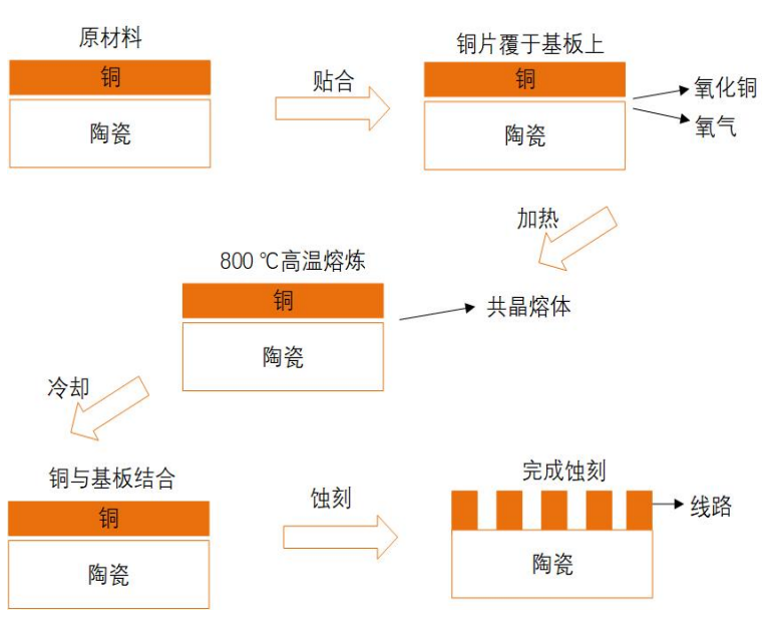
图 DBC工艺流程
普通无氧铜的耐热性较差,经高温热处理后,晶粒迅速长大,晶粒尺寸甚至可达毫米级,这将在无氧铜板与陶瓷板的结合面及其自由表面处形成“橘皮组织”,增加无氧铜板的表面粗糙度。

图 普通无氧铜的晶粒生长,来源:古河电工
一方面,结合面粗糙度的增加会加大无氧铜板与陶瓷板之间的间隙,进而导致铜/陶瓷结合强度降低甚至结合失败;
另一方面,自由表面粗糙度的增加也会给后续刻蚀、清洗、焊接等工艺带来一系列负面影响,进而导致铜/元件焊缝强度降低甚至焊接失败。
此外还存在下一工序的检查精度降低、镀膜后外观变差等问题。
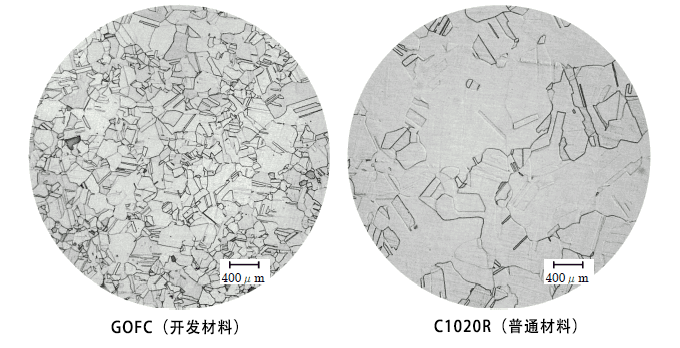
图 陶瓷覆铜板用无氧铜与普通无氧铜在形成结晶颗粒方面的对比(800℃,1H),来源:古河电工
晶粒大小将影响铜带和陶瓷的结合强度。晶粒较细,铜带与陶瓷基板结合非常紧密,有着结合力高、电阻率低的优点。因此,陶瓷覆铜板不仅对铜带表面质量、公差要求较高,同时对高温性能和晶粒度均有较高要求。为确保无氧铜带满足使用要求,制定专用生产工艺,通过材料、加工率和退火工艺控制,同时严格控制薄带板型、表面质量控制等难题,确保无氧铜带满足高温热稳定性。
2.高端无氧铜带亟需国产化
陶瓷覆铜板用无氧铜必须具有优异的耐热性,在高温下要保持细晶状态,目前高端无氧铜主要依赖国外进口。随着国内功率半导体器件行业快速发展,国内企业越来越多的关注到陶瓷覆铜板用铜带材料,并进行了开发,以解决高端无氧铜带材料的卡脖子问题。

图 无氧铜带GOFC,来源:古河电工
目前陶瓷覆铜板用铜带相关供应商有:古河电工、JX金属、金威铜业、江西铜业、中铜华中铜业、博威合金、中铝洛阳铜加工等。
原文始发于微信公众号(艾邦陶瓷展):功率半导体器件陶瓷覆铜板用无氧铜带
为加快产业上下游企业交流,艾邦建有IGBT产业链交流,欢迎识别二维码加入产业链微信群及通讯录。

长按识别二维码关注公众号,点击下方菜单栏左侧“微信群”,申请加入群聊
成员: 5306人, 热度: 153517
陶瓷 天线 通讯 终端 汽车配件 滤波器 电子陶瓷 LTCC MLCC HTCC DBC AMB DPC 厚膜基板 氧化铝粉体 氮化铝粉体 氮化硅粉体 碳化硅粉体 氧化铍粉体 粉体 生瓷带 陶瓷基板 氧化铝基板 切割机 线路板 铜材 氮化铝基板 氧化铍基板 碳化硅基板 氮化硅基板 玻璃粉 集成电路 镀膜设备 靶材 电子元件 封装 传感器 导电材料 电子浆料 划片机 稀土氧化物 耐火材料 电感 电容 电镀 电镀设备 电镀加工 代工 等离子设备 贴片 耗材 网版 自动化 烧结炉 流延机 磨抛设备 曝光显影 砂磨机 打孔机 激光设备 印刷机 包装机 叠层机 检测设备 设备配件 添加剂 薄膜 材料 粘合剂 高校研究所 清洗 二氧化钛 贸易 设备 代理 其他 LED

