在半导体行业飞速发展的今天,高带宽内存(HBM)和先进封装技术(如 COWOS)正朝着更高性能、更高密度的方向迈进。而玻璃基板,这一曾经不起眼的材料,正逐渐成为推动这些技术突破的关键力量。
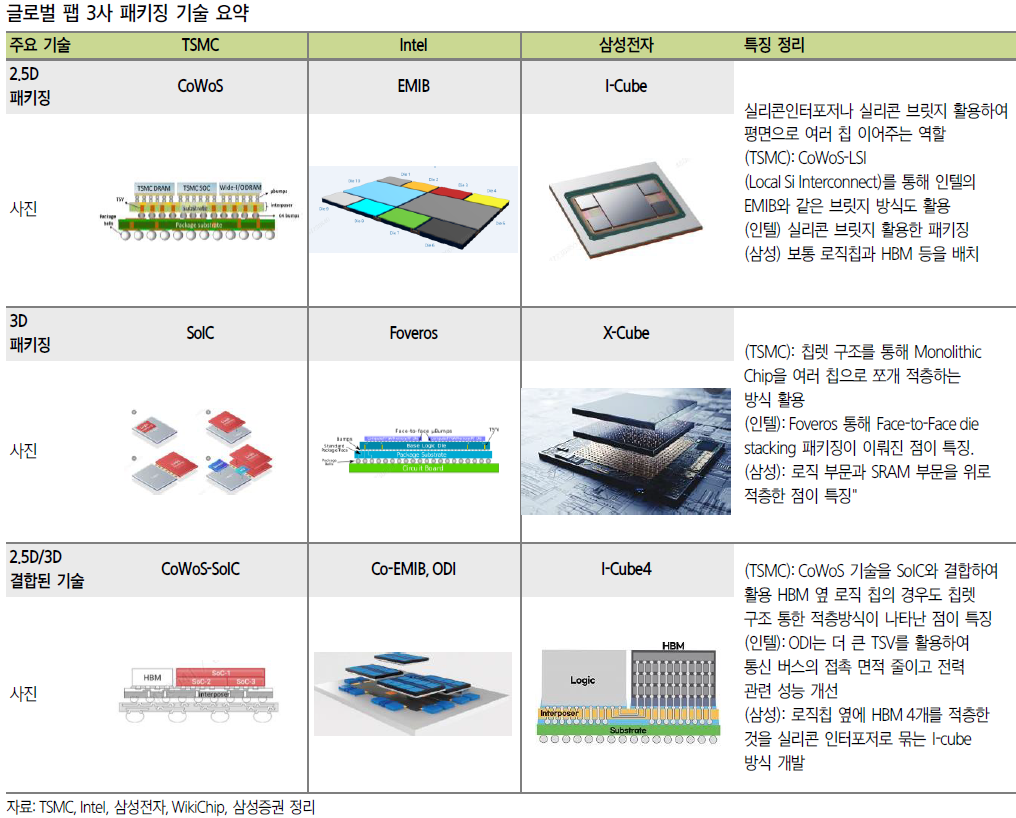
HBM 迭代:玻璃基板的 “用武之地”
目前,HBM4 预计 2026 年量产,HBM8 则可能在 2032-2035 年量产。随着 HBM 不断升级,对基板的要求也日益严苛,玻璃基板将在多个方面展现出巨大潜力。
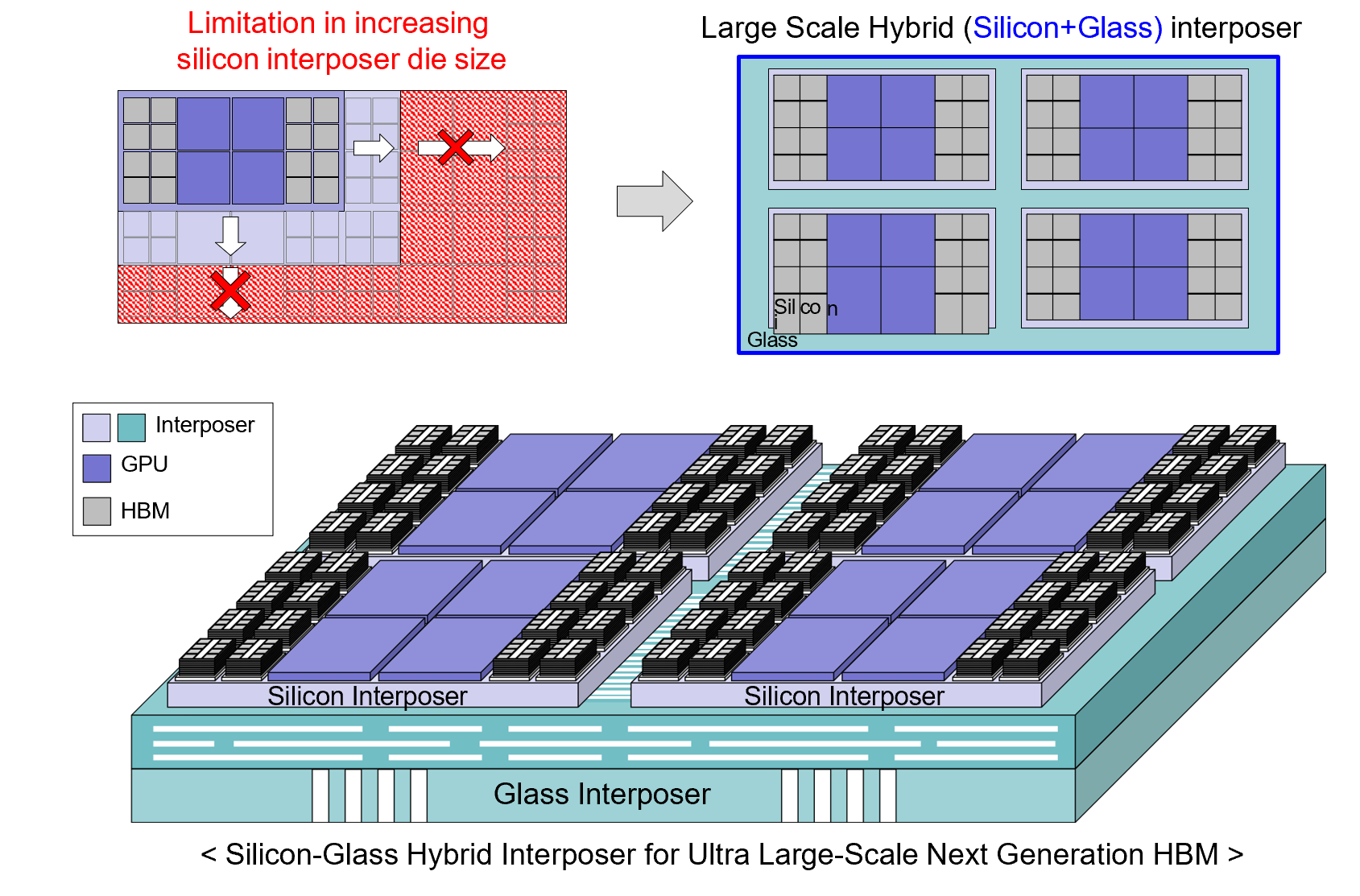
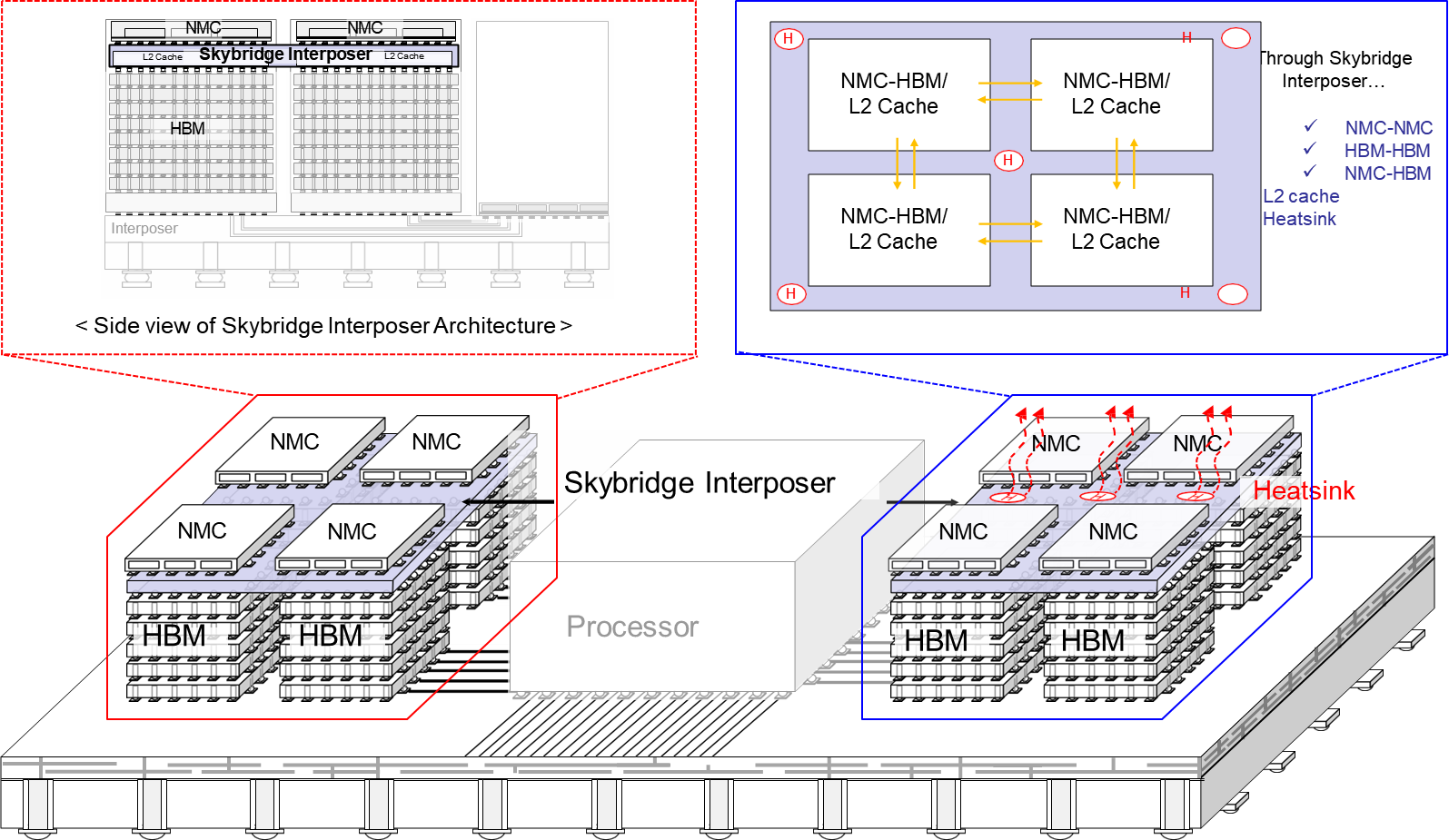
在材料性能上,玻璃基板通过成分优化,能实现低介电常数和低损耗,降低信号延迟与功耗,匹配HBM8 超过 1.5TB/s 的高带宽;同时调整成分配比,减少与硅芯片的热膨胀系数差异,提升可靠性。
工艺方面,超精密穿孔技术可实现小于 10μm 的玻璃通孔,满足高密度互连需求;表面金属化技术通过原子层沉积(ALD)或电镀铜填充TGV,则能确保低电阻和高良率。
结构设计上,玻璃基板支持 3D 异构集成,助力 HBM 与逻辑芯片紧密互连。利用其化学稳定性集成冷却通道,可应对 HBM8 可能突破 10W / 层的功耗散热挑战。
COWOS 技术:玻璃基板的 “创新舞台”

来源: KAIST
COWOS 是台积电开发的先进封装技术,玻璃基板可作为硅中介层的替代或补充方案,发挥重要作用。
相比传统基板,玻璃基板互联密度高,能实现微米级线路;热膨胀系数接近硅,减少热应力问题;平整度和尺寸稳定性优异,适合高精度加工。在 COWOS 中,它可部分替代昂贵的硅中介层,支持多层互联结构以减少信号串扰,还能通过内嵌导热材料优化散热。
当然,玻璃基板在 COWOS 应用中也面临制程工艺、通孔填充及供应链成熟度等挑战。但未来,其有望与硅中介层互补,在 3D 集成等领域大展拳脚,台积电、英特尔等巨头的布局也预示着其广阔前景。
综上,玻璃基板凭借在性能、工艺等方面的优势,正逐渐成为 HBM 和 COWOS 技术发展的重要支撑,虽目前面临一些挑战,但未来潜力无限,或将重塑先进封装生态。
海世高半导体也在积极发力,从技术研发、材料创新、产业链协同到标准化推动,为玻璃基板在HBM 领域的应用添砖加瓦。



