
在完成玻璃通孔的制备后,需要在玻璃基板表面进行布线来实现互联互通的电气连接,相对于有机衬底而言,玻璃表面的粗糙度小,所以在玻璃上可以进行高密度的布线操作。但由于半加成工艺法在线宽小于5μm的时候会面临许多挑战,例如在窄间距内刻蚀种子层容易对铜走线造成损伤且窄间距里的种子层残留易造成漏电,因此针对玻璃基板的表面高密度布线,学界和业界也有不同工艺路线的探索。
1. 线路转移(CTT)和光敏介质嵌入(PTE)
针对在玻璃表面直接进行窄距布线会造成缺陷的问题,刘富汉等人研究开发了线路转移(CTT)和光敏介质嵌入(PTE)。根据《Advances in Embedded Traces for 1.5µm RDL on 2.5D Glass Interposers》,CTT(Copper Trace Transfer,线路转移)主要包括两个过程:
1. 预制RDL线路:首先在可移动载体上单独制造一层薄导电层,通过光刻、电镀和去胶制作出RDL线路,并在转移到基板上之前测试或检查细线成品率。
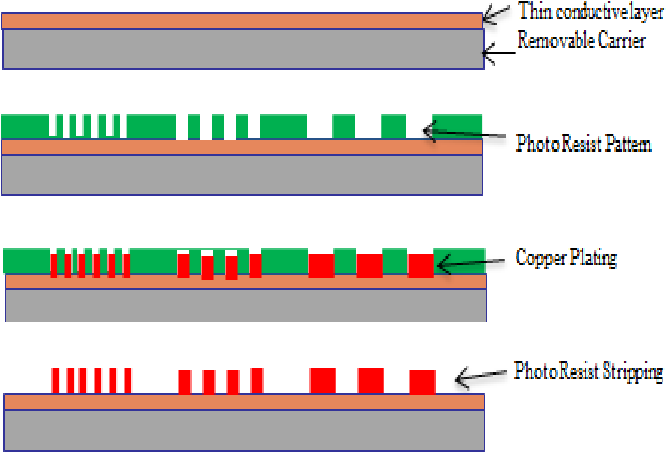
图 RDL线路预制工艺流程
2. RDL层集成:完成RDL层的制备后,先在玻璃中介层的两面利用钝化胶形成钝化层,随后使用热压合的方式将预制RDL层转移到钝化层上,最后去除载板和导电胶。
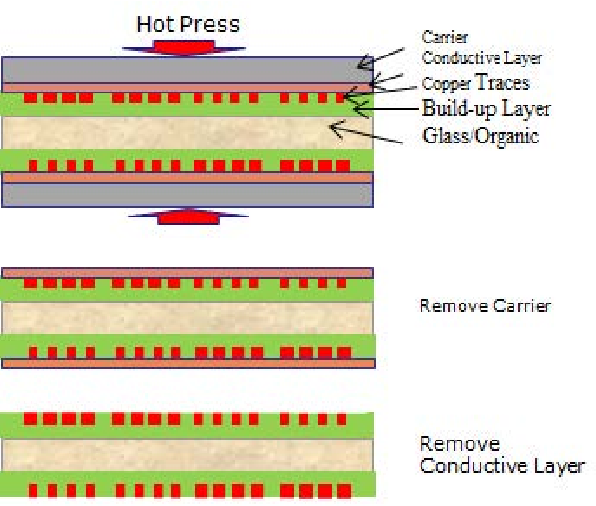
图 双面RDL集成工艺流程
PTE(Photo Trench Embedding,光敏介质嵌入)的详细工艺流程包括:1. 首先刻蚀基板下侧铜箔,并使用真空压膜机在基板上侧压合感光膜;2. 随后在光刻图案化后进行种子层沉积,采用物理气相沉积(PVD)分别沉积Ti和Cu作为阻挡层和种子层,接着采用电镀工艺填充沟槽;3. 沟槽填充完后,使用化学腐蚀剂刻蚀掉上表面的铜从而露出线路。
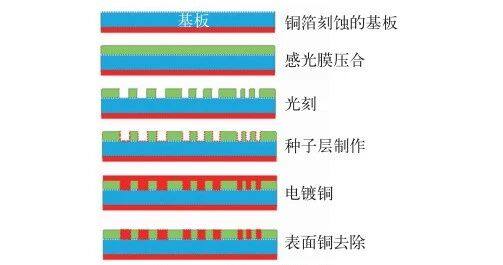
图 PTE工艺流程
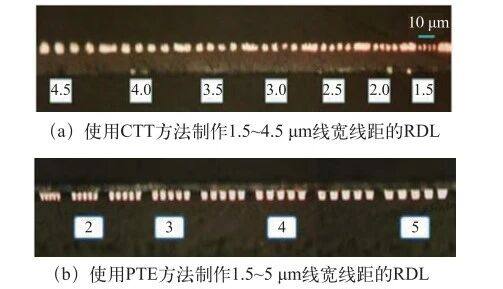
2. 多层RDL的2.5D玻璃转接板技术
在多层RDL制备领域,乔治亚理工学院的LU等研究了多层RDL的2.5D玻璃转接板技术,实现了面板级光刻后1.5~5 μm的线条沟槽制备,并提出改进式半加成工艺法(SAP)达到了5 μm以下低成本的线宽制作工艺,即用旋转金刚刀取代昂贵的CMP对层间RDL表面平坦化,进而做到低成本多层RDL堆叠。
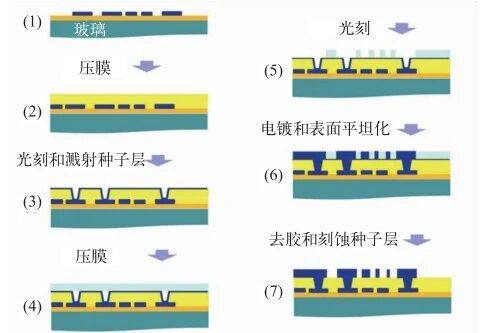
其工艺步骤包括:1. 在第一层RDL上进行压膜;2. 通过光刻和溅射制作通孔并暴露出第一层 RDL的铜焊盘,然后进行种子层溅射;3. 随后将高分辨率的光刻薄膜层压在基板,进行曝光显影来显露第二层的RDL图案;4. 随后采用电镀工艺填充通孔形成RDL线路,并用旋转金刚刀进行表面平坦化,去除光刻薄膜并完成种子层刻蚀。
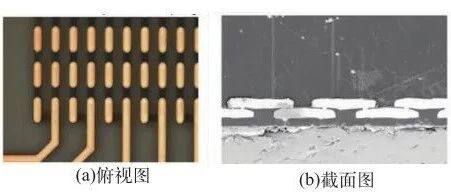
图 TGV金属化后的多层RDL堆叠结果
2.Advances in Embedded Traces for 1.5µm RDL on 2.5D Glass Interposers,Fuhan Liu 等

包括但不仅限于以下议题
| 序号 | Topic |
|---|---|
| 1 | Challenges and solutions of TGV glass core technology |
| 2 | 玻璃基板先进封装技术发展与展望 |
| 3 | 三维封装硅通孔与玻璃通孔技术发展及应用 |
| 4 | 先进封装对玻璃基板基材的要求 |
| 5 | 无机玻璃材料的本构模型、破坏机理及其在工程中的应用 |
| 6 | 玻璃基互连技术助力先进封装产业升级 |
| 7 | 真空镀膜设备在玻璃基板生产加工中的关键作用 |
| 8 | 玻璃芯板及玻璃封装基板技术 |
| 9 | 玻璃通孔结构控制、电磁特性与应用 |
| 10 | 玻璃基板及先进封装技术研究与应用 |
| 11 | 如何打造产化的玻璃基板供应链 |
| 12 | 电镀设备在玻璃基板封装中的关键作用 |
| 13 | 玻璃基FCBGA封装基板 |
| 14 | Application of microscope in semiconductor advanced packaging defect detection |
| 15 | 激光系统应用于TGV制程发展 |
| 16 | Panel level laser induced etching & AOI |
| 17 | Laser-induced deep etching technology is used to realize the processing of glass substrates with integrated multi-functional structures |
| 18 | FLEE-TGV助力先进封装玻璃基板发展 |
| 19 | 在玻璃基板上开发湿化学铜金属化工艺 |
| 20 | 异构封装中金属化互联面临的挑战 |
| 21 | 电化学沉积法制备TGV-3D互连结构 |
| 22 | 高效RDL制造技术:赋能多种互联结构的面板级封装 |
| 23 | Difficulties in the production of TGV metal lines and their technical solutions |
| 24 | 玻璃基光子解键合技术 |
| 25 | 基板积层胶膜材料 |
| 26 | 面向先进封装的磨划解决方案 |
| 27 | Application of Multi-physics Simulation Technology in Glass-based Advanced Packaging |
| 28 | Integrated passive on glass substrate |
| 29 | Design, development and application of high-performance IPD based on TGV |
| 30 | 下一代ABF载板-玻璃基及其潜在的机遇与挑战 |
| 31 | 面板级键合技术在FOPLP中的应用 |
更多相关议题征集中,演讲及赞助请联系李小姐:18823755657(同微信)
报名方式一:扫码添加微信,咨询会议详情
李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名
或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100272
阅读原文,点击报名




