2025年8月,大族半导体顺利向多家客户批量交付Panel级玻璃通孔(TGV)设备。此批交付的设备均为历经客户严苛认证的成熟机型,具有高度稳定性与可靠性,能为客户即刻投入生产、抢占技术落地先机提供关键支撑。这一里程碑式的批量交付,不仅彰显了大族半导体在先进封装领域实现关键技术自主可控的显著成就,更为我国光通信、射频模块、光电系统集成、MEMS封装、消费电子、医疗器械等众多行业提供了核心装备的有力支撑,开启了先进封装领域的全新纪元。


本批交付设备已通过国内某TOP3封装厂商层层验证,凭借卓越的性能和稳定的品质赢得了客户的高度赞誉。客户技术总监表示:“大族半导体TGV设备成功攻克了大尺寸玻璃基板加工的三大难题:深径比突破、孔壁粗糙度控制、大尺寸基板均匀性,显著提升了我们的产品良率,为下一代Chiplet封装量产扫清了障碍,让我们对未来市场前景充满信心!”
大族半导体历经多年攻坚,成功研发出新一代飞秒激光增强玻璃蚀刻技术(FLEE)。该技术能满足玻璃等透明材料在加工过程中对效率高、无应力、小尺寸、细间距、高深径比通孔加工的要求。
单次处理面积提升300%,封装成本直降40%,让企业在量产中有效降本增效;
通孔直径≤5μm,深宽比≥50:1,达到国际领先水平,确保产品的质量与性能;
适配铝硼硅、硼硅、石英等多类型材料,满足高频/高速/高散热需求;突破性支持大尺寸玻璃基板(最大尺寸达730mmx920mm);支持盲孔、通孔、圆锥孔、方孔、微槽等任意形状加工。广泛的材料兼容性和灵活的加工能力能够满足不同客户的多样化需求,成为行业内的“多面手”。
作为国内首个实现TGV工业量产的设备供应商,大族半导体已构建从技术研发到设备量产落地的完整成熟闭环,彰显了在半导体装备领域卓越的引领地位。

FLEE-TGV设备可以实现各种尺寸通孔、盲孔、异形孔、圆锥孔制备,在先进封装、显示制造、消费电子、生命科学等领域有巨大的应用潜力。
✦ 灵活的尺寸兼容性,最大可加工尺寸(730mmx920mm);
✦ 采用飞秒激光技术,高效、高品质加工;
✦ 配备高精度的监测与自动校正系统;
✦ 拥有多项自主知识产权及核心技术。
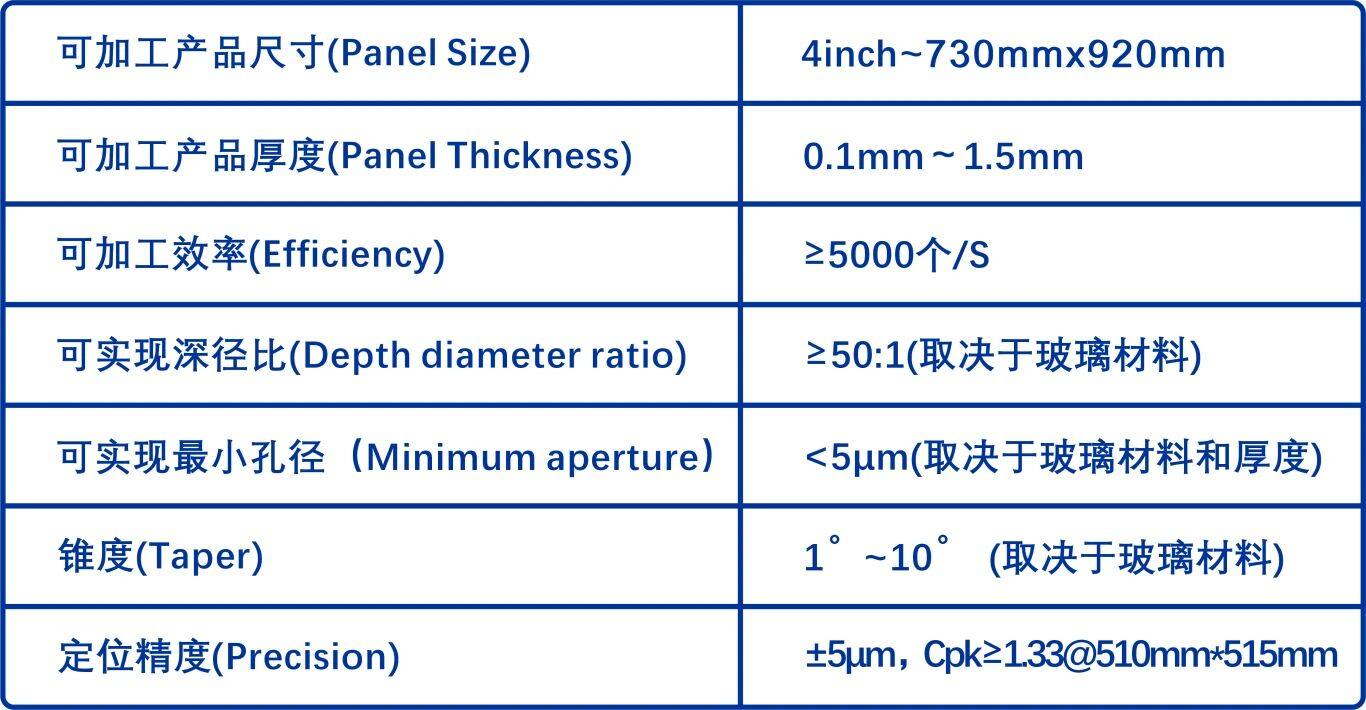

大族半导体将以此次批量交付为新的起点,持续迭代设备性能,不断探索玻璃基板与硅转接板混合集成、光互连等前沿应用。我们坚信,在大族半导体的不懈努力下,中国半导体产业必将突破“卡脖子”技术瓶颈,在“后摩尔时代”实现弯道超车,引领全球科技发展潮流!




