随着摩尔定律的发展迟缓,微电子器件的高密度化、微型化对先进封装技术提出了更高的要求。作为2.5D/3D封装中的关键技术,与硅通孔(TSV)互连相比,玻璃通孔(TGV)中介层因其具有优良的高频电学特性、 工艺简单、 成本低以及可调的热膨胀系数等优点,在2.5D/3D先进封装领域受到广泛关注。
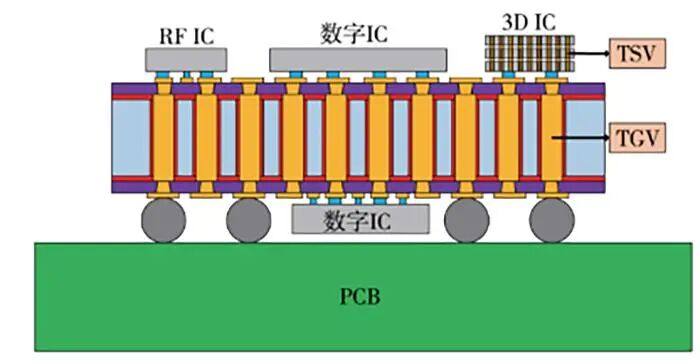
基于玻璃中介层的系统级封装示意图
一、TGV孔型
受刻蚀工艺的影响,TGV孔的形状不同,主要有以下四种类型:盲孔、垂直通孔、X型通孔以及V型通孔。
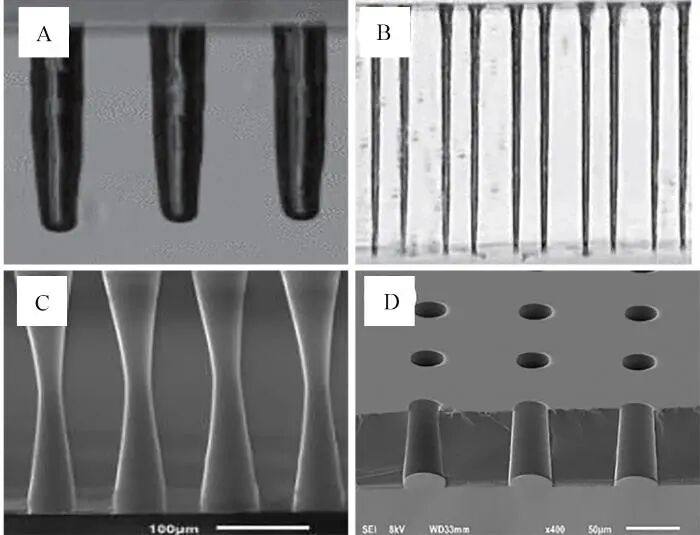
四种TGV孔型示意图:(A)盲孔;(B)垂直通孔;(C)X形通孔;(D)V形通孔
在玻璃基板TGV技术中,激光打孔的孔型主要取决于激光加工工艺和后续应用需求。玻璃基板因其脆性、绝缘性和高频性能优势,广泛应用于先进封装(如2.5D/3D IC集成)、射频器件、MEMS传感器和显示面板。不同孔型直接影响电性能、可靠性、成本和工艺复杂度。以下是主要孔型及其应用场景:
二、TGV填孔技术
为了实现TGV的无孔洞(void)、无缝隙(seam)填充,不同孔形的填充方式也不同,主要有“自下而上(bottom-up)填充”、“蝶形填充(butterfly model, BFT)”、“共形填充(conformal)”三种填充方式。
1、Bottom-up填充机理(盲孔)
目前,对于TGV盲孔的主要填充方式是bottom-up的填充。抑制剂吸附在TGV孔口侧壁及表面产生强烈的抑制作用,加速剂主要分布在盲孔底部产生加速作用。在多种添加剂的协同作用下,TGV底部铜的沉积速率高于孔口的沉积速率,从而产生“bottom-up”的填充方式,避免了填充过程中void和seam的出现。
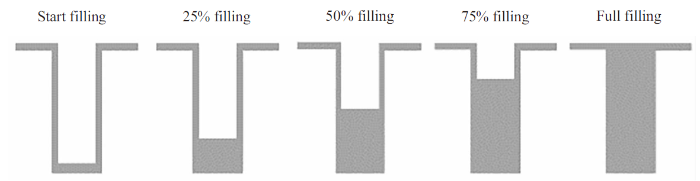
Bottom-up填充过程示意图
2、蝶形填充机制(垂直通孔)
目前,垂直TGV通孔的电镀填充方式一般为BFT填充。与盲孔填充相比,通孔填充在流体力学与质量传输方面存在明显差异。盲孔填充时,镀液在孔内很难流动,而镀液可以在通孔内部流动从而加强通孔内部的传质。且通孔与盲孔的几何形状不同,没有盲孔所谓的底部,不会产生自下而上的填充方式。由于通孔与盲孔在几何形状、流场、质量传输等方面的差异,导致用于盲孔填充的电镀配方无法直接用于通孔的电镀填充。
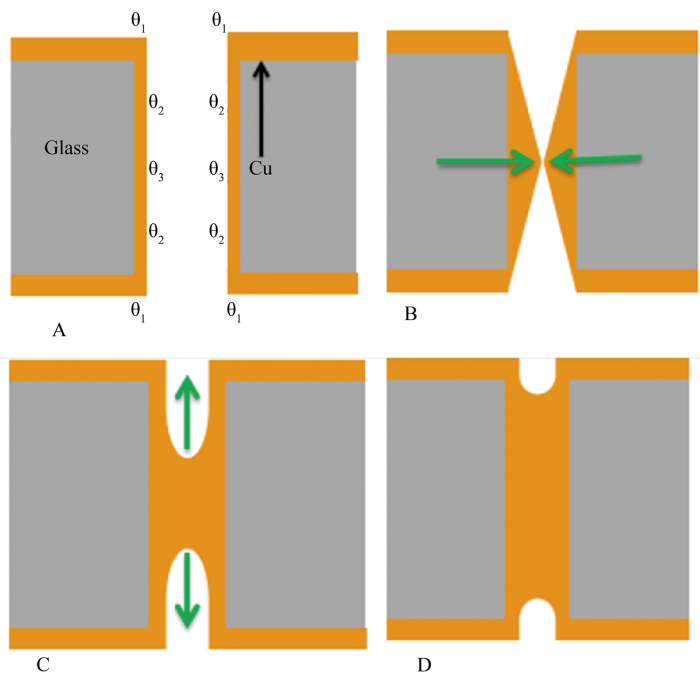
BFT填充方式示意图
3、Conformal填充机制(X形、V形通孔)
Conformal填充是通过添加剂的作用使得TGV孔内铜的沉积速率与孔的侧壁以及表面的沉积速率相当的一种电镀方式。对于垂直的盲孔与通孔,conformal填充模式下随着填充过程的进行,其深宽比不断增大,在填充的最后阶段容易出现seam缺陷。
conformal填充是X形、V形的通孔常用的填充方式,由于其自身特殊孔形的原因,从根本上避免了seam缺陷的形成。以V形孔为例,侧壁金属先以等厚的模式进行生长,一段时间后,通孔小孔率先封孔,形成类似盲孔的结构,此时加速剂在孔底促进金属的沉积,抑制剂在孔口和表面降低过电位,抑制金属的沉积速率,实现孔内金属自下而上的生长。而X形孔与V形孔相类似,首先在通孔中心产生封孔连接,然后形成两个对称的盲孔结构,紧接着通过自下而上的生长实现完整填充。相比于垂直通孔的BFT电镀模式,conformal的电镀模式由于加速剂的使用以及TGV孔形的原因,可以实现更大电流密度下通孔的完整快速填充。
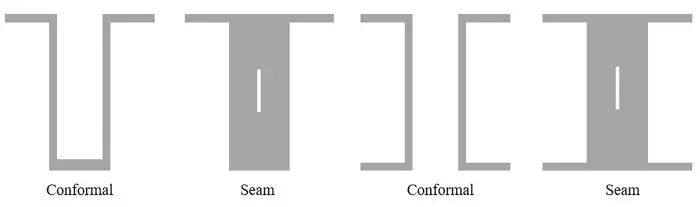
Conformal填充过程中的seam缺陷
4、TGV孔内电镀薄层
除上述3种TGV 电镀填实工艺外,TGV 也可采用通孔内电镀薄层方案实现电学连接。据《玻璃通孔技术研究进展》研究内容,在电性能方面,薄层电镀与实心电镀的插入损耗差别较小。采用薄层电镀方案的优势是在保证电学性能的同时可以有效减小电镀时间和电镀成本。通常电镀填孔需要沉积金属粘附层如钛(Ti)、铬(Cr)等,种子层 Cu,然后进行电镀,否则会出现脱落等现象。
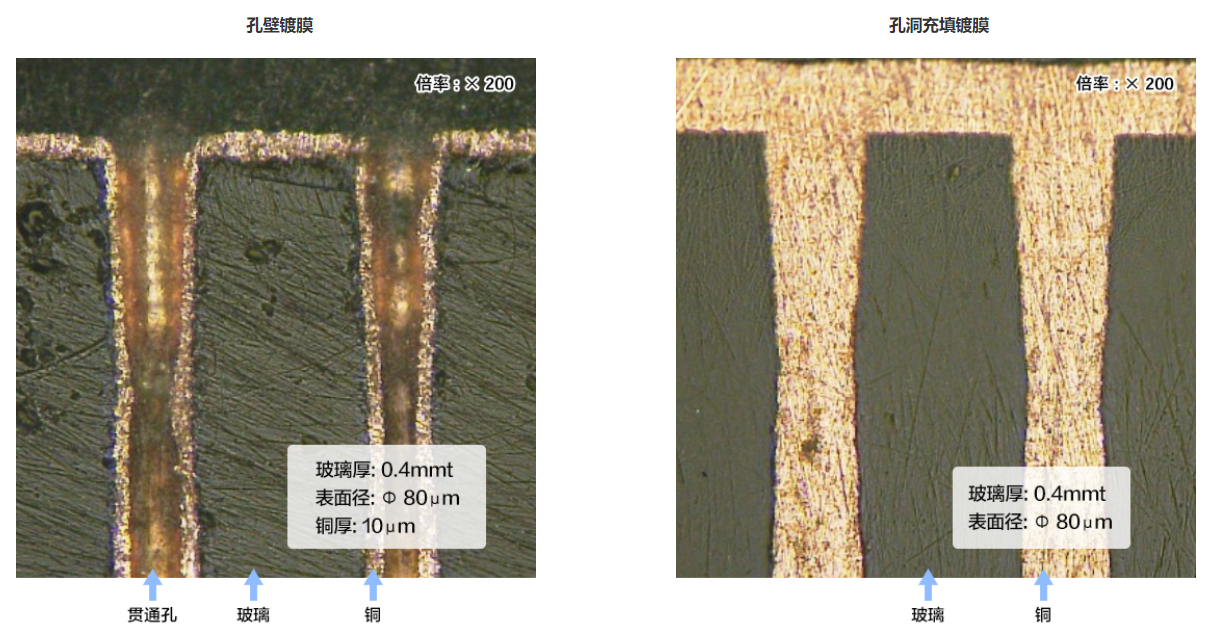
来源:NSC株式会社官网
来源:
1.玻璃通孔三维互连镀铜填充技术发展现状,纪执敬等
2.玻璃通孔技术研究进展,陈力等
3.广发证券发展研究中心

包括但不仅限于以下议题
| 序号 | Topic |
|---|---|
| 1 | Challenges and solutions of TGV glass core technology |
| 2 | 玻璃基板先进封装技术发展与展望 |
| 3 | 三维封装硅通孔与玻璃通孔技术发展及应用 |
| 4 | 先进封装对玻璃基板基材的要求 |
| 5 | 无机玻璃材料的本构模型、破坏机理及其在工程中的应用 |
| 6 | 玻璃基互连技术助力先进封装产业升级 |
| 7 | 真空镀膜设备在玻璃基板生产加工中的关键作用 |
| 8 | 玻璃芯板及玻璃封装基板技术 |
| 9 | 玻璃通孔结构控制、电磁特性与应用 |
| 10 | 玻璃基板及先进封装技术研究与应用 |
| 11 | 如何打造产化的玻璃基板供应链 |
| 12 | 电镀设备在玻璃基板封装中的关键作用 |
| 13 | 玻璃基FCBGA封装基板 |
| 14 | Application of microscope in semiconductor advanced packaging defect detection |
| 15 | 激光系统应用于TGV制程发展 |
| 16 | Panel level laser induced etching & AOI |
| 17 | Laser-induced deep etching technology is used to realize the processing of glass substrates with integrated multi-functional structures |
| 18 | FLEE-TGV助力先进封装玻璃基板发展 |
| 19 | 在玻璃基板上开发湿化学铜金属化工艺 |
| 20 | 异构封装中金属化互联面临的挑战 |
| 21 | 电化学沉积法制备TGV-3D互连结构 |
| 22 | 高效RDL制造技术:赋能多种互联结构的面板级封装 |
| 23 | Difficulties in the production of TGV metal lines and their technical solutions |
| 24 | 玻璃基光子解键合技术 |
| 25 | 基板积层胶膜材料 |
| 26 | 面向先进封装的磨划解决方案 |
| 27 | Application of Multi-physics Simulation Technology in Glass-based Advanced Packaging |
| 28 | Integrated passive on glass substrate |
| 29 | Design, development and application of high-performance IPD based on TGV |
| 30 | 下一代ABF载板-玻璃基及其潜在的机遇与挑战 |
| 31 | 面板级键合技术在FOPLP中的应用 |
更多相关议题征集中,演讲及赞助请联系李小姐:18823755657(同微信)
报名方式一:扫码添加微信,咨询会议详情
李小姐:18823755657(同微信)
邮箱:lirongrong@aibang.com

注意:每位参会者均需要提供信息
方式二:长按二维码扫码在线登记报名
或者复制网址到浏览器后,微信注册报名
https://www.aibang360.com/m/100272
阅读原文,点击报名





